1. Основы полупроводниковой электроники. Контактные явления
| Вид материала | Документы |
- Учебная программа по дисциплине электротехника и электроника лахтина, 44.8kb.
- Стенограмм а совещания Межфракционного депутатского объединения, 648.41kb.
- Стенограмм а совещания Межфракционного депутатского объединения, 752.44kb.
- Рабочая программа по дисциплине основы компьютерной электроники для студентов специальности, 487.92kb.
- Программа спецкурса "Практическая полупроводниковая электроника", 52.59kb.
- 1. Определение электронных приборов. Классификация электронных приборов по характеру, 163.96kb.
- Паспорт специальности 01. 04. 07 – физика конденсированного состояния, 1004.81kb.
- Методические указания по выполнению индивидуальных заданий по курсу «основы электроники», 383.4kb.
- Программа учебной дисциплины «Основы твердотельной и физической электроники» Специальность, 107.28kb.
- Физические основы электроники, 499.24kb.
| 1.1.1. Чистые полупроводники. Полупроводниковые материалы занимают промежуточное место по электропроводности между проводниками и изоляторами. Удельное сопротивление таких хороших проводников как серебро, медь, железо составляет 10-6…10-4 ом·см. Хорошие изоляторы: кварц, слюда, каучук, бумага — имеют удельное сопротивление от 1018 до 1010 ом·см. Промежуток удельных сопротивлений 106…10-3 ом·см занимают полупроводники. Для изготовления современных полупроводниковых приборов и особенно интегральных микросхем используются кристаллы чистых кремния и германия. Равномерная кристаллическая решетка в виде тетраэдров этих материалов, атомы которых имеют четыре валентных электрона на внешней оболочке, обеспечивают устойчивую структуру: соседние атомы кристалла попарно объединяются, так что каждый атом представляет собой устойчивую структуру с восемью электронами на внешней оболочке, в которую входят четыре соседних атома. На рис. 1.1. показана упрощенная плоская модель соединения атомов в кристалле чистого (беспримесного) кремния, где каждая линия между атомами обозначает ковалентную связь. Из-за неразличимости отдельных электронов любой валентный электрон оказывается принадлежащим в одинаковой степени всем атомам кристалла.  Рис. 1.1 Такая структура при температуре абсолютного нуля представляет собой изолятор, так как свободных электронов, обуславливающих электропроводность, в ней нет. Однако, при увеличении температуры даже такие крепкие связи могут нарушиться, что приведет к появлению, с одной стороны, свободных электронов, а с другой – к так называемым «дыркам» - местам в решетке, которые покинули электроны. Свободный электрон может занять дырку (произойдет рекомбинация). Дырку может занять ближайший связанный электрон, в результате чего уже на его бывшем месте образуется новая дырка. Всякий переход электрона от одного атома к другому сопровождается одновременно встречным переходом дырки. Если электрон имеет отрицательный заряд, то дырке условно приписывается положительный заряд такой же величины, как заряд электрона. Дырка как бы перемещается (движется) по кристаллу, также как электрон. Процесс образования под влиянием температуры пары электрон-дырка называют термогенерацией. Таким образом, в чистом полупроводнике одновременно хаотично блуждают электроны и дырки, причем их число одинаково, а при увеличении температуры это число увеличивается. При определенной температуре существует термодинамическое равновесие между генерацией и рекомбинацией, в результате чего в полупроводнике устанавливается некоторая, вполне определенная концентрация свободных носителей заряда. Среднее время существования пары электрон-дырка называют временем жизни носителей заряда, а расстояние L , пройденное частицей за время ее жизни – диффузионной длиной. Число свободных носителей заряда (электронов ni и дырок pi) в чистом1 полупроводнике определяется соотношением
где  - энергия активации, Т – абсолютная температура, k - постоянная Больцмана. - энергия активации, Т – абсолютная температура, k - постоянная Больцмана. При отсутствии внешнего электрического поля носители заряда движутся в полупроводнике хаотично. Это движение называют диффузией. Диффузионное движение зарядов обусловлено неравномерностью концентрации зарядов и тепловой энергией. Если теперь к кристаллу приложить внешнее напряжение, то может возникнуть небольшой ток, обусловленный дрейфом электронов и дырок, причем скорости дрейфа электрона и дырки разные, они зависят от их подвижности и напряженности электрического поля. В целом число свободных электронов и дырок незначительно. Например, в кристалле германия при комнатной температуре есть только 2 свободных электрона на 1010 атомов, но в 1 грамме германия имеется 1022 атомов. Таким образом, в одном грамме содержится 2·1012 свободных электронов, что и создает собственную проводимость чистого полупроводника. Однако для создания тока в один ампер потребуется 6·1018 электронов в секунду! Поэтому ток чистого полупроводника очень мал. Термогенерация свободных носителей, их дрейф, диффузия и рекомбинация очень важны для понимания процессов, происходящих в полупроводниках, но они не исчерпывают всего многообразия происходящих в полупроводнике явлений. Многие вопросы количественного анализа работы полупроводников базируются на зонной теории твердого тела2. 1 Параметры чистого полупроводника обозначаются обычно с индексом i от intrinsic – истинный. 2 Эти вопросы подробно рассматриваются в курсе «Физические основы микросхемотехники». |
1.1.2. Полупроводники n — p типа
Чистые i - полупроводники практически не используют. В них специально вводят атомы других элементов (примеси) трехвалентных (алюминий, галлий, индий, бор) или пятивалентных (мышьяк, фосфор, сурьма) элементов или их соединений. При этом на 107…108 атомов i - полупроводника вводят один атом примеси. Атомы пятивалентной примеси называются донорами: они увеличивают число свободных электронов. Каждый атом такой примеси добавляет один лишний электрон. При этом лишних дырок не образуется. Примесный атом в структуре полупроводника превращается в неподвижный положительно заряженный ион. Проводимость полупроводника теперь будет определяться в основном числом свободных электронов примеси. В целом такой тип проводимости называют проводимостью n–типа, а сам полупроводник – полупроводником n–типа.
При введении трехвалентной примеси одна из валентных связей полупроводника оказывается незаполненной, что эквивалентно образованию дырки и неподвижного отрицательно заряженного иона примеси. Таким образом, в этом случае увеличивается концентрация дырок. Примеси такого типа называются акцепторами, а проводимость, обусловленная введением акцепторной примеси, называют проводимостью р–типа. Полупроводник данного вида называют полупроводником р–типа.
Преобладающие носители заряда в полупроводнике называются основными. Так в полупроводнике n–типа основными носителями являются электроны, а неосновными – дырки, а в полупроводнике р–типа основными носителями являются дырки, а неосновными – электроны. Как видим, в отличие от проводимости проводников, в которых ток обусловлен направленным движением только электронов, в полупроводниках ток может быть обусловлен двумя типами носителей – электронами и дырками.
| 1.2.1. Электронно - дырочный переход без внешнего воздействия В полупроводниковых приборах и микросхемах применяют кристаллы, в которых можно выделить области собственного полупроводника (i -типа), области с донорными (n-типа) и акцепторными ( р -типа) примесями, границы между полупроводниками с разными типами проводимости и с различной концентрацией примеси, слои между полупроводником и металлом для организации внешних выводов или других функциональных назначений. Границу между двумя областями полупроводника с разными типами проводимости называют электронно-дырочным переходом или p-n - переходом. Переходы между двумя областями полупроводника одного и того же типа электропроводности, но с различными значениями удельной электрической проводимости называют изотипными переходами. Различают изотипные электронно-электронный (n-n+) и дырочно-дырочный (р-р+) переходы, причем знак «+» отмечает область с более высокой концентрацей соответствующих носителей заряда, полученной за счет большей концентрации примесей. В зависимости от используемых в переходах материалов их разделяют на гомогенные и гетерогенные. Гомогенным переходом называют переход, созданный в одном полупроводниковом материале (только в германии, только в кремнии, только в арсениде галлия). Гетерогенный переход создается на границе различных полупроводниковых материалов: германий-кремний, кремний-арсенид галлия. В зависимости от характера изменений концентрации примесей на границе различают ступенчатый и плавный p-n -переходы; в ступенчатом переходе изменение концентрации имеет скачкообразный характер. Здесь концентрация примесей на границе изменяется на расстоянии, соизмеримом с диффузионной длиной L. В плавном переходе такие изменения происходят на расстоянии, значительно превышающем L. Особую роль играют переходы металл-полупроводник (МП), являющиеся неотъемлемой частью каждого полупроводникового прибора. Различают невыпрямляющие (или омические) и выпрямляющие переходы МП. Выпрямляющие переходы имеют характеристики, зависящие от направления и величины приложенного к ним напряжения. Любой электрический переход не может быть создан путём простого соприкосновения двух полупроводниковых кристаллов. Для их изготовления используют специальные технологические приемы. В настоящее время наиболее распространены сплавные и диффузионные переходы. Для изготовления сплавного перехода на поверхности чистого полупроводника укрепляют небольшую «таблетку» примеси и помещают в печь, где происходит ее нагрев до температуры ниже точки плавления полупроводника, но выше точки плавления примеси. В результате происходит вплавление в кристалл примеси и формирование p-n-перехода. Для изготовления диффузионного p-n-перехода сначала полупроводниковую пластину с защитным окисным слоем предварительно обрабатывают, создавая «окна» заданной конфигурации на ее поверхности, а затем через них проводят диффузию примеси.1 При создании технологического контакта материалов с разными типами проводимости в области границы образуется небольшой слой, который и называется собственно p-n-переходом (рис.1.2)  Рис. 1.2 В этой области противоположно заряженные неподвижные ионы примесей создают отталкивающее поле для основных носителей заряда, и последние уходят из зоны соприкосновения. При этом движение основных носителей осуществляется за счет диффузии и рекомбинации с неосновными носителями. Для неосновных носителей (дырок в полупроводнике n -типа и электронов в полупроводнике р-типа) поле зарядов является ускоряющим, и они дрейфуют к «соседям». В результате на границе образуется обедненный носителями обоих типов слой, он имеет большое удельное сопротивление. Двойной слой зарядов неподвижных ионов примесей в слое не компенсированы электронами и дырками, что создает внутреннее электрическое поле с напряженностью Е . Это поле препятствует переходу дырок из области р в область n и электронов из области n в область р . Но оно же создает дрейфовый поток, перемещающий дырки из области n в область р и электроны из области р в область n (дрейф неосновных носителей). Обедненный слой и есть p-n-переход. В установившемся режиме дрейфовый поток равен диффузионному. При одинаковой концентрации основных носителей заряда справа и слева от границы, p-n-переход симметричен. Если концентрации не одинаковы, то говорят о несимметричном p-n-переходе. В этом случае слой с большей концентрацией основных носителей (меньшим удельным сопротивлением или большей проводимостью) называют эмиттером, а с меньшей концентрацией – базой. В базе ширина обедненного слоя шире. Поле Е оценивается потенциальным барьером для основных носителей, который препятствует их диффузии в полупроводник другого типа. В электротехнике величину потенциала определяют как работу на перемещение единичного положительного заряда. При этом график распределения потенциалов вдоль перехода имеет вид, представленный на рис.1.3. 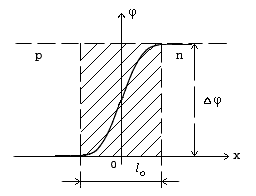 Рис. 1.3 При отсутствии внешнего поля величина потенциального барьера (или контактная разность потенциалов)  определяется соотношением определяется соотношением
где е = 1,6·10-19 кул – заряд электрона, k = 1,38·10-23 - постоянная Больцмана, Т- абсолютная температура, NА, NД – концентрация атомов акцепторов и доноров, nр, nn–концентрации дырок и электронов в р и n-областях,  - температурный потенциал. Для комнатной температуры температурный потенциал составляет примерно 0,025 вольт. Ширину (или толщину) несимметричного резкого p - n -перехода можно вычислить по формуле - температурный потенциал. Для комнатной температуры температурный потенциал составляет примерно 0,025 вольт. Ширину (или толщину) несимметричного резкого p - n -перехода можно вычислить по формуле
Она составляет обычно единицы микрометров. Как следует из формулы (1.3) для увеличения ширины p-n-перехода нужно использовать слабо легированные полупроводники, а для создания узкого перехода – сильно легированные. |
1.2.2. Электронно - дырочный переход при внешнем воздействии
При подключении к p-n-переходу внешнего напряжения плюсом к полупроводнику р-типа (прямое включение) потенциальный барьер для основных носителей уменьшается, через переход потечет ток, увеличивающийся с увеличением внешнего напряжения. При изменении полярности внешнего напряжения (обратное включение) потенциальный барьер увеличивается, весьма малый обратный ток определяется дрейфом только неосновных носителей.
Зависимость тока через переход от приложенного к нему внешнего напряжения определяет так называемую вольтамперную характеристику перехода (ВАХ). Для идеального p-n-перехода имеет место следующая зависимость тока от напряжения
 | (1.4) |
где Is - обратный ток насыщения неосновных носителей при обратном напряжении на переходе. При u >> 0,025 В величина
 , поэтому в этом случае можно считать
, поэтому в этом случае можно считать  , а при u << -0,025 В,
, а при u << -0,025 В,  , поэтому можно считать, что при больших обратных напряжениях обратный ток равен току насыщения.
, поэтому можно считать, что при больших обратных напряжениях обратный ток равен току насыщения.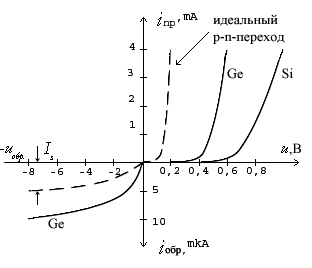
Рис. 1.4
На рис.1.4 пунктиром показана ВАХ идеального p - n -перехода в соответствии с выражением (1.4) для тока насыщения, равного 5 мкА, сплошные кривые соответствуют реальным переходам с кристаллом из германия ( Ge ) и кремния ( Si ). Для германия ток насыщения составляет примерно 10 мкА, а для кремния 10-15…10-13 А. В выражение (1.4) для малых токов кремниевого перехода в формулу (1.4) вводят коэффициент m =2…2,5:

Обычно графики для прямых и обратных токов представляются в разных масштабах как для токов, так и для напряжений, поскольку прямые напряжения составляют доли вольта при токах несколько миллиампер , а обратные напряжения – десятки вольт при токе доли и единицы микроампер.
В каждой точке нелинейной ВАХ можно найти производную, которая характеризует дифференциальные проводимость или сопротивление, сильно отличающиеся на прямой и обратной ветвях ВАХ.
На вид и положение ВАХ в значительной степени влияет температура p - n -перехода . Считается, что ток насыщения IS изменяется примерно в два раза у германиевых переходов и в 2,5 раза у кремниевых на каждые 10 градусов изменения температуры, при этом изменение падения напряжения на переходе составляет –(2…2,5) mВ/оС. В интегральных схемах это изменение достигает величины -1,5 mВ/оС.
Максимально допустимые температуры для германиевых переходов составляют 80…100оС, для кремниевых переходов – 150…200оС .
1.2.3. Пробой p-n-перехода
Пробоем называют резкое изменение режима работы p-n-перехода, находящегося под большим обратным напряжением. ВАХ для больших значений обратных напряжений показана на рис. 1.5
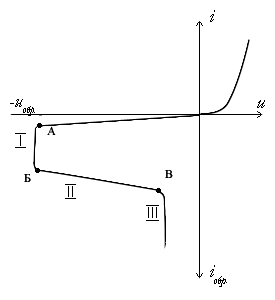
Рис. 1.5
Началу пробоя соответствует точка А. После этой точки дифференциальное сопротивление перехода стремится к нулю.
Различают три вида пробоя p-n-перехода:
- Туннельный пробой (А-Б),
- Лавинный пробой (Б-В),
- Тепловой пробой (за т.В).
Туннельный пробой возникает при малой ширине p-n-перехода (например, при низкоомной базе), когда при большом обратном напряжении электроны проникают за барьер без преодоления самого барьера. В результате туннельного пробоя ток через переход резко возрастает и обратная ветвь ВАХ идет перпендикулярно оси напряжений вниз.
Лавинный пробой возникает в том случае, если при движении до очередного соударения с нейтральным атомом кристалла электрон или дырка приобретают энергию, достаточную для ионизации этого атома, при этом рождаются новые пары электрон-дырка, происходит лавинообразное размножение носителей зарядов; здесь основную роль играют неосновные носители, они приобретают большую скорость. Лавинный пробой имеет место в переходах с большими удельными сопротивлениями базы («высокоомная база»), т.е. в p-n-переходе с широким переходом.
Тепловой пробой характеризуется сильным увеличением тока в области p-n-перехода в результате недостаточного теплоотвода.
Если туннельный и лавинный пробои, называемые электрическими, обратимы, то после теплового пробоя свойства перехода меняются вплоть до разрушения перехода.
Напряжения и токи в p-n-переходах зависят от параметров перехода и его температуры.



