Изучение полупроводникового диода Методические указания к лабораторной работе №9 по электромагнетизму Иваново 2006
| Вид материала | Методические указания |
- Методические указания к лабораторной работе по курсу «Информатика» для студентов всех, 254.72kb.
- Методические указания к лабораторной работе по курсу «Информатика» Основы алгоритмизации, 441.82kb.
- Методические указания к лабораторной работе по курсу "Техническая термодинамика" Иваново, 452.64kb.
- Методические указания к лабораторной работе по органической химии для студентов специальностей, 227.51kb.
- Методические указания к лабораторной работе по курсу «Механизация и автоматизация технологических, 316.57kb.
- Методические указания к лабораторной работе №3 по дисциплине «Периферийные устройства», 217.77kb.
- Для заданного полупроводникового диода, 92.07kb.
- Методические указания к лабораторной работе волгоград 2000, 186.18kb.
- Методические указания к лабораторной работе по курсу «Механизация животноводческих, 506.22kb.
- Методические указания к лабораторной работе по курсу Компьютерный анализ электронных, 270.05kb.
Федеральное агентство по образованию
Государственное образовательное учреждение
высшего профессионального образования
«Ивановский государственный энергетический университет
имени В.И. Ленина»
Кафедра физики
Изучение полупроводникового диода
Методические указания к лабораторной работе № 2.9
по электромагнетизму
Иваново 2006
Составители: И.А. КРЫЛОВ,
Е.Я. ПОДТЯЖКИН,
Г.А. ШМЕЛЕВА.
Редактор В.Х. КОСТЮК.
Лабораторная работа № 2.9 «Изучение полупроводникового диода» является частью лабораторного практикума по электромагнетизму.
Методические указания предназначены для самостоятельно выполнения студентами лабораторной работы. Они могут быть использованы как дополнение к основной учебной литературе по физике или в качестве самостоятельного методического пособия при изучении данной темы.
Утверждено цикловой методической комиссией ИФФ.
Рецензенты:
кафедра физики ГОУВПО «Ивановский государственный энергетический университет имени В.И. Ленина»;
канд.техн.наук В.Н. Егоров (кафедра Э и МС ИГЭУ)
Изучение полупроводникового диода
Методические указания к лабораторной работе 2.9
по электромагнетизму
Составители: Крылов Игорь Александрович
Подтяжкин Евгений Яковлевич
Шмелева Галина Александровна
Редактор Н.Б. Михалева
Лицензия ИД № 05285 от 4июля 2001 года
Подписано в печать Формат 60х841/16
Печать плоская. Усл.печ.л. 1,39 Тираж 150 экз. Заказ
ГОУВПО «Ивановский государственный энергетический
университет им. Ленина»
153003, г. Иваново, ул. Рабфаковская, 34
Содержание
Цель работы …………………………………………………………………..……4
Приборы и принадлежности………………………………………………..……...4
Теоретическая часть
- Элементы зонной квантовой теории твердых тел…………………..……..4
- Примесная проводимость полупроводников…………………………...... 9
- Электронно-дырочный переход (PN – переход)…………………..….....13
Экспериментальная часть
- Снятие вольт-амперной характеристики (ВАХ) диода, включенного в прямом направлении.....………………………...…………………………..18
- Снятие вольт-амперной характеристики (ВАХ) диода, включенного в обратном направлении ………………………………………………………..19
- Наблюдение осциллограммы напряжения на выходе трансформатора...21
- Наблюдение осциллограммы напряжения на выходе однополупериодного выпрямителя………………………………………………………………...21
- Наблюдение осциллограммы напряжения после однополупериодного выпрямителя с емкостным фильтром ………………………………………..22
- Наблюдение осциллограммы напряжения на выходе двухполупериодного выпрямителя…………………………………………………………………22
Контрольные вопросы……………………………………………………………..23
Библиографический список…………………………………………………… ..24
ЦЕЛЬ РАБОТЫ
Изучение элементов зонной теории твердых тел и явления примесной проводимости полупроводников. Изучение теории электронно-дырочных переходов. Ознакомление с практическими приемами измерения характеристик диодов и работой устройств, выполненных на их основе.
ПРИБОРЫ И ПРИНАДЛЕЖНОСТИ
Источники постоянного тока, амперметр и вольтметр, стенд с понижающим трансформатором, диодами и конденсатором, осциллограф, реостат.
ТЕОРЕТИЧЕСКАЯ ЧАСТЬ
1. Элементы зонной квантовой теории твердых тел
Зонная квантовая теория позволяет объяснить с единой точки зрения механизм проводимости металлов, полупроводников и диэлектриков. Поскольку подробное рассмотрение квантовой теории в данной главе не входит в нашу задачу, мы сформулируем два ее положения, нужные нам, в виде постулатов.
В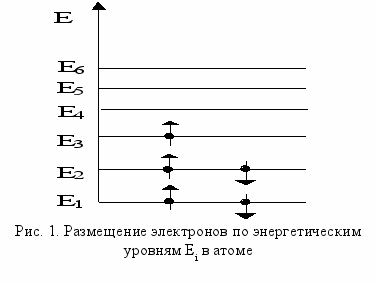 о-первых, энергия электрона в квантовых системах (атомах, молекулах, -кристаллах и т.д.) может принимать не любые значения, а лишь дискретный ряд значений, которые называют разрешенными уровнями энергии. В качестве примера на рис. .1 изображена энергетическая диаграмма атома, имеющая шесть разрешенных уровней энергии электронов.
о-первых, энергия электрона в квантовых системах (атомах, молекулах, -кристаллах и т.д.) может принимать не любые значения, а лишь дискретный ряд значений, которые называют разрешенными уровнями энергии. В качестве примера на рис. .1 изображена энергетическая диаграмма атома, имеющая шесть разрешенных уровней энергии электронов.
Во-вторых, электроны подчиняются принципу запрета Паули: в любой квантовой системе, например в атоме или в кристалле, в данном квантовом состоянии может находиться не более одного элек-трона. Обычно одному энергетическому уровню соответствуют два различных квантовых состояния электрона с противоположно направленными собственными моментами импульсов. (Собственный момент импульса элементарных частиц называют спином.) Поэтому принцип запрета Паули (В.Паули – швейцарский физик-теоретик) формулируют еще и таким образом: в квантовой системе на каждом энергетическом уровне может находиться не более двух электронов с противоположно направленными спинами. Такое попарное размещение электронов по уровням условно показано на рис. 1. Стрелками показано направление спинов.
При оценке распределения электронов по энергетическим уровням следует также учитывать, что система электронов стремится занять состояние с минимальной в данных условиях энергией. Поэтому заполнение электронами энергетических уровней начинается снизу: сначала заполняются уровни с наименьшими значениями энергии. В основном (невозбужденном) состоянии атома верхние разрешенные уровни остаются незаполненными (рис. 1). На эти уровни переходят электроны при сообщении им энергии, т.е. при возбуждении атома.
По мере сближения отдельных атомов между ними возникает взаимодействие, в результате которого их одинаковые энергетические уровни несколько смещаются друг относительно друга, образуя энергетические зоны из близко расположенных уровней.
Рассмотрим подробнее возникновение этих зон в воображаемом процессе формирования кристалла из отдельных атомов при их сближении. Схема этого процесса изображена на рис. 2.
Пусть, например, кристалл образуется из N отдельных одинаковых атомов, условная энергетическая диаграмма каждого из которых изображена на рис. 2,в. При этом энергетические уровни 2, 3 и 4 принадлежат внешним (валентным) электронам атома. В основном состоянии атома уровни 2 и 3 заполнены электронами, а уровень 4 остается свободным. Уровень 1 принадлежит внутренним электронам, расположенным ближе к ядру атома.
При сближении атомов усиливается взаимодействие их электронных оболочек. При достижении расстояния r1 между атомами начинается расщепление уровней валентных электронов: каждый уровень расщепляется на N близко расположенных уровней (рис. 2,б). Уровни внутренних электронов атомов начинают расщепляться при значительно меньших расстояниях между атомами (уровень 1 на рис. 2,б).
При дальнейшем сближении атомов расщепление энергетических уровней усиливается - происходит образование энергетических зон. При малых расстояниях между атомами может произойти перекрытие зон, получающихся из двух соседних уровней (уровни 2 и 3 на рис. 2,б). Число уровней в такой слившейся зоне равно сумме числа уровней, на которые расщепляются оба уровня атома. В конце концов при достижении определенного расстояния между атомами, соответствующего их равновесному расположению и равного d, формирование кристалла заканчивается.
На рис. 2,а изображена энергетическая диаграмма кристалла, имеющего равновесное расстояние между атомами, равное d. На этой диаграмме видно, что в результате расщепления энергетического уровня 4 отдельного атома в кристалле образуется энергетическая зона 4, называемая разрешенной зоной. В результате расщепления уровней 2 и 3 отдельного атома и перекрытия образовавшихся при этом зон в кристалле появляется разрешенная зона 23. Эти зоны разделены промежутками, в которых разрешенных значений энергии электронов нет. Такие промежутки называются запрещенными зонами. Поскольку в данном кристалле уровень 1 в зону не расщепляется, постольку в дальнейшем он и подобные ему уровни нас интересовать не будут.
На энергетической диаграмме некоторого кристалла (рис. 3) изображены для простоты только две разрешенные зоны. Нижняя зона образовалась из уровня, на котором находились один или два валентных электрона в основном состоянии атома. Эту зону мы будем называть валентной. Верхняя зона образовалась из уровня, не занятого валентными электронами в основном состоянии атома. Эту зону мы будем называть свободной. Между этими зонами расположена запрещенная зона с шириной Е.
Оказывается, что ширина разрешенных и запрещенных зон не зависит от размеров кристалла. Ширина разрешенных зон имеет величину порядка нескольких электрон-вольт (1эВ=1,610-19 Дж). Следовательно, густота расположения уровней в зоне зависит от размеров кристалла.
В кристалле размером в 1 см3 содержится примерно 1022 атомов. При ширине разрешенной зоны в 1 эВ уровни в ней будут располагаться на расстоянии 10-22 эВ друг от друга. Это з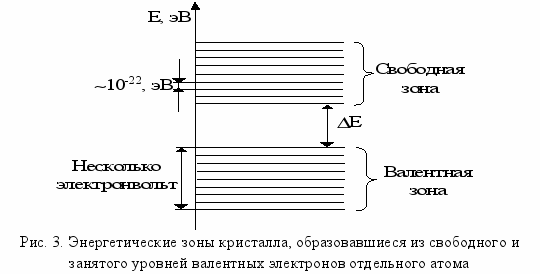
начение расстояния между энергетическими уровнями в зоне мы будем использовать в дальнейшем.
Заполнение валентной зоны электронами начинается снизу. В соответствии с принципом Паули на каждом уровне располагается не более двух электронов с противоположно направленными спинами. При температуре Т=0 К энергия кристалла имеет минимальное значение. В зависимости от степени заполнения валентной зоны при Т=0 К и от ширины Е запрещенной зоны всю совокупность кристаллов можно разбить на следующие три основные группы.
1) Валентная зона при Т=0 К заполнена электронами неполностью.
Н
апример, заполнение валентной зоны наполовину происходит, если на последнем занятом уровне в основном состоянии атома находится только один электрон (рис. 4,а). Частичное заполнение этой зоны происходит и в случае перекрытия зон, образовавшихся из занятого и свободного уровней атома (рис.4,б). Численные оценки показывают, что при помещении кристалла во внешнее электрическое поле, оно передает электронам, находящимся в валентной зоне, дополнительную энергию порядка 10-20 эВ. Этой энергии оказывается достаточно для перевода электронов на более высокие свободные уровни. Такие переходы эквивалентны приобретению ими скорости упорядоченного движения против электрического поля, т.е. возникновению электрического тока. Кристалл с подобной энергетической диаграммой представляет собой металл, а валентная зона на ней называется зоной проводимости.
2) Валентная зона при Т=0 К заполнена полностью, а ширина запрещенной зоны Е не превышает 23 эВ (рис. 5,а).
В этом случае для увеличения энергии электронов их надо перевести из заполненной валентной зоны на незанятые уровни свободной зоны. Это можно сделать, лишь сообщив им энергию, не меньшую, чем ширина Е запрещенной зоны. Электрическое поле сообщить электронам такую энергию не в состоянии. Поэтому при Т=0 К перевода электронов через запрещенную зону нет и полупроводник ведет себя как изолятор (рис. 5,а).
При температуре больше нуля энергии теплового движения оказывается достаточно, для того чтобы перевести часть электронов из валентной зоны в свободную. Электроны, переведенные в свободную зону и частично ее заполняющую, будут находиться в условиях, аналогичных тем, в которых находятся электроны валентной зоны в металле (рис. 5,б). Поэтому свободная зона становится зоной проводимости. Вследствие ухода некоторого количества электронов из валентной зоны в ней освобождается такое же количество мест на верхних уровнях (рис. 5,б). В результате в валентной зоне появляется возможность перехода электронов с нижних уровней на освободившиеся места верхних уровней.
Количественные оценки, однако, показывают, что число электронов, переведенных в свободную зону при комнатной температуре, сравнительно невелико. Следовательно, невелики будут концентрация носителей тока n в кристалле и его электропроводность n. Из-за сравнительно невысокой электропроводности такие кристаллы называют полупроводниками.
3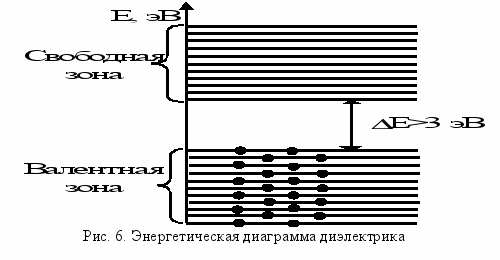 ) Валентная зона при Т=0 К заполнена полностью, а ширина запрещенной зоны Е больше 3 эВ (рис. 6).
) Валентная зона при Т=0 К заполнена полностью, а ширина запрещенной зоны Е больше 3 эВ (рис. 6).
При такой широкой запрещенной зоне тепловое движение уже не способно перевести заметное число электронов из валентной в свободную зону (рис. 6). Поэтому подобные кристаллы относят к диэлектрикам.
Следует отметить, что разделение кристаллов на полупроводники и диэлектрики носит в известном смысле условный характер. Четкая граница между ними отсутствует.
2. Примесная проводимость полупроводников
Полупроводниками являются вещества, у которых при Т=0 К валентная зона заполнена электронами полностью, а ширина запрещенной зоны не превышает 23 эВ (обычно не более 1 эВ) (рис. 5,а). Название «полупроводники» обусловлено тем, что по величине электропроводности эти вещества занимают промежуточное положение между металлами и диэлектриками. Однако характерной особенностью полупроводников является то, что их электрическое сопротивление падает с увеличением температуры, а не растет, как у металлов
Различают собственные и примесные полупроводники. К собственным относится ряд чистых химических элементов (германий Ge, кремний Si, селен Se и др.), а также многие химические соединения (арсенид галлия GaAs, антимонид индия InSb, карбид кремния SiC и др.). Содержание примесей в них не превышает 10-7 %. К примесным относят полупроводники с искусственно введенными примесями, которые и определяют их электрические свойства.
Изменяя концентрацию примесей, можно значительно изменять концентрацию носителей тока. Одни примеси вызывают увеличение концентрации только электронов проводимости. Такие примеси называют донорными. Другие примеси вызывают увеличение концентрации только дырок. Они называются акцепторными.
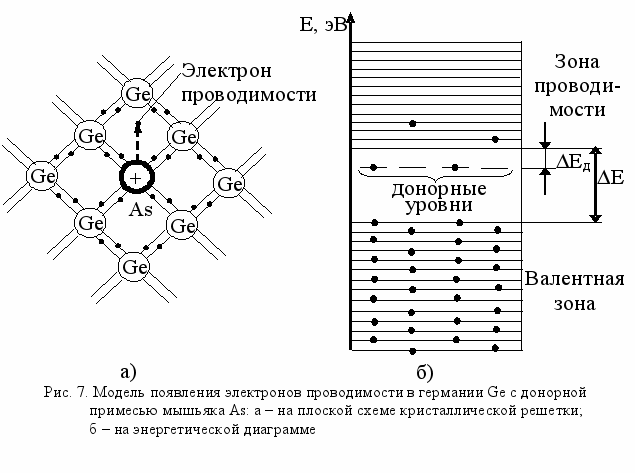
Донорные примеси. Атомы этих примесей имеют валентность, которая на единицу больше валентности основных атомов полупроводника. В качестве примера на рис. 7,а приведена плоская схема структуры кристаллической решетки 4-валентного германия Ge с примесью 5-валентных атомов мышьяка As. В решетке Ge каждый атом связан ковалентными (парно-электронными) связями с четырьмя равноотстоящими от него соседними атомами. На рис. 7,а эти связи условно изображены двойными линиями, а валентные электроны, обусловливающие их, черными кружочками. Для образования ковалентных связей с соседями 5-валентному атому мышьяка As достаточно только четырех электронов. Пятый валентный электрон в образовании связей не участвует и оказывается слабо связанным с атомом As. Его энергия связи Eд с этим атомом составляет всего 0,01 эВ. Даже при низких температурах он легко покидает атом As за счет энергии теплового движения и свободно перемещается в кристаллической решетке Ge, становясь электроном проводимости.
С точки зрения зонной теории все сказанное о донорных примесях выглядит следующим образом. Уровни пятого электрона примесного атома мышьяка As размещаются у дна зоны проводимости (рис. 7,б). Расстояние этих уровней до дна зоны Eд0,01 эВ значительно меньше ширины запрещенной зоны, которая у германия Ge равна E0,72 эВ. При сообщении электронам, находящимся на примесных уровнях, сравнительно небольшой энергии, равной Eд, они переходят в зону проводимости и становятся носителями тока. Образующиеся при этом избыточные положительные заряды локализуются на неподвижных атомах мышьяка As (рис. 7,а) и в электропроводности не участвуют.
Атомы примесей, являющиеся источниками электронов проводимости, называют донорами, а энергетические уровни этих примесей – донорными уровнями. Так как значение энергии Eд меньше ширины запрещенной зоны E примерно в 70 раз, то переход электронов с примесных уровней в зону проводимости начнется при гораздо более низких температурах, чем переход электронов из валентной зоны. Следовательно, в полупроводниках с донорной примесью основными носителями тока будут электроны. Поэтому такие полупроводники называются электронными полупроводниками или полупроводниками n-типа (от латинского слова negativ - отрицательный).Следует заметить, что в полупроводниках n-типа кроме основных носителей тока будет существовать некоторое количество неосновных носителей тока - дырок. Они образуются при переходах электронов из валентной зоны в зону проводимости. Количество неосновных носителей тока в них всегда меньше, чем основных.
При повышении температуры число электронов в зоне проводимости будет увеличиваться, а число электронов на донорных уровнях будет уменьшаться. В конце концов освободятся все донорные уровни - наступит примесное истощение. Дальнейший рост температуры будет приводить к увеличению числа электронов в зоне проводимости только за счет их перехода из валентной зоны. Поэтому при достаточно высокой температуре в полупроводнике с донорной примесью будет преобладать собственная проводимость.
Акцепторные примеси. Атомы этих примесей имеют валентность, которая на единицу меньше валентности основных атомов полупроводника. В качестве примера на рис. 8,а приведена схема кристаллической решетки 4-валентного кремния Si с примесью 3-валентных атомов бора B. Для образования ковалентных связей с четырьмя атомами кремния Si 3-валентному атому бора B не хватает одного электрона. Незаполненная связь атома B с одним из соседей может быть занята электроном, перешедшим из разорванной ковалентной связи двух соседних атомов кремния Si (слева на рис. 8,а). Для этого перехода требуется сравнительно небольшая энергия Eа, которая для атома B в решетке Si составляет примерно 0,045 эВ. Такое значение имеет энергия тепловых колебаний решетки даже при низких температурах. Вблизи же 3-валентного атома B, захватившего дополнительный электрон, возникает избыточный отрицательный заряд, который, будучи связанным, с этим атомом, в электропроводности участвовать не будет (рис. 8,а).
Все сказанное об акцепторных примесях с точки зрения зонной теории выглядит следующим образом. Незаполненные уровни атома B располагаются у потолка валентной зоны. Расстояние этих уровней до потолка зоны Eа0,045 эВ значительно меньше ширины запрещенной зоны Е, которая у Si равна 1,1 эВ. При сообщении электронам, находящимся в валентной зоне, сравнительно небольшой энергии, равной Eа, они переходят на примесные уровни бора B. Связываясь с атомами B, эти электроны теряют способность перемещаться в кристалле Si и в проводимости не участвуют. Носителями тока в таком примесном полупроводнике оказываются дырки, возникающие в валентной зоне в результате подобных переходов. Атомы примесей, легко захватывающие э
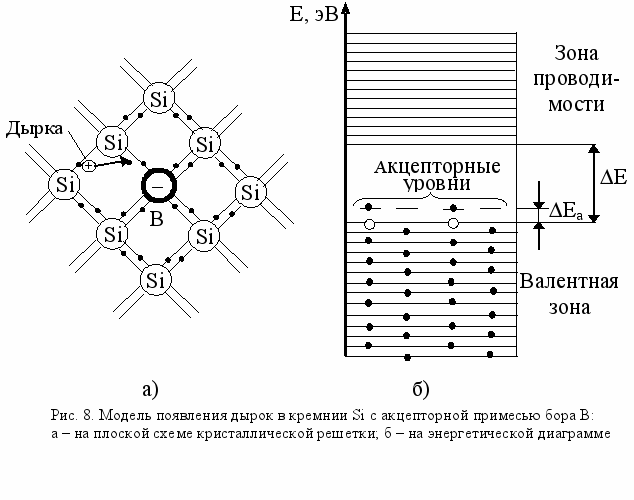
лектроны из валентной зоны с образованием в ней дырок, называются акцепторами (от латинского слова acceptare – принимать), а энергетические уровни этих примесей – акцепторными уровнями. Так как энергия Eа значительно меньше ширины запрещенной зоны Е, то переход электронов из валентной зоны на акцепторные уровни с образованием дырок в валентной зоне начнется при гораздо более низких температурах, чем переход электронов в зону проводимости. Следовательно, в полупроводнике с акцепторной примесью основными носителями тока будут дырки. Поэтому такие полупроводники называются дырочными полупроводниками или полупроводниками p-типа (от латинского слова positiv – положительный).
В полупроводнике p-типа кроме основных носителей тока будет существовать некоторое количество неосновных носителей тока – электронов. Они образуются при переходах электронов из валентной зоны в зону проводимости. Количество неосновных носителей тока всегда меньше, чем основных. При увеличении температуры все большее число электронов будет переходить на акцепторные уровни из валентной зоны с образованием в последней дырок – основных носителей тока. В конце концов все акцепторные уровни будут заняты – наступит примесное истощение. Дальнейший рост температуры будет приводить к увеличению числа дырок в валентной зоне только за счет перехода электронов из валентной зоны в зону проводимости. Таким образом, при достаточно высокой температуре в полупроводнике с акцепторной примесью будет преобладать собственная проводимость.
3. Электронно-дырочный переход
Э
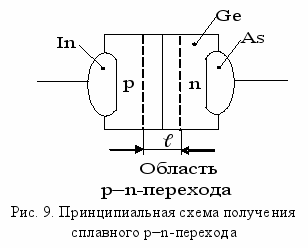 лектронно-дырочный переход (pn-переход) является основным элементом многих полупроводниковых приборов: диодов, транзисторов, интегральных схем и других. Он представляет собой тонкий слой на границе между двумя областями одного и того же полупроводникового кристалла, обладающими различными типами примесной проводимости: электронной и дырочной. В соответствии со сказанным о примесной проводимости pn-переход принципиально можно получить, например, следующим образом. Из монокристалла очень чистого германия Ge, обладающего только собственной проводимостью, вырезают тонкую пластинку. Затем вплавляют в нее с одной стороны таблетку мышьяка As (донорной примеси). Во время этой операции атомы As диффундируют в кристалл германия на некоторую глубину и создают в области проникновения примесную электронную проводимость. Эта область называется областью n-типа (рис. 9). С другой стороны пластинки Ge аналогичным образом вплавляют таблетку индия In (акцепторной примеси). Проводимость области германия, в которую диффундируют атомы In, становится дырочной. Эта область называется областью p-типа (рис. 9). На границе между областями p-типа и n- типа образуется очень тонкий переходный слой, называемый pn-переходом. Толщина pn-перехода
лектронно-дырочный переход (pn-переход) является основным элементом многих полупроводниковых приборов: диодов, транзисторов, интегральных схем и других. Он представляет собой тонкий слой на границе между двумя областями одного и того же полупроводникового кристалла, обладающими различными типами примесной проводимости: электронной и дырочной. В соответствии со сказанным о примесной проводимости pn-переход принципиально можно получить, например, следующим образом. Из монокристалла очень чистого германия Ge, обладающего только собственной проводимостью, вырезают тонкую пластинку. Затем вплавляют в нее с одной стороны таблетку мышьяка As (донорной примеси). Во время этой операции атомы As диффундируют в кристалл германия на некоторую глубину и создают в области проникновения примесную электронную проводимость. Эта область называется областью n-типа (рис. 9). С другой стороны пластинки Ge аналогичным образом вплавляют таблетку индия In (акцепторной примеси). Проводимость области германия, в которую диффундируют атомы In, становится дырочной. Эта область называется областью p-типа (рис. 9). На границе между областями p-типа и n- типа образуется очень тонкий переходный слой, называемый pn-переходом. Толщина pn-перехода  составляет примерно 10-610-7 м.
составляет примерно 10-610-7 м.Следует заметить, что на практике для получения pn-перехода берут пластинку германия, уже обладающую примесной электронной проводимостью, и вплавляют в нее таблетку индия In (акцепторной примеси). При этом добиваются, чтобы в области, в которую обильно диффундируют атомы In, электронная проводимость сменилась на дырочную. В результате на границе областей германия с электронной и вновь образованной дырочной проводимостями образуется pn-переход.
Рассмотрим подробнее pn-переход, изображенный на рис. 9. На рис. 10, а приведены графики одного из возможных вариантов изменения концентраций акцепторной примеси индия In и донорной примеси мышьяка As в области pn-перехода в направлении, перпендикулярном к границе раздела. В соответствии с этими графиками на рис. 10,б показано расположение атомов In и As на плоской схеме кристаллической решетки германия Ge. Для того чтобы излишне не з

агромождать рисунок, сами атомы Ge на нем не изображены.
В правой части рис. 10,б изображена область кристалла германия n-типа, в которой донорами являются атомы мышьяка As. Основными носителями тока в ней являются электроны, отданные донорами в зону проводимости. При этом доноры превращаются в положительные ионы As. Кроме того, в области n-типа имеется небольшое число неосновных носителей тока – дырок, которые образуются в результате тепловых переходов электронов из валентной зоны в зону проводимости.
В левой части рис. 10,б изображена область кристалла германия p-типа, в которой акцепторами являются атомы индия In. Основными носителями тока в ней являются дырки, образующиеся в результате захвата акцепторами электронов из валентной зоны. При этом сами акцепторы становятся отрицательными ионами. Так же, как и в области n-типа, здесь имеется небольшое число неосновных носителей тока – электронов, появляющихся в зоне проводимости вследствие их переброски тепловым движением из валентной зоны.
Таким образом, в области кристалла n-типа образуется много электронов, которые будут диффундировать в область p-типа, где их мало. Дырки будут диффундировать во встречном направлении из области p-типа в область n-типа. При этом дырки и электроны будут рекомбинировать друг с другом (взаимно уничтожаться). В результате pn-переход толщиной
 оказывается сильно обедненным носителями тока – электронами и дырками (рис. 10,б).
оказывается сильно обедненным носителями тока – электронами и дырками (рис. 10,б).Обеднение носителями тока pn-перехода, во-первых, приводит к увеличению его электрического сопротивления, а во-вторых, приводит к образованию двойного электрического слоя на границе между областями кристалла p-типа и n-типа. В правой части pn-перехода толщиной
 (рис. 10,б) заряд положительных ионов донорной примеси As уже не будет компенсироваться электронами проводимости, в результате чего эта часть приобретает избыточный положительный заряд (рис. 11,а). В левой же части pn-перехода толщиной
(рис. 10,б) заряд положительных ионов донорной примеси As уже не будет компенсироваться электронами проводимости, в результате чего эта часть приобретает избыточный положительный заряд (рис. 11,а). В левой же части pn-перехода толщиной  (рис. 10,б) заряд отрицательных ионов акцепторной примеси In не будет компенсироваться дырками, в результате чего эта часть приобретает избыточный отрицательный заряд (рис. 11,а). В итоге возникает двойной электрический слой, который создает контактное электрическое поле, характеризующееся напряженностью
(рис. 10,б) заряд отрицательных ионов акцепторной примеси In не будет компенсироваться дырками, в результате чего эта часть приобретает избыточный отрицательный заряд (рис. 11,а). В итоге возникает двойной электрический слой, который создает контактное электрическое поле, характеризующееся напряженностью  и разностью потенциалов на его границах, составляющей несколько десятых долей вольта (рис. 10,б и рис. 11,а).
и разностью потенциалов на его границах, составляющей несколько десятых долей вольта (рис. 10,б и рис. 11,а).Контактное электрическое поле представляет собой достаточно высокий потенциальный барьер для основных носителей тока. Вследствие этого область контактного поля преодолевается только очень небольшим числом наиболее быстрых основных носителей тока. Поэтому ток основных носителей Iосн через pn-переход мал (рис. 11,а). Наоборот, для неосновных носителей тока контактное поле
 способствует переходу через pn-переход – они «скатываются» с потенциального барьера, а не преодолевают его. Но ток неосновных носителей Iнеосн ограничен их очень маленькой концентрацией и от напряженности контактного поля почти не зависит. Направлен этот ток навстречу току основных носителей (рис. 11,а). В конце концов равновесие между областями p-типа и n-типа устанавливается при такой напряженности Eк контактного поля, при которой оба тока компенсируют друг друга Iосн=Iнеосн (рис. 11,а).
способствует переходу через pn-переход – они «скатываются» с потенциального барьера, а не преодолевают его. Но ток неосновных носителей Iнеосн ограничен их очень маленькой концентрацией и от напряженности контактного поля почти не зависит. Направлен этот ток навстречу току основных носителей (рис. 11,а). В конце концов равновесие между областями p-типа и n-типа устанавливается при такой напряженности Eк контактного поля, при которой оба тока компенсируют друг друга Iосн=Iнеосн (рис. 11,а).Рассмотрим влияние внешнего электрического поля на свойства pn-перехода. Сначала подадим на кристалл, содержащий pn-переход, внешнее напряжение Uпрям так, чтобы «+» источника тока был подключен к p-области крис
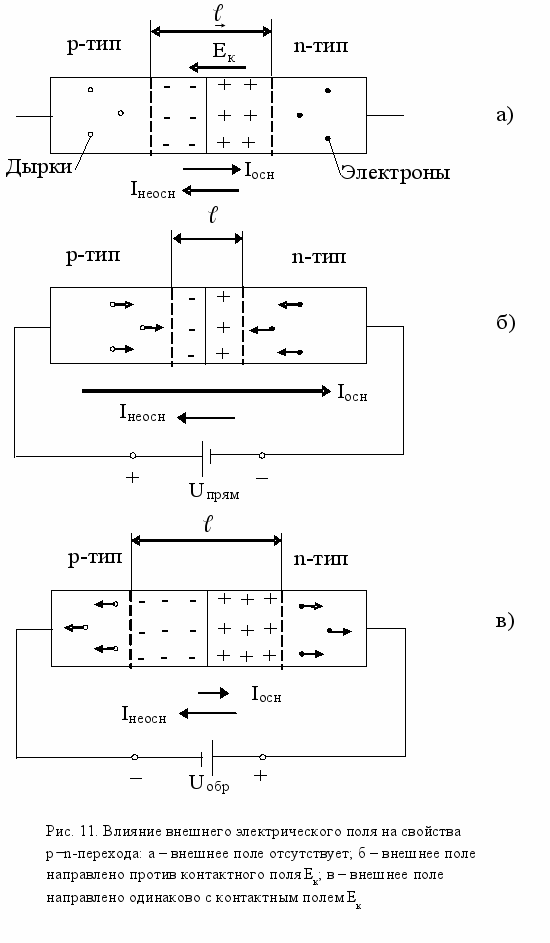
талла, а «» был подключен к n-области (рис. 11,б). Такое напряжение называется прямым. В этом случае внешнее электрическое поле будет направлено навстречу контактному полю Eк и будет ослаблять его, что приведет к уменьшению потенциального барьера. В результате ток основных носителей Iосн увеличится, а ток неосновных носителей Iнеосн останется прежним, так как он не зависит от напряженности контактного поля. Следовательно, через pn-переход будет протекать результирующий ток, называемый прямым:
 .
.Он будет быстро нарастать при увеличении Uпрям. Внешнее поле при этом «поджимает» основные носители к границе раздела между областями, вследствие чего толщина
 слоя pn-перехода, обедненного носителями тока, уменьшается (рис. 11,б). Соответственно уменьшается и сопротивление перехода, причем тем сильнее, чем больше напряжение. Поэтому зависимость прямого тока Iпрям от напряжения Uпрям является нелинейной (рис. 12,а).
слоя pn-перехода, обедненного носителями тока, уменьшается (рис. 11,б). Соответственно уменьшается и сопротивление перехода, причем тем сильнее, чем больше напряжение. Поэтому зависимость прямого тока Iпрям от напряжения Uпрям является нелинейной (рис. 12,а).Теперь подадим на кристалл с pn-переходом напряжение Uобр так, чтобы «+» источника тока был подключен к n-области кристалла, а «» был подключен к p-области (рис. 11,в). Такое напряжение называется обратным.
Внешнее электрическое поле будет направлено одинаково с контактным полем Eк и будет усиливать его, что приведет к увеличению потенциального барьера. В результате с увеличением Uобр небольшой ток основных носителей Iосн будет уменьшаться, стремясь к нулю. Ток неосновных носителей Iнеосн, как и в предыдущем случае, останется прежним.
В

итоге результирующий ток, называемый обратным (
 ), быстро достигнет насыщения и станет равным Iобр=Iнеосн (рис. 12,а). При достижении Uобр определенной величины сила Iобр начинает резко возрастать, что обусловлено электрическим пробоем pn-перехода (рис. 12,а). Поэтому для каждого pn-перехода указывается предельное значение Uобр, при котором он может надежно работать без пробоя.
), быстро достигнет насыщения и станет равным Iобр=Iнеосн (рис. 12,а). При достижении Uобр определенной величины сила Iобр начинает резко возрастать, что обусловлено электрическим пробоем pn-перехода (рис. 12,а). Поэтому для каждого pn-перехода указывается предельное значение Uобр, при котором он может надежно работать без пробоя.Внешнее поле, возникающее в кристалле при приложении к нему Uобр, «оттягивает» основные носители от границы раздела между областями, что приводит к увеличению толщины
 слоя pn-перехода, обедненного носителями (рис. 11,в). Вследствие этого увеличивается сопротивление перехода. Поэтому сопротивление pn-перехода в обратном направлении гораздо больше, чем в прямом.
слоя pn-перехода, обедненного носителями (рис. 11,в). Вследствие этого увеличивается сопротивление перехода. Поэтому сопротивление pn-перехода в обратном направлении гораздо больше, чем в прямом.Описанная вольт-амперная характеристика pn-перехода (рис. 12,а) позволяет использовать его для выпрямления переменного электрического тока. Если к pn-переходу приложить синусоидальное переменное напряжение U (рис. 12,б), то через переход потечет практически выпрямленный ток I , так как Iпрям>>Iобр (рис. 12,в).
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
4. Снятие вольт-амперной характеристики (ВАХ) диода, включенного в прямом направлении
Собирается схема, показанная на рис. 13. Источником регулируемого напряжения (03В) служит стабилизатор, включаемый в сеть переменного тока с напряжением 220 В. Данные вольтметра и амперметра приведены под рис.13.
П
 еред включением стабилизатора нужно повернуть против часовой стрелки до упора ручку регулировки выходного напряжения на нем. При этом напряжение на выходе стабилизатора будет минимальным.
еред включением стабилизатора нужно повернуть против часовой стрелки до упора ручку регулировки выходного напряжения на нем. При этом напряжение на выходе стабилизатора будет минимальным.Включив стабилизатор, увеличивают ток через диод до тех пор, пока стрелка амперметра не установится на значении 0,2 А. Производят первый отсчет тока и напряжения. Затем увеличивают ток ступенями по 0,2 А, снимая при этом показания вольтметра. Ток увеличивают до 1,4 – 1,6 А .
Данные заносят в табл.1 , где в первой колонке указывают номер опыта, во второй – отсчет в делениях шкалы амперметра, в третьей – цену деления шкалы амперметра (достаточно указать один раз), в четвертой – вычисленный с учетом цены деления шкалы ток через диод в амперах. В пятой – седьмой колонках аналогично записываются показания вольтметра.
Таблица 1.Результаты измерений ВАХ диода, включенного в прямом направлении
| NN п/п | Прямой ток диода | Напряжение на диоде | ||||
| в дел. шкалы | цена деления | в амперах | в дел. шкалы | цена деления | В вольтах | |
| 1 | 2 | 3 | 4 | 5 | 6 | 7 |
По данным табл. 1 строят график ВАХ, откладывая по вертикали ток в амперах, по горизонтали – напряжение в вольтах (см. рис.12,а).
График строится на миллиметровой бумаге. Масштаб выбирается так, чтобы экспериментальные точки укладывались на 10 15 см, масштабные метки наносятся внутрь поля графика длиной 2 мм, стрелки на концах координатных осей не ставятся. Экспериментальные точки отмечаются на графике в виде ясно различимых кружочков, треугольников или квадратиков. Кривую проводят плавно. Если на пути кривой попадается кружочек, линия не должна его зачеркивать. На вертикальной оси, в конце ее, ставится буквенное обозначение откладываемой величины тока в амперах ( I, A ), на конце горизонтальной оси – напряжения в вольтах ( U, B ). График следует надписать, указать тип диода и дать расшифровку принятых обозначений.
5. Снятие вольт-амперной характеристики диода, включенного
в обратном направлении
Собирается схема по рис. 14. В качестве источника используется регулируемый выпрямитель ВУП-2 постоянного тока с напряжением от 0 до 250 В. Выпрямитель включается в сеть переменного тока на 220 В. Данные вольтметра и миллиамперметра приведены под рис.14.
Перед включением выпрямителя ВУП-2 поворачивают ручку регулировки выходного напряжения до упора против часовой стрелки. При этом напряжение на выходе выпрямителя будет минимальным.
Включив выпрямитель, увеличивают напряжение на диоде до тех пор, пока оно не достигнет 20 В. При этом значении производят первый отсчет напряжения и силы тока через диод. Затем увеличивают напряжение ступенями по 20 В до 220 В, снимая при этом показания вольтметра и миллиамперметра. После окончания измерений напряжение плавно уменьшают до минимума и выключают выпрямитель ВУП-2.
П
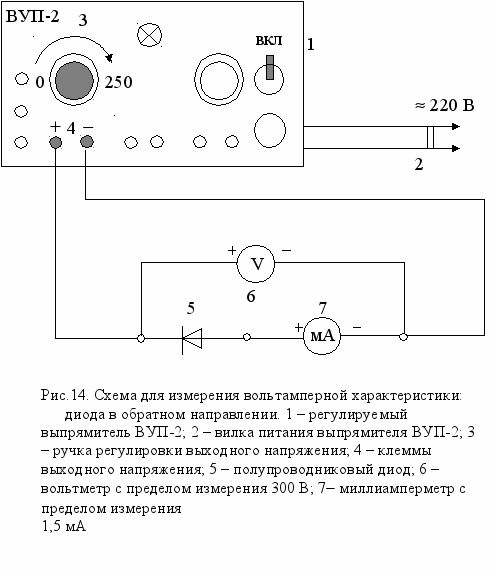
олученные данные заносят в табл. 2. В первой колонке таблицы указывают номер опыта по порядку, во второй – отсчет тока по миллиамперметру в делениях шкалы, в третьей – цену деления шкалы миллиамперметра (достаточно указать один раз), в четвертой – силу тока через диод в миллиамперах, вычисленную с учетом цены деления шкалы. В пятой - седьмой колонках записываются аналогичным образом показания вольтметра.
Таблица 2 Результаты измерений ВАХ диода, включенного в обратном направлении
| NN п/п | Обратный ток диода | Напряжение на диоде | ||||
| в дел. шкалы | цена деления | в милли амперах | в дел. шкалы | цена деления | в вольтах | |
| 1 | 2 | 3 | 4 | 5 | 6 | 7 |
По данным табл. 2 строят график обратной ВАХ диода, откладывая по вертикали вниз ток в миллиамперах, а по горизонтали справа - налево напряжение в вольтах (см. рис.12,а). При построении графика следует учитывать правила, изложенные в конце разд. 4.
6. Наблюдение осциллограммы напряжения на выходе
трансформатора
С
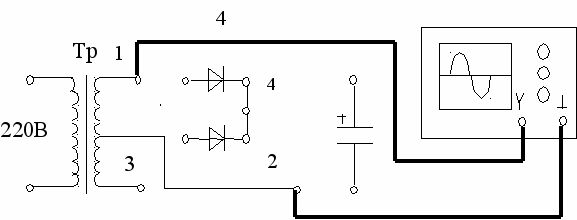
обирают схему, показанную на рис. 15 (соединительные провода на схеме показаны более толстой линией).
Рис.15. Схема наблюдения осциллограммы напряжения
Среднюю точку 2 трансформатора Тр соединяют с корпусом осциллографа (клемма, помеченная знаком ). Точку 1 соединяют со входом вертикального усилителя осциллографа (осциллограф предварительно включен в сеть и настроен лаборантом). Наблюдают кривую на экране осциллографа и зарисовывают ее на миллиметровой бумаге.
Присоединив провода, идущие к осциллографу, к точкам 1 и 3 трансформатора, убеждаются, что амплитуда синусоиды удвоилась.
7. Наблюдение осциллограммы напряжения на выходе
однополупериодного выпрямителя
С

обирается схема по рис. 16 (соединительные провода на схеме показаны более толстой линией).
Рис.16 Схема однополупериодного выпрямителя
Движок реостата Rн ставят примерно посередине. Присоединяют провода осциллографа к точкам 4 и 2. Необходимо следить за тем, чтобы провод от клеммы осциллографа «земля» оказался присоединенным к точке 2. На экране осциллографа появится срезанная в нижнем полупериоде синусоида. Наблюдают кривую на экране осциллографа и зарисовывают ее на миллиметровой бумаге.
8. Наблюдение осциллограммы напряжения после
однополупериодного выпрямления с емкостным фильтром
С
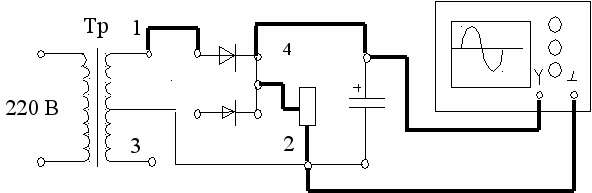
обирают схему по рис. 17 (соединительные провода на схеме показаны более толстой линией).
Рис. 17. Схема однополупериодного выпрямителя с емкостным фильтром
Движок реостата ставят в верхнее (по схеме) положение. К точкам 4 и 2 присоединяют осциллограф и срисовывают получившуюся пилообразную кривую. Переводят движок реостата вниз примерно на две трети. Ток нагрузки выпрямителя возрастает. Форма кривой на экране осциллографа изменится. Срисовывают ее на миллиметровую бумагу.
- Наблюдение осциллограммы напряжения на выходе
двухполупериодного выпрямителя
Собирают схему по рис. 18 (соединительные провода на схеме показаны более толстой линией).
Поившееся на экране осциллографа изображение выпрямленного напряжения срисовывают на миллиметровку. По окончании работ первичную обмотку трансформатора отсоединяют от сети, осциллограф выключают.

Рис. 18. Схема двухполупериодного выпрямителя
КОНТРОЛЬНЫЕ ВОПРОСЫ
- Сформулируйте принцип запрета Паули.
- Какие уровни занимаются электронами в невозбужденном состоянии в первую очередь?
- Каким образом образуются энергетические зоны в кристаллах?
- Какие зоны называются запрещенными?
- Каково примерное расстояние между ближайшими энергетическими уровнями в разрешенных зонах?
- Какую примерно дополнительную энергию может передать электрическое поле электронам валентной зоны?
- Чем с точки зрения зонной теории отличаются металлы, полупроводники и диэлектрики?
- Какие полупроводники называются собственными?
- Какие примеси называются донорными, а какие акцепторными?
- Какова валентность атомов донорных примесей по сравнению с основными атомами полупроводника?
- Где располагаются донорные уровни в запрещенной зоне?
- Какие частицы являются основными и какие неосновными носителями тока в полупроводниках с донорными примесями?
- Какое явление называется примесным истощением?
- Какова валентность атомов акцепторных примесей по сравнению с основными атомами полупроводника?
- Где располагаются акцепторные уровни в запрещенной зоне?
- Какие частицы являются основными и какие неосновными носителями тока в полупроводниках с акцепторными примесями?
- Что представляет собой pn-переход?
- Каковы примерные размеры pn-перехода?
- Каким способом изготавливается pn-переход?
- Как образуется двойной электрический слой на границе полупроводников с разным типом проводимости?
- Для каких носителей тока контактное электрическое поле представляет потенциальный барьер?
- Что происходит при подаче прямого напряжения на pn-переход?
- Что происходит при подаче обратного напряжения на pn-переход?
- Как изменяется сила тока, протекающего через pn-переход, при подаче на него напряжения изменяющегося по гармоническому закону?
- Поясните вид, полученных экспериментально, вольт-амперных характеристик диода в прямом и обратном направлении.
- Зависимость каких величин наблюдается на экране осциллографа при работе с однополупериодным выпрямителем (пункт 4.4) ?
- Почему при уменьшении сопротивления реостата в пункте 4.5 пульсации напряжения на выходе выпрямителя возрастают?
- Предложите схему двухполупериодного выпрямителя на диодах, если в используемом трансформаторе имеется только одна вторичная обмотка.
БИБЛИОГРАФИЧЕСКИЙ СПИСОК
- Савельев, И.В. Курс общей физики / И.В. Савельев, Т.3.- М: Наука, 1987.
- Иродов, И.Е. Физика макросистем. Основные законы./ Е.И. Иродов
/М: СПб., Физматлит,2001.
- Волков, В.Н. Физика / В.Н. Волков, Г.И. Рыбакова, М.И. Шипко, Т.2; Ивановский государственный энергетический университет.- Иваново, 1993.
- Крылов, И.А. Физические основы электромагнитных процессов в технических средствах автоматизации: учеб. пособие / И.А. Крылов; Ивановский государственный энергетический университет.- Иваново, 2004.
- Блейкмор, Дж. Физика твердого тела / Дж.Блейкмор.- М: Мир, 1988.
- Гольдин, Л.Л., Введение в квантовую физику / Л.Л. Гольдин, Г.И. Новикова.-М: Наука, 1988.