Основы микроэлектроники (курс лекций)
| Вид материала | Курс лекций |
- Лекция №11 Сжатие изображений Курс лекций «Алгоритмические основы машинной графики», 54.41kb.
- Основы семейной психопедагогики (курс лекций), 11111.59kb.
- О. В. Свидерская Основы энергосбережения Курс лекций, 2953.76kb.
- Курс лекций введение в профессию "социальный педагог", 4415.45kb.
- Курс лекций по дисциплине " основы компьютерных технологий" Часть I. Microsoft Word, 432.92kb.
- Курс лекций Барнаул 2001 удк 621. 385 Хмелев В. Н., Обложкина А. Д. Материаловедение, 1417.04kb.
- Курс лекций. Учебное пособие / В. Е. Карпов, К. А. Коньков, 68.87kb.
- Курс лекций по автоматизированному электроприводу для итр проектный организаций с применением, 24.37kb.
- Программа курса лекций (1 курс магистратуры, 1 сем., 36 ч, экзамен) Профессор,, 34.75kb.
- Основы политологии: Курс лекций. 2-е изд., доп. Ростов на/Дону.: Феникс, 1999. 573, 14.9kb.
Конец лекции 21
Лекция 22
Пример расчета параметров МДП-транзистора
ЗАДАНО:
1. Структура: МДП-транзистор на основе кремния, с алюминиевой металлизацией и подзатворным диэлектриком из двуокиси кремния, и индуцированным каналом n-типа.
2. Геометрические размеры: Толщина SiO2 d = 0,1 мкм, длина канала L = 5 мкм, ширина Z = 500 мкм.
3. Электрофизические параметры: Концентрация акцепторной примеси Na = 3.1016 см-3, плотность поверхностных зарядов Nss = 2.1011 см-2, подвижность электронов в канале n = 600 см2/(В.с), разность работ выхода алюминия и кремния с этой концентрацией примеси (в вольтах) V0 = –0,8 В, диэлектрическая проницаемость двуокиси кремния SiO2 = 4.
ОПРЕДЕЛИТЬ:
1. Основные электрические параметры: пороговое напряжение Uпор, емкость затвор-канал Сзк.
2. Передаточную характеристику Ic = f(Uзи) и ее крутизну в области насыщения.
3. Семейство выходных характеристик Ic = f(Ucи) при разных Uзи .
4. Максимальную рабочую частоту fmax.
ПОРЯДОК РАСЧЕТА:
1. Определяем основные электрические параметры. Пороговое напряжение рассчитываем по формуле (1), выведенной на прошлой лекции. При расчете нужно учесть знаки входящих в формулу слагаемых. Для МДП-транзистора с каналом n-типа положительный поверхностный потенциал в SiO2 и к.р.п. для МДП-структуры, в сумме составляющие V0F = V0 + Qss/C0, будут способствовать образованию индуцированного канала, поэтому знаки соответствующих слагаемых будут противоположными знаку дополнительно прикладываемого напряжения V0B, необходимого для образования инверсионного слоя. Итак, пороговое напряжение
Uпор = V0F + V0B = V0 + Qss/C0 + 2VFS + Q /C0 . (1)
– 43 – Лекция 22
Вычислим компоненты формулы, необходимые для определения порогового напряжения. Удельная емкость между затвором и подложкой (когда S = 1)
C0 = SiO2 . 0 / dSiO2 = 4 8,86.10–14/(0,1.10–4) = 3,54.10-8 Ф/см2 = 354 пФ/мм2.
Напряжение на ОПЗ — то, которое равно 2VFS:
2VFS = 2 T .ln(Na/ni) = 2 0,026 ln(3.1016/(2.1010) = 0,74 В.
Ширина ОПЗ в области возле канала под затвором:
______________ _____________________________________
= ..Si.2VFS/(q.Na) = 2 12 8,86.10-14 0,74 / (1,6.10–19 3.1016) =
= 1,8 . 10–5 см = 0,18 мкм.
Плотность заряда в ОПЗ:
Q = qNa = 1,6.10–19 3.1016 1,8.10–5 = 8,64.10–8 Кл/см2.
Плотность поверхностного заряда в двуокиси кремния:
Qss = q.Nss = 1,6.10–19 2.1011 = 3,2.10–8 Кл/см2.
Теперь, когда все элементы формулы (1) у нас определены, можно найти пороговое напряжение:
Uпор = –0,8 – (3,2.10–8) / (3,54.10–8) + 0,74 + (8,64.10-8) / (3,54.10–8) = –1,7 + 3,18 = 1,48 В.
(Пойдем на маленькую хитрость: для красоты графиков удобнее взять цифру Uпор = 1,3 В.)
Здесь следует воспользоваться формулами для крутого и пологого участков ВАХ (формулы взяты из курса ФОЭП, прочитанного в прошлом семестре).
Для крутого участка (нарастания тока в канале) (здесь индекс "д" — диэлектрик):
0дn Uси2
Ic = –––––––– [(Uзи – Uпор) . Uси – –––– ]. (2)
d . L 2
Для участка насыщения (после перекрытия канала):
0дn
Ic = –––––––– (Uзи – Uпор)2 . (3)
2 d . L
2. Рассчитываем передаточную характеристику по формуле (3) (размеры в см):
4 8,86.10–14 600 500.10–4
Ic = ––––––––––––––––––––––––– (Uзи – 1,3)2 = 1,05.10–3(Uзи – 1,3)2 .
2 0,1.10–4 5.10–4
Задавая значения Uзи, получаем:
| Uзи, В | 1,8 | 2,3 | 2,8 | 3,3 | 3,8 | 4,3 | 4,8 | 5,3 |
| Ic, мА | 0,25 | 1,05 | 2,4 | 4,2 | 6,6 | 9,4 | 12,9 | 16,8 |
| S, мА/В | 1,05 | 2,1 | 3,2 | 4,2 | 5,3 | 6,3 | 7,4 | 8,5 |
– 44 – Лекция 22 – 23
Передаточная характеристика изображена на рисунке внизу и слева. Для тех же значений Uзи рассчитываем крутизну по формуле (производная от (3)):
S = дnZ/(d.L) (Uзи – Uпор) = 2,1.10–3 (Uзи– 1,3) (см. третью строку таблицы) .
3. Расчет выходных характеристик. Строится только восходящий участок по формуле (2). Точки даны для трех Uзи: 3,3; 4,3; и 5,3 В. Границу насыщения определяем с помощью передаточной характеристики и условия Uси,нас = Uзи – Uпор.

4. Для оценки частотных свойств транзистора нам еще понадобится емкость "затвор-канал":
Сзк = д L Z / d = С0 L Z .
Удельная емкость была уже вычислена ранее: С0 = 354 пФ/мм2. Поэтому
Сзк = 354 5.10–3 500.10–3 = 0,88 пФ.
Максимальную рабочую частоту определяем при Uзи = 2 Uпор = 2,6 В по формуле
fmax = S/(2.Cзк) = 2,75.10–3 / (2 3,14 9.10–13) = 5 . 108 Гц.
(Конец расчета)
(Конец лекции 22)
Лекция 23
Репрограммируемые логические элементы на основе МДП-структур
Данные приборы относятся к классу так называемых электрически программируемых матриц. Если нужно быстро сделать ПЗУ (пассивное запоминающее устройство, информацию в котором не требуется изменять — часто встречающиеся константы, подпрограммы вычисления функций и т.д.) или какой-то дешифратор, который не нужно перестраивать, можно использовать так называемые ПЛМ — программируемые логические матрицы. Это — диоды и транзисторы, выстроенные рядами в длину и в ширину и имеющие какие-то проводные связи друг с другом — шины, отводы, перемычки и т.д. Подачей достаточно больших токов на перемычки их пережигают и создают раз и навсегда фиксированную функцию БИС. То же самое можно сделать, подавая достаточно большие Vобр на диоды и пробивая их. Перепрограммировать такие БИС уже нельзя. Было бы удобно, если бы электрическим путем можно было изменять функции БИС, если это требуется.
Такие устройства — со стиранием и перезаписью реализуемых функций существуют и называются репрограммируемыми логическими матрицами (РПЛМ).
– 45 – Лекция 23
Репрограммируемый элемент на основе МДП-транзистора с плавающим затвором
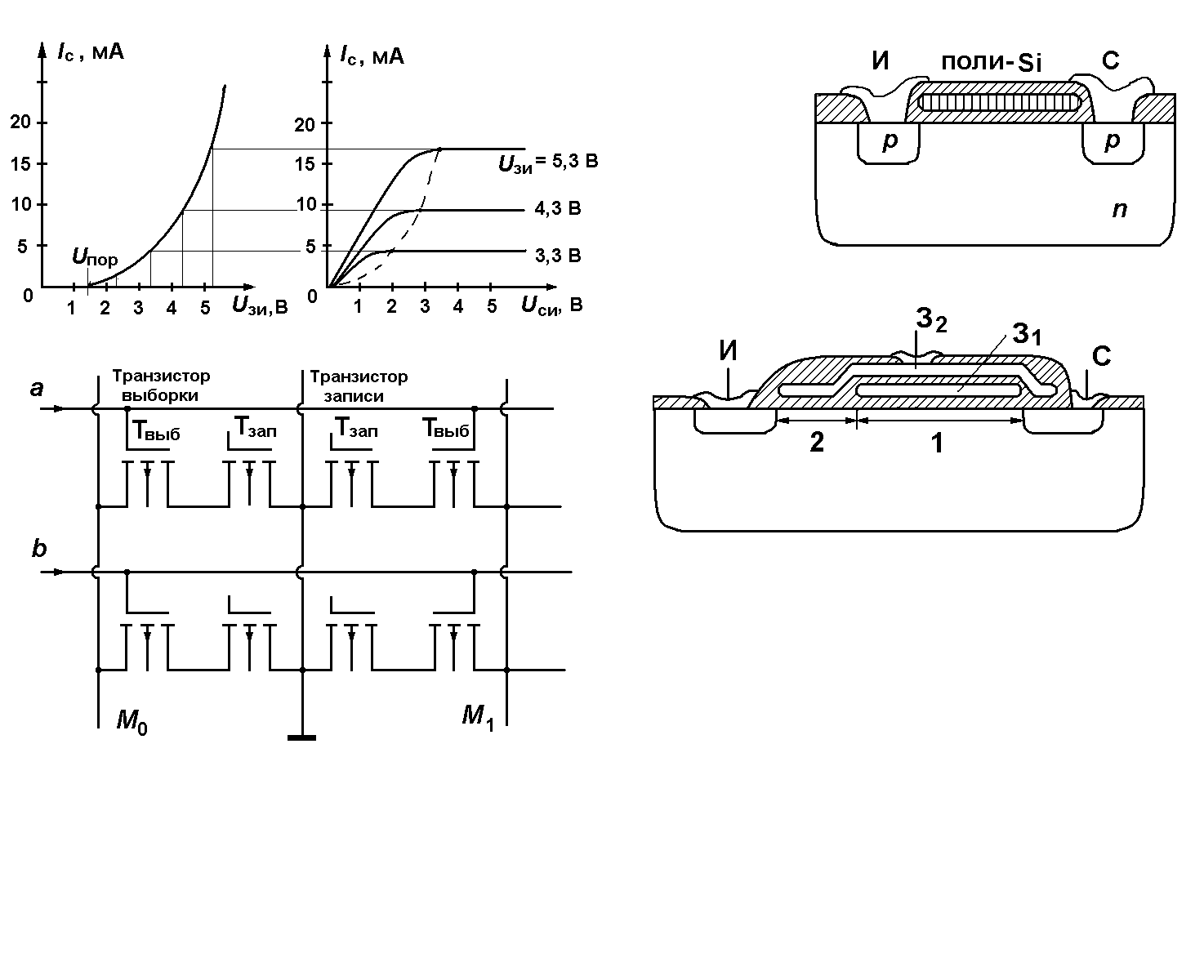
Поликремниевый плавающий затвор гальванически не связан с другими цепями. В исходном состоянии этот транзистор не имеет проводимости между стоком и истоком. Для перевода транзистора в открытое состояние (запись) прикладывается достаточно
большое Vси = 50 В в течение около 5 мс. Это вызывает лавинный пробой истокового или стокового р-n-перехода и инжекцию электронов в поликремниевый затвор. Заряд электронов, порядка 107 Кл/см2, захваченный затвором, индуцирует р-канал и может сохраняться многие годы после снятия напряжения Vси.
Стирание информации осуществляется при облучении поверхности структуры ультрафиолетовыми лучами с энергией, достаточной для выбивания электронов из затвора и переноса их в подложку. Стирание также можно выполнить, используя ионизирующее, например, рентгеновское излучение.
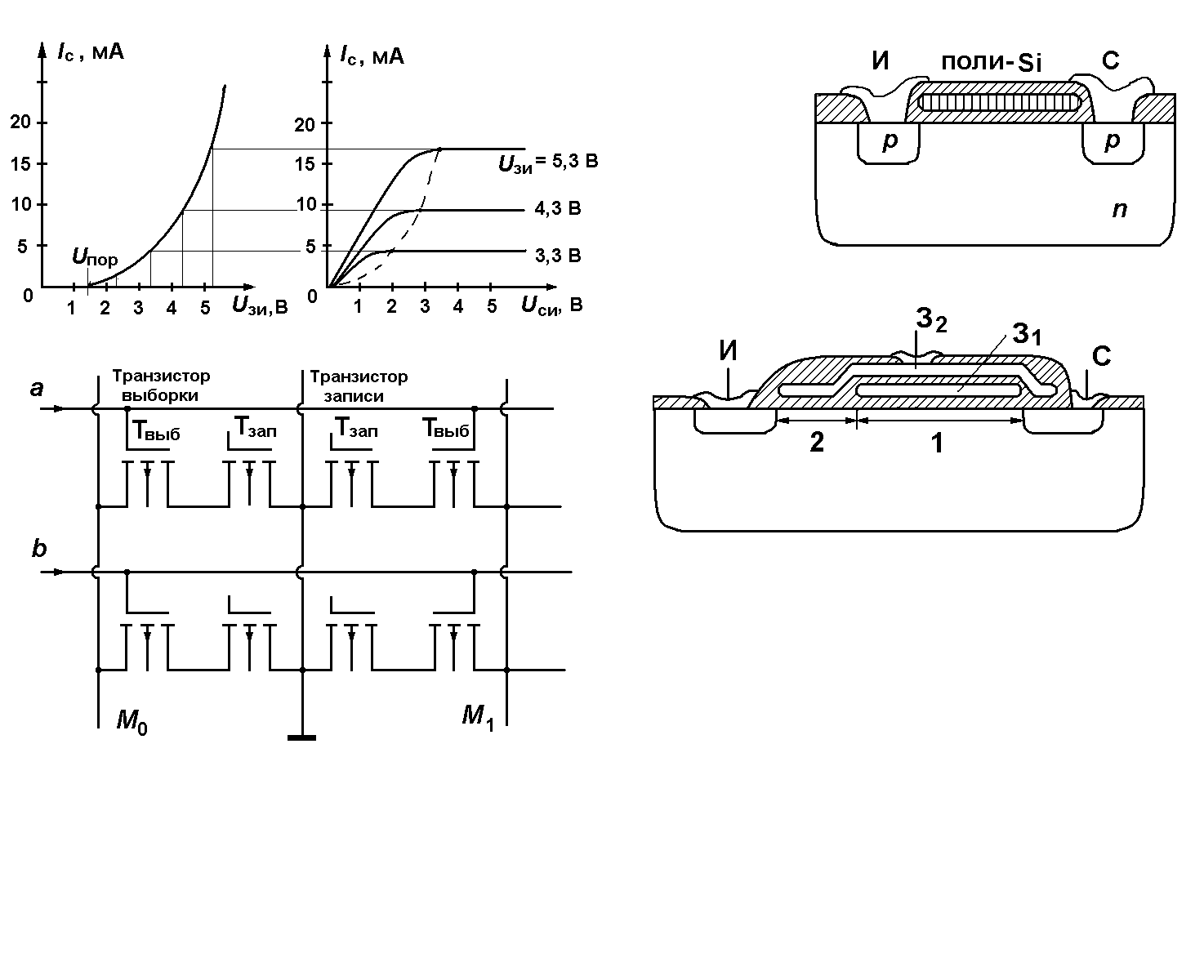 Считывание информации из матрицы происходит при подаче напряжения питания
Считывание информации из матрицы происходит при подаче напряжения питания 5 15 В и контроле тока, проходящего через транзистор. Для организации выборки опре-деленных ячеек в матрицу, последовательно с транзисторами с плавающими затворами включают обычные МДП-транзисторы.
Недостатком таких ПЛМ является невозможность выборочной перезаписи информации. Поэтому разработан еще один элемент, в котором эта возможность реализована.
В МДП-транзисторы с плавающим затвором вводят еще один затвор, который позволяет осуществить выборочную перезапись и исключить из матрицы транзисторы выборки. В этой конструкции канал образуется только тогда, когда на З1 накоплен заряд электронов и когда на З2 поступает сигнал считывания.
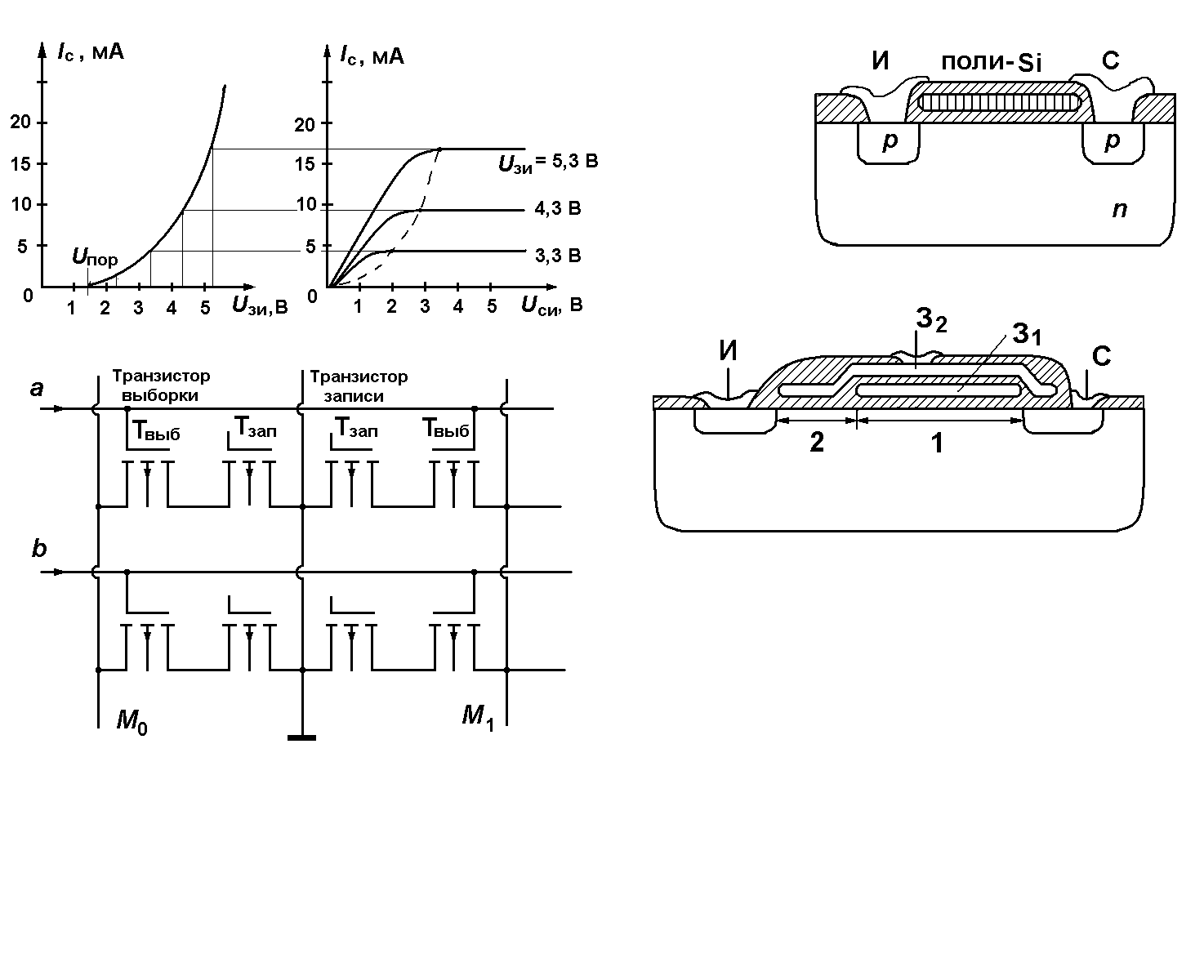
МДП-транзистор с плавающим затвором
и затвором выборки (считывания)
1 — часть канала, открываемая затвором З1;
2 — часть канала, открываемая затвором З2
Приборы с зарядовой связью (ПЗС)
Прибор с зарядовой связью представляет собой совокупность взаимодействующих МДП-конденсаторов. Взаимодействие обеспечивается общностью полупроводникового слоя и малым расстоянием между МДП-структурами.
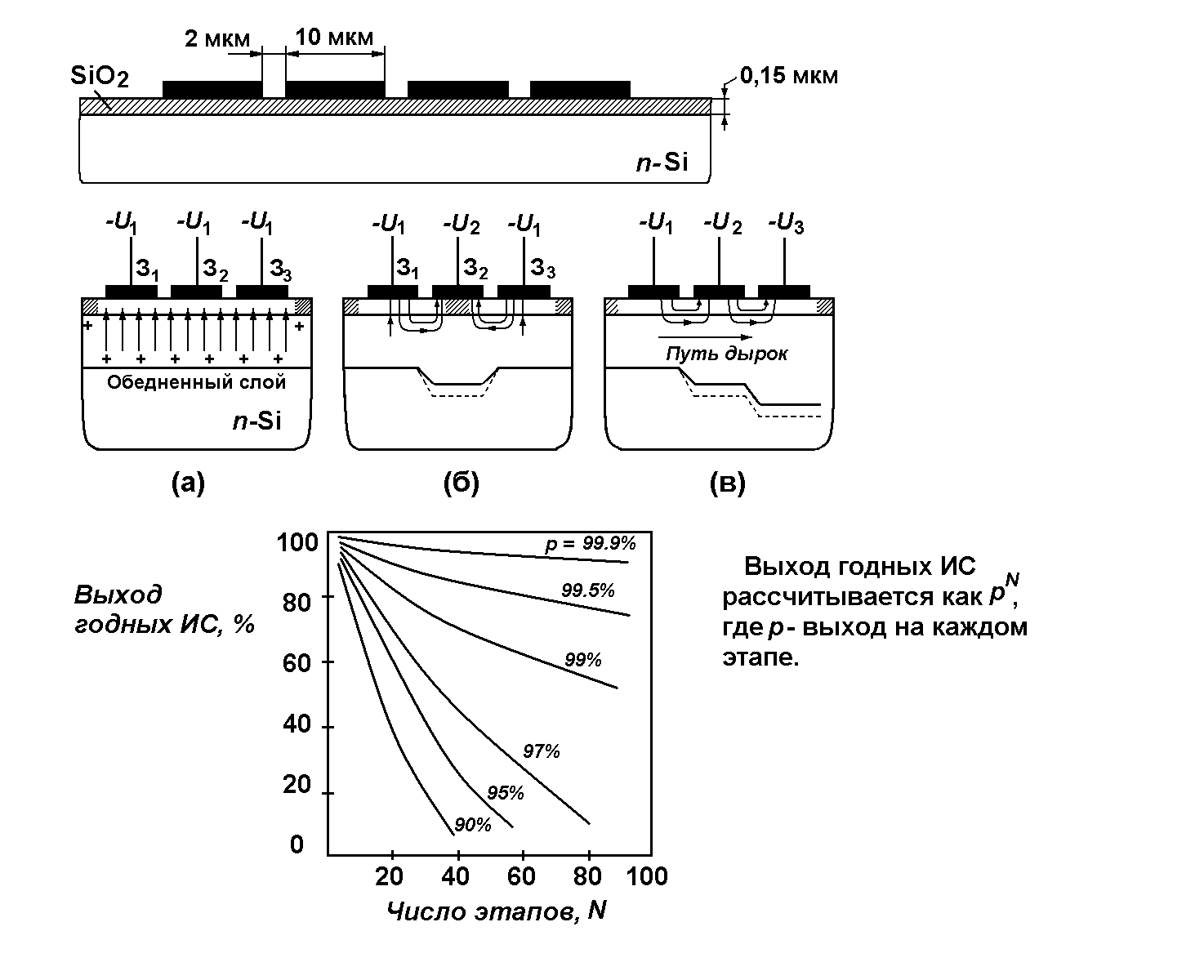
– 46 – Лекция 23 – 24
Принцип действия ПЗС состоит в том, что в каждой отдельной МДП-структуре можно создавать локальный приповерхностный заряд неосновных носителей (зарядовый пакет) и перемещать его вдоль поверхности — от одной МДП-структуры к другой, меняя должным образом напряжения на металлических электродах. Как создается этот пакет, мы не будем здесь обсуждать. Это можно прочитать в книге Калниботского "Расчет и ... ", стр. 123, и посмотреть на рис. 3-21б (с помощью инжектирующего р-n-перехода).
Поскольку общность полупроводникового слоя принципиальна для работы ПЗС, его формально можно рассматривать как особый полупроводниковый прибор, который нельзя осуществить и даже смоделировать на дискретных компонентах, таких, как транзисторы. Однако то, что ПЗС состоит из множества технологически объединенных МДП-структур, позволяет считать его типичным продуктом микроэлектроники, т. е. интегральной схемой и даже БИС, так как число МДП-структур в нем достигает нескольких тысяч.
(Конец лекции 23)
