Основы микроэлектроники (курс лекций)
| Вид материала | Курс лекций |
- Лекция №11 Сжатие изображений Курс лекций «Алгоритмические основы машинной графики», 54.41kb.
- Основы семейной психопедагогики (курс лекций), 11111.59kb.
- О. В. Свидерская Основы энергосбережения Курс лекций, 2953.76kb.
- Курс лекций введение в профессию "социальный педагог", 4415.45kb.
- Курс лекций по дисциплине " основы компьютерных технологий" Часть I. Microsoft Word, 432.92kb.
- Курс лекций Барнаул 2001 удк 621. 385 Хмелев В. Н., Обложкина А. Д. Материаловедение, 1417.04kb.
- Курс лекций. Учебное пособие / В. Е. Карпов, К. А. Коньков, 68.87kb.
- Курс лекций по автоматизированному электроприводу для итр проектный организаций с применением, 24.37kb.
- Программа курса лекций (1 курс магистратуры, 1 сем., 36 ч, экзамен) Профессор,, 34.75kb.
- Основы политологии: Курс лекций. 2-е изд., доп. Ростов на/Дону.: Феникс, 1999. 573, 14.9kb.
Конец лекции 18
Лекция 19
При подаче на вход х высокого потенциала р-МОП-транзистор запирается, а n-МОП-транзистор отпирается. При подаче на вход х низкого потенциала р-МОП-транзистор открывается, а n-МОП-транзистор запирается.
Поскольку один из транзисторов всегда находится в закрытом состоянии, ток от Е+ к Е– через эти транзисторы отсутствует. Следовательно, если входной сигнал не изменяется, потребляемая инвертором мощность практически равна нулю (я не говорю о динамических потерях на фронтах при переключении — здесь какая-то мощность рассеивается).
В комплементарных МОП-ИМС на одном и том же кристалле необходимо делать транзисторы обоих типов — с n- и р-каналом. Здесь один из транзисто-ров надо размещать в специальном кармане. Напри-мер, если в качестве подложки используется р-кремний, то n-канальный транзистор можно создавать непосредственно в подложке, а для р-канального потребуется карман с электронной проводимостью (см. рисунок). П
 олучение такого кармана в принципе не сложно, но связано с дополнительными технологическими операциями (фотолитография, диффузия доноров и др.). Кроме того, затрудняется получение низкоомных слоев в верхней (сильнолегированной) части n-кармана. Другим способом изготовления КМОП-транзисторов на одной подложке является КНС-технология. В этом случае на сапфировой подложке создаются "островки" кремния с собственной проводимостью, после чего на одних островках проводится диффузия донорной примеси и получаются n-канальные транзисторы, а в других — диффузия акцепторной примеси, и получаются р-канальные транзисторы. Хотя число технологиче-ских операций в этом случае больше, чем при изготовлении транзисторов одного типа, зато отпадают трудности в получении низкоомных слоев истока и стока.
олучение такого кармана в принципе не сложно, но связано с дополнительными технологическими операциями (фотолитография, диффузия доноров и др.). Кроме того, затрудняется получение низкоомных слоев в верхней (сильнолегированной) части n-кармана. Другим способом изготовления КМОП-транзисторов на одной подложке является КНС-технология. В этом случае на сапфировой подложке создаются "островки" кремния с собственной проводимостью, после чего на одних островках проводится диффузия донорной примеси и получаются n-канальные транзисторы, а в других — диффузия акцепторной примеси, и получаются р-канальные транзисторы. Хотя число технологиче-ских операций в этом случае больше, чем при изготовлении транзисторов одного типа, зато отпадают трудности в получении низкоомных слоев истока и стока. Выводы по качествам КМОП
Достоинства: КМОП обладают высокой помехозащищенностью и малой потребляемой мощностью. Они имеют колоссальный коэффициент разветвления: на малых частотах
неограниченный (при Rвх = 1014 Ом), при более высоких — не менее 50, что практически
всегда достаточно.
– 38 – Лекции 19- 20
Недостатки: Нужно создавать дополнительную изолирующую область под одной из двух групп транзисторов, что приводит к увеличению площади ИМС и, следовательно, КМОП обладают меньшей степенью интеграции, чем "однофазные" МОП ИС.
Повышение качества МОП-структур
В процессе развития микроэлектроники усовершенствование МОП-транзисторов проходило по двум главным направлениям: повышение быстродействия и снижение порогового напряжения, и второе — для уменьшения рабочих напряжений МОП и рассеиваемой ими мощности. Поскольку полная мощность кристалла ограничена, уменьшение мощности, рассеиваемой одним транзистором, способствует повышению степени интеграции, а уменьшение напряжения питания облегчает совместную работу МОП и низковольтных биполярных ИМС без специальных согласующих элементов.
Повышение быстродействия МОП-транзисторов связано прежде всего с уменьшением емкостей перекрытия. Существенное (примерно на порядок) уменьшение емкостей перекрытия достигается при использовании технологии самосовмещенных затворов. Общая идея такой технологии состоит в том, что слои стока и истока осуществляются не до, а после реализации затвора. При этом затвор используется в качестве маски при получении слоев стока и истока, а значит, края затвора и этих слоев будут совпадать, и перекрытие будет отсутствовать.
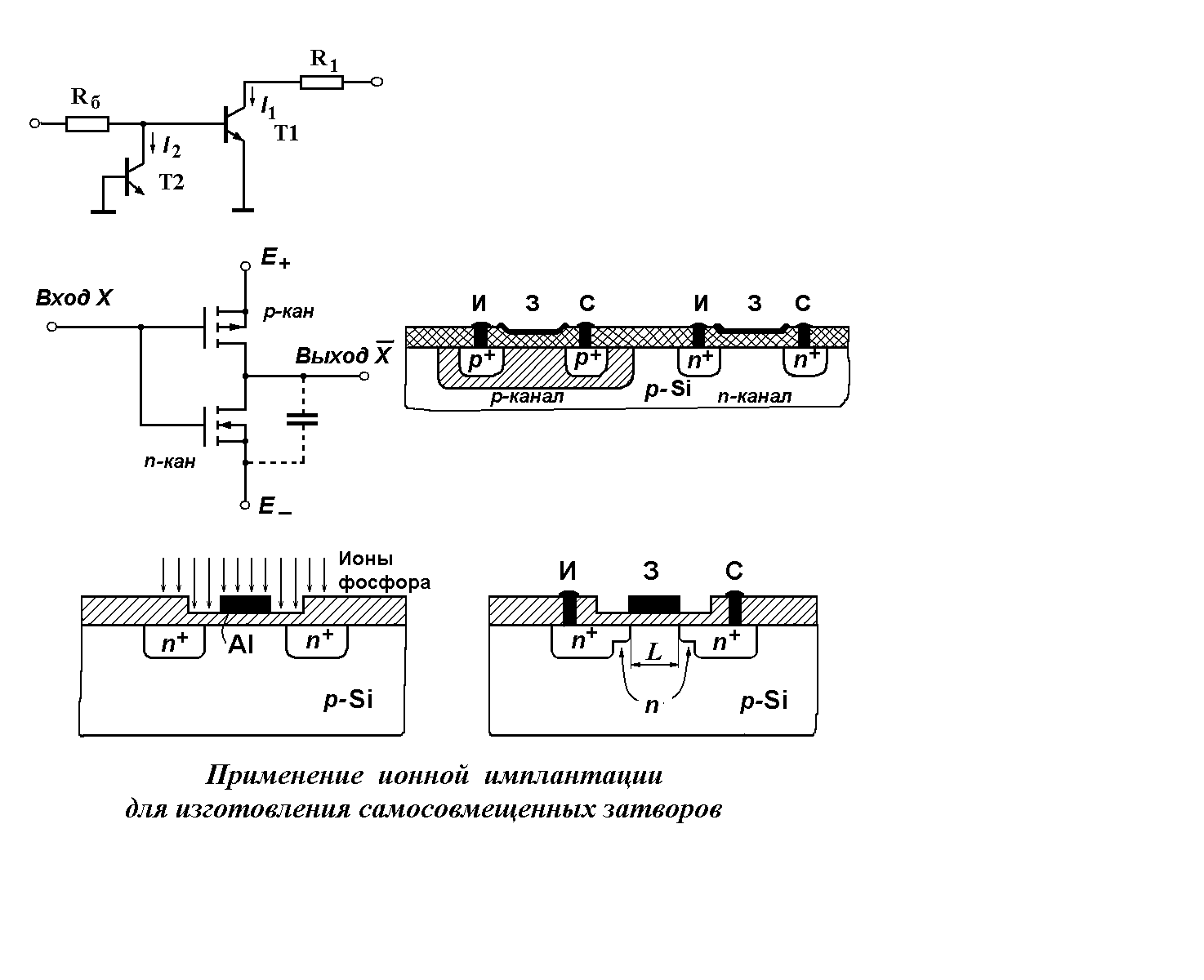
Один из вариантов МОП-транзистора с самосовмещенным затвором изображен на этом рисунке. Последовательность технологических операций при этом такова. Сначала проводится диффузия n+-слоев, причем расстояние между ними делается заведомо больше желательной длины канала. Затем осуществляется тонкое окисление на участке между n+-слоями и частично над ними. Далее на тонкий окисел напыляют алюминиевый электрод затвора, причем, его ширина меньше расстояния между n+-слоями. Наконец, проводится ионное легирование (имплантация атомов фосфора) через маску, образуемую алюминиевым затвором и толстым защитным окислом. Атомы фосфора проникают в кремний через тонкий окисел и "продлевают" n+-слои до края алюминиевой полоски, так что края затвора практически совпадают с краями стока и истока. Имплантированные слои легированы несколько слабее, чем диффузионные; поэтому для них использовано обозначение "n" вместо "n+". Глубина имплантации также несколько меньше, чем глубина диффузии, и составляет 0,1 0,2 мкм.
Конец лекции 19
Лекция 20
МОП-транзистор с самосовмещенным поликремниевым плавающим затвором (Из лекции изъят из-за сокращения числа часов, желательна самостоятельная проработка.)
Другой вариант МОП-транзистора с самосовмещенным затвором показан на следующем рисунке. Здесь сначала вытравливают окно в окисле с размерами, соответствующими всей
– 39 – Лекция 20

структуре транзистора. Затем в средней части окна проводят тонкое окисление кремния в виде полоски, ширина которой равна длине будущего канала L. Далее на эту полоску напыляют поликристаллический слой кремния той же ширины, но более длинный, выходящий за границы исходного окна в окисле. Удельное сопротивление напыляемого кремния делается достаточно малым, так что слой поликристаллического кремния выполняет роль металлического затвора в обычных МОП-транзисторах. На следующем этапе проводят мелкую диффузию донорной примеси через маску, образуемую полоской поликристаллического кремниевого затвора и защитным окислом, окружающим окно. В результате получаются n+-слои истока и стока, края которых почти совпадают с краями кремниевого затвора. Далее всю поверхность кристалла окисляют, и в этом окисле, как обычно, делают окна для омических контактов, в том числе для контакта с кремниевым затвором. На рисунке видно, что поликристаллический кремниевый затвор оказывается погруженным в слой защитного окисла, а омический контакт к нему располагается за пределами рабочей области транзистора. (Этот абзац и сопутствующий рисунок из лекции изъяты.)
Когда паразитные емкости МОП-транзистора и, прежде всего — емкость перекрытия Сзс, сведены к минимуму, на первый план выдвигается задача уменьшения постоянной времени пролета s. При малых емкостях она становится главным фактором, ограничивающим быстродействие (не совсем обычный параметр, но очень полезный для оценки скорости работы приборов, см. Степаненко, ОМ, с. 149, ф-ла (5.25)).
Переход от транзисторов с р-каналом к транзисторам с n-каналом позволил снизить значение s примерно в 3 раза благодаря увеличению подвижности носителей. Дальнейшее уменьшение s требует уменьшения длины канала L. Эта цель наиболее радикально реализуется методом двойной диффузии. Конструкция МОП-транзистора, полученного этим методом, показана на рисунке.
 Данная структура аналогична структуре классического n-р-n-транзистора, с той суще-ственной разницей, что эмиттерный n+-слой
Данная структура аналогична структуре классического n-р-n-транзистора, с той суще-ственной разницей, что эмиттерный n+-слой (в данном случае это слой истока) имеет почти такую же площадь, что и базовый р-слой (в дан-ном случае это слой канала). Для того чтобы
обеспечить точное "вписывание" n+-слоя в р-слой,
диффузию доноров для n+-слоя осуществляют через то же самое окно в окисле, через которое до этого проводили диффузию акцепторов для р-слоя. Тем самым устраняется необходимость в совмещении фотошаблонов для двух последовательных фотолитографий, а значит,
– 40 – Лекция 20 – 21
и нет ошибки совмещения, которая могла бы привести к сдвигу n+-слоя относительно n-слоя. В результате расстояние между n+- и n-слоями, т.е. толщина р-слоя, может иметь примерно те же значения, что и ширина базы w у n-р-n-транзистора — до 1 мкм и менее.
Вблизи поверхности расстояние между n+- и n-слоями играет роль длины канала L. При значениях L 1 мкм (вместо 4–5 мкм у наиболее совершенных МОП-транзисторов, полученных по обычной технологии) постоянная времени s может быть менее 0,005 нс, а граничная частота fг — более 30 ГГц.
