Правила топологического проектирования Мида-Конвей ( Карвер Иид, Линн Конвей )
| Вид материала | Лекция |
СодержаниеПравила топологического проектирования Мида-Конвей |
- А. Ч. Бхактиведанты Свами Прабхупады, прочитанная 6 октября 1969 года в Конвей-Холле, 107.89kb.
- Программа составлена так, что в полном объеме представлен маршрут проектирования, 70.02kb.
- Линн Пикнетт – Код Марии Магдалины Сенсационная версия возникновения христианства, 4507.49kb.
- 1 Процесс проектирования, 232.08kb.
- Лекция №8 методологии структурного и системного анализа и проектирования, 76.52kb.
- Санитарные правила санитарные правила проектирования, строительства и эксплуатации, 244.8kb.
- Технологические правила проектирования, 2013.95kb.
- Принципы и задачи проектирования 1 Уровни, аспекты и этапы проектирования, 399.58kb.
- Правила пожарной безопасности на железнодорожном транспорте ппбо-109-92, 1800.31kb.
- Правила пожарной безопасности на железнодорожном транспорте ппбо-109-92, 1607.6kb.
Лекция № 8
ПРИНЦИПЫ И МЕТОДЫ ТОПОЛОГИЧЕСКОГО
ПРОЕКТИРОВАНИЯ БИС
Связь технологии и топологии ИМС
Основой для любого проектирования ИМС является технологический процесс изготовления микросхем. Документ, отражающий возможности техпроцесса - "проектные нормы" составляется совместно технологами и разработчиками ИМС. С другой стороны, процесс проектирования топологии становится все более автоматизированным, формализованным и слабо связанным с используемой технологией. Системы автоматизации основаны на следующих особенностях структуры ИМС:
а) Все возможные технологии создают логические элементы с одинаковыми функциями.
6) Структура планарных ИМС послойная. Элементы ИМС создаются взаимодействием слоев, причем, только следующих друг за другом.
в) Логическая структура ИМС формируется системой электрических соединений (металлизацией). Полупроводниковые элементы в формировании логической структуры не участвуют.
г) Принцип пропорциональной миниатюризации предполагает, что все элементы ИМС могут быть масштабно уменьшены или увеличены.
В любом обозримом будущем полностью автоматическое проектирование топологии ИМС не представляется возможным. Библиотека элементов создается конструкторами с использованием элементов САПР. Повышение производительности достигается применением специальных правил.
Правила топологического проектирования Мида-Конвей
( Карвер Иид, Линн Конвей )
Эти правила были сформулированы для N - канальной МОП технологии и мы рассмотрим их в авторском варианте. Сейчас разработаны формальные правила и для других базовых технологических процессов. Методы формального проектирования не позволяют получить минимальную площадь элементов, но значительно повышают скорость проектирования и снижают число ошибок.
а) Итак, структура N-МОП микросхемы включает последовательно следующие слои: диффузионный, поликремневый, металлический. При пересечении поликремневого и диффузионного слоев образуется МОП транзистор. Металл пересекает нижележащие слои без взаимодействия.
б) Для электрического соединения слоев используются контактные окна. Через контактные окна металл соединяется с поликремневыми или диффузионными областями. Электрическое соединение поликремневого и диффузионного слоев возможно только путем их объединения металлом и контактными окнами.
в) Размеры элементов ИМС измеряются величиной . Величина строго больше, но очень близка к величине максимального смещения границ топологического элемента.
г) Ширина проводников:
- в поликремневом и диффузионном слоях не менее 2*;
- в слое металла – 3*.
д) Зазоры между проводниками:
- в поликремнии не менее 2*;
- между диффузионными и металлическими областями – 3*;
- от поликремневого проводника до диффузионной области вне транзистора - .
е) Перекрытие диффузионной области поликремнием в транзисторе не менее 2*.
ж) Контактное окно размером не менее 2*х2* размещается в центре переходной площадки размером 4*х4*.
з) Для соединения поликремневого и диффузионного слоев используются следующие конструкции:
- Две площадки в диффузионной и поликремневой областях, соединенные сверху металлом;
- Торцевой контакт, две площадки (диффузионные размером 4*х4* и поликремневых 3*х3*) перекрываются на величину и образуют одну площадку размером 4*х6*. На общей площадке - окно 2*х4* и сверху металл 4*х6*;
- Скрытый контакт, поликремневый проводник шириной 2 и диффузионная область размером 6*х6* перекрывается на величину 4*. На этой площадке размещено окно 4*х4* и металл 6*х6*.
Ограничения на расстояния между переходными площадками определяются ограничениями на составляющие слои.
и) Контактные окна не следует делать большими. Лучше использовать все окна шириной 2*. Если требуется, то параллельно включать много окон (в шинах питания). Расстояния между параллельно соединенными окнами на одной переходной площадки не менее 2*.
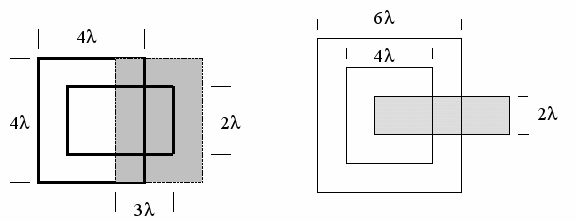
Торцевой контакт Скрытый контакт
Рис.8.1
к) В логических элементах сопротивление нагрузочных резисторов должно быть выше сопротивления открытого ключевого транзистора в 8 и более раз.
л) Все элементы ИМС формируются прямоугольниками. Проектирование топологии ведется в координатной сетке. Минимальный шаг сетки не менее . Косые проводники рисуются лесенкой. Обычно шаг сетки проектирования равен половине шага размещения проводников, т.е. 2* или 3*.
м) При проектировании соединений логические элементы размещают в узлах сетки, проводники проводят по линиям сетки. Если проводник встречает на пути узел, занятый логическим элементом, то это должен быть вход или выход логического элемента.
н) Проводники нельзя проводить через логический элемент, если они не подключены к его выходам или входам.
о) Двунаправленные шины не используются, выходы логических элементов не объединяются.
п) Логические элементы с большим числом входов – выходов должны занимать несколько узлов сетки.
р) Максимальное число входов ЛЭ должно быть ограничено.
с) Число входов, подключенных к одному выходу, правилами топологического проектирования не ограничено.
т) Топология схемы (блока схемы) должна быть выпуклой ( не допускается образования вмятин, колец и т.п.). Кристалл ИМС должен быть прямоугольником с соотношением сторон не более 2:1.
Использование правил проектирования Мида - Конвей резко уменьшает число проектных норм, облегчает автоматическую проверку топологии, позволяет автоматизировать процесс трассировки ЛЭ. Самое главное - этот метод обеспечивает переход от одной технологии к другой.
Топология периферийной области кристалла
В периферийной области находятся: разделительные дорожки, контактные площадки и шины питания. Размеры этих элементов топологии ИМС зависят от используемого сборочного оборудования и тока потребления ИМС. При переходе к другой технологии (при масштабном уменьшении топологических размеров элементов ИМС) размеры периферийных элементов часто требуется сохранять без изменения.
Разделительные дорожки имеют ширину от 100 до 140 мкм в зависимости от типа используемого оборудования для разрезания пластин на кристаллы. В перспективе возможно небольшое уменьшение ширины дорожек до 80 мкм, но большой прогресс не предвидится, так как с увеличением диаметра пластин они становятся толще, и резать приходится глубже.
Контактные площадки имеют размеры от 80 до 140мкм. Размер площадки определяется размером сварного соединения и точностью сварного оборудования. Минимальный размер площадки 2*(d+), где d - диаметр проволоки для сварки, - точность установки сварочного оборудования. Типовые величины: d=30мкм, =20мкм, размер КП - 100мкм. Для дискретных СВЧ приборов: d=10мкм, =10мкм, размер КП - 40мкм (меньше не бывает). Для мощных приборов используют проволоку диаметром 50мкм, а размер КП увеличивают до 140мкм. Зазоры между КП зависят от размеров корпуса, их выбирают так, чтобы проволочки не задевали друг друга. Обычно 40…60мкм.
Контактные площадки размещают по периферии кристалла на расстоянии не более 300мкм от края кристалла. Если все необходимые площадки не помещаются по периметру кристалла, то допускается их размещение в два ряда в шахматном порядке, причем, край внутреннего ряда не должен отстоять от края кристалла более чем на 300мкм. Число площадок должно совпадать с числом внутренних траверс корпуса. Даже если есть свободные выводы корпуса, их траверсы приваривают к неподключенным площадкам на кристалле. Это облегчает процесс сборки. Площадка, соединяемая с первым выводом корпуса, должна быть выделена цифрой "1" или ключом (выступом на КП). При обычном монтаже кристалла в корпус, когда крышка сверху, а теплорастекатель снизу, нумерация площадок ведется против часовой стрелки. При перевернутом монтаже - по часовой стрелке.
В пределах 300мкм, выделенных для размещения КП, можно проводить обводные шины снаружи от КП. Обычно это шины питания. На площадки питания допускается приваривать до 4 проволочек с одного траверса корпуса. Площадки питания при этом приходится соответственно увеличивать.
При проектировании шин питания необходимо выполнить два условия: падение напряжения на шинах не должно быть больше 5% от логического перепада и плотность тока не должна превышать критическую величину.
При масштабном уменьшении кристалла число квадратов на пути растекания тока не изменяется. Если удается сохранить слоевое сопротивление металлизации, то и сопротивление шин питания не изменится. Ток питания ИМС при этом также не меняется. Если приходится использовать более тонкий металл, то следует повторить расчет статических помех на шинах питания. Допустимая плотность тока в алюминиевых проводниках – 2*105[А/см2] или 2[мА/мкм2]. Для многослойной металлизации на основе золота допустимая плотность тока 5*105[А/см2]. Для БИС ограничение на сопротивление проводников обычно более тяжелое. Плотность тока надо обязательно рассчитывать для сварных соединений на контактных площадках. Не следует экономить на проволоке для сварки, лучше сделать больше сварных соединений, если есть опасения насчет допустимой плотности тока.
В ряде случаев возможности масштабного уменьшения размеров кристаллов ограничены именно размерами контактных площадок. Несмотря на простоту топологии периферийные элементы плохо поддаются формализации проектирования. И во всех случаях их следует рассматривать отдельно от логических элементов, используя свои собственные ограничения на проектирование.
Символьный метод проектирования топологии
Допустим, что проектирование топологии ИМС ведется по правилам Мида-Конвей и используется сетка проектирования с шагом, равным половине шага проводников. В этом случае число возможных сочетаний слоев в узлах сетки будет ограничено. Все эти сочетания можно обозначить условными символами. Тогда можно использовать программы, которые сами нарисуют необходимые контура слоев по символам, расставленным в узлах сетки. Метод символьного проектирования не является автоматическим, но может сократить время ручного проектирования топологии в 2-3 раза по сравнению с контурным методом.
Рассмотрим подробнее символьный метод.
Назначим следующие символы:
|- металлический слой
- - диффузионный слой
/ -поликремниевый слой
Х - пересечение поликремния и диффузионного слоя - это МОП
транзистор
О - контактное окно к поликремнию или диффузионной области
+ - пересечение металла с поликремнием и диффузионным слоем
без взаимодействия.
Нарисуем топологию МОП вентиля символьным методом и контурным.
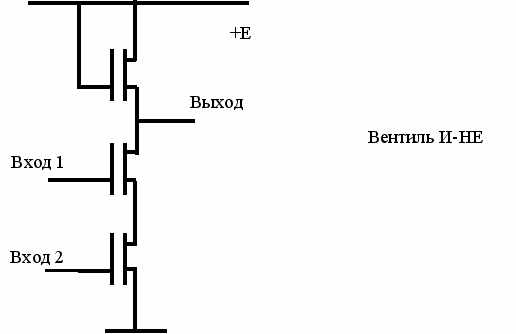

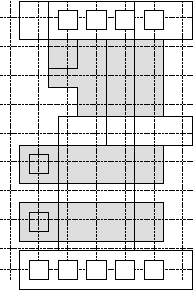
Символьная топология вентиля Контурная топология вентиля
Электрическая схема
Рис.8.2
