Рецензенти: доц. Московського станкоинструментального інституту, канд техн наук Г. И. Гранітів; викладач Московського технікуму електронних приладів А. В. Закревская Гаркуша Ж. М
| Вид материала | Документы |
СодержаниеЗалежність параметрів |
- Україна харківська міська рада харківської області виконавчий комітет управління освіти, 181.85kb.
- Гост 17623-87, 138.94kb.
- М. А. Ляшко доц., канд физ мат наук; Т. Н. Смотрова доц., канд, 2299.13kb.
- Надійності та безпеки в будівництві, 692.13kb.
- Гост 5382-91, 1729.88kb.
- Д. М. Лаковский (руководитель темы); И. В. Колечицкая; С. А. Резник, канд техн наук;, 203.82kb.
- Гост 14637-89: Прокат толстолистовой из углеродистой стали обыкновенного качества Технические, 310.23kb.
- Государственный стандарт союза сср здания и сооружения Методы измерения яркости, 278.78kb.
- Гост 26824-86, 248.28kb.
- Строительные нормы и правила отопление, вентиляция и кондиционирование, 2477.63kb.
У стані термодинамічної рівноваги в обсязі полупровидника встановлюється рівноважна концентрація електронів і дірок, рівні захоплення і рекомбінації мають рівноважне заповнення. Рівноважне заповнення зон і локальних вирівняний визначає рівноважне положення рівня Ферми. Рівноважний стан характеризується рівністю швидкостей теплової генерації і рекомбінації, електричною нейтральністю напівпровідника і рівновагою між концентраціями носіїв зарядів у зонах:
n0p0=nt2
Процес установлення рівноважного стану на поверхні напівпровідника також включає взаємодія поверхневих пасток зі своїми зонами і взаємодія носіїв заряду за допомогою генерації і рекомбінації электронно-дырочных пара. Електричної нейтральності на поверхні відповідає рівність поверхневого заряду сумарному заряду іонізованих поверхневих допоровши й акцепторів. В області просторового заряду рівноважні концентрації електронів і дірок є функцією електростатичного потенціалу, тому
nt2= n0(y)p0(Y)
209
Для поверхневої концентрації справедливе вираження

У процесі рекомбінації поверхневі пастки діють подібно об'ємним і при виникненні нерівновагих процесів у напівпровіднику вони беруть участь у цих процесах нарівні з об'ємними. Додаткова генерація носіїв заряду змінює ступінь заповнення пасток захоплення і рекомбінації як в обсязі напівпровідника, так і на його поверхні. Особливістю поверхневої рекомбінації є та обставина, що поява нерівновагих носіїв заряду на поверхні під дією якого-небудь збудливого фактора приводить до зміни величини поверхневого заряду і захопленню частини цих носіїв поверхневими состояними.
Зміна поверхневого заряду за рахунок захоплення компенсується перерозподілом у шарі просторового заряду як надлишкових, так і рівноважних носіїв заряду. Це перерозподіл носіїв характеризується новою величиною електростатичного поверхневого потенціалу.
Після припинення порушення величина електростатичного потенціалу знову зміниться, тому що в зонах відсутні нерівновагі носії заряду і компенсація поверхневого заряду здійснюється за рахунок перерозподілу рівноважних носіїв заряду. Захоплені поверхневими пастками носії згодом повертаються в дозволені зони.
Оскільки величина електростатичного потенціалу неоднакова по всій товщині шаруючи просторового заряду, то концентрації надлишкових носіїв заряду - електронів і дірок - не рівні між собою. Отже, швидкості поверхневої рекомбінації для електронів і дірок різні.
Зазначені швидкості для електронів Sn і дірок Sp визначаються відношенням інтенсивності поверхневої рекомбінації до нерівновагої концентрації носіїв заряду:

де Us - темп поверхневої рекомбінації, чисельно рівний коли честву актів рекомбінації, що протікають в одиницю часу але одиниці поверхні.
При малих відхиленнях від рівноважного стану можна прийняти єдину швидкість поверхневої рекомбінації для електронів і дірок. У цьому випадку швидкість поверхневої рекомбінації визначається не здатністю пастки здійснювати акти рекомбінації, а швидкістю дифузії нерівновагих электронно-дырочных пара з обсягу напівпровідника до поверхні. Швидкістю по-верхностной рекомбінації називають відношення щільності потоки носіїв заряду, рекомбинировавших на поверхні напівпровідника, до концентрації надлишкових носіїв заряду в поверхні.
210
Швидкість поверхневої рекомбінації залежить від положення рівня Ферми в обсязі напівпровідника, температури, складу навколишньої газового середовища, виду хімічної обробки поверхні.
При збільшенні концентрації основних носіїв заряду в напівпровіднику швидкість поверхневої рекомбінації спочатку збільшується, а потім залишається постійної і приблизно рівної швидкості теплової рекомбінації. Збільшення концентрації носіїв заряду поблизу поверхні кремнію приводить до поступової нейтралізації пасток поверхневої рекомбінації і відповідно до зменшення швидкості поверхневої рекомбінації. Процес зменшення швидкості поверхневої рекомбінації зв'язаний із взаи-

модействием електронів поверхневих атомів напівпровідника з 'адсорбованими атомами кисню.
Прогрій зразків напівпровідника у вакуумі при температурі, більшої 500 ДО, приводить до зміни швидкості поверхневої рекомбінації. Це зв'язано з тим, що поверхневий потенціал стає більш негативним. При цьому зменшується концентрація поверхневих центрів акцепторного чи тину росте концентрація поверхневих центрів донорного типу, чи одночасно змінюються значення концентрації і тих і інших. Тривалість прогріву змінює характер залежності швидкості поверхневої рекомбінації від поверхневого потенціалу {мал. 9.27), що обумовлено зміною' системи поверхневих пасток рекомбінації.
Як показали експериментальні дослідження швидкості поверхневої рекомбінації в газовому циклі Браттейна - Бардіна сухої ОБ2 - озон Оз -сухий ОБ2 - вологий ПРО*2 - сухий ПРО2 ), харак-тер її зміни не залежить від типу електропровідності напівпровідника і його питомого опору, а визначається видом хи-
211
мической обробки. Отже, пастки рекомбінації в напівпровідниках п- і р-типов мають однакову природу, і швидкість поверхневої рекомбінації визначається тільки величиною поверхневого заряду. Усе це вказує на сильну залежність швидкості поверхневої рекомбінації від величини поверхневого потенціалу.На мал. 9.28 показана ця залежність для різних положень рекомбінаційного рівня щодо рівня Ферми. Максимум кривої відповідає нульовому поверхневому потенціалу за умови рівності ефективних перетинів захоплення електронів і дірок.
Зменшення швидкості рекомбінації з ростом потенціалу порозумівається зменшенням концентрації одного з видів носіїв

заряду на поверхні. При видаленні рівня від середини забороненої зони криві стають ширше. Це зв'язано з ослабленням рскомбинационных властивостей рівня. При різних ефективних перетинах захоплення електронів і дірок максимум кривої зміщається убік позитивного потенціалу, якщо ефективний перетин захоплення дірок більше перетину захоплення електронів, і убік негативного потенціалу в протилежному випадку (мал. 9.29). Поверхнева рекомбінація протікає в основному через локальні рівні пасток рекомбінації. Крім локальних рівнів, на поверхні напівпровідника МОЖУТЬ існувати поверхностные зони. Утворення зон відбувається при великій концентрації однотипних дефектів і малій відстані між дефектами. Якщо концентрація поверхневих дефектів невелика, то поверхневі зони можуть створюватися в тому випадку, коли енергія закріплення на них електронів різна. ,
Поверхневі пастки рекомбінації бувають однозарядними і багатозарядними. Експериментально встановлено, що на поверхні можуть існувати двозарядні пастки рекомбінації. Їхня особливість складається в появі другого рівня для захоплення другого електрона лише після захоплення першого електрона.
При легуванні поверхні германія і кремнію золотом збільшується концентрація швидких поверхневих станів і швидкість поверхневої рекомбінації збільшується. Поверхневий заряд при цьому майже не змінюється. Легування золотом приводить до утворення цілої системи енергетичних рівнів - центральний з них є пасткою рекомбінації.
Після травлення в лугах поверхня виходить шорсткуватої з висотою нерівностей 2-15 мкм. З лужних травителей на поверхні адсорбируется велика кількість катіонів лужних
212
металів (ДО+, Na+). На ретельно промитій поверхні кремнію може адсорбироваться до 1010 см~2, причому переважне число їх адсорбируется в області /р-n-псрехола.
Структурні недосконалості, висока концентрація домішки лужних металів і продуктів оксидування приводять до високих швидкостей поверхневої рекомбінації.
Після травлення в сумішах азотної і фтористоводородной кислот структурних дефектів на поверхні напівпровідника утвориться значно менше, ніж після травлення в лугах, а тому і швидкість поверхневої рекомбінації нижче. На величину цієї швидкості впливає початкова обробка пластин напівпровідника перед хімічним травленням. Після грубого шліфування швидкість поверхневої рекомбінації на кілька порядків вище, рем після тонкого шліфування.
§ 9.9. ШВИДКІ І ПОВІЛЬНІ СТАНИ
При дослідженні поверхневої електропровідності за допомогою ефекту полючи було встановлено, що па поверхні напівпровідника існує два тини поверхневих станів: швидкі і повільні (див. § 9.6). Швидкі беруть участь у процесах рекомбінації і захоплення. При кімнатній температурі більш тривалим виявляється процес рекомбінації, тому постійні часу процесу виявляються близькими до ефективного часу життя надлишкових носіїв заряду. Однак при знижених температурах, а також при дуже високих позитивних і негативних значеннях поверхневого потенціалу переважає процес захоплення носіїв заряду швидкими поверхневими станами. Тривалість цього процесу і визначає час установлення поверхневої електропровідності.Повільні стани в рекомбінації не беруть участь: вони служать пастками захоплення носіїв.У загальному випадку можна вважати, що поверхневий заряд утворений зарядом швидких і повільних станів. Співвідношення Між цими складовими заряду визначається фізико-хімічним станом поверхні напівпровідника і навколишньої газового середовища. Досвідченим шляхом було встановлено, що поверхневий заряд восновном є зарядом повільних станів. Концентрація повільних станів складає близько 1011-1013 см~2. Рівноважне заповнення станів визначається їхнім положенням отиотелыно рівня Ферми і температурою напівпровідника. При измнении рівноважного стану напівпровідника міняється рівноважне заповнення повільних рівнів, але після припинення возбужння відбувається відновлення колишнього заряду. Швидкість вос-становлення істотно залежить від навколишньої атмосфери, що називає на адсорбційну природу повільних станів. Поява повільних станів зв'язано з утворенням оксидної плівки на поверхні напівпровідника. На атомарно чистій поверхні, дослідженої в надвисокому вакуумі, повільні стани
213
не виявлені. Однак при приміщенні зразка в звичайну атмосферу починається ріст щільності повільних станів, причому тем швидше, чим вище вологість навколишнього середовища. Припускають, що повільні стани можуть знаходитися як усередині окисла, так і па його поверхні. Різні значення часу захоплення носіїв заряду цими станами зв'язані з різною товщиною оксидної плівки.
Обмін носіями між обсягом напівпровідника і повільних станів відбувається двома шляхами: туннелированием крізь плівку й емісією через потенційний бар'єр. Для тонких оксидних плівок більш ймовірним стає тунельний механізм.Швидкі поверхневі стани знаходяться на границі напівпровідник-оксид. Чи буде швидкий рівень пасткою чи рекомбінації захоплення - залежить від багатьох факторів. Наприклад, під час витримки кристала на чи повітрі у вакуумі швидкість рекомбінації зростає, а швидкість захоплення не міняється. Короткочасний прогрів при 600-650 До зменшує швидкість рекомбінації, а тривала витримка при 650 До майже не змінює швидкості рекомбінації і захоплення. Прогрів при більш високій температурі збільшує швидкість захоплення.Пастки захоплення і рекомбінації являють собою різні по природі дефекти поверхні, причому пасток захоплення кількісно більше.Становить інтерес зміна повного поверхневого заряду при прогріві зразків у вакуумі. Концентрація швидких поверхневих станів змінюється в значних межах, а рівноважний поверхневий потенціал і повний поверхневий заряд міняються незначно. Заряд швидких станів істотно змінюється. Зміна заряду швидких станів при постійній величині повного заряду порозумівається зміною заряду, що відбувається в протилежному напрямку, повільних станів.Зі сказаного можна зробити висновок про наявність взаємних преобертань швидких і повільних станів при прогріві зразкау вакуумі. Зміна заряду повільних станів відбувається
внаслідок зміни ступеня адсорбції на поверхні плівки ізмін у структурі самої плівки. "
Зміни повного заряду за рахунок зміни заряду швидких станів не відбувається, оскільки цей заряд раніше був присутній на повільних станах, частина яких при 500 До перетворилася у швидкі. Прогрів при 650 До відповідає зворотному перетворенню частини швидких поверхневих станів у повільні.
Контрольні питання і задачі
1. У чому відмінність ідеальної поверхні напівпровідника від реальної?
2. Дати визначення поверхневих станів.
3. Чим визначається величина скривлення енергетичних зон в області
просторового заряду?
4. Чому положення рівня Ферми на поверхні напівпровідника відрізняється від його положення в обсязі зразка?
214
5. Чим визначається товщина області просторового заряду у випадку
утворення інверсійного шару?
6. У якім середовищі небажана обробка поверхні п- н р-областей
напівпровідників і чому?
7. У чому розходження між енергетичним рівнем адсорбованої частини
цы і рівнем домішки, спеціально введеної в ґрати напівпровідника?
8. Яка природа центрів адсорбції на поверхні напівпровідника?
9. Яка форма хемосорбції приводить до зміни поверхневого заряду?
10. Чим визначається кількість води, адсорбованої на поверхні?
11. Чому адсорбція кисню збільшує роботу виходу з напівпро
водники л- і р-типов?
12. Якими носіями заряду здійснюється поверхнева электропро
водность у дырочном напівпровіднику, якщо на його поверхні утворився по
ложительный заряд?
13. Як впливає хімічна обробка поверхні напівпровідника на вели
чину поверхневої електропровідності?
14. Якщо на металеву обкладку Мдп-структуры поданий позитивний
заряд, то якими частками він буде скомпенсований, якщо другою обкладкою
служить дырочный напівпровідник?
15. У чому розходження швидких і повільних поверхневих станів?
16. Визначити ємність Мдп-структуры, якщо товщина диоксидной плівки
кремнію дорівнює dn=0,2 мкм, а товщина збідненого шару в кремнії l= 10-3 див
{эsі=І2єsіj, =5).
17. Чому при утворенні на поверхні напівпровідника збагаченого
шару ємність Мдп-структуры практично не залежить від величини прикладенийі
ного напруги?
18. Що служить причиною утворення каналів провідності на поверхно
сти напівпровідника?
19. Чому вплив каналів позначається при включення р-n-перехода в про
ратний напрямок?
20. Чим відрізняється поверхнева рекомбінація від об'ємної?
21. Від яких факторів залежить швидкість поверхневої рекомбінації?
22. На якій поверхні - шліфованої чи полірований - швидкість по-
верхносной рекомбінації більше і чому?
23. Які основні функції виконують швидкі і повільні поверхност
ные стану?
24. Як зв'язані між собою час життя нерівновагих носіїв зоря
та й їхній ефективний перетин захоплення?
ГЛАВА 10
ЗАЛЕЖНІСТЬ ПАРАМЕТРІВ
НАПІВПРОВІДНИКОВИХ ПРИЛАДІВ
ВІД СТАНУ ПОВЕРХНІ
§ 10.1. ВПЛИВ ВЛАСТИВОСТЕЙ ПОВЕРХНІ НА ПАРАМЕТРИ 1
НАПІВПРОВІДНИКОВИХ ПРИЛАДІВ
Для виготовлення напівпровідникових діодів і транзисторів зі сплавними і дифузійними переходами використовують пластини напівпровідника після механічного полірування і хімічного травлення. Для планарных приладів і Мдп-транзисторов поверхня таких пластин спеціально оксидують. Властивості оксидованої поверхні залежать від способу її обробки і технології оксидування. Необхідно враховувати ступінь однорідності по-
215
верхности і якість оксиду (однорідність по товщині, наявність дефектів, пористість).
Основними параметрами реальної поверхні є поверхневий потенціал, концентрація поверхневих станів і швидкість поверхневої рекомбінації. Властивості поверхні можуть змінюватися в зовнішнім середовищі, а саме вони визначають такі параметри напівпровідникових приладів, як зворотний струм через р-n-переход, струм поверхневих витоків, напруга пробою, опір р-n-перехода, шуми і коефіцієнт підсилення транзисторів. Розглянемо докладніше ці параметри.
Виміру величин зворотних струмів германиевых і кремнієвих діодів у стаціонарному й імпульсному режимах показали, що ці струми не є постійними, а змінюються при кімнатній і більш низьких темпепатурах за законом
І=AUn
де А и n- деякі постійні, причому п близька до 1 при кімнатній температурі і досягає значень 2-4 зі зниженням температури.
При температурах вище кімнатної зворотний струм міняється за законом

де В, З - постійні для даного зразка.
У загальному випадку зворотний струм можна представити у виді суми двох складових:

де Іv - об'ємний струм, тобто дрейфовий струм неосновних носіїв заряду; /-поверхневий струм, обумовлений неосновними носіями заряду, генерируемым" на поверхні напівпровідника.
Поверхнева складова зворотного струму тим більше, чим менше товщина напівпровідникової пластини. Експериментальні дослідження показали, що зворотний струм на 50-90% обумовлений поверхневої складовий, котра пропорційна ШВИДКОСТІ поверхневої рекомбінації:

де S - швидкість поверхневої рекомбінації; d - товщина зразка.
Поверхнева складова залежить від напруги зворотного зсуву внаслідок наявності крайового полючи, що діє на поверхню напівпровідника поблизу об'ємного заряду. Горизонтальна складова крайового полючи дуже впливає на дифузію неосновних носіїв на поверхні напівпровідника поблизу області об'ємного заряду р-n-перехода. Для несиметричного переходу (за умови, що рn"рр) зворотний струм в основному задається дірками, генерируемыми на поверхні напівпровідника.
216
Щільність цього струму

де Ег-напряженность полючи горизонтальної складовий.
Вертикальна складова крайового полючи викликає термічну іонізацію дірок на поверхні напівпровідника:

де Ев - вертикальна складова;

тут U - прикладена напруга, х - відстань від середини області об'ємного заряду до розглянутої крапки, а; -ширина р-п- переходу.

Можна записати

Остаточно маємо

де
При низьких температурах швидкість поверхневої рекомбина-ции велика і впливом Ег можна зневажити. Зі збільшенням температури струм зростає за рахунок об'ємної і поверхневий складових. Об'ємна складова росте внаслідок збільшення (концентрації неосновних носіїв заряду. Поверхнева, що поставляє з ростом температури росте повільніше, ніж об'ємна, тому що при значеннях температури вище кімнатної швидкість рекомбінації знижується. Подальше підвищення температури викликає експонентний ріст струму:

При вивченні зворотної галузі вольт-амперної характеристики в діодів була виявлена залежність зворотного струму від тривалості імпульсу напруги, що прикладається. Спочатку за 10- 30 мс струм різко падає, потім поступово наростає. Різкий спад струму відбувається за рахунок зменшення об'ємної складової струму
217
і вертикальної складової крайового полючи, що спочатку створює надлишкову концентрацію дірок за рахунок їхнього підтягування з обсягу за час 10~8 с. Потім ця надлишкова концентрація дірок починає зменшуватися: частина їх іде в р-область напівпровідника, частина рекомбинирует.Подальше зростання зворотного струму зв'язано з екрануванням поверхні напівпровідника дірками, що рухаються в шар оксиду під дією вертикальної складової крайового полючи. Це приводить до росту поверхневого потенціалу і збільшенню швидкості поверхневої рекомбінації і, отже, до росту зворотного струму.
§ 10.2. ТІК ПОВЕРХНЕВОГО ВИТОКУ
Поверхневі витоки зворотного струму обумовлені омічним шунтуванням р-n-нерехода па поверхні і появою каналь. ных струмів. Тік поверхневого витоку часто є основний складової зворотного струму через перехід.
Раніше згадувалося, що на реальній поверхні напівпровідника осаджується багатошарова плівка вологи і міститься багато сторонніх домішок, адсорбованих із травителей і промивної води. Помітну частину цих домішок складають позитивні іони лужних металів. Під дією напруги, прикладеного до переходу, ці іони дрейфують у плівці вологи, створюючи іонний струм витоку, величина якого зростає зі збільшенням вологості. Переміщення іонів приводить до зміни поверхневого заряду і викликає нестабільність параметрів полупровод-пиковых приладів.
При виникненні на поверхні напівпровідників інверсійних шарів можливе утворення каналів. Довжина капала залежить від величини зворотної напруги, прикладеного до р-n-переходу. Якщо відстань між р-n-переходом і омічним переходом невелико, то при великих напругах канал досягає омічного контакту і шунтирует р-n-переход. Це веде до виникнення значних струмів витоку.
У пленарних транзисторах, для яких характерна сталість поверхневого заряду, при подачі зсуву на канал відбувається перекриття каналу збідненим шаром і концентрація рухливих носіїв заряду зменшується. При великій щільності поверхневого заряду канал поширюється до омічного переходу і виникає наскрізний канальний струм. Утворення каналів у планарных транзисторах приводить до пробою переходу, що також сприяє збільшенню зворотного струму.
Додатковими джерелами надлишкового струму стають дефекти р-n-перехода в чи обсязі па поверхні напівпровідника, порушені шари, подряпини, тріщини.
У германиевых і кремнієвих приладах поверхневий пробій може наступити раніш об'ємного. Адсорбція пар води приводить до утворення позитивного поверхневого заряду. Возиик-
218
новенно такого заряду на высокоомпой n-області напівпровідника поблизу р-n-перехода приводить до того, що негативний заряд акцепторів в області р-n-перехода в поверхні буде частково компенсуватися цим зарядом. Відбувається звуження р-n-перехо-да в поверхні. Напруженість полючи тут збільшується в порівнянні з полем в обсязі кристала, що викликає интенсивнос множення носіїв заряду і веде до поверхневого пробою (мал. 10.1).
Зі зростанням температури відбувається зневоднювання поверхневого оксиду, що зменшує позитивний поверхневий заряд. Ширина р-n-перехода в поверхні наростає, слабшає процес множення носіїв зарядів, тому з ростом температури напруга поверхневого пробою збільшується.
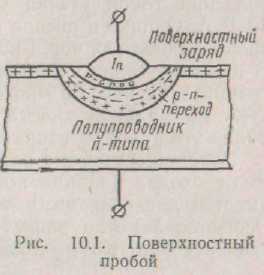
Відповідно змінюється зворотний струм. При малих температурах унаслідок великого коефіцієнта множення носіїв заряду зворотний струм зростає. З ростом температури зворотний струм зменшується.
У планарных приладів позитивний заряд, що існує в оксиді, значно знижує значення пробивної напруги. Структура оксидної плівки в області р-n-перехода може відрізнятися від її структури на р-и n-областях, тому що товщина плівки залежить від питомого опору
(чим воно більше, тим тонше плівка). Свій вплив робить хімічна обробка поверхні. В області p-n-переходу осаджується підвищена кількість домішок із травителей, що приводить до зміни поверхневого заряду, зміні швидкості поверхневої рекомбінації і величини пробивної напруги.
Стан поверхні позначається на величині повного опору p-n-псрехода. Еквівалентна схема переходу має вид рівнобіжного з'єднання опору і ємності переходу, послідовно до них підключене опір бази. При утворенні каналу площа переходу зростає, відповідно росте ємність переходу. Це особливо впливає на параметри діодів, використовуваних у якості керованих емкостей - варикапів.Шумові характеристики є одними з найважливіших длянапівпровідникових приладів. Установлено, що надлишковий шум,назад пропорційний частоті, чи шум типу І/f майже мети кому визначається станом поверхні і створюється основними
носіями заряду. В вологому середовищі шум 1/f різко зростає.Шум приписують захопленню носіїв заряду повільними поверхностными станами. Флуктуації числа носіїв на медленних станах приводять до зміни висоти поверхневого потенційного бар'єра, так що електропровідність зразка зміняється. Це є причиною появи шуму.
8* 219
Основним джерелом шуму служить р-n-переход, включений у зворотному напрямку. Виникнення шуму зв'язане зі зміною швидкості поверхневої рекомбінації, що змінює струм неосновних носіїв заряду па поверхні, і зі зміною струмів поверхневого витоку.
Планарные прилади мають дуже малий шум 1/f завдяки оксидуванню поверхні. Поверхневий пробій р-n-переходов супроводжується виникненням шумів.
Обмеження застосування польових транзисторів зв'язано з наявністю в них низькочастотних шумів. Ці шуми досягають значної величини, коли через оксидну плівку Моп-структуры проходять надлишкові струми витоку. Електропровідність оксидної плівки при кімнатній температурі мала. При E = 5-10° В/див значення струмів витоку в польових транзисторів не перевищують 10~12 А. Однак в оксиді зустрічаються ділянки з підвищеною електропровідністю, через які проходять надлишкові струми витоку. Як такі ділянки виступають дефекти типу пір і мікро-тріщин в оксиді. У багатьох випадках надлишкові струми не перешкоджають нормальній роботі приладів, але для посилення малих сигналів ці прилади непридатні.
Раніше розглянутий вплив поверхні на властивості окремого переходу. Вплив поверхні на властивості транзистора, де мається два зв'язаних р-n-перехода, буде позначатися сильніше. Особливо помітно впливає поверхня на підсилювальні властивості транзисторів. Коефіцієнт передачі струму эмиттера транзистора

де Y - ефективність эмиттера, B - коефіцієнт переносу, М - коефіцієнт множення.
Коефіцієнт переносу визначає ту частину струму инжектированных носіїв заряду, що досягає колекторного переходу. Для збільшення коефіцієнта переносу потрібно зменшувати втрати на рекомбінацію носіїв у базі. Цього можна досягти шляхом збільшення часу життя носіїв заряду, а час життя залежить від швидкості поверхневої рекомбінації. Особливо сильно позначається поверхнева рекомбінація на значенні коефіцієнта передачі струму эмиттера при низьких рівнях иyжекции. Для збільшення коефіцієнта передачі швидкість поверхневої рекомбінації повинна бути мінімальної.
Отже, швидкість поверхневої рекомбінації повинна мати таке значення, щоб забезпечити оптимальні значення параметрів напівпровідникових приладів: зворотного струму, пробивної напруги, коефіцієнта передачі эмиттерного струму.
§10.3. СТАБІЛЬНІСТЬ ХАРАКТЕРИСТИК ПРИЛАДІВ
Стабільність параметрів напівпровідникових приладів і інтегральних мікросхем визначає надійну роботу радіоелектронних пристроїв, у яких вони використовуються.
220
Стійкість роботи напівпровідникових приладів визначається фізичними процесами, що протікають на поверхні напівпровідника, особливо в області р-n-перехода. Розглянемо ці процеси.
Зміни, що відбуваються на поверхні напівпровідників протягом тривалого часу експлуатації і збереження приладів, обумовлюють процес старіння - зміна параметрів приладів. Старіння приладу визначається наступними причинами: чутливістю поверхні до сторонніх домішок, що знаходиться в приладі і проникає через герметизирующие покры-
тия; механічною нестабільністю; електронними і фізико-хімічними процесами, що протікають у зразках.
У готовому приладі на поверхні напівпровідника продовжується наростання оксидної плівки, її склад і структура міняються, що приводить до зміни поверхневого заряду, швидкості поверхневої рекомбінації, появі струмів витоку і зміні параметрів приладів. У германиевых транзисторів зростає швидкість поверхневої рекомбінації, що знижує значення коефіцієнта передачі струму а.
У процесі експлуатації прилади нагріваються, що викликає зневоднювання оксиду і зрушення потенціалу убік поверхні р-типа. Величина зворотного струму теж змінюється. На кремнієвих р-n+-переходах при малих зворотних напругах з часом зворотний струм зменшується, при великих - зростає (мал. 10.2).
Для боротьби зі старінням приладів проводять так називане штучне старіння при підвищених температурах. При нагріванні закінчується формування оксиду, що дозволяє стабілізувати параметри приладів.
У планарных приладів захист поверхні оксидною плівкою істотно змінила характер процесу старіння. Змін па-
221
раметров, зв'язаних зі збільшенням товщини оксиду, не спостерігається, але в стовщеному оксиді мається значний рухливий позитивний заряд, величина якого залежить від прикладеної напруги і нагрівання.
Найбільшу небезпеку представляють умови, коли при підвищеній температурі електричне поле в оксиді спрямовано до поверхні напівпровідника і позитивний заряд скапливается на границі кремній - диоксид кремнію.
Нагромадження позитивного заряду приводить до утворення інверсійних шарів. Для транзисторів типу п-р-п такі слон утворяться в області бази, тому що позитивний заряд накопичується поблизу колектора. Позитивний заряд істотно змінює коефіцієнт передачі струму, оскільки міняється швидкість поверхневої рекомбінації (мал. 10.3).
Поява "провалу" на залежності р(t) зв'язано з нагромадженням такого позитивного заряду, при якому швидкість поверхневої рекомбінації має максимальне значення. У приладів Свч-диапазона через неглибоке залягання эмиттерного р-n-перeхода і малої його ширини в процесі роботи коефіцієнт передачі эмиттерного струму може сильно змінюватися через наявність вологи в навколишнім середовищі, тому що шар оксиду під эмиттером тонкий і не має достатніх захисних властивостей.
Зміна зворотного струму p-n-переходу й інших параметрів приладів приводить до зміни електричних характеристик електронних схем, що містять напівпровідникові прилади. Дрейф зворотного струму залежить від стану поверхні і навколишньої газового середовища. У вакуумі порядку 10-6-10~7 Па ні на германії, ні на кремнії дрейф не спостерігається незалежно від величини зворотного струму. При зміні поверхневого заряду прикладеним зовнішнім полем у випадку утворення каналу зворотний струм зростає, але дрейф його не спостерігається. Тільки при дуже великих значеннях напруги і нагріванні напівпровідника спостерігається дрейф струму, причому струм швидко наростає, що закінчується тепловим пробоєм.
Дрейф струму отсутствует у сухих середовищах і в середовищах з малим відсотком вологості. Коли вологість навколишнього середовища зростає до десяти і більш відсотків, спостерігається позитивний дрейф струму. При великих парціальних тисках вологи струм досягає максимуму і починає зменшуватися. Напрямок дрейфу струму залежить від величини напруги зсуву на переході.
Позитивний дрейф - зростання зворотного струму - при малих напругах зсуву зв'язаний з ростом довжини каналу. При наявності багатошарової адсорбованої плівки води на поверхні р-n-перехода можлива поява дрейфу зворотного струму більш складного характеру, оскільки з'являється складова, зв'язана з переміщенням рухливих іонів у плівці, що викликає модуляцію полючи в p-n-персходе.
Дрейф зворотного струму супроводжується дрейфом повного опору діода, що зв'язано зі зміною довжини каналу і їм-
222
кісти p-n-переходу. У транзисторах спостерігається дрейф коефіцієнта передачі струму й амплітуди шуму.
Найбільш значний дрейф при наявності каналів і поверхневому пробої переходу.
У планарных приладів дрейф істотно менше. При наявності вологи мається можливість переміщення і нагромадження великих зарядів на зовнішній поверхні оксиду, що змінює величину поверхневого заряду і швидкість поверхневої рекомбінації. При зростанні температури дрейф здійснюється за рахунок переміщення і нагромадження позитивного заряду в оксиді під дією прикладеного полючи.
Робота Мдп-приборов заснована на модуляції поверхневої електропровідності зовнішнім електричним полем, подаваним на затвор. У випадку транзистора з індукованим каналом до затвора необхідно прикласти така напруга, щоб на поверхні напівпровідника між стоком і джерелом утворився інверсійний шар - канал. Цю напругу називають граничним. Бажано, щоб гранична напруга була як можна меншим. Це можливо в тому випадку, якщо мала концентрація поверхневих станів і рухливість заряду в оксиді незначна. Рухливий заряд утвориться позитивними іонами лужних металів і протонами.
Міграція іонів лужних металів приводить до нестабільності вольт-фарадных характеристик Мдп-структур в електричних полях. Ця нестабільність особливо помітна при підвищених температурах. Іони лужних металів адсорбируются поверхнею з різних хімічних реактивів. При концентрації домішок у реактивах порядку 10~5-10-10% на поверхні напівпровідника осаджується до 1011 -1015 см~2. Зменшення концентрації домішок на поверхні напівпровідника від 1013 см~2 до величини, меншої 1011 см~2, зменшує ефективний заряд на поверхні в 2- 2,5 рази.
Щільність рухливого заряду залежить від методу одержання оксидної плівки і її властивостей і складає приблизно 10~9 Кл/див2.
§ 10.4. СТАБІЛІЗАЦІЯ ПОВЕРХНЕВОГО ЗАРЯДУ
Основна нестабільність поверхневого заряду обумовлена міграцією іонів лужних металів. Мігруючі іони створюють рухливий заряд. Під дією прикладеної напруги іони дрейфують до границі роздягнула кремній - диоксид кремнію і змінюють величину поверхневого заряду. Наявність протонів також приводить до нестабільності електронних процесів на поверхні, тому що протони утворять швидкі і повільні поверхневі стани.
Рухливий заряд зменшують, вирощуючи оксидні плівки в присутності пар соляної кислоти, негативно заряджені іони хлору якої нейтралізують іони лужних металів, а міграція нейтральних атомів до границі кремній - оксид кремнію не
223
змінює поверхневий заряд. Уведенням домішок свинцю, фосфору і сурми можна зв'язати іони натрію, калію, водню.
При нанесенні на зовнішню поверхню диоксида кремнію шаруючи пентоксида фосфору, атоми кисню заповнюють кисневі вакансії в диоксиде, тим самим усуваючи їхню міграцію до границі роздягнула кремній - диоксид кремнію і забезпечуючи стабілізацію поверхневого заряду.
Для стабілізації поверхневого заряду проводять пассивацию поверхні напівпровідника. Для цього на поверхню напівпровідника наносять діелектричну плівку. Крім стабілізації поверхневого заряду, плівка повинна захищати поверхню від впливу навколишнього середовища.
До плівки, що пасивує, висувають наступні вимоги: поверхневий потенціал напівпровідника не повинний істотно змінюватися в процесі збереження і роботи приладу; поверхневий потенціал повинний бути оптимальним; швидкість поверхневої рекомбінації в результаті захисту плівкою, що пасивує, не повинна зростати.
Найбільше поширення для зашиті і пассивации поверхні знайшли плівки диоксида кремнію. Однак диоксид виконує свої функції лише у визначених навколишніх умовах.
У диоксиде існують рухливі і нерухомі заряди. Останні обумовлені іонізованими поверхневими станами на границі роздягнула Sі-Sі2. Щільність нерухомого заряду залежить від орієнтації кремнію і може бути рівної 1010-1012 см~2. Величина його залежить від способу оксидування і термообробки, проведеної після оксидування. При повільному оксидуванні величина заряду менше, зі збільшенням товщини плівки заряд наростає.
Деяка частина нерухомого заряду зосереджена на швидких станах, частина з яких служить пастками рекомбінації. Ця частина заряду залежить від способу одержання оксиду. Інший заряд знаходиться на повільних станах.
Покриття оксидної плівки боросиликатным склом поліпшує герметизирующие властивості плівки. За допомогою органічних сполук можна зменшити чутливість плівки до вологи.
Плівки нітриду кремнію мають кращі електричні характеристики, чим плівки диоксида кремнію. Стабільність характеристик зберігається навіть при високих температурах. Плівки нітриду кремнію огнеупорны і кислотостойки.
Структура плівок визначається температурою утворення плівки. При низьких температурах плівка виходить аморфної й однорідний. Для пассивации краще використовувати аморфні плівки, тому що на границі їхній з підкладкою виникають менші механічні напруги, чим на границі кристалічної плівки з підкладкою. Структура поверхні плівок нітриду кремнію залежить від методу одержання плівки.
У зв'язку з тим що плівку нітриду кремнію осаджують шляхом синтезу з компонентів, а не вирощують за рахунок матеріалу подлож-
224
ки, вона може бути нанесена на будь-який матеріал: германій, арсенід галію й ін.
Експериментальні дослідження плівок нітриду кремнію показали, що плівки нітриду кремнію володіють кращими захисними властивостями стосовно іонів натрію, чим диоксид кремнію; у плівках нітриду кремнію набагато менше дрейф іонів, чим у диоксиде кремнію.
Гарними стабілізуючими властивостями володіють плівки оксиду алюмінію. Ці плівки характеризуються високою щільністю, великою діелектричною проникністю, високою здатністю, що маскує, і малою чутливістю до радіації. Ефект стабілізації особливо добре виявляється при нанесенні плівки АІ2ПРО3 на плівку S1O2. Плівка Та2ПРО5 має високу вологостійкість і низьку хімічну активність.
Для захисту поверхні кремнію використовують кремнийорганическне полімерні плівки. При полімеризації відбувається хімічна сполука плівки, що утвориться, з поверхневими атомами кремнію, що забезпечує надійну адгезію і тому обумовлює відсутність дефектів на границі кремній - плівка, а отже, і відсутність механічних напруг. Крім того, ці плівки володіють високої газо- і вологостійкістю, інертністю до різних хімічних активних речовин і теплостійкістю.
Ефективним методом стабілізації поверхневого заряду є нанесення фосфорно-силікатного, свинцево-силікатного й іншого видів стекол на поверхню напівпровідникових структур. Фосфорно-силікатне скло діє стосовно іонів як геттер, особливо при підвищенні температури. Фосфор і свинець підвищують аморфність плівки, що пасивує, і зв'язують іони лужних металів.
Для того щоб ці плівки володіли гарними властивостями, що пасивують, вони повинні задовольняти наступним вимогам: діелектрична проникність їхній повинна бути гранично малої, інакше це приведе до виникнення великої паразитної ємності; питомий опір плівок повинен бути великим.
Останнім часом для стабілізації поверхневого заряду використовують двошарові покриття: плівку оксиду, що пасивує, кремнію покривають іншою плівкою, що пасивує - Sі3N4, AІ2O3, Ta2O5 і ін. Плівка Sі3N4 захищає плівку Sі2 від дифузії в неї натрію і геттерирует натрій, що потрапив до нанесення плівок Sі3N4 і Sі2. Крім того, плівка Sі3N4 володіє високою діелектричною міцністю, що дозволяє зменшити товщину шару, що пасивує.
Контрольны питання
1. З чим зв'язана зміна зворотних струмів -германиевых і кремнієвих при
бора зі зміною напруги при постійній температурі?
2. Чому величина поверхневої складової зворотного струму, як пра
вило, більше величини об'ємної складовий?
225
3Як зв'язані між собою зворотний струм і швидкість поверхневої ре
комбінації?
4Чим обумовлені струми поверхневого витоку?
Чи завжди наявність каналів па поверхні напівпровідника приводить до збільшення зворотних струмів?
3. Чому ширина р-n-иерехода в поверхні кристала значно мень
ше, чим в обсязі?
4. Чому з ростом температури напруга поверхневого пробою росте?
5. Чому у вологому середовищі шум типу l/f різко зростає?
6. Чому в Мдп-транзисторов шумові характеристики гірше, ніж у планарных?
10. Як впливає стан поверхні на коефіцієнт передачі по струму
транзистора?
11. Що краще, з погляду стабільності параметрів напівпровідникових
приладів велика чи мала швидкість рекомбінації?
12. Що таке "старіння" напівпровідникових приладів?
13. До чого приводить дрейф зворотного струму?
14. Як впливає стан поверхні на величину граничної напруги
Мдп-транзисторов?
15. Чим в основному обумовлене утворення рухливого заряду в оксиді?
16. Чому для стабілізації поверхневого заряду використовують диэлектри
ческие плівки?
