Рецензенти: доц. Московського станкоинструментального інституту, канд техн наук Г. И. Гранітів; викладач Московського технікуму електронних приладів А. В. Закревская Гаркуша Ж. М
| Вид материала | Документы |
СодержаниеКонтакти напівпровідника з діелектриком і напівпровідником |
- Україна харківська міська рада харківської області виконавчий комітет управління освіти, 181.85kb.
- Гост 17623-87, 138.94kb.
- М. А. Ляшко доц., канд физ мат наук; Т. Н. Смотрова доц., канд, 2299.13kb.
- Надійності та безпеки в будівництві, 692.13kb.
- Гост 5382-91, 1729.88kb.
- Д. М. Лаковский (руководитель темы); И. В. Колечицкая; С. А. Резник, канд техн наук;, 203.82kb.
- Гост 14637-89: Прокат толстолистовой из углеродистой стали обыкновенного качества Технические, 310.23kb.
- Государственный стандарт союза сср здания и сооружения Методы измерения яркости, 278.78kb.
- Гост 26824-86, 248.28kb.
- Строительные нормы и правила отопление, вентиляция и кондиционирование, 2477.63kb.
КОНТАКТИ НАПІВПРОВІДНИКА З ДІЕЛЕКТРИКОМ І НАПІВПРОВІДНИКОМ
§ 7.1. УТВОРЕННЯ p-n-переходів
Розглянемо фізичні процеси, що протікають на контакті двох напівпровідникових матеріалів, що володіють різним типом електропровідності. До входження в контакт обоє напівпровідникових матеріалу электрически нейтральні: у напівпровіднику n-типу заряд основних носіїв-електронів - компенсується зарядом іонізованих донорів, а в напівпровіднику р-типа заряд діркою-зарядом іонізованих акцепторів. У випадку контакту напівпровідників, на границі виявляється великий перепад концентрацій електронів і дірок, що викликає виникнення дифузійних потоків основних носіїв заряду: електронів з напівпровідника n-типу в напівпровідника р-типа і дірок у зустрічному напрямку. Носії заряду, що дифундують, створюють дифузійні струми. Дифузія носіїв заряду приводить до порушення електричної нейтральності напівпровідників. У приконтактной області електронного напівпровідника залишається нескомпенсирован-ный позитивний заряд донорів, а в дырочном напівпровіднику - некомпенсований негативний заряд акцепторів. Між цими об'ємними зарядами виникає електричне поле, що перешкоджає дифузії основних носіїв заряд-виникає потенційний бар'єр. Для переходу границі напівпровідників основні носії заряду повинні мати енергію, достатньої для подолання сил електричного полючи. В міру росту некомпенсованих зарядів донорів і акцепторів потенційний бар'єр збільшується й основним носіям стає усе сутужніше його переборювати, тому дифузійні потоки електронів і дірок зменшуються.
Неосновні носії заряду, роблячи тепловий рух, можуть потрапити в область дії образовавшегося електричного полючи, що підхоплює їхній і переносить через границю в сусіднього напівпровідника. Неосновні носії заряду створюють потоки носіїв, спрямовані назустріч дифузійним. Струми неосновних носіїв називають дрейфовими, тому що вони обумовлені дією електричного полючи. В міру наростання напруженості електричного полючи, потоки неосновних носіїв будуть рости. Стан термодинамічної рівноваги в перехідній області наступлять тоді, коли потоки неосновних носіїв заряду зрівноважать потоки основних.
У загальному випадку можна сказати, що через границю напівпровідників проходять чотири струми: два дифузійних струми основних носіїв і два дрейфових струми неосновних носіїв заряду. У стані рівноваги сума струмів, що проходять через перехід, дорівнює нулю.
139
У стані термодинамічної рівноваги рівень Ферми в обохнапівпровідниках проходить на одній висоті (мал. 7.1), щоведе до скривлення енергетичних зон і утворенню потенци ального бар'єра. Електрону, що знаходиться на дні зони проводь мости напівпровідника n-типу, для переходу в напівпровідника р-типа потрібно перебороти потенциальный бар'єр у той час як электроны, що знаходяться в зоні провідності напівпровідника р-типа, вільно "скачуються" у напівпровідника n-типу.

Перехідний шар між двома областями напівпровідника, одна з яких має електропровідність п-типа, а інша - р-типа, називають электронно-дырочным чи переходом р-п-переходом. Довжина його при відсутності зовнішнього зсуву звичайно складає десяті частки мікрометра. Область р-n-перехода збіднена основними носіями заряду і володіє високим питомим опором. Щоб p-n-перехід був электрически нейтральний, нескомпенсовані заряди донорів і акцепторів повинні бути однакові. Як видно з мал. 7.2, а, у р-n-переходе маються електрони і дірки, але заряди, внесені ними, пренебрежимо малі в порівнянні з зарядами донорів і акцепторів, тому можна вважати, що просторовий заряд переходу утворений іонами при-
140
месей. Максимальний по величині заряд розташовується на границі напівпровідників і поблизу її, а за межами переходу заряд буде дорівнює нулю (мал. 7.2, б).
Перехід від області позитивного об'ємного заряду до області негативного визначає зміна контактної різниці потенціалів. За початок відліку контактної різниці потенціалів може бути прийнята будь-яка границя області просторового заряду р-л-перехода, тоді на протилежній границі контактна різниця потенціалів буде максимальна (мал. 7.2, в). Величину контактної різниці потенціалів визначають по формулі

Максимальна напруженість електричного полючи буде там, де відбувається стрибкоподібна зміна щільності і знака объ-емных зарядів (мал. 7.2, г).
§ 7.2. КЛАСИФІКАЦІЯ р-n-переходов
У залежності від співвідношення між шириною області простpанственного заряду і товщиною шаруючи, у якому відбувається изме-нение концентрації і типу при-
месных атомів, р-л-переходы поділяють па різкі і плавні. Електричний перехід, у якому товщина області зміни концентрації домішки значи-тельно менше товщини області просторового заряду, називають різким (мал. 7.3, а). Перехід, у якому товщина області зміни концентрації домішки порівнянна з товщиною області просторового заряду, назы-вают плавним (мал. 7.3, б).

Властивості р-n-переходов, що випрямляють, багато в чому залежать від пределенности фіксації границі між n- і р- областями. Границя є фіксованої в тому випадку, якщо модуль градієнта концентрації домішок поблизу неї задовольняє нерівності:
- дебаевекая дли-
де N - концентрація домішки;
на, що характеризує проникнення електричного полючи у тверде тіло, узята для напівпровідника з власною електропровідністю ( -температурний потенціал: =k(e).
141
З приведеної нерівності випливає, що на дебаевской довжині концентрація домішок повинна сильно змінитися. Якщо концентрація домішок на границі переходу міняється таким чином, що dNіdx>>N/lx, то перехід має фіксовану границю і гарні властивості, що випрямляють. Якщо градієнт концентрації домішки дуже малий, то в околиці границі подвійний електричний шар не утвориться і р-n-переход отсутствует.
Переходи підрозділяють на симетричні і несиметричні в залежності від співвідношення концентрацій донорів і акцепторів у п- і р-областях. На практиці використовують несиметричні переходи, у яких концентрації домішок відрізняються в 100-1000 разів.
Ширина несиметричного переходу визначається в основному областю з більш високим питомим опором. Для різкого несиметричного переходу при NД<

Розглянуті па мал. 7.2 графіки відносяться до різкого симетричного p-n-переходу. Глибина проникнення р- n-переходу в обидва напівпровідників однакова і тем більше, чим більше значення питомого опору напівпровідників: /P//n = N/Na, де Іp і 1п-глубины проникнення переходу відповідно в р- і n-об-ластях. Ширину різкого симетричного p-n-иерсхода можна визначити по формулі

Заряди донорів і акцепторів у несиметричному переході теж однакові, тому довжини областей зарядів різні (мал. 7.4).
Розглянемо плавний несиметричний р-n-переход (мал. 7.5), Його особливістю є характерне для неоднородно легованого напівпровідника наявність внутрішнього електричного полючи, обумовленого градієнтом концентрації домішок по товщині пластини. Це поле пренебрежимо мало в порівнянні з полем переходу і їм зневажають. Плавний перехід утвориться неоднородно легованими ділянками р- і n-шарів (область Д). Товщина р-n-иерехода -/.
В області d перекриття об'ємні заряди складаються з зарядів донорів і акцепторів e(Nд-Na') і градієнт концентрації заряду визначається сумою градієнта розподілу донорів і градієнта розподілу акцепторів. На інших ділянках об'ємні заряд-це заряди або допоровши, або акцепторів, і величини градієнтів відрізняються від градієнта в області d. Перехід, показаний на мал. 7.5, називають "широким"-його границі виходять за межі однорідного градієнта концентрації. Звичайно плавні переходи мають товщину l
142
Різкі переходи одержують при сплавному методі створення переходу, плавні - за допомогою дифузії. Найбільш розповсюдженим методом одержання p-n-переходів є дифузія. Способів проведення дифузії багато: дифузія з газової, рідкої чи твердої фази -у залежності від агрегатного стану диффу-занта. При проведенні дифузії домішок концентрація їх на поверхні пластини максимальна, а в глиб пластини плавно зменшується за законом, близькому по характері до експонентного.
Якщо взяти пластину n-типу, провести в неї дифузію акцепторної домішки (мал. 7.6), то па відстані від поверхні пластини до глибини Х0 концентрація акцепторів буде перевищувати концентрацію донорів, і ця частина пластини буде мати електропровідність р-типа.

Іншим розповсюдженим способом одержання р-n-переходов
143
є сплавка напівпровідника з металом. На напівпровідникову пластину з електропровідністю, наприклад, n-типу, товщиною 100-200 мкм накладають таблетку металу, що володіє властивостями примесного акцепторного матеріалу. Пластину з таблеткою поміщають у вакуумну чи камеру водневу піч і
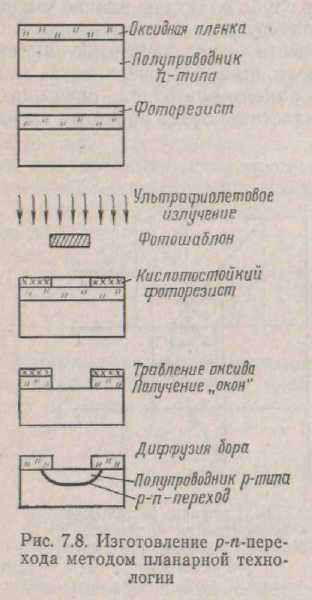
нагрівають до температури плавлення домішки. Таблетка розплавляється і розчиняє прилягаючий до неї напівпровідник. Виходить розплав визначеного складу. Потім виконують повільне охолодження. При цьому напівпровідник рекристаллизуется з розплаву, наращиваясь на тверду частину кристалічних ґрат. У рекристаллизованную зону попадає значна кількість атомів домішки. Оскільки домішка є акцепторної, ре-кристалізований шар напівпровідника має електропровідність .р-типа (мал. 7.7).
Недоліком розглянутих методів є неможливість одержання p-n-переходів малої площі.
Одним з найбільш розповсюджених сучасних методів виготовлення різних напівпровідникових приладів є так називана пленарна * технологія, при якій на напівпровідниковій пластині в єдиному технологічному циклі виходить велика кількість р-n-переходов. В основі планарний технології лежать технологічні операції: окислювання, фотолітографія і дифузія. Послідовність технологічних операцій при виготовленні планарного переходу приведена на мал. 7.8. Пластину кремнію з електропровідністю, припустимо, n-ти-па, відполіровану до 14-го класу чистоти, піддають оксидуванню. На оксидну поверхню наносять фоточуттєвий шар речовини, називаного фоторезистом. Пластину поміщають в установку сполучення й експонування і через фотошаблон засвечивают її ультрафіолетовим випромінюванням. Цей процес аналогічний фотографічному.
* Пленарна технологія одержала назву від англійського planar -плоский, тому що границі всіх р-n-переходов виходять на поверхню пластини і лежать в одній площині.
144
Особливість фоторезисту полягає в тім, що під дією ультрафіолетового випромінювання в ньому змінюються фізико-хімічні властивості, і він перетворюється в кислотостойкий шар. Незасвічені ділянки віддаляються проявом. У цих місцях пластини при обробці її у фтористоводородной кислоті розчиняються ділянки диоскида кремнію, незахищені кислотостойким фоторезистом,-у шарі диоксида з'являються "вікна". У ці вікна для одержання p-n-псрехода проводиться дифузія акцепторної домішки. Плівка диоксида кремнію перешкоджає дифузії домішок у всю пластину.
% 7.3. ПРИРОДА СТРУМІВ ЧЕРЕЗ р-n-переход
З зони провідності напівпровідника з електропровідністю n-типу в зону провідності напівпровідника з електропровідністю р-типа можуть дифундувати тільки ті електрони, а з валентної зони р-области у валентну зону n-області тільки ті дірки, що можуть перебороти потенційний бар'єр. Концентрації рухливих електронів і дірок, здатних перебороти потенційний бар'єр:

де n0 і ро - рівноважні концентрації електронів і дірок у кристалі відповідно.
Для р-области електрони, що перейшли в неї, є нерівновагими носіями заряду, тому вони будуть рекомбинировать з дірками валентної зони. Ці переходи електронів обусловливав ют дифузійну складову струму, що по своїй природі є струмом рекомбінації. На відстані дифузійної довжини від р-п-перехода відбувається рекомбінація електронів і дірок.
Неосновні носії заряду - електрони - у зоні провідності р-области під дією що прискорює полючи "скачуються" з потенційного бар'єра в зону провідності n-області. Через перехід електронів у напівпровідника n-типу концентрація їх у напівпровіднику р типу знижується і стає менше концентрації, обумовленої умовою термодинамічної рівноваги. Це приводить до генерації электронно-дырочных пара, причому дірки, що утворилися, дифундують у n-область, де потім рекомбинируют з електронами. Складову електронного струму, обумовлену електронами, що скачуються з потенційного бар'єра, называ-ют дрейфової; вона по своїй фізичній природі представляє струм генерації. Природа дырочных струмів аналогічна. У стані термодинамічної рівноваги через р-n-переход проходять дифузійні струми 1nn і Іpp основних носіїв електронів і дірок і дрейфові струми неосновних носіїв Jnp і Jpn відповідно. Сума цих струмів дорівнює нулю: 1nn+lрр + lnр+ 145
+/рп=О. Прикладемо до р-n-переходу зовнішня напруга: плюс до п- і мінус до р-области. Така полярність зовнішньої напруги відповідає полярності контактної різниці потенціалів і приводить до збільшення висоти потенційного бар'єра на величину eUB4 де UBп- прикладена напруга (мал. 7.9).

Через збільшення висоти потенційного бар'єра в n-області зменшується кількість електронів, а в р-области - количестводырок, що мають енергію, достатню для подолання потенційного бар'єра:

При визначеній висоті потенційного бар'єра потоки основних носіїв заряду через р-n-переход практично припиняються і струм через перехід буде обумовлений тільки потоками неосновних носіїв, що скачуються з потенційного бар'єра.
Таким чином, при даній полярності зовнішнього джерела напруги через р-n-переход проходить тільки струм генерації неосновних носіїв заряду, величина якого визначається їхньою концентрацією. Концентрація неосновних носіїв заряду залежить від температу ры і не залежить від напруги в порівняно широких межах зміни останнього. Тік, обумовлений генерацією неосновних носіїв заряду, називають струмом насичення Js- Розглянуте включення р-п-перехода називають зворотним напрямком.
При зміні полярності прикладеної зовнішньої напруги: плюс - до р-области, мінус - до n-області - прямий напрямок, висота потенційного бар'єра зменшується. Кількість основних носіїв заряду, що мають енергію, необхідну для подолання потенційного бар'єра, збільшиться:
Це приводить до зростання дифузійного струму через перехід; дрейфовий струм не змінюється.

146
При збільшенні зовнішньої напруги в прямому напрямку ширина переходу зменшується, а концентрація носіїв заряду збільшується; при зростанні напруги в зворотному направ-

лении ширина переходу збільшується, а концентрація носіїв зменшується.
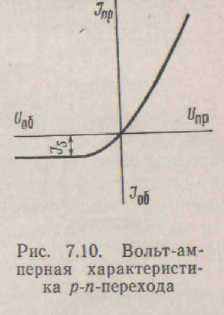
Процес уведення носіїв заряду в напівпровідника називають інжекцією, а процес виведення носіїв заряду з напівпровідника - екстракцією. При прямому зсуві на р-n-переходе відбувається інжекція неосновних носіїв, а при зворотн-екстракція. Можна зробити висновок про те, що при включенні переходу в будь-якому напрямку дрейфові струми залишаються постійними, а змінюються дифузійні струми. Концентрація носіїв заряду, здатних перебороти потенційний бар'єр, змінюється по експонентному законі, тому зміна дифузійного струму Судет відбуватися по тім же законі:
Jаиф\=Js ехр[e/(k)}. Повний струм через перехід при прямому напрямку (Uвн>0):
Jпр=Jдиф-Jр = Js(exp[eUвн/(k)]-1)> при зворотному напрямку (UВН<0):
Jобр-Jдр-Jдиф=J(1-ехр[-eUвн/(k])-
При прямому напрямку переходу можна зневажити дрейфової складовий: JПР = Js exp[eUвп{k)], а при зворотній-дифузійній: Jобр = Js. Залежність струму від величини прикладеного до р~п-переходу напруги називають вольт-амперною характеристикою переходу. Графічно вольт-амперна характеристика р-n-перехода представлена на мал. 7.10.
§ 7.4. ОМІЧНІ ПЕРЕХОДИ. ПЕРЕХОДИ n-n+, р-р+
Омічні переходи є обов'язковими елементами будь-якого напівпровідникового чи приладу мікроелектронного пристрою, тому що вони здійснюють зв'язок між елементами приладу і зовнішнім ланцюгом. Омічні переходи повинні задовольняти наступним вимогам. 1) мати лінійну вольт-амперну характеристику; 2) мати дуже малий опір; 3) у них повинна
147
отсутствовать інжекція; 4) мати високу теплопровідність; 5) мати мале розходження в температурних коефіцієнтах розширення контактуючих матеріалів; 6) мати велику механічну міцність.
Створити омічний перехід, що цілком відповідає цим усім вимогам одночасно, практично неможливо. Для прибли-


ження реального контакту до ідеального омічного переходу в поверхневій області напівпровідника п- чи р-типа створюють сильно легований шар з електропровідністю n+- чи р+-ти-па відповідно, і на цей шар наносять металевий електрод для одержання омічного переходу.
Розглянемо електронно-електронний і дырочно-дырочный пе-
реходы п-п+ і р-р+. На мал. 7.11 представлені зонні діаграми переходу п-п+ при відсутності зовнішнього полючи і при його наявності. Особливість переходів полягає в тім, що вони не є збідненими шарами і не мають выпрямляющими властивості.
У цих переходах практично отсутствует інжекція неосновних носіїв заряду у высокоомную область. Наприклад, при прямому напрямку зсуву переходу п-п+: плюс - до n-шару, мінус - до n+-шарую, потенційний бар'єр для електронів шаруючи п+ зменшиться і струм через перехід буде обумовлений основними носіями заряду. При зворотному включенні у высокоомный напівпровідника будуть инжектироваться дірки, однак їхня концентрація в шарі п+ мала і цією інжекцією можна зневажити.
Тепер розглянемо структуру метал - сильно легований напівпровідник - слабко легований напівпровідник м - п+ - n, зонна діаграма якої в рівноважному стані приведена на мал. 7.12. Обидва переходи м-n+ і п+-п є неинжектирующими,
148
тому що у всіх областях основними носіями є електрони. Прикладемо зовнішня напруга до структури в прямому напрямку: плюс - до n-шару, мінус - до металу. Тоді потенційний бар'єр п-п+ понизиться, а бар'єр n+-м підвищиться. Електрони із шару п+ будуть переходити в n-шар, а електрони металу - у n+-шар. При зворотній полярності прикладеної напруги висота бар'єра п-п+ збільшиться, а бар'єра n+-м зменшиться. Потоки електронів будуть спрямовані з n-шару в n+-шар, а з n+-шаруючи- у метал.
Через такий контакт, отже, струм проходить в обох напрямках і здійснюється основними носіями заряду.
§ 7.5. ГЕТЕРОПЕРЕХОДЫ
Останнім часом широке застосування знаходять переходи, що утворяться на границі контакту двох різнорідних полупроводникое. Напівпровідники можуть відрізнятися шириною забороненої зони, структурою кристалічних ґрат, можуть мати однаковий тип електропровідності. Ці переходи, що одержали назву гетерогенних чи переходів гетеропереходов, можна одержати на границі таких пар, як Ge-GaAs, GaAs-GaхAlі-xAs, GaAs- GaAsxPі-x, CdTe-CdSe, Sі-Cd і ін.
Для виготовлення гетеропереходов звичайно застосовують метод эпитаксиального нарощування монокристаллического шаруючи одного матеріалу на монокристаллической підкладці або эпитаксиаль-ном шарі з іншого матеріалу. Розглянемо фізичні процеси, що протікають у гетеропереходе, утвореному з напівпровідників різного типу электропро-водности, причому ширина забороненої зони напівпровідника n-типу ширше, ніж у матеріалу з електропровідністю р-типа (мал. 7.13).
Обмін носіями заряду між цими напівпровідниками відбувається аналогічно обміну на кожнім з розглянутих раніше переходів двох матеріалів. Електрони з n-області будуть переходити в р-область, тому що
; напівпровідник n-типу зарядиться позитивно завдяки некомпенсованому заряду донорів, а напівпровідник р-типа-отрицательно через нескомпенсований заряд акцепторів. Негативний заряд р-области буде перешкоджати переходу електронів, тому їхній потік зменшиться. У стані рівноваги рівні Ферми напівпровідників збігаються {мал. 7.13, б), і в перехоле виникає контактна різниця потенціалів. В обох напівпровідниках поблизу границі утворять- ся збіднені шари.Повна контактна різниця потенціалів розподіляється між напівпровідниками в залежності від концентрації основних носи- телей заряду:

149
Особливістю зонної діаграми гетеропереходов є розрив енергетичних зон. Величина розриву визначається різницею значень енергій заборонених зон напівпровідників і різницею енергій спорідненості до електрона і може бути різної для зон провідності і валентних зон. Розриви зон можуть мати вид або "стінки", або "гака".

Другою особливістю гетеропереходов є рознос значення
потенційних бар'єрів для електронів і дірок. Величина бар'єрів залежить від ширини розриву зон.
При додатку зовнішньої напруги змінюються потенційні бар'єри для електронів і дірок (див. мал. 7.13). Вольт-амперна характеристика гетеропереходов має вид, аналогічний звичайному р-n-переходу:
Для гомогенного р-n-перехода А = = 1. У гетеропереходах на вид вольт-амперної характеристики істотний вплив роблять недосконалості границі між двома матеріалами, що виявляються в утворенні великої кількості дефектів і скупченні домішок. Ці дефекти і домішки беруть участь у процесах генерації і рекомбінації носіїв заряду, що сильно впливає на проходження струму. У гетеро переходах тому А перевищує одиницю. На вольт-амперну характеристику великий вплив може робити туннелирование носіїв заряду через потенційний бар'єр, якщо ширина його невелика.
Гетеропереходы одержують і при контакті двох напівпровідників n-типу (мал. 7.14) чи при контакті двох напівпровідників р-типа (мал. 7.15). У таких гетеропереходах умови руху електронів при прямому і зворотному напрямках неоднакові, а це значить, що структура буде мати выпрямляющими властивості. Особливістю структур є те, що при будь-якому напрямку в електропровідності беруть участь тільки основні носії заряду, а, виходить, при
переключенні на зворотну напругу в кристалі не буде відбуватися процес рассасывания неосновних носіїв заряду, що сприяє підвищенню граничної частоти напівпровідникових

приладів, створених на основі гетеропереходов. У гетеропереходах рівень Ферми одного з напівпровідників може виявитися в дозволеній зоні, і цей шар виявляється вырожденным (див. мал. 7.15).
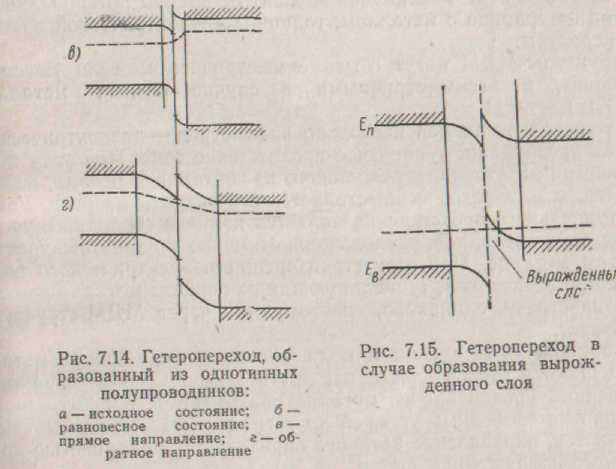
Для з'єднань типу A111Bv характерна випромінювальна рекомбінація. Гетеропереходы, створені з таких з'єднань, використовуються для створення цифрознаковых індикаторів, оптичних транзисторів, инжекционных лазерів, фотоелементів і ін.
