Проекта
| Вид материала | Отчет |
- Оценка экономической эффективности инвестиционного проекта, 66.94kb.
- Задачи стажера в рамках проекта (индивидуальное проектное задание), 8.2kb.
- Бизнес-план инвестиционного проекта это предназначенный для участников проекта структурированный, 769.62kb.
- Тема: Оценка финансовой реализуемости проекта, 13.29kb.
- А. Описание возможностей проекта > Название проекта, 93.63kb.
- Методическое представление Введение. Методический паспорт учебного проекта. Осуществление, 257.36kb.
- Концепция активности Наиболее активный в проекте это менеджер проекта. Как только активность, 5.38kb.
- Применение метода системного анализа при разработке концепции проекта, 129.27kb.
- Задачи проекта Управленческо-кадровый аспект проекта Содержание проекта и механизм, 762.91kb.
- Содействие реформе вторичной медицинской помощи в Украине, 347.59kb.
Интеграционный проект фундаментальных исследований Учреждения Российской академии наук Сибирского отделения РАН и Национальной академии наук Беларуси
ОТЧЕТ
Первый этап 2010 г
Тема проекта:
«Наноструктуры Ge/Si, формируемые при низкоэнергетическом ионном воздействии»
Организации-исполнители:
- Институт физики полупроводников СО РАН (ИФП СО РАН)
- Научно-практический центр по материаловедению НАН Беларуси (НПЦ НАНБ)
Координаторы проекта: Член-корр. РАН, д.ф.-м.н., профессор, зам. директора ИФП СО РАН
Двуреченский Анатолий Васильевич;
Д.ф.-м.н., г.н.с. НПЦ по материаловедению НАН Беларуси
Мудрый Александр Викторович.
Ученый секретарь проекта: к.ф.-м.н. Смагина Ж.В.
ИФП СО РАН
Новосибирск-2010
Объявленные ранее ожидаемые результаты проекта на 2010 год:
На этап 2010 г. было запланировано:
- Разработка методов создания однородного массива квантовых точек, упорядоченных в направлении роста, с помощью молекулярно-лучевой эпитаксии германия на кремнии.
- Экспериментальное исследование структурных параметров выращенного массива с помощью метода фотолюминесценции и высокоразрешающей электронной микроскопии.
- Выявление механизма зародышеобразования и роста однородного массива КТ на кремнии при различных размерах и плотности «мест зарождения», сформированных с помощью воздействия пучком низкоэнергетичных ионов.
- Построение модели и проведение исследования методами компьютерного моделирования процесса ионного воздействия, зарождения и роста наноостровков Ge на Si.
Степень выполнения поставленных в проекте задач
Поставленные задачи выполнены.
Полученные за отчетный год важнейшие результаты
Задачи, поставленные в проекте, решались в ходе совместных исследований с использованием взаимодополняющих методик. Поскольку наноструктуры Si/Ge с квантовыми точками Ge обладают повышенной вероятностью излучательных переходов в системе “Si – КТ Ge”, исследования фотолюминесценции этих наноструктур, проводимые белорусскими коллегами, находились в общем русле работ, направленных на решение перспективной задачи создания наноструктур для оптоэлектроники с возможностью контролируемого управления их оптическими свойствами. Актуальность данной задачи обусловлена тем, что на современном этапе развития полупроводниковой оптоэлектроники на основе кремния происходит интенсивная разработка различных подходов по повышению эффективности люминесценции материала, в том числе – наноструктур с КТ Ge в Si. Работа коллектива сотрудников ИФП СО РАН была посвящена экспериментальному и теоретическому изучению процессов формирования массивов КТ Ge на Si, включая многослойные структуры. Серии образцов, полученных в ИФП при варьируемых условиях эпитаксии (включая низкоэнергетическое ионное воздействие), отправлялись для исследования фотолюминесценции в НПЦ НАНБ с тем, чтобы в результате совместного поиска выяснить оптимальный режим роста, обеспечивающий эффективную фотолюминесценцию наноструктур. В качестве перспективной цели ставилась реализация возможности контролируемого управления оптическими свойствами структур Si с КТ Ge.
Основная часть исследований проводилась на Si/Ge наноструктурах, сформированных на пластинах монокристаллического кремния КДБ-50 (кремний p-типа проводимости, легированный бором, с удельным сопротивлением 50 Ом∙см). Используемый набор исходных образцов был изготовлен с применением молекулярно-лучевой эпитаксии (МЛЭ) на подложке Si с ориентацией (100). Перед созданием слоев методом МЛЭ проводилась полная химическая обработка пластин Si и операция по сгону оксида кремния в установке при Т = 720 °С. На подложке Si после сгона оксида кремния выращивался буферный слой кремния при температуре 750 °С толщиной 50 нм. Затем производился рост германия. Гетероэпитаксия осуществлялась
Таблица 1. Параметры кремниевой подложки, а также слоев кремния и германия входящих в Si/Ge наноструктуры.
| Наименование образцов | Наименование слоев Si и Ge в наноструктуре Si/Ge | Количество слоев Si и Ge в нанострукту-рах Si/Ge, шт. | Толщина слоев Si и Ge в нанострукту-рах Si/Ge, нм | Темпера-тура роста слоя Si или Ge, °С |
| Si подложка – монокристаллическая пластина КДБ-50, (p-типа проводимости, легированная бором, с удельным сопротивлением 50 Ом.см), R1 | – | – | 300 | – |
| Наноструктура Si подложка / Si эпитаксиальный слой, R15 | Si буферный | 1 | 50 | 750 |
| Наноструктура Si/Ge, R16 | Si буферный квантовые точки Ge (тонкий слой) Si закрывающий | 1 1 1 | 50 0.848 50 | 750 300 300 – 500 |
| Наноструктура Si/Ge, R14 | Si буферный квантовые точки Ge (толстый слой) Si закрывающий | 1 1 1 | 50 10 50 | 750 300 300 – 500 |
| Наноструктура Si/Ge, R18 | Si буферный квантовые точки Ge Si разделяющий Si закрывающий (6-ой слой) | 1 6 5 1 | 50 0.848 5 50 | 750 300 300 – 500 500 |
как с ионным воздействием, так и без него. При ионном воздействии степень ионизации молекулярного пучка составляла 0.3%, энергия ионов от 140 до 220 В, температура роста Ge 350°C. В одних экспериментах ионное воздействие производилось в непрерывном режиме, в других – в импульсном. Длительность импульса составляла 0.5 с.
Параметры кремниевой подложки и всех слоев в гетероструктурах Si/Ge для образцов, полученных без применения ионного воздействия, приведены в таблице 1. Рост одного слоя Ge с квантовыми точками толщиной 8.5 и 100 Å производился при 300 °С для образцов R16 и R14, соответственно. Для образца R18 выращивалось шесть слоев Ge при 300 °С толщиной 8.5 Å и пять разделяющих слоев Si при постепенном подъеме температуры от 300 до 500 °С. Закрывающие слои Si имели толщину ~500 Å.Полученные образцы анализировались методами СТМ, АСМ, электронной микроскопии и люминесценции. На рис. 1 представлены СТМ-изображения поверхностных структур Ge, полученных при импульсном ионном воздействии и без него, при прочих идентичных условиях роста. На изображениях хорошо проявляется типичный эффект низкоэнергетического ионного воздействия: плотность островков Ge в массиве увеличивается, а их средний средний размер уменьшается. Кроме того, как показывает количественный анализ, в случае ионного воздействия увеличивается однородность массива по размерам островков. Представления о механизме ионного воздействия, предложенного ранее, основывалось на предположении, что при падении иона на поверхности создаются вакансионные комплексы, а в приповерхностной области – междоузлия. Первые служат эффективными центрами зарождения трехмерных островков, вторые – стимулируют процесс зарождения, создавая благоприятные для него локальные области упругих деформаций растяжения. В рамках данного проекта методом молекулярной динамики с использованием эмпирического потенциала межатомного взаимодействия Терсоффа исследованы элементарные процессы, происходящие на атомарных масштабах в течение нескольких пс после падения низкожнергетического иона.
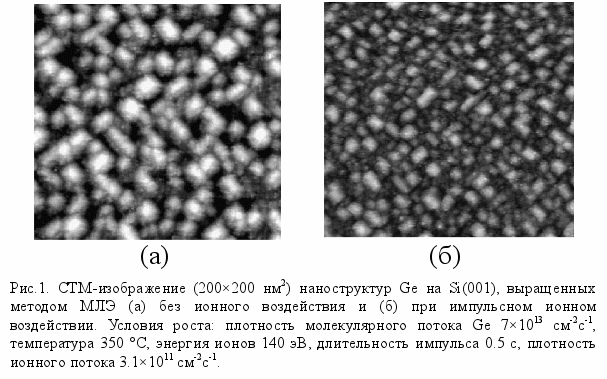
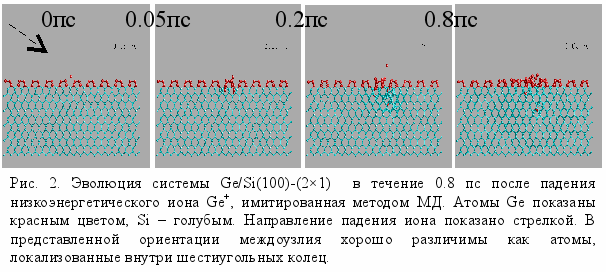
На рис.2 представлена серия ”мгновенных снимков“ моделируемой структуры в течение долей пс после падения иона. Величина и направление скорости иона соответствовали экспериментальным условиям роста и геометрии системы. Рис.2 иллюстрирует характерные процессы, иницируемые ионом: генерацию междоузлий, выбивание атома (распыление материала) и локальное изменение структуры поверхности. Нами было установлено, что интенсивность каждого процесса зависит от точки падения иона. В связи с этим моделирование
методом МД было проведено для множества ~100 начальных положений падающего иона в пределах элементарной ячейки структуры Si/Ge(001)-(2×1). На рис.3 представлены сечения генерации междоузельных атомов. Проведенная серия вычислительных экспериментов позволила определить среднее число междоузлий, генерируемых при падении одного иона (9.97), и распыленных атомов (0.95). Приблизительно половина междоузлий генерируется в объеме пленки, на глубине от 4 до 8 монослоев (МС). Эти данные позволили уточнить результаты, полученные ранее методом Монте-Карло в рамках феноменологической модели, включающей решение упругой задачи. В частности, был воспроизведен эффект ионно-стимулированного увеличения плотности островков в массиве, количественно согласующийся с данными экспериментов.

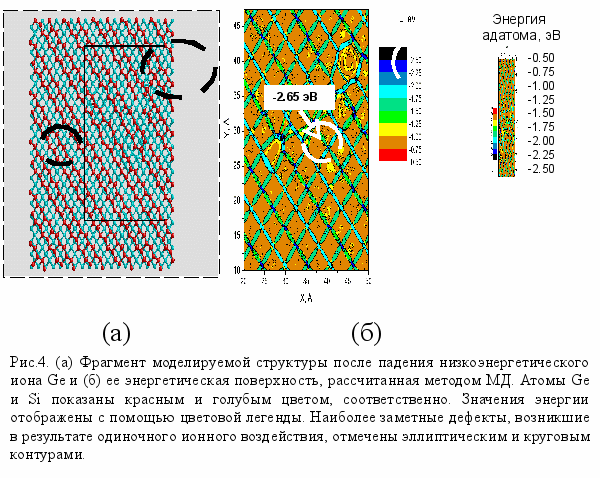 Методом МД было установлено, что основные элементарные процессы происходят в течение первых 2 пс после падения иона. По крайней мере за временной интервал между 2 и 20 пс заметных структурных изменений не наблюдается. Для системы в этом метастабильном состоянии с использованием потенциала Терсоффа была рассчитана энергетическая поверхность, выражающая потенциальную энергию адатома германия в заисимости от точки, в которой осуществляется его связь с поверхностью (рис.4). На основании полученной энергетической поверхности можно отметить два основных эффекта. Во-первых, в области ионного воздействия формируется глубокий минимум (-2.65 эВ, внутри кругового контура), который действует как эффективная ловушка для адатомов, участвующих в поверхностной диффузии. Во-вторых, на пути диффузионных каналов возникает дефект, блокирующий быстрый транспорт, имеющий место при анизотропии поверхностной диффузии на поверхности Si/Ge(001)-(2×1) (эллиптический контур на рис.4). Оба эффекта способствуют зарождению трехмерных островков на стадии после осаждения псевдоморфного слоя Ge.
Методом МД было установлено, что основные элементарные процессы происходят в течение первых 2 пс после падения иона. По крайней мере за временной интервал между 2 и 20 пс заметных структурных изменений не наблюдается. Для системы в этом метастабильном состоянии с использованием потенциала Терсоффа была рассчитана энергетическая поверхность, выражающая потенциальную энергию адатома германия в заисимости от точки, в которой осуществляется его связь с поверхностью (рис.4). На основании полученной энергетической поверхности можно отметить два основных эффекта. Во-первых, в области ионного воздействия формируется глубокий минимум (-2.65 эВ, внутри кругового контура), который действует как эффективная ловушка для адатомов, участвующих в поверхностной диффузии. Во-вторых, на пути диффузионных каналов возникает дефект, блокирующий быстрый транспорт, имеющий место при анизотропии поверхностной диффузии на поверхности Si/Ge(001)-(2×1) (эллиптический контур на рис.4). Оба эффекта способствуют зарождению трехмерных островков на стадии после осаждения псевдоморфного слоя Ge. 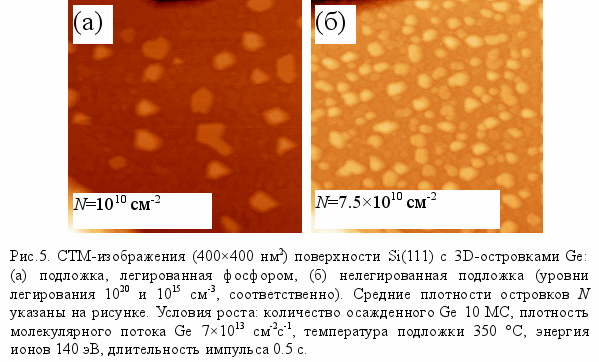
Для выявления роли точечных дефектов в формировании островков были проведены эксперменты по росту при ионном воздействии на легированных подложках Si. Известно, что примеси обладают способностью собирать на себя междоузлия, ослабляя тем самым их вклад в процесс зарождения островков на поверхности. На рис. 5 представлены СТМ-изображения наноструктур, полученной на подложке, легированной фосфором, и на нелегированной, соответственно. Плотность островков на легированной подложке оказалась приблизительно в 8 раз ниже, чем в тех же условиях – на нелегированной. Та же тенденция, хотя и в меньшей степени (двукратное уменьшение плотности островков), проявилась на подложке, легированной бором. Полученные экспериментальные результаты усиливают аргументы в пользу механизма зарождения островков, обусловленного междоузлиями.
В образцах с одиночными и несколькими слоями германия была исследована фотолюминесценция. Спектры фотолюминесценции регистрировались в оптическом криостате при непосредственном погружении исследуемых образцов в жидкий гелий и их охлаждении до 4.2 К. Генерация неравновесных носителей заряда в Si/Ge наноструктурах осуществлялась с использованием лазера на неодивомом стекле с диодной накачкой, работающего на длине волны 532 нм (вторая гармоника) мощностью до 70 мВт и диаметром светового пучка до 1 мм2. Излучение, испускаемое образцами перефокусировалось на входную щель монохроматора сферическим зеркалом с фокусным расстоянием зеркального объектива f ~ 15 см. Спектральный состав излучения анализировался дифракционным монохроматором МДР-23 с фокусным расстоянием зеркального объектива f ~ 60 см оснащенного дифракционной решеткой 600 штрх/мм ( дисперсия 26 А/мм). Выходящий из монохроматора разложенный свет детектировался InGaAs p-i-n фотодиодом (фирма “Hamamatsu”, Япония) сигнал с которого поступал на низкочастотный усилитель (частота 20 Гц) и в дальнейшем на синхронный фазовый детектор. В последующем постоянный сигнал обрабатывался аналого-цифровым преобразователем и поступал на компьютер для автоматической записи спектров.
 В данной работе исследовалось влияние нескольких технологических факторов, таких как температура роста нанослоев Si и Ge, количество слоев KT Ge, обработка структур в плазме водорода при температуре ~ 200 °С, на оптические свойства. Серия образцов изготавливалась с применением молекулярно-лучевой эпитаксии (МЛЭ) на подложках Si с ориентацией (100) и толщиной ~300 мкм, обладающих p-типом проводимости (легирование бором) с удельным сопротивлением ~50 Ом∙см. Некоторые из созданных наноструктур Si/Ge подвергались термической обработке при температуре Т~200 °С в плазме Н2-водорода в течение 45 минут при мощности воздействия Р~70 Вт.
В данной работе исследовалось влияние нескольких технологических факторов, таких как температура роста нанослоев Si и Ge, количество слоев KT Ge, обработка структур в плазме водорода при температуре ~ 200 °С, на оптические свойства. Серия образцов изготавливалась с применением молекулярно-лучевой эпитаксии (МЛЭ) на подложках Si с ориентацией (100) и толщиной ~300 мкм, обладающих p-типом проводимости (легирование бором) с удельным сопротивлением ~50 Ом∙см. Некоторые из созданных наноструктур Si/Ge подвергались термической обработке при температуре Т~200 °С в плазме Н2-водорода в течение 45 минут при мощности воздействия Р~70 Вт.На рис.6 представлены спектры фотолюминесценции Si/Ge наноструктур с шестью и двенадцатью слоями квантовых точек германия, снятые при 4.2 К. Спектры регистрировались при возбуждении неравновесных носителей заряда световым пучком лазера с диодной накачкой на неодимовом стекле на длине волны 532 нм (вторая гармоника) с мощностью до 70 мВт. Спектры показаны для двух типов структур с 6-тью слоями (образец R18) и 12-тью слоями (образец R17) без обработки и после обработки при 200 °С в плазме водорода, образцы R18H и R17H, соответственно. Как видно из рис.6, в случае формирования наноструктуры Si/Ge с шестью слоями квантовых точек Ge (образец R18) в примесной области спектра 0.7–1.0 эВ наблюдаются две широкие полосы люминесценции с максимумами 0.77 эВ и 0.81 эВ, относящиеся к КТ Ge. В случае формирования структур с двенадцатью слоями (образец R17) присутствовала менее интенсивная полоса в области 0.77 эВ и сплошной фон до 1.0 эВ. Обработка образцов в плазме водорода при температуре 200 °С приводила к изменению спектральной формы полосы люминесценции и смещению максимума широкой полосы с 0.81эВ до 0.83эВ для образца R18. Для наноструктуры Si/Ge с 12-ю слоями КТ Ge, обработанной в плазме водорода при 200 °С, наблюдалось появление дополнительной полосы ФЛ в области 0.97 э

В.

На рисунках 7 и 8 приведены спектры люминесценции наноструктур образцов R18 и R18H, снятые при 4.2 К для различных уровней возбуждения. Как видно, с уменьшением уровня возбуждения интенсивность полос люминесценции уменьшается, а изменения спектрального положения широких полос и их спектральной формы не происходит. Эти экспериментальные данные свидетельствуют о стабильности положения энергетических уровней в запрещенной зоне кремния и КТ Ge, через которые происходит излучательная рекомбинация.
На следующем этапе выполнения данного проекта планируются совместные публикации с использованием результатов по фотолюминесценции КТ германия.
На основании полученных при выполнении исследований по проекту результатов можно сделать вывод, что в целом задачи первого года исследований выполнены успешно.
Степень новизны полученных результатов
Научная новизна полученных в рамках выполнения проекта результатов заключается в следующем:
- Впервые с учетом геометрии системы и сверхструктурной перестройки поверхности определены процессы, инициируемые падением низкоэнергетичного иона на поверхность Si/Ge(001)-(2×1). Установлены типы генерируемых дефектов и определены средние количественные параметры, определяющие плотность этих дефектов и их пространственное распределение.
- Впервые построена энергетическая поверхность структур Si/Ge в области воздействия низкоэнергетичного иона.
- Впервые экспериментально установлено влияние легирования подложки Si на плотность островков Ge в массивах, выращенных при низкожнергетическом ионном воздействии.
Полученные результаты соответствуют мировому уровню исследований в данной области.
Библиографический список всех публикаций по проекту
1. J.V. Smagina, V.A. Zinoviev, P.L. Novikov, V.A. Armbrister, E.S. Koptev and A.V. Dvurechenskii, "Ge/Si nanostructures with quantum dots grown by ion-beam assisted heteroepitaxy", Journal of Physics: Conference Series, Volume 245, Number 1 (2010) 012071 (4 pages)
2. Zh.V. Smagina, P.L. Novikov, V.A. Zinoviev, V.A. Armbrister, S.A. Teys, A.V. Dvurechenskii, "Molecular-beam epitaxial growth of Ge/Si nanostructures under low-energy ion irradiation", Journal of Crystal Growth (принята в печать)
3. Ж.В. Смагина ,П.Л. Новиков , А.В. Зиновьев , В.А. Армбристер, А.В. Ненашев, С.А.Тийс, А.В. Двуреченский, ”Наноструктуры Ge/Si с квантовыми точками, формируемые при низкоэнергетическом ионном воздействии”, Тезисы докладов VII Международной конференции «Кремний-2010» (Нижний Новгород, Россия, 6-9 июля 2010) 166.
4. P.A. Kuchinskaya, Zh.V. Smagina, V.A. Zinoviev, A.V. Dvurechenskii, “Nucleation of Ge nanoislands on Si by pulsed ion irradiation”, XI International conference and seminar EDM 2010, June 30- July 4, Erlagol, p. 3-5.
5. Zh.V. Smagina, V.A. Zinoviev, P.L. Novikov, V.A. Armbrister, A.V. Dvurechenskii, “Nanoislands nucleation during growth of Ge/Si structures under low-energy ion irradiation”, X International Conference on Nanostructured Materials, September 13-17, 2010, Rome, T25-040.
