І. П. Основи дефектоскопії-К.: «Азимут-Україна», 2004. 496 с. Ермолов И. Н., Останин Ю. А. Методы и средства неразрушающего контроля качества. М.: Высшая школа, 1988. Неразрушающий контроль металлов и изделий. Справочник
| Вид материала | Справочник |
- Название Организации, 14.27kb.
- Аннотация дисциплины «методы неразрушающего контроля», 12.16kb.
- Государственный стандарт республики беларусь, 859.5kb.
- Неразрушающий контроль и техническая диагностика в промышленности , 23.73kb.
- Основные понятия и определения в области неразрушающего контроля, 280.3kb.
- Государственные стандарты. Неразрушающий контроль, 41.04kb.
- Комплексное исследование параметров качества биметаллических листов, 20.46kb.
- Семинар студентов, аспирантов, молодых ученых и специалистов отраслевых предприятий, 54.06kb.
- Правила аттестации специалистов неразрушающего контроля, 385.22kb.
- Неразрушающий контроль разрушает границы, 73.42kb.
Лекция 7-а
Электронный микроскоп
Электро́нный микроско́п (ЭМ) — прибор, позволяющий получать изображение объектов с максимальным увеличением до 106 раз, благодаря использованию вместо светового потока пучка электронов с энергиями 30÷200 кЭв и более. Разрешающая способность электронного микроскопа в 1000÷10000 раз превосходит разрешение светового микроскопа и для лучших современных приборов может составлять несколько ангстрем. Для получения изображения в электронном микроскопе используются специальные магнитные линзы, управляющие движением электронов в колонне прибора при помощи магнитного поля.

Рисунок 1 – Электро́нный микроско́п
Виды электронных микроскопов
1. Просвечивающий электронный микроскоп
2. Растровый электронный микроскоп
3. Растровый просвечивающий электронный микроскоп
4. Растровый туннельный микроскоп
История создания электронного микроскопа
Сферы применения электронных микроскопов
1. Полупроводники и хранение данных
- Редактирование схем
- Метрология 3D
- Анализ дефектов
- Анализ неисправностей
2. Биология и биологические науки
- Криобиология
- Локализация белков
- Электронная томография
- Клеточная томография
- Крио-электронная микроскопия
- Токсикология
- Биологическое производство и мониторинг загрузки вирусов
- Анализ частиц
- Фармацевтический контроль качества
- 3D изображения тканей
- Вирусология
- Стеклование
3. Научные исследования
- Квалификация материалов
- Подготовка материалов и образцов
- Создание нанопрототипов
- Нанометрология
- Тестирование и снятие характеристик устройств
- Исследования микроструктуры металлов
4. Промышленность
- Создание изображений высокого разрешения
- Снятие микрохарактеристик 2D и 3D
- Макрообразцы для нанометрической метрологии
- Обнаружение и снятие параметров частиц
- Конструирование прямого пучка
- Эксперименты с динамическими материалами
- Подготовка образцов
- Судебная экспертиза
- Добыча и анализ полезных ископаемых
- Химия/Нефтехимия
Основные мировые производители электронных микроскопов
- Carl Zeiss NTS GmbH — Германия
- Delong Group
- FEI Company — США (слилась с Philips Electron Optics)
- FOCUS GmbH — Германия
- Hitachi — Япония
- JEOL — Япония (Japan Electron Optics Laboratory)
- KYKY — Китай
- Nion Company — США
- Tescan — Чехия
- ОАО «SELMI» — Украина
Просвечивающий электронный микроскоп
Просвечивающий электронный микроскоп (ПЭМ) — это установка, в которой изображение от ультратонкого объекта (толщиной порядка 0,1 мкм) формируется в результате взаимодействия пучка электронов с веществом образца с последующим увеличением магнитными линзами (объектив) и регистрацией на флуоресцентном экране. Для регистрации изображения возможно использование сенсоров, например, ПЗС-матрицы. Первый практический просвечивающий электронный микроскоп был построен Альбертом Пребусом и Дж. Хиллиером в университете Торонто (Канада) в 1938 году с использованием концепции, предложенной ранее Максом Кноллом и Эрнстом Руска.

Рисунок 1 – Первый практический ПЭМ, на экспозиции в немецком музее в Мюнхене, Германия
Основы
Теоретически максимально возможное разрешение в оптическом микроскопе ограничено длиной волны фотонов, используемых для освещения образца и угловой апертурой оптической системы. В начале 20-го столетия ученые обсуждали вопрос преодоления ограничений относительно большой длины волны видимого света (длины волн 400—700 нанометров) путём использования электронов. Электроны эмиттируются в электронном микроскопе посредством термоэлектронной эмиссии из нити накаливания (вольфрамовая проволока или монокристалл гексаборида лантана ), либо посредством полевой эмиссии. Затем электроны ускоряются высокой разностью потенциалов и фокусируются на образце электромагнитными (или реже — электростатическими) линзами. Прошедший через образец луч содержит информацию об электронной плотности, фазе и периодичности; которые используются при формировании изображения.
Компоненты
ПЭМ состоит из нескольких компонентов:
— вакуумная система;
— источник электронов (электронный прожектор, электронная пушка) для генерирования электронного потока;
— источник высокого напряжения для ускорения электронов;
— набор электромагнитных линз и электростатических пластин для управления и контроля электронного луча;
— экран, на который проецируется увеличенное электронное изображение.
Источники
1. Я. С. Уманский, Ю. А. Скаков, А. Н. Иванов, Л. Н. Расторгуев. Кристаллография, рентгенография и электронная микроскопия. М.: Металлургия, 1982, 632 с.
2. Д. Синдо. Т. Оикава. Аналитическая просвечивающая электронная микроскопия. М.: Техносфера, 2006, 256 с. ISBN 5-94836-064-4
Сканирующий туннельный микроскоп
Сканирующий туннельный микроскоп (СТМ, англ. STM — scanning tunneling microscope) — вариант сканирующего зондового микроскопа, предназначенный для измерения рельефа проводящих поверхностей с высоким пространственным разрешением.
История создания
Сканирующий туннельный микроскоп (СТМ) в современном виде изобретен (принципы этого класса приборов были заложены ранее другими исследователями) Гердом Карлом Биннигом и Генрихом Рорером из лаборатории IBM в Цюрихе в 1981 году. За это изобретение были удостоены Нобелевской премии по физике за 1986 год, которая была разделена между ними и изобретателем просвечивающего электронного микроскопа Э. Руска.
В СССР первые работы по этой тематике была сделаны в 1985 году в Институте Физических проблем АН СССР.
В СТМ острая металлическая игла подводится к образцу на расстояние нескольких ангстрем. При подаче на иглу относительно образца небольшого потенциала возникает туннельный ток. Величина этого тока экспоненциально зависит от расстояния образец-игла. Типичные значения 1—1000 пА при расстояниях около 1 Å. Сканирующий туннельный микроскоп первый из класса сканирующих зондовых микроскопов, атомно-силовой и сканирующий ближнепольный оптический были разработаны позднее.
В процессе сканирования игла движется вдоль поверхности образца, туннельный ток поддерживается стабильным за счёт действия обратной связи, и показания следящей системы меняются в зависимости от топографии поверхности. Такие изменения фиксируются, и на их основе строится карта высот. Другая методика предполагает движение иглы на фиксированной высоте над поверхностью образца. В этом случае фиксируется изменение величины туннельного тока и на основе данной информации идет построение топографии поверхности.
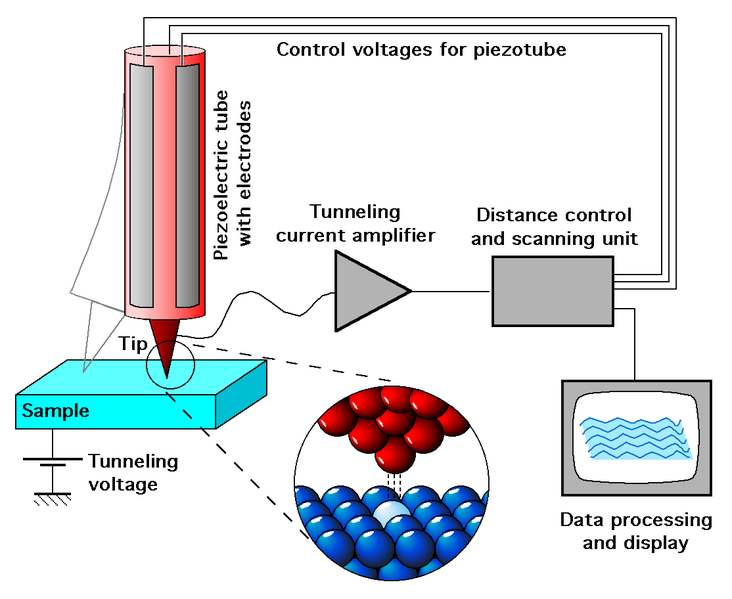
Рисунок 1 – Схема работы СТМ
Таким образом, сканирующий туннельный микроскоп (СТМ) включает следующие элементы:
- зонд (иглу),
- систему перемещения зонда относительно образца по 2-м (X-Y) или 3-м (X-Y-Z) координатам,
- регистрирующую систему.
Регистрирующая система фиксирует значение функции, зависящей от величины тока между иглой и образцом, либо перемещения иглы по оси Z. Обычно регистрируемое значение обрабатывается системой отрицательной обратной связи, которая управляет положением образца или зонда по одной из координат (Z). В качестве системы обратной связи чаще всего используется ПИД-регулятор.

Рисунок 2 – Типичная схема атомно-силовой микроскопии
Ограничения на использование метода накладываются, во-первых, условием проводимости образца (поверхностное сопротивление должно быть не больше 20 МОм/см²), во-вторых, условием «глубина канавки должна быть меньше её ширины», потому что в противном случае может наблюдаться туннелирование с боковых поверхностей. Но это только основные ограничения. На самом деле их намного больше. Например, технология заточки иглы не может гарантировать одного острия на конце иглы, а это может приводить к параллельному сканированию двух разновысотных участков. Кроме ситуации глубокого вакуума, во всех остальных случаях мы имеем на поверхности осаждённые из воздуха частицы, газы и т. д. Технология грубого сближения также оказывает колоссальное влияние на действительность полученных результатов. Если при подводе иглы к образцу мы не смогли избежать удара иглы о поверхность, то считать иглу состоящей из одного атома на кончике пирамиды будет большим преувеличением.
Литература
Arie van Houselt and Harold J. W. Zandvliet Colloquium: Time-resolved scanning tunneling microscopy (англ.) // Rev. Mod. Phys.. — 2010. — Т. 82. — С. 1593—1605.
Ссылки
1. История создания сканирующего туннельного микроскопа
2. В. Л. Миронов. Основы сканирующей зондовой микроскопии
3. Сканирующая туннельная микроскопия (СТМ). Основы.
ЛЕКЦИЯ 7
Растровый электронный микроскоп
Растровый электронный микроскоп (РЭМ, англ. Scanning Electron Microscope, SEM) — прибор, основанный на принципе взаимодействия электронного пучка с веществом, предназначенный для получения изображения поверхности объекта с высоким пространственным разрешением (несколько нанометров), а также о составе, строении и некоторых других свойствах приповерхностных слоёв.
Принцип работы РЭМ, заключающийся в сканировании поверхности образца сфокусированным электронным пучком и анализе отраженных от поверхности частиц и возникающего в результате взаимодействия электронов с веществом рентгеновского излучения, был впервые предложен в работах Максом Кноллом и Манфредом фон Арденне в 1930 годы. Анализ частиц позволяет получать информацию о рельефе поверхности, о фазовом различии и кристаллической структуре приповерхностных слоёв. Анализ рентгеновского излучения, возникающего в процессе взаимодействия пучка электронов с образцом дает возможность качественно и количественно охарактеризовать химический состав приповерхностных слоёв.
Работы, которые велись в Кембриджском университете группой Чарльза Отли в 1960 годы весьма способствовали развитию РЭМ и в 1965 году фирмой «Cambridge Instrument Co.» был выпущен первый коммерческий сканирующий электронный микроскоп — Stereoscan[1].
Современный РЭМ позволяет работать в широком диапазоне увеличений приблизительно от 10 крат (то есть эквивалентно увеличению сильной ручной линзы) до 1 000 000 крат, что приблизительно в 500 раз превышает предел увеличения лучших оптических микроскопов.
Сегодня возможности растровой электронной микроскопии используются практически во всех областях науки и промышленности от биологии до наук о материалах. Существует огромное число выпускаемых десятками фирм разнообразных конструкций и типов РЭМ, оснащенных детекторами различных типов.
Основные типы сигналов, которые генерируются в процессе работы РЭМ:
- сигнал детектора вторичных электронов (ВЭ или режим рельефа)
- отражённых электронов (ОЭ или режим фазового контраста)
- прошедшие через образец электроны, в случае установленной STEM-приставки (используется для исследования органических объектов)
- дифракции отражённых электронов (ДОЭ)
- потери тока на образце (ПЭ или детектор поглощенных электронов)
- ток прошедший через образец (ТЭ или детектор прошедших электронов)
- характеристическое рентгеновское излучение (РСМА или ренгеноспектральный микроанализ)
- ВДА или волнодисперсионный анализ)
- световой сигнал (КЛ или катодолюминесценция).
Все возможные типы детекторов, установленные на одном приборе встречаются крайне редко.
Детекторы вторичных электронов — первый и традиционно устанавливаемый на все РЭМ тип детекторов. В этом режиме разрешающая способность РЭМ максимальна. Разрешение детекторов вторичных электронов в современных приборах уже достаточно для наблюдения субнанометровых объектов [2]. Из-за очень узкого электронного луча РЭМ обладают очень большой глубиной резкости (0,6-0,8 мм), что на два порядка выше, чем у оптического микроскопа и позволяет получать четкие микрофотографии с характерным трехмерным эффектом для объектов со сложным рельефом. Это свойство РЭМ крайне полезно для понимания поверхностной структуры образца. Микрофотография пыльцы демонстрирует возможности режима ВЭ РЭМ.
Отражённые электроны (ОЭ) — это электроны пучка, отражённые от образца упругим рассеиванием. ОЭ часто используются в аналитическом РЭМ совместно с анализом характеристических спектров рентгеновского излучения. Поскольку интенсивность сигнала ОЭ напрямую связана со средним атомным номером (Z) засвечиваемой области образца, изображения ОЭ несут в себе информацию о распределении различных элементов в образце. Например, режим ОЭ позволяет обнаружить коллоидные золотые иммунные метки диаметра 5-10 нм, которые очень тяжело или даже невозможно обнаружить в биологических объектах в режиме ВЭ. Микрофотография поверхности аншлифа металл-оксидной системы демонстрирует возможности режима ОЭ РЭМ.
Характеристическое рентгеновское излучение генерируется в случае, когда электронный луч выбивает электроны с внутренних оболочек элементов образца, заставляя электрон с более высокого энергетического уровня перейти на нижний уровень энергии с одновременным испусканием кванта рентгеновского излучения. Детектирование спектра характеристического рентгеновского излучения позволяет идентифицировать состав и измерить количество элементов в образце.
Принцип работы. Разрешающая способность (способность различать тонкие детали) человеческого глаза, вооруженного оптическим микроскопом, помимо качества увеличительных линз ограничена длиной волны фотонов видимого света. Наиболее мощные оптические микроскопы могут обеспечить наблюдение деталей с размером 0.1-0.2 мкм [9]. Если мы захотим увидеть более тонкие детали, необходимо сократить длину волны, которая освещает объект исследования. Для этого можно использовать не фотоны, а, например, электроны, длина волны которых намного меньше. Электронные микроскопы — результат воплощения этой идеи.
Принципиальная схема «исторического» сканирующего микроскопа.
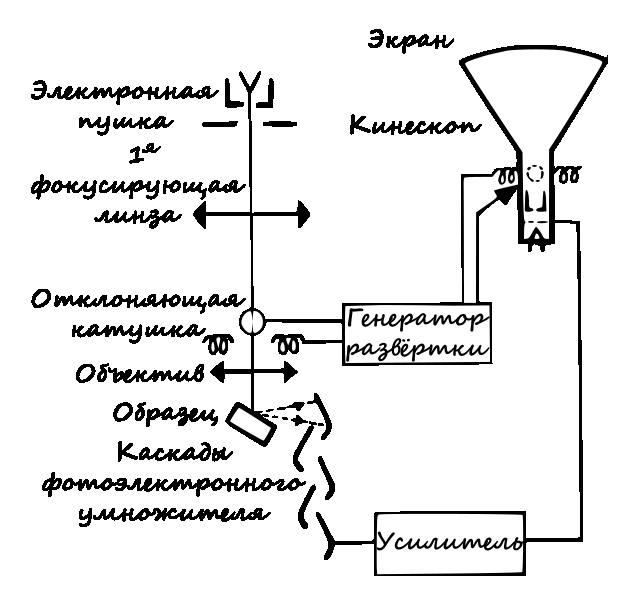
Рисунок 1 – Принципиальная схема РЭМ
Принципиальная схема РЭМ: тонкий электронный зонд (электронный пучок) направляется на анализируемый образец. В результате взаимодействия между электронным зондом и образцом возникают низкоэнергетичные вторичные электроны, которые отбираются детектором вторичных электронов. Каждый акт столкновения сопровождается появлением электрического сигнала на выходе детектора. Интенсивность электрического сигнала зависит как от природы образца (в меньшей степени), так и от топографии (в большей степени) образца в области взаимодействия. Таким образом, сканируя электронным пучком поверхность объекта, возможно получить карту рельефа проанализированной зоны.
Тонкий электронный зонд генерируется электронной пушкой, которая играет роль источника электронов, сокращенного электронными линзами, которые играют ту же роль по отношению к электронному пучку как фотонные линзы в оптическом микроскопе к световому потоку. Катушки, расположенные согласно двум взаимоперпендикулярным направлениям (x, y), перпендикулярным направлению пучка (z) и контролируемые синхронизированными токами, позволяют подвергнуть зонд сканированию подобно сканированию электронного пучка в электронно-лучевой трубке телевизора. Электронные линзы (обычно сферические магнитные) и отклоняющие катушки образуют систему, называемую электронной колонной.
В современных РЭМ изображение регистрируется исключительно в цифровой форме, но первые РЭМы появились в начале 1960 годов задолго до распространения цифровой техники и поэтому изображение формировалось способом синхронизации развёрток электронного пучка в кинескопе с электронным пучком в РЭМ и регулировки интенсивности трубки вторичным сигналом. Изображение образца тогда появлялось на фосфоресцирующем экране кинескопа и могло быть зарегистрировано на фотопленке.
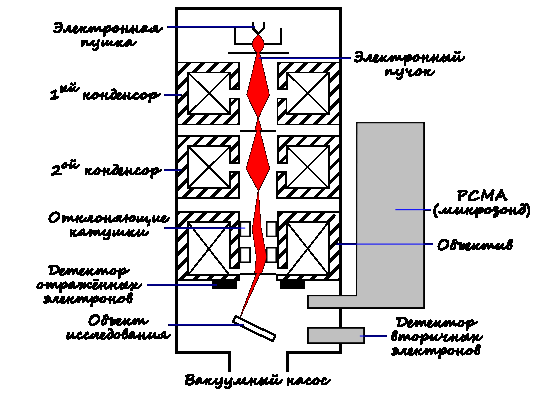
Рисунок 2 – Схема РЭМ, оснащенного детектором рентгеновских лучей — «РСМА» (микрозондом)
Основа сканирующего электронного микроскопа — электронная пушка и электронная колонна, функция которой состоит в формировании остросфокусированного электронного зонда средних энергий (10 — 50 кэВ) на поверхности образца. Прибор обязательно должен быть оснащен вакуумной системой (в современных моделях микроскопов высокий вакуум желателен, но не обязателен). Также в каждом РЭМ есть предметный столик, позволяющий перемещать образец минимум в трех направлениях. При взаимодействии зонда с объектом возникают несколько видов излучений, каждое из которых может быть преобразовано в электрический сигнал. В зависимости от механизма регистрирования сигнала различают несколько режимов работы сканирующего электронного микроскопа: режим вторичных электронов, режим отражённых электронов, режим катодолюминесценции и др. РЭМ оснащаются детекторами позволяющими отобрать и проанализировать излучение возникшее в процессе взаимодействия и частицы изменившие энергию в результате взаимодействия электронного зонда с образцом [10] Разработанные методики позволяют исследовать не только свойства поверхности образца, но и визуализировать информацию о свойствах подповерхностных структур.
Взаимодействие электронов с веществом
В классическом микроскопе видимый свет реагирует с образцом и отраженные фотоны анализируются детекторами или глазом человека. В электронной микроскопии пучок света заменен пучком электронов, взаимодействующих с поверхностью образца и отраженные фотоны заменены целым спектром частиц и излучения: вторичные электроны, обратноотраженные электроны, Оже-электроны, рентгеновское излучение, катодолюминесценция и т. д. Эти частицы и излучение являются носителями информации различного типа о веществе, из которого создан образец [10].

Рисунок 3 – Виды взаимодействия электронов с веществом
Вторичные электроны
В результате взаимодействия с атомами образца электроны первичного пучка могут передать часть своей энергии электронам из зоны проводимости, то есть слабо связанным с атомами. В результате такого взаимодействия может произойти отрыв электронов и ионизация атомов. Такие электроны называются вторичными. Эти электроны обычно обладают небольшой энергией (порядка 50 эВ). Любой электрон первичного пучка обладает энергией, достаточной для появления нескольких вторичных электронов.
Так как энергия вторичных электронов невелика, их выход возможен только с приповерхностных слоев материала (менее 10 нм). Благодаря небольшой кинетической энергии эти электроны легко отклоняются небольшой разностью потенциалов. Это делает возможным существенно повысить эффективность детекторов (собрать максимально возможное их количество) и получить высококачественные изображения с хорошим отношением сигнал/шум и разрешением порядка 4 нм при диаметре пучка 3 нм.

Рисунок 4 – Вторичные электроны
Принимая во внимание, что вторичные электроны генерируются приповерхностными слоями, они очень чувствительны к состоянию поверхности. Минимальные изменения отражаются на количестве собираемых электронов. Таким образом, этот тип электронов несет в себе информацию о рельефе образца. Однако, они мало чувствительны в отношении плотности материала, а, следовательно, и фазового контраста [10].
Устройство РЭМ
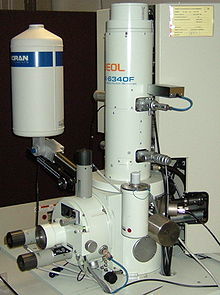
Рисунок 5 – РЭМ JEOL JSM 6430F
Режимы работы
Обычно для получения информации о структуре поверхности используются вторичные и/или отражённые (обратно-рассеянные) электроны. Контраст во вторичных электронах сильнее всего зависит от рельефа поверхности, тогда как отражённые электроны несут информацию о распределении электронной плотности (области, обогащённые элементом с бо́льшим атомным номером выглядят ярче). Поэтому обратно-рассеянные электроны, которые генерируются одновременно со вторичными, кроме информации о морфологии поверхности содержат дополнительную информацию и о составе образца. Облучение образца пучком электронов приводит не только к образованию вторичных и отражённых электронов, а также вызывает испускание характеристического рентгеновского излучения. Анализ этого излучения позволяет определить элементный состав микрообъёма образца (разрешение не лучше 1 мкм).
Детектирование вторичных электронов
Для определения вторичных электронов используется детектор Эверхарта-Торнли, позволяющий селективно идентифицировать электроны с энергией менее 50 эВ.
Детектирование отражённых электронов
Некоторые модели микроскопов оснащены высокочувствительным полупроводниковым детектором обратно-рассеянных электронов. Детектор смонтирован на нижней поверхности объективной линзы либо вводится на специальном стержне под полюсной наконечник. Это позволяет путем выбора режима из меню получить изображения топографии поверхности, изображение в композиционном контрасте или в темном поле.
Разрешение
Пространственное разрешение сканирующего электронного микроскопа зависит от поперечного размера электронного пучка, который, в свою очередь зависит от электронно-оптической системы, фокусирующей пучок. Разрешение также ограничено размером области взаимодействия электронного зонда с образцом. Размер электронного зонда и размер области взаимодействия зонда с образцом намного больше расстояния между атомами мишени. Таким образом, разрешение сканирующего электронного микроскопа не достаточно для отображения атомных плоскостей и даже атомов, в отличие от современных просвечивающих микроскопов. Тем не менее, растровый электронный микроскоп имеет ряд преимуществ перед просвечивающим микроскопом. Это — визуализация сравнительно большой области образца, исследование массивных объектов (а не только тонких пленок), набор аналитических методов, позволяющих измерять состав и свойства изучаемого объекта.
В зависимости от конкретного прибора и параметров эксперимента, может быть получено разрешение от десятков до единиц нанометров. На 2009 год наилучшее разрешение было достигнуто на микроскопе Hitachi S-5500 и составило 0.4 нм (при напряжении 30 кВ) [2].
Как правило, наилучшее разрешение может быть получено при использовании вторичных электронов, наихудшее — в характеристическом рентгеновском излучении. Последнее связано с большим размером области возбуждения излучения, в несколько раз превышающим размер электронного зонда. При использовании режима низкого вакуума разрешение несколько ухудшается.
Подготовка объектов
Порошковые материалы наносятся малым количеством, как правило, на проводящий углеродный скотч. Массивные (не порошковые) образцы фиксируются либо на тот же скотч, либо на серебряный или углеродный клей.
Если образцы непроводящие, то на них напыляется тонкий проводящий слой. Это может быть любое проводящее вещество, однако, чаще всего используют углерод и золото. Первый, как правило, имеет малый размер напыляемых частиц, и, как следствие, позволяет получать микрофотографии с большим увеличением без собственной визуализации. Иногда в случае напыления золотом, бывают заметны нанесенные частицы. Однако при напылении золотом получаются более светлые изображения, по сравнению с углеродом, что связано с энергией выхода электрона. Если невозможно напыление пленки на образец, то возможно снятие зарядки с образца на вводимую в камеру атмосферу (обычно азот). Для получения более четких изображений в современных микроскопах возможно локальное подведение газа.
Применение
Растровые микроскопы применяются как исследовательский инструмент в физике, электронике, биологии и материаловедении. Их главная функция — получение изображения исследуемого образца, которое зависит от регистрируемого сигнала. Сопоставление изображений, полученных в разных сигналах, позволяют делать вывод о морфологии и составе поверхности. Растровый электронный микроскоп практически единственный прибор, который может дать изображение поверхности современной микросхемы или промежуточной стадии фотолитографического процесса.
ЛЕКЦИЯ 8
Дифракция отражённых электронов
Дифракция отражённых электронов (ДОЭ) — микроструктурная кристаллографическая методика, используемая для исследования кристаллографических ориентаций многих материалов, которая может использоваться для исследования текстуры или преимущественных ориентаций моно- или поликристаллического материала. ДОЭ может использоваться для индексирования и определения семи кристаллических систем, также применяется для картирования кристаллических ориентаций, исследования дефектов, определения и разделенияфаз, изучение межзёренных границ и морфологии, картирования микродеформаций и т. д. Традиционно такой тип исследований проводился с помощью рентгеноструктурного анализа, нейтронной дифракции и дифракции электронов в ПЭМ.
Основана на дифракции отражённых электронов. Проводится в растровом электронном микроскопе с ДОЭ-приставкой. Последняя состоит из люминесцентного экрана, вводящегося в камеру с образцом РЭМ, CCD-камеры… Вертикальный пучок электронов падает на наклонённый образец (70° — наиболее оптимальный угол наклона к горизонтали). Уменьшение угла наклона понижает интенсивность получаемой дифракционной картины.
В мире ДОЭ распространена уже более 10 лет. Является устоявшейся востребованной методикой. В России широкого применения не имеет.
Применение
Позволяет проводить точечный анализ, картирование кристаллических ориентаций. С его помощью возможно построение трёхмерных карт вещества
Типы ДОЭ экспериментов
Точечный анализ
Картирование кристаллических ориентаций
Получение высококачественных изображений методом картирования
Изображение зерен и межзеренных границ
Анализ текстуры
Разделение фаз

Рисунок 1 – Картина, полученная методом дифракции отражённых электронов (National Institute of Standards and Technology Materials Reliability Division

Рисунок 2 – Изображение одного кристалла кремния, полученное методом дифракции отражённых электронов
Индексирование
Центры линий Кикучи на дифракционной картине являются пересечением кристаллографических осей, генерирующие данную линию, исследуемой точки образца с поверхностью люминесцентного экрана. Пересечения линий Кикучи соответствуют пересечению кристаллографических осей с люминесцентным экраном. Поэтому как линиям Кикучи, так и их пересечениям можно приписать соответствующие индексы.
Автоматическое индексирование
Возможно также автоматическое индексирование дифракционных линий. Для этого используется преобразование Хафа.
Преобразование Хафа
Преобразование Хафа — метод по извлечению элементов из изображения, используемый в анализе, обработке изображения и компьютерном зрении. Данный метод предназначен для поиска объектов принадлежащий определённому классу фигур с использованием процедуры голосования. Процедура голосования применяется к пространству параметров, из которого и получаются объекты определённого класса фигур по локальному максимуму в, так называемом, накопительном пространстве (accumulator space) которое строится при вычислении трансформации Хафа.
Для понимания преобразования Хафа, применительно к ДОЭ, необходимо понимать, что при этом происходит преобразование из одного пространства в другое. При этом прямые (линии Кикучи) переходят в точки. Они собственно и отмечаются.
Анализ после преобразования Хафа
Далее возвращаемся в обычное пространство, в котором с помощью преобразования Хафа уже отмечены линии Кикучи и их центры. Полученным линиям в соответствии с выбранными фазами оператором и их геометрическому положению уже присваиваются индексы Миллера. И, таким образом, определяется ориентация кристалла и фаза в исследуемой точке.
Картирование кристаллографических ориентаций
Картирование производится методом автоматического индексирования по узлам некоторой сетки на поверхности образца. Чем мельче будет выбрано зерно сетки, тем более детальная информация будет получена. Но при этом может значительно увеличиться время эксперимента. Необходимо соблюсти баланс детальности во времени исследования в зависимости от задач эксперимента. Очевидным результатом картирования являются крайне наглядные и привлекательные карты, но все же основным результатом подробная информация о зернах, межзеренных границах, текстуре. Для непроводящих материалов возможны затруднения, связанные с скоплением заряда на поверхности образца, при этом картина ДОЭ будет «плыть», либо вообще не получится получить данных. Избежать этих явлений можно либо с помощью компенсации дрейфа (при незначительной зарядке), а также съемкой в режиме низкого вакуума либо локального низкого вакуума, когда атмосфера создается в локальной области над исследуемой частью образца.
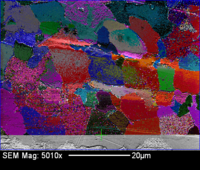
Рисунок 3 – Карта в процессе ее получения, наложенная на электронномикроскопическое изображение

Рисунок 4 – Видна зарядка образца в точках, в которых снималась дифракция
