Элементарная теория работы полевых транзисторов физической основой работы полевого транзистора со структурой металл-диэлектрик-полупроводник является эффект поля
| Вид материала | Документы |
- Лекция 4, 201.1kb.
- Методические указания к лабораторной работе по исследованию статических характеристик, 104.56kb.
- Полупроводниковые приборы, 355.8kb.
- Л. М. Чирок Математическая модель электрохимического датчика, 44.36kb.
- "Анализ и расчет статических параметров транзистора в схеме с общим затвором." по курсу, 229.13kb.
- Программа междисциплинарного экзамена для поступления в магистратуру по направлению, 51.62kb.
- Вприближении двухмерной модели атома водорода рассмотрены свойства мелких примесных, 25.62kb.
- Работа № ключевой режим работы транзистора, 358.55kb.
- Аннотация дисциплины, 786.67kb.
- 1. Какие требования предъявляются к транзисторам рэ в стабилизаторах с импульсивным, 463.58kb.
Глава 3. ЭЛЕМЕНТАРНАЯ ТЕОРИЯ РАБОТЫ ПОЛЕВЫХ ТРАНЗИСТОРОВ
Физической основой работы полевого транзистора со структурой металл-диэлектрик-полупроводник является эффект поля. Напомним, что эффект поля состоит в том, что под действием внешнего электрического поля изменяется концентрация свободных носителей заряда в приповерхностной области полупроводника. В полевых приборах со структурой МДП внешнее поле обусловлено приложенным напряжением на металлический электрод-затвор. В зависимости от знака и величины приложенного напряжения присутствуют четыре состояния области пространственного заряда (ОПЗ) полупроводника - обогащение, обеднение, слабая и сильная инверсия. Полевые транзисторы в активном режиме могут работать только в области слабой или сильной инверсии, т.е. в том случае, когда инверсионный канал между истоком и сроком отделен от объема подложки слоем обеднения. На рис.1 была приведена топология МДП транзистора, где этот факт наглядно виден.
В области инверсии концентрация неосновных носителей заряда в канале выше, чем концентрация основных носителей в объеме полупроводника. Изменяя величину напряжения на затворе, можно менять концентрацию свободных носителей в инверсионном канале и тем самым модулировать сопротивление канала. Источник напряжения в стоковой цепи вызовет изменяющийся в соответствии с изменением сопротивления канала ток стока и тем самым будет реализован эффект усиления. Таким образом, МДП транзистор является сопротивлением, регулируемым внешним напряжением. К нему даже в большей степени, чем к биполярным приборам, подходит историческое название "транзистор" так как слово „transistor" образовано от двух английских слов - „transfer" и „resistor", что переводится как "преобразующий сопротивление".
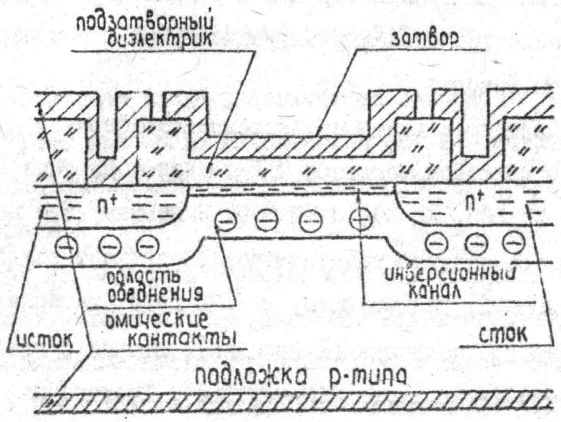
Рис.1. Полевой транзистор со структурой металл-диэлектрик полупроводник.
3.1. Характеристики МОП ПТ в области плавного канала
Рассмотрим полевой транзистор со структурой МДП, схема которого приведена на рис.4. Координата z направлена вглубь полупроводника, y- вдоль по длине канала и х - по ширине канала получим вольтамперную характеристику (ВАХ) такого транзистора при следующих предположениях:
1) Токи через р-n переходы истока и стока и подзатворный диэлектрик равны нулю.
2) Подвижность электронов
 постоянна по глубине и длине
постоянна по глубине и длине инверсионного канала и не зависит от напряжения на затворе VGS и на стоке VDS.
инверсионного канала и не зависит от напряжения на затворе VGS и на стоке VDS.3) Канал плавный, то есть в области канала нормальная составляющая электрического поля Еz существенно больше тангенциальной Еy.
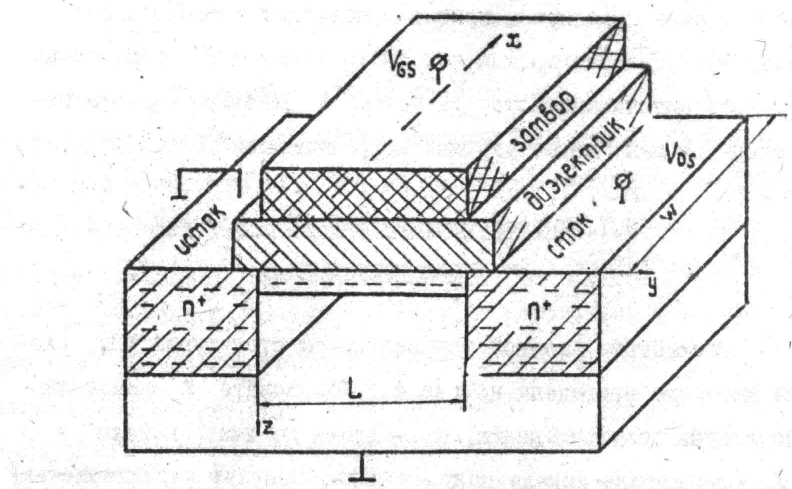
Рис.4. Схема МДП транзистора
Ток в канале МДП транзистора, изготовленного на подложке р-типа, обусловлен свободными электронами, концентрация которых n(z). Электрическое поле Еу обусловлено напряжением между истоком и стоком VDS . Согласно
 (3.1)
(3.1)где
 - заряд электрона,
- заряд электрона,  - подвижность электронов в канале, V - падение напряжения от истока до точки канала с координатами ( x, y , z ).
- подвижность электронов в канале, V - падение напряжения от истока до точки канала с координатами ( x, y , z ).Проинтегрируем (3.1) по ширине ( x ) и глубине ( z ) канала. Тогда интеграл в левой части (3.1) дает нам полный ток канала IDS , а для правой части получим
 (3.2)
(3.2)Величина
 есть полный заряд электронов в канале
есть полный заряд электронов в каналена единицу площади
 . Тогда
. Тогда (3.3)
(3.3)Найдем величину заряда электронов Qn . Для этого запишем уравнение электронейтральности для зарядов в МДП транзисторе на единицу площади в виде
 (3.4)
(3.4)Согласно (3.4) заряд на металлическом электроде Qm уравновешивается суммой зарядов свободных электронов Qn и ионизованных акцепторов QB в полупроводнике и встроенного заряда в окисле QOX.На рис.5 приведена схема расположения этих зарядов. Из определения геометрической емкости окисла СOX следует, что полный заряд на металлической обкладке МДП-конденсатора Qm.
Qm = COX ·VOX (3.5)
VOX - падение напряжения на окисном слое, СOX - удельная емкость подзатворного диэлектрика.

Рис.5. Расположение зарядов в МДП транзисторе.
Поскольку падение напряжения в окисле равно VOX в полупроводнике равно поверхностному потенциалу
 , а полное приложенное напряжение к затвору VGS , то
, а полное приложенное напряжение к затвору VGS , то (3.6)
(3.6)где
 - разность работ выхода металл-полупроводник,
- разность работ выхода металл-полупроводник,  - величина поверхностного потенциала в равновесных условиях, т.е. при напряжении стока VDS = 0.
- величина поверхностного потенциала в равновесных условиях, т.е. при напряжении стока VDS = 0.Из (3.4) я (3.5) и (3.6) следует
Qn = Qm - Qox - Qв = Cox
 - Qox + Qв (3.7)
- Qox + Qв (3.7)Поскольку в области сильной инверсии при значительном изменении напряжения на затворе VGS величина поверхностного потенциала меняется слабо, будем в дальнейшем считать ее постоянной и равной потенциалу начала области сильной инверсии
 . Поэтому будем также считать, что заряд акцепторов Qв не зависит от поверхностного потенциала. Введем пороговое напряжение VТ как напряжение на затворе VGS , соответствующее открытию канала в равновесных условиях
. Поэтому будем также считать, что заряд акцепторов Qв не зависит от поверхностного потенциала. Введем пороговое напряжение VТ как напряжение на затворе VGS , соответствующее открытию канала в равновесных условиях  .
.При этом

Из (3.7) следует, что
 (3.8)
(3.8)Тогда с учётом (3.8)
 (3.9)
(3.9)Подставляя (3.9) в (3.3), разделяя переменные и проведя интегрирование вдоль канала при изменении
 от 0 до L , а
от 0 до L , а  от 0 до
от 0 до  , получаем
, получаем (3.10)
(3.10)Уравнение (3.10) описывает вольтамперную характеристику полевого транзистора в области плавного канала.
Как следует из уравнения (3.9), по мере роста напряжения исток-сток VDS в канале может наступить такой момент, когда произойдет смыкание канала, т.е. заряд электронов в канале в некоторой точке станет равным нулю. Это соответствует условию
 (3.11)
(3.11)Поскольку максимальная величина напряжения V (y) реализуется на стоке, то смыкание канала или отсечки произойдет у стока. Напряжение стока VDS , необходимое для смыкания канала, называется напряжением отсечки
 . Величина напряжения отсечки определяется соотношением (3.11). На рис.6 показаны оба состояния - состояние плавного и отсеченного канала. С ростом напряжения стока VDS точка канала, соответствующая условию отсечки (3.11), сдвигается от стока к истоку. В первом приближении при этом на участке плавного канала от истока до точки отсечки падает одинаковое напряжение
. Величина напряжения отсечки определяется соотношением (3.11). На рис.6 показаны оба состояния - состояние плавного и отсеченного канала. С ростом напряжения стока VDS точка канала, соответствующая условию отсечки (3.11), сдвигается от стока к истоку. В первом приближении при этом на участке плавного канала от истока до точки отсечки падает одинаковое напряжение  , не зависящее от напряжения исток-сток. Эффективная длина плавного канала L' от истока до точки отсечки слабо отличается от истинной длины канала L и обычно
, не зависящее от напряжения исток-сток. Эффективная длина плавного канала L' от истока до точки отсечки слабо отличается от истинной длины канала L и обычно  . Это обуславливает в области отсечки в первом приближении ток стока IDS не зависящий от напряжения стока VDS. Подставив напряжение отсечки
. Это обуславливает в области отсечки в первом приближении ток стока IDS не зависящий от напряжения стока VDS. Подставив напряжение отсечки  из (3.11) в (3.10) вместо напряжения стока VDS, получаем для области отсечки выражение для тока стока
из (3.11) в (3.10) вместо напряжения стока VDS, получаем для области отсечки выражение для тока стока (3.12)
(3.12)Соотношение (3.12) представляет из себя запись вольтамперной характеристики МДП транзистора в области отсечки. На рис.7,8 приведены характеристики в области плавного канала и в области отсечки. Зависимости тока стока IDS от напряжения на затворе VGS называются обычно переходными характеристиками, а зависимости тока стока IDS от напряжения на стоке VDS - проходными характеристиками транзистора.
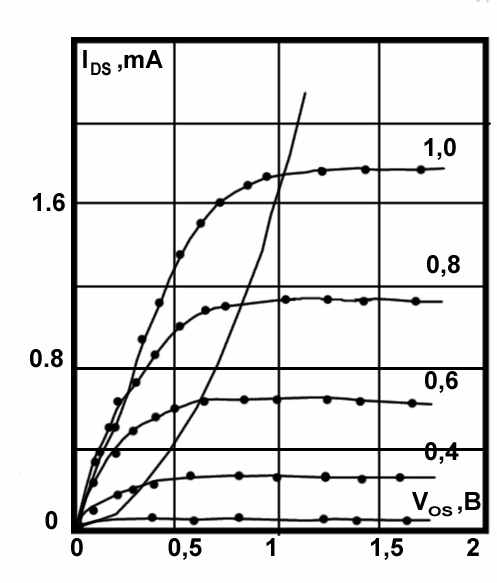
Рис.7. Зависимость тока стога IDS от напряжения на стоке VDS для МОП ПТ при различных напряжениях на затворе. Пороговое напряжение VT =0,1 В, Сплошная линия - расчет по (3.10) и (3.12), точки - экспериментальные результаты.


Рис.8. Зависимость тока стока IDS от напряжения на затворе VGS в области плавного канала при VDS = 0.1B - кривая 1; зависимость корня из тока стока
 от напряжения на затворе в области отсечки - кривая 2.
от напряжения на затворе в области отсечки - кривая 2.При значительных величинах напряжения исток-сток и относительно коротких каналах ( L = 10÷20 мкм) в области отсечки наблюдается эффект модуляции длины канала. При этом точка отсечки смещается к истоку, и напряжение отсечки
 падает на меньшую длину L’ канала. Это вызовет увеличение тока IDS канала. Величина напряжения
падает на меньшую длину L’ канала. Это вызовет увеличение тока IDS канала. Величина напряжения  , падащая на участке
, падащая на участке  от стока отсечки, будет
от стока отсечки, будет (3.13)
(3.13)Поскольку напряжение
 падает на обратно-смещённом p-n+ переходе, его ширина
падает на обратно-смещённом p-n+ переходе, его ширина  будет
будет (3.14)
(3.14)Ток канала равен
 , когда напряжение исток-сток
, когда напряжение исток-сток  равно напряжению отсечки и величина
равно напряжению отсечки и величина  =0. Обозначим IDS ток стока при большем напряжении стока
=0. Обозначим IDS ток стока при большем напряжении стока 
Тогда
 (3.15)
(3.15)Следовательно, ВAX МДП-транзистора с учетом модуляция длины канала примет следующий вид
 (3.16)
(3.16)Эффект модуляции длины канала оказывает большое влияние, как будет видно из главы 5, на проходные характеристики МДП-транзистора с предельно малыми геометрическими раз мерами.
3.3. Эффект смещения подложки.
Рассмотрим, как меняются характеристики МДП-транзистора при приложении напряжения между истоком и подложкой. Отметим, что приложенное напряжение между истоком и подложкой при условия наличия инверсионного канала падает на обедненную область индуцированного р-n перехода.
В этом случае при прямом его смещении будут наблюдаться значительные токи соответствующие прямым токам р-n пере хода. Эти тока попадут в стоковую цепь и транзистор работать не будет. Поэтому используется только напряжение подложки, соответствующее обратному смещению индуцированного и истокового р-n перехода. По полярности это будет - напряжение подложки противоположного знака по сравнению напряжением стока. При приложении напряжения канал-подложка происходит расширение ОПЗ и увеличение заряда ионизованных акцепторов
 (3.17)
(3.17)Поскольку напряжение на затворе VGS постоянно, то постоянен и заряд на затворе МДП транзистора Qm . Следовательно, из уравнения электронейтральности вытекает, что если заряд акцепторов в слое обеднения QB вырос, заряд электронов в канале Qn должен уменьшиться. С этой точки зрения подложка выступает как второй затвор МДП-транзистора, поскольку регулирует также сопротивление инверсионного канала между истоком и стоком.
При возрастании заряда акцепторов в слое обеднения возрастет и пороговое напряжение, транзистора VТ, как видно из (3.3). Изменение порогового напряжения будет
 (3.18)
(3.18)
Рис.9. Влияние напряжения смещения канал-подложка VSS на проходные характеристики транзистора в области плавного канала VDS = 0,1 В.


Рис.10. Переходные характеристики МДП транзистора при нулевом напряжении смещения канал-подложка (сплошные линий) и при напряжении VSS =-10В (пунктирные линии).
Поскольку смещение подложки приводит только к изменению порогового напряжения VТ, то переходные характеристики МДП-транзистора при различных напряжениях подложки VSS смещаются параллельно друг другу. На рис.9,10 показан эффект влияния смещения подложки на проходные и переходные характеристики.
3.4. Малосигнальные параметры.
Для МДП-транзистора характерны следующие малосигнальные параметры - крутизна характеристики S , внутреннее сопротивление Ri, коэффициент усиления
 . Крутизна переходной характеристики S определяется как
. Крутизна переходной характеристики S определяется как |
| (3.19)
(3.19)и характеризуется изменением тока стока при единичном увеличении напряжения на затворе при постоянном напряжении на стоке.
Внутреннее сопротивление Ri определяется
 |
| (3.20)
(3.20)и характеризует изменением напряжения в выходной цепи, необходимое для единичного увеличения тока стока при неизменном напряжении на затворе.
Коэффициент усиления
 определяется
определяется |
| (3.21)
(3.21)и характеризуется изменением напряжения в выходной цепи при единичном изменении напряжения во входной и неизменном токе стока. Очевидно, что
в области плавного канала крутизна S и дифференциальное сопротивление Ri будут иметь значения
 ;
;  (3.22)
(3.22)При этом коэффициент усиления
 , равный их произведению всегда меньше единицы
, равный их произведению всегда меньше единицы
Таким образом, необходимо отметить, что МДП полевой транзистор как усилитель не может быть использован в области плавного канала.
Сравним дифференциальное сопротивление Ri и омическое сопротивление R0 ,равное Ri=VDS / IDS в области плавного канала. Величина R0 равна

Отметим, что дифференциальное сопротивление транзистора в этой области Ri совпадает с сопротивлением R0 канала МДП транзистора по постоянному току. Поэтому МДП транзистор в области плавного канала можно использовать как линейный резистор с сопротивлением R0. При этом величина сопротивления невелика, составляет сотни Ом и легко регулируется напряжением..
Рассмотрим напряжения для малосигнальных параметров в области отсечки. Из (3.12) и (3.19) следует, что крутизна МДП транзистора
 (3.23)
(3.23)Из (3.23) следует, что крутизна характеристики определяется выбором рабочей точки и конструктивно - технологическими параметрами транзистора.
Величина в получила название удельной крутизны и не зависит от выбора рабочей точки. Для увеличения крутизны характеристики необходимо: уменьшать длину канала L и увеличивать его ширину W; уменьшать толщину подзатворного диэлектрика dox или использовать диэлектрики с высоким значением диэлектрической проницаемости
 ; использовать для подложки полупроводники с высокой подвижностью
; использовать для подложки полупроводники с высокой подвижностью  свободных носителей заряда; увеличивать напряжение на затворе VDS транзистора.
свободных носителей заряда; увеличивать напряжение на затворе VDS транзистора.Динамическое сопротивление Ri в области отсечки, как следует из (3.20) и (3.12) стремится к бесконечности
