Неравновесные процессы при формировании диэлектрических слоев и влияние объемного заряда на характеристики мдп структур
| Вид материала | Автореферат |
- В. В. Чикун емкость смесительных диодов с балочными выводами, 61.5kb.
- Таможенная конвенция о международной перевозке грузов с применением книжки мдп (конвенция, 1647.14kb.
- Таможенная конвенция о международной перевозке грузов с применением книжки мдп (Конвенция, 1294.93kb.
- I. Общие положения Глава II. Выдача книжек мдп. Ответственность гарантийных объединений, 892.36kb.
- Таможенная конвенция о международной перевозке грузов с применением книжки мдп (конвенция, 1036.88kb.
- Образования Российской Федерации Воронежский государственный университет Физический, 321.39kb.
- Таможенная конвенция о международной перевозке грузов с применением книжки мдп (конвенция, 270.53kb.
- Химическая и радиационная физика мемориал О. И. Лейпунского, 152.71kb.
- Удк 537. 311. 322 Моделирование энергетического спектра носителей заряда наноэлектронных, 88.99kb.
- Е при ввозе или вывозе или в связи с ввозом или вывозом грузов, но исключая суммы, 1221.61kb.
На правах рукописи
Авдеев Николай Алексеевич
НЕРАВНОВЕСНЫЕ ПРОЦЕССЫ
ПРИ ФОРМИРОВАНИИ ДИЭЛЕКТРИЧЕСКИХ
СЛОЕВ И ВЛИЯНИЕ ОБЪЕМНОГО ЗАРЯДА
НА ХАРАКТЕРИСТИКИ МДП СТРУКТУР
Специальность - 01.04.04 - физическая электроника
АВТОРЕФЕРАТ
диссертации на соискание ученой степени
кандидата физико-математических наук
Петрозаводск
2007
Работа выполнена в Петрозаводском государственном университете.
Научный руководитель:
доктор физико-математических наук, профессор Гуртов Валерий Алексеевич.
Официальные оппоненты:
доктор физико-математических наук, профессор Плотников Г.С.
доктор физико-математических наук, профессор Сысун В.И.
Ведущая организация
Карельский государственный педагогический университет
Защита состоится «14 »_сентября_2007 года в 14-00 на заседании диссертационного совета К.212.190.01 в Петрозаводском государственном университете по адресу: г. Петрозаводск, Ленина 33, ауд. 271
С диссертацией можно ознакомится в библиотеке Петрозаводского государственного университета.
Автореферат разослан «11 »_августа_2007
Ученый секретарь
Д
 иссертационного совета
иссертационного совета Доктор физико-математических наук Фофанов А.Д.

ОБЩАЯ ХАРАКТЕРИСТИКА РАБОТЫ
Актуальность работы определяется необходимостью создания прочных и однородных диэлектрических слоев на поверхности полупроводников. С практической точки зрения основная задача заключается в определении условий получения окислов, обладающих высококачественными диэлектрическими свойствами, т.к. главной областью применения в микроэлектронике таких диэлектриков как Ta2O5, Nb2O5, SiO2 является производство оксидно-полупроводниковых конденсаторов и электронных приборов на основе структуры металл - диэлектрик - полупроводник (МДП). В этом смысле технология анодного окисления позволяет с высокой точностью формировать толщину диэлектрического слоя, управлять электрофизическими свойствами объема и границы окисел-полупроводник. Перенос вещества приводит к образованию фазы со значительными отклонениями от равновесного состояния, что является результатом появления подвижных примесных и собственных дефектов, внедренных в междоузлия или расположенных в узлах структуры. Такое неравновесное состояние сохраняется достаточно длительное время и проявляется в существовании фаз с отклонением от стехиометрии, возникновении высокой концентрации заряженных дефектов и появлении электретных свойств вещества. Соответственно в некристаллических анодных окислах при термообработках, облучении и полевых воздействиях, а иногда и спонтанно могут происходить структурные изменения, которые оказывают значительное влияние на стабильность и долговечность работы создаваемых электронных приборов. В этом контексте актуальной задачей представляется исследование анодного окисления с точки зрения модели диффузионно-дрейфового переноса вещества, который происходит в условиях образования новой фазы. Изучение кинетических параметров процесса анодного окисления дает возможность целенаправленно совершенствовать технологию формирования анодных пленок с регулируемой величиной встроенного заряда в объеме окисла и на границе с полупроводниковой подложкой.
Несмотря на длительное применение структур металл-диэлектрик-полупроводник в микроэлектронике, продолжается исследование таких систем и поиск путей улучшения их характеристик. В настоящее время основные усилия направлены на использование новых материалов, совершенствование методов нанесения диэлектрических пленок, получение высококачественной границы полупроводник-диэлектрик. В данных направлениях интенсивно ведутся работы по созданию фотоприемных устройств в виде матриц с высокой плотностью чувствительных элементов. Основой для создания многоэлементных фотоприемников в интервале длин волн λ=2.5-3.05 мкм являются структуры металл диэлектрик полупроводник на арсениде индия. Все технологические процессы на InAs необходимо производить при температуре менее 2500С, так как при более высоких температурных воздействиях происходит разрушение поверхности полупроводника. Использование низкотемпературной технологии анодного окисления, позволяет получать структуры InAs с собственным окислом в качестве диэлектрика.
В качестве перспективного материала для создания диэлектрического слоя МДП структур рассматривается и окисел тантала. Окисел тантала используется как просветляющее покрытие в оптике, обладает высокой химической и термической стойкостью, большими значениями диэлектрической проницаемости (ε =27) и удельного сопротивления (ρ =1012 - 1014 Ом·см). Структуры Si-Ta2O5 применяются для создания элементов памяти больших интегральных схем (БИС), в работе которых главную роль играют процессы накопления, хранения и удаления заряда в диэлектрике.
Измерение фотоэлектрических параметров анодных окислов, исследование спектра энергетических состояний в диэлектрических пленках Ta2O5 и в собственном анодном окисле (САО) на поверхности InAs; определение величины потенциальных барьеров на межфазных границах, изучение закономерностей накопления заряда и распределения его в диэлектрике, позволяет прогнозировать стабильность работы создаваемых фотоматриц и элементов памяти больших интегральных схем. С этой же точки зрения, представляется актуальным вопрос модификации методик, направленных на увеличение информативности определения параметров переноса и распределения заряда в окисле МДП структуры.
Изучение этих проблем представляет не только самостоятельный научный интерес, но имеет большое значение для совершенствования технологии выращивания диэлектрических слоев и улучшения оптоэлектронных характеристик фотоприемных устройств.
Цель работы состоит в исследовании неравновесных процессов при формировании анодных оксидных слоев сложного состава на полупроводниках при накоплении объемного заряда как в процессе формирования анодных окислов, так и при внешних воздействиях на сформированные МДП структуры.
Основные задачи исследования:
- Разработка методик формирования структур Si-Ta2O5, InAs-САО с анодным окислом на поверхности полупроводников и исследование влияния параметров окисления на электрофизические характеристики создаваемых МДП структур.
- Развитие диффузионно-дрейфовой модели с подвижной границей для процесса анодного окисления и определение кинетических параметров реакции образования анодного окисла.
- Исследование процесса накопления заряда в МДП структурах Si-Ta2O5-Ме , InAs-САО-Ме при ультрафиолетовом фотовозбуждении.
- Разработка методики определения характеристик неравновесных носителей (подвижность, квантовый выход) на основе измерений переходных фототоков в МДП структурах.
- Анализ методов и выбор оптимального способа решения интегрального уравнения применительно к расчету распределения радиационно-индуцированного заряда в диэлектрических слоях МДП структур.
Научная новизна и состоит в том, что впервые:
- Исследовано влияние режимов окисления на электрофизические характеристики создаваемых МДП структур Si-Ta2O5 и показано, что в окисле Ta2O5 после завершения процесса анодного окисления находится значительный отрицательный заряд Nox >1013см -2.
- Реакция анодного окисления рассмотрена с позиций диффузионно-дрейфовой модели с подвижной границей. Рассчитаны кинетические параметры реакции образования окисла: коэффициент диффузии D=8∙10-21 м2/с, подвижность μ=3∙10-19м2/В∙с, скорость химической реакции χ=2,8∙10-10м/с.
- Определены пороги фотоинжекции в структурах Si-Ta2O5 (hν ~ 2.5 эВ) и собственной фотопроводимости окисла Ta2O5 (hν ~ 4.0 эВ). Для структур InAs-САО-Ме порог собственной фотопроводимости равен hν ~ 3.5 эВ, определено значение подвижности неравновесных дырок μp = 8·10-10 см2/В·с и квантового выхода Y(E) =8∙10-2.
- На основе решения интегральных уравнений с применением методов регуляризации получен вид распределения радиационно-индуцированного заряда в окислах МДП структур.
Практическая ценность работы
- Разработанная методика формирования анодного окисла на поверхности полупроводников позволяет получать структуры Si-Ta2O5 и InAs-САО пригодные для изготовления электронных устройств.
- Расчет кинетических параметров реакции образования анодного окисла, согласно принятой модели диффузионно-дрейфового переноса, предоставляет возможность определять оптимальные режимы окисления поверхности полупроводников, позволяющие снизить плотность поверхностных состояний на границе окисел-полупроводник и величину встроенного в окисном слое заряда.
- Исследование закономерностей накопления заряда в структурах Si-Ta2O5 - Ме, InAs-САО-Ме при ультрафиолетовом облучении и распределения радиационно-индуцированного заряда в окисле МДП структур позволяет прогнозировать стабильность работы приборов на их основе.
Основные положения выносимые на защиту:
- Методика формирования анодных окислов на поверхности полупроводников в структурах Si-Ta2O5 и InAs-САО.
- Применение диффузионно-дрейфовой модели с подвижной границей для описания процесса анодного окисления и определение влияния технологических параметров образования окисла на его электрофизические свойства.
- Закономерности накопления заряда и его распределение в окисле при облучении структур.
- Методика расчета подвижности и квантового выхода неравновесных носителей заряда на основе измерений переходных фототоков в МДП структурах.
- Способ расчета распределения заряда на основе решения интегральных уравнений при послойном стравливании диэлектрика.
Апробация работы: Основные результаты диссертационной работы были доложены на:
II Всесоюзной научной конференции. Физика окисных пленок.- Петрозаводск, 1987, III Всесоюзной конференции. - Петрозаводск, 1991, Международной конференция "Диэлектрики - 97", Санкт-Петербург, РГПУ им. А. И. Герцена, 9-й Международной конференции "Физика диэлектриков - 2000", РГПУ им. А. И. Герцена, 2000, Научных семинарах кафедры физики твердого тела ПетрГУ.
Основные результаты опубликованы в виде статей и тезисов докладов конференций
По материалам диссертации опубликовано 10 работ. Список основных публикаций приведен в конце автореферата.
Вклад автора. Все экспериментальные исследования и теоретические расчеты проведены за период 1986 – 2007г. при непосредственном участии автора, которым сформулированы и обоснованы все задачи диссертации. В коллективных работах автору принадлежат изложенные в диссертации выводы и защищаемые положения.
Обьем и структура диссертации. Диссертация состоит из введения, 6 глав, заключения, списка литературы. Диссертация содержит 115 стр., включая 43 рисунка на 24 стр., 4 таблицы и 119 наименований библиографических ссылок на 9 стр.
СОДЕРЖАНИЕ РАБОТЫ
Во введении обоснована актуальность исследуемых проблем, сформулированы цели и задачи работы, ее научная новизна, практическая значимость полученных результатов, приведены научные положения, выносимые на защиту.
Первая глава представляет обзор литературных данных о физико-химических механизмах образования термических и анодных окислов, механизмах переноса. Рассмотрены сведения о строении, природе, возможности перемещения дефектов в окисле. Представлены сведения о влиянии дефектов на энергетическую структуру окисных слоев, отмечена их определяющая роль в формировании межфазных границ и ловушек в объеме окислов кремния, тантала и арсенида индия. Проведено рассмотрение полевых моделей ионного переноса и электрохимических представлений, применяемых для описания процесса формирования анодного окисла. Проведен анализ тенденций развития фотопремных устройств на основе МДП структур. Показано, что необходимость создания структур металл - окисел - полупроводник (МОП)
с совершенной границей раздела и контролируемой величиной встроенного заряда определяется проблемами, связанными со стабильностью работы устройств микроэлектроники и увеличением чувствительности элементов фотоприемных матриц. Отмечены направления решения указанных проблем: с помощью совершенствования методов формирования диэлектрических слоев, подбором новых материалов при создании МДП структур. На основании проведенного обзора установлено, что до настоящего времени отсутствуют адекватные модельные представления, позволяющие производить теоретическое рассмотрение влияния условий формирования анодного окисла на свойства границы раздела и степень дефектности объема окисного слоя.
Эти обстоятельства и обусловили постановку задач настоящей работы, направленной на изучение закономерностей формирования окислов и исследование их электрофизических свойств.
Вторая глава посвящена описанию методик приготовления образцов для экспериментальных исследований, описанию измерительных установок и методик проведения исследований. Предварительная очистка пластин кремния и арсенида индия проводилась химической обработкой поверхности полупроводника. Поверхность пластины подвергалась обезжириванию, удалению естественного окисного слоя (для SiO2), промывке в перекисно-кислотном травителе и деионизованной воде. Для осаждения пленки тантала на кремниевую подложку используется метод магнетронного распыления. Совмещение в вакуумном объеме высокочастотного разрядника и магнетронной головки позволяет проводить очистку, травление поверхности полупроводника и осаждение металла на подложку в одном цикле. Окисление планарной поверхности образца проводилось в специально сконструированной ячейке, которая дает возможность точно устанавливать величину плотности тока. Определение качества границы раздела и величины встроенного заряда в окисном слое проводилось с помощью измерения вольтфарадных и вольтсименсных характеристик МДП структур. Расчет плотности поверхностных состояний при обработке вольтфарадных характеристик производился с помощью дифференциального метода Термана. Методика нормированной проводимости позволяет выделить вклад поверхностных состояний (ПС) на фоне заряда в окисле, определить распределение флуктуации ПС по энергиям и по глубине проникновения ПС в окисел. Исследование спектральных характеристик полученных МДП структур выполнялось с помощью фотоэлектрических измерений. В методе стационарной фотопроводимости исследуются фототоки от уровня IФ = 10-12 А. С помощью монохроматора МДР-2 энергия излучения изменялась в спектральном диапазоне (1 ÷ 5.4) эВ, при сохранении постоянного светового потока пф=2×1014 см-2 сек-1. Степень структурного разупорядочения окисла определяется с помощью аппроксимации длинноволнового участка спектра фототока в полулогарифмических координатах lnIф(hν) согласно правилу Урбаха. Пороговые значения энергий инжекционных фототоков и собственной фотопроводимости измерялись методом фотозаряжения, в котором за счет интегрального накопления заряда удается снизить влияние помех токовых шумов и значительно повысить точность регистрации воздействия излучений. Измерение переходных фототоков используется для определения кинетических параметров переноса неравновесных носителей. Быстродействие установки ограничено скоростью срабатывания модулятора излучения τмод =10-3 сек.
Присутствие слоя SiO2 в полученных структурах Si-Ta2O5 контролировалось с помощью определения интенсивности линий λ = 1050 -1100 см-1 инфракрасного поглощения, соответствующих связи (Si-O) в решетке SiO2. Измерение ИК спектров проводилось на спектрофотометре УР-10. Распределение массовой плотности по толщине окисного слоя, шероховатость поверхности кремний окисел определялись методом рентгеновской рефрактометрии.
Третья глава содержит описание технологии получения окисных пленок на поверхности полупроводников. Приведены результаты тестовых исследований полученных структур Si-Ta2O5.
Важной стадией при анодном окислении пленки тантала на поверхности полупроводника в смешанном режиме является определение напряжения формирования окисла при постоянном токе, соответствующее полному преобразованию металлической пленки в окисел до границы металл-полупроводник. Момент полного окисления металлической пленки контролировался по достижению напряжения Uф, после которого наблюдалось изменение скорости роста напряжения, соответствующее окислению кремния в ГС режиме рис.1.
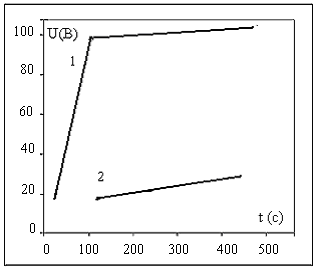
Рис. 1 Кинетические зависимости роста напряжения U(t) в гальваностатическом режиме окисления j =1mA/cm2: 1) анодное окисление структур Si-Ta; 2) анодное окисление монокристалла Si.
В вольтстатическом (ВС) режиме окончание окисления пленки тан-
тала и начало окисления кремния можно определить по отклонению зависимости 1/j(t) от линейного закона. Создание структур Si-Ta2O5 c малыми токами утечки без образования подслоя SiO2 производилось окислением тантала до напряжения, составляющего (0,75 - 0.8) от напряжения перегиба Uф, дальнейшее окисление происходило в ВС режиме при 0.75Uф до появления резкого изменения зависимости 1/j(t). Значения плотности тока устанавливались на уровне j = 10-50 мкА/см2.
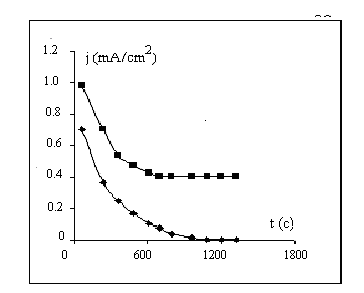
Рис. 2 Кинетика спада тока в вольтстатическом режиме. Окисление в ГС режиме до 100В. Напряжение формирования в ВС режиме: 1) UФ= 100В, 2) UФ= 75В.
Измерение ВФХ оказалось возможным только после проведения отжига при температуре 2500С в течение 10 минут, так как сразу после окисления емкость не модулировалась вплоть до пробивных напряжений (рис. 3(1)), что можно объяснить присутствием значительного заряда в окисле Ta2O5.
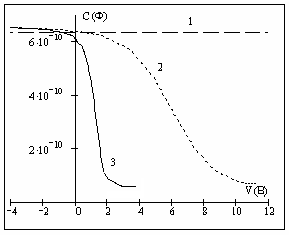
Рис. 3 Вольтфарадные характеристики для системы (p)Si-Ta2O5: 1) измерение емкости сразу после окисления, 2) после отжига для ГС режима, 3) после отжига для смешанного режима (отжиг 250оС, t = 10 мин.).
В результате отжига встроенный заряд, как для гальваностатического, так и смешанного режима удается снизить до значений 6∙10-7 Кл/см2 и 2∙10-7 Кл/см2 соответственно.
Значение емкости в состоянии обогащения равняется ~ 640пФ, что совпадает с величиной емкости, измеренной до проведения операции отжига, и указывает, что заряд в окисле имеет отрицательный знак. Формирование окисла Ta2O5 только в гальваностатическом режиме (рис. 3(2)) не позволяет снизить плотность состояний ниже уровня Nss = 1013см-3. В структурах, сформированных в смешанном режиме (рис. 3 (3)), плотность состояний стабилизируется на уровне Nss = 5∙1012 см-3.
Измерения ИК спектров, проведенные после анодного окисления в смешанном режиме пленки тантала на кремнии, показали уменьшение интенсивности линии λ = 1050 -1100 см-1 в структуре Si-Ta2O5 относительно интенсивности поглощения той же линии для связи (Si-O) естественного окисла, образовавшегося после химической обработки поверхности кремния. Это является следствием травления поверхности пластины в разряде аргона и подтверждением того, что в процессе анодного окисления тантала поверхность кремниевой подложки затрагивается незначительно.
С помощью измерения нормированной проводимости для анодных окислов кремния (рис. 4) определены значения дисперсии распределения поверхностных состояний (ПС) по энергиям и глубина залегания ПС в диэлектрике в зависимости от режима окисления поверхности кремния (табл.1).
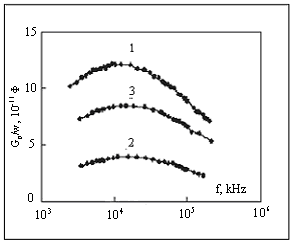
Рис. 4 Частотные зависимости нормированной проводимости для анодного окисла Si-SiO2: 1) смешанный режим j = 5 mA/см2, 2) смешанный режим j = 0.8 mA/см2, 3) гальваностатический режим j = 0.8 mA/см2
Табл.1 Влияние режима окисления на концентрацию и дисперсию поверхностных состояний (ПС) по энергиям и глубине залегания ПС в диэлектрике
| № обраца | Способ получения | Режим | σs(kT/q) | D, (Ǻ) | Nss (см-2) |
| 1. | Анодный смешанный | j = 5 mA/см2 j = 0.5 mA/см2 | 2.0 | 2.4 | 6.24·1011 |
| 2. | Анодный смешанный | j= 0.8 mA/см2 j= 0.3 mA/см2 | 1.5 | 1.8 | 2.04·1011 |
| 3. | Анодный гальваностатический | j= 0.8 mA/см2 | 2.1 | 2.0 | 4.52·1011 |
Измерения, проведенные методом нормированной проводимости, позволяют выделить вклад ПС на фоне полного заряда МДП структуры. В приведенных результатах просматривается влияние снижения тока формирования окисла в ГС и смешанном режиме на уменьшение величины плотности ПС, а также на снижение разупорядоченности границы раздела, которая проявляется в виде распределения флуктуаций поверхностных состояний по заглублению в окисел и по уровням энергий.
Методом рентгеновской рефлектометрии обнаружено снижение величины шероховатости границы Si-SiO2 при уменьшении плотности тока формирования анодного окисла. Такая взаимосвязь позволяет сделать вывод, что степень разупорядочения (дефектности) границы раздела Si-SiO2 определяется скоростью химической реакции, протекающей на поверхности полупроводника.
Четвертая глава посвящена рассмотрению процесса анодного окисления с точки зрения диффузионно-дрейфовой модели переноса вещества в условиях образования новой фазы при окислении поверхности металла. В этом случае модель процесса анодного окисления можно представить системой уравнений, которая отражает ряд последовательных стадий: (1)-постоянный поток подвижных частиц из электролита; (2)-изменение их концентрации за счет диффузии и дрейфа внутри окисла; (3)-химическая реакция на внутренней границе окисел- металл. Уравнения (4) и (5) определяют, соответственно, скорость образования (роста толщины) окисла и распределение поля в окисной пленке.
 (1)
(1) (2)
(2) (3)
(3) (4)
(4) (5)
(5)где c(x,t)- концентрация подвижных ионов, c0 - концентрация неподвижного заряда, D, μ, - соответственно коэффициент диффузии, подвижность ионов, а Ε - напряженность электрического поля, – константа скорости роста окисла, MOX – молярная масса образующегося оксида, ρOX - плотность оксида, NA – число Авогадро, nox – валентность подвижного иона.
Решение системы уравнений (1) - (5) позволяет определить кинетические закономерности роста напряжения формирования и толщины окисной пленки, получить распределение концентрации подвижных дефектов по толщине и установить величину барьера на границе металл окисел.
Результаты моделирования ГС режима для анодного окисления тантала представлены на рис.5. При совпадении расчетных (сплошные линии) и экспериментальных зависимостей (точки) кинетики роста напряжения при разных плотностях тока рассчитана постоянная роста для плотности тока j=1 мА/см2, величина которой равна 14.3 Ǻ/В, что совпадает с экспериментальным значением, определенным с помощью рентгеновской рефрактометрии.
Для этой же плотности приведены рассчитанные кинетические параметры реакции образования окисла: коэффициент диффузии D=8∙10-21 м2/с, подвижность μ=3∙10-19 м2/В∙с, скорость химической реакции χ=2,8∙10-10м/с.
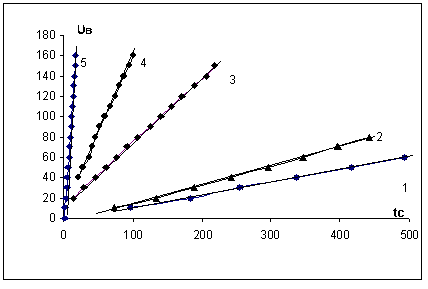
Рис. 5 Экспериментальные и расчетные зависимости напряжения Uф от времени при плотности тока: 1) 0.5mA/cm2, 2) 1 mA/cm2, 3) 3mA/cm2, 4) 5 mA/cm2, 5) 10 mА/cm2.
В вольтстатическом режиме уменьшение тока и соответственно скорости химической реакции приводит к меньшему числу дефектов на межфазной границе Si-Ta2O5, таким образом, снижается плотность поверхностных состояний, что проявляется после отжига МДП структур (2500С, в течение 10 минут) при измерении вольтфарадных характеристик.
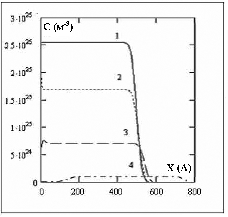
Рис. 6 Рассчитанное распределение концентрации носителей по толщине окисла после перехода системы в ВС режим за интервалы времени: 1)-0с; 2)-2с; 3)-10с; 4) - 300с.
Распределение концентрации подвижных дефектов в смешанном режиме представлено на рис. 6. За время спада тока встроенный заряд в окисле уменьшается до значений Q = 2∙10-5 Кл/см2 и толщина окисла возрастает на 25% относительно величины, достигнутой в ГС режиме.
Результаты расчетов демонстрируют снижение величины встроенного заряда и плотности поверхностных состояний и, соответственно, снижение концентрации неравновесных дефектов в объеме и на границе окисел металл (полупроводник) при уменьшении тока формирования анодного окисла.
В пятой главе приведены результаты исследования спектров фототока и фотозаряжения в МДП структурах на основе анодной пятиокиси тантала Si-Ta2O5-Au без буферного подслоя двуокиси кремния. В структурах Si-Ta2O5-Au плотность поверхностных состояний при напряжении плоских зон стабилизируется на уровне – (1÷2)·1012 см-2. Абсолютная величина фототока не зависит от направления тянущего поля и материала затвора (Au, Al, Ni). Это указывает на объемный характер фотопроводимости при энергии квантов hν > 4.0 эВ.
Изменение заряда в диэлектрике проявляется в сдвиге ВФХ структуры Si-Ta2O5-Au, подвергнутой процедуре заряжения (рис.7). Приложение поля Vg = +10В, приводит к накоплению заряда в результате полевой инжекции.
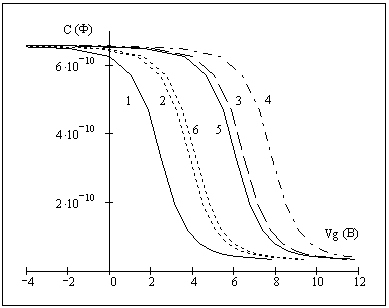
Рис. 7 Фотозаряжение структур Si-Ta2O5 –Au при 2930К: 1) Исходная кривая, 2) Vg = +10В (300сек), 3) hν =2.5 эВ, 4) hν = 3.5 эВ, 5) hν = 4.0 эВ, 6) hν = 4.7 эВ.
При освещении светом выше пороговой энергии hν > 2.5 эВ наблюдается значительное накопление отрицательного заряда, возникающее вследствие фотоинжекции электронов из полупроводника. В отсутствие подслоя накопленный заряд (Qox = -1.1÷8.4∙10-7Кл/см2) полностью удаляется при воздействии облучения в области собственного поглощения Ta2O5 hν = 4.6 эВ, как в режиме короткого замыкания, так и при плавающем потенциале затвора. В этом спектральном диапазоне структуры Si-Ta2O5-Au оказываются более стойкими к радиационным воздействиям.
Исследованы спектральные зависимости фотопроводимости и фотозаряжения МДП структур с собственными анодными окислами на поверхности InAs. Определена ширина запрещенной зоны окисных пленок hν = =4.9 эВ. Обнаружено для этих материалов наличие протяженных участков под краем фундаментального поглощения, связываемое с наличием локализованных состояний в аморфных пленках. Высказано предположение, что во всей спектральной области фотопроводимость определяется объемом диэлектрика.
Методом переходных фототоков в структурах на InAs проведено разделение полного фототока на сквозную составляющую и на компоненту, связанную с захватом носителей заряда в окисных слоях. Исследованы условия записи и стирания зарядов при облучении сетом. Продемонстрирована возможность получения информации о параметрах ловушек диэлектрика данными методом. Определена величина квантового выхода в МДП структуре Y(E) =8∙10-2, значение подвижности дырок μp = 1∙10-10 см2/В·с.
Исследованный эффект фотозаряжения позволяет использовать структуры Si-Ta2O5-Au, InAS-САО-Ni в устройствах с репрограммируемой оптической записью и хранением информации, а также приборов для регистрации УФ изображений.

Рис. 8 Кинетика нарастания фототока в InAS - САО - Ni при Т=77 К (Vg= –10В), 1) экспериментальная зависимость, 2) расчетная зависимость.
В шестой главе приведено описание метода расчета распределения заряда по толщине диэлектрика путем нахождения решений интегрального уравнения методом регуляризации Тихонова.
 (6)
(6)Проведено сравнение точности нахождения распределения плотности заряда ρ(х) методами определения центроида, двойного дифференцирования и решения интегрального уравнения.
Величина положительного заряда у границы окисла с полупроводником Q = 3.5∙10-7 Кл/см2, а на внешней границе - QN = 3.8∙10-7 Кл/см2. В средней части диэлектрика заряд либо отсутствует, либо полностью скомпенсирован.

Рис. 9 Распределение относительной плотности радиационно-индуцированного заряда y(x) в МНОП структуре: 1) рассчитанное по методу регуляризации Тихонова, 2) рассчитанное методом двойного дифференцирования. dox = 30 Å, dN = 1000 Å
В результате проведенного исследования выявлен полный вид распределения объемного заряда, индуцированного облучением потоком электронов, в диэлектрике МНОП структур. Опробован новый метод обработки экспериментальных результатов с помощью нахождения решений интегрального уравнения, показаны его преимущества относительно методов определения центроида заряда и двойного дифференцирования.
В заключении сформулированы основные выводы.
ОСНОВНЫЕ ВЫВОДЫ
Применена диффузионно-дрейфовая модель процесса анодного окисления с учетом перемещения фазовой границы. Определены кинетические параметры ионного переноса: подвижность μ = 3∙10-19 м2/В∙с, коэффициент диффузии D = 8∙10-21 м2/с, скорость химической реакции χ=2,8∙10-10м/с. Показано, что в гальваностатическом режиме у границ окисла наблюдается значительный градиент концентрации подвижных частиц. В вольтстатическом режиме формирования окисла наблюдается смещение пика концентрации подвижных дефектов к границе окисел полупроводник.
- Исследовано влияние режимов окисления на электрофизические характеристики создаваемых МДП структур и показано, что в окисле Ta2O5 после завершения процесса анодного окисления находится значительный отрицательный заряд Nox >1013см-2. Установлено, что уменьшение плотности тока формирования окисла до 2 mA/cм2 снижает плотность ПС до 1011cм-2, шероховатость межфазной границы окисел полупроводник до 20±2 Ǻ, скорость химической реакции до 4∙10-10 м/с.
- Методом фотопроводимости определена ширина запрещенной зоны в анодном окисле InAs (4.9 эВ) и анодном окисле Ta2O5 (4.6 эВ). Показан объемный характер фотопроводимости в САО на InAs и слое Ta2O5. Методом фотозаряжения определена пороговая энергия (hν =2.5 эВ) накопления заряда, возникающего за счет появления инжекционных токов в структуре Si-Ta2O5-Au. Независимость спектральной характеристики от толщины, разная полярность токов фотозаряжения и тока деполяризации окисла InAs указывают на локализацию заряда у границы окисла с полупроводником.
- На основе разработанной методики анализа переходных фототоков определены подвижность дырок μp = 1∙10-10 см2/В·с и величина квантового выхода Y(E) =8∙10-2 в анодном окисле InAs.
- Разработана методика для расчета распределения плотности заряда по толщине окисла с помощью решения интегральных уравнений с применением методов регуляризации. Распределение радиационно-индуцированного заряда в диэлектрическом слое МНОП структур характеризуется его локализацией у межфазных границ окисла.
Основные результаты диссертации опубликованы в следующих работах:
1) Авдеев Н.А. Анализ частотной зависимости проводимости МДП структур с учетом флуктуационной и туннельной теоретических моделей / Н.А Авдеев,. В.А Гуртов, И.В Климов, Р.А Яковлев // Физика и техника полупроводников. - 2006, том 40, вып.6 - С. 711-716.
2) Авдеев Н.А. Определение локализации радиационного заряда в диэлектриках на поверхности кремния методом решения интегральных уравнений / Н.А Авдеев, А.И Назаров, В.А Гуртов // Поверхность. - 2001г. №12, - С.11-16.
3) Авдеев Н.А. Фотопроводимость собственного анодного окисла на поверхности арсенида индия / Н.А Авдеев, Ю.Е. Гардин, В.А Гуртов, С.Н Кузнецов // Микроэлектроника. - 1985, т.14, N5, - С. 458-459.
4) Авдеев Н.А. Численное моделирование кинетики переходных фототоков в диэлектрических слоях / Н.А. Авдеев, Г.С. Сиговцев // V Международная конференция «Аморфные и микрокристаллические полупроводники» - Санкт-Петербург, 2006, - с. 362-363.
5) Авдеев Н.А. Исследование фотоэлектрических свойств анодного окисла на арсениде индия / Н.А. Авдеев, Ю.Е. Гардин, В. А. Гуртов, С.Н. Кузнецов //Тезисы докладов молодых физиков - Петрозаводский государственный университет им. О.В. Куусинена, 1984. - С.28-29.
6) Авдеев Н.А. Получение анодных пленок Ta2O5 на Si без буферного слоя SiO2 и фотоэлектрические свойства МДП структур / Н.А Авдеев // Физика окисных пленок: Тезисы докладов II Всесоюзной научной конференции. Часть I. - Петрозаводск, 1987.- С.3.
7) Авдеев Н.А. Анодирование системы металл - полупроводник / Н.А Авдеев // Физика окисных пленок, тезисы докладов III Всесоюзной конференции. Часть I. - Петрозаводск, 1991, - с.3.
8) Авдеев Н.А.,. Восстановление пространственного распределения зарядовой плотности из толщинной зависимости эффективного заряда в МДП структурах / Н.А Авдеев, А.И. Назаров // Международная конференция "Диэлектрики - 97", тезисы докладов, том 1, - Санкт-Петербург, издательство РГПУ им. А. И. Герцена, 1997 - С.15-16.
9) Авдеев Н. А., Савенков Г. Ю. Модель процесса анодного окисления при монополярном переносе ионов // 9-я Международная конференция "Физика диэлектриков - 2000", 17-22.09.2000, тезисы докладов, том 1, - Санкт-Петербург, издательство РГПУ им. А. И. Герцена, 2000, - С.16-17.
10) Авдеев Н. А. О математических моделях процессов анодного окисления / Н.А. Авдеев, Г.С. Сиговцев // Труды Петрозаводского университета. Прикладная математика и информатика (вып. 8) – Петрозаводск, 2000 - с.57-64.
Подписано в печать 09.04.07. формат 60´841/16
Бумага офсетная. Уч.-изд. л. 1.
Тираж 100 экз. Изд. № 107
Государственное образовательное учреждение
высшего профессионального образования
ПЕТРОЗАВОДСКИЙ ГОСУДАРСТВЕННЫЙ УНИВЕРСИТЕТ
Отпечатано в типографии Издательства ПетрГУ
1

 85910, г. Петрозаводск, пр. Ленина, 33
85910, г. Петрозаводск, пр. Ленина, 33