«Ntegra Aura»
| Вид материала | Лабораторная работа |
СодержаниеТребования к оборудованию Этапы выполнения работы Описание этапа. |
Лабораторная работа с применением СЗМ, предназначенная для выполнения студентами ВУЗов.
Исследование особенностей нанесения резиста для электронной нанолитографии
c помощью СЗМ «Ntegra Aura»
Огнев Алексей Вячеславович
заведующий лаборатории тонкопленочных технологий
Федеральное государственное автономное образовательное учреждение высшего профессионального образования
«Дальневосточный федеральный университет»
ognevav@gmail.com
Самардак Александр Сергеевич
доцент кафедры электроники, ведущий инженер-электроник
Федеральное государственное автономное образовательное учреждение высшего профессионального образования
«Дальневосточный федеральный университет»
asamardak@gmail.com
Аннотация
Представленная лабораторная работа может выполняться в рамках курса «Наноинжиниринг металлических систем» и направлена на развитие у студентов навыков проведения исследований на профессиональном научном оборудовании под руководством сотрудников лаборатории и анализ полученных результатов. В процессе научной работы студенты осваивают методы подготовки и очистки подложек для исследования, центрифугирования фоторезистов на кремниевой подложке. Центральное место в процессе исследования занимает работа на сканирующем зондовом микроскопе Ntegra Aura компании НТ-МДТ, направленная на измерение профиля фоторезиста после процесса литографии. Подразумевается, что студенты предварительно прошли обучение на атомно-силовых микроскопах NanoEducator. Знания и умения, приобретенные студентами в ходе выполнения исследования, нацелены на понимание процесса проведения научного исследования, обработку и анализ полученных результатов.

Трехмерное изображение шаблона цепочки наноточек, полученное на сканирующем зондовом микроскопе Ntegra Aura компании НТ-МДТ.
Введение
Современное развитие науки и техники позволяет осуществлять не только аналитическую и диагностическую работу по исследованию структуры материалов со сверхвысоким разрешением, но и проводить работу по целенаправленному формированию и наноструктурированию металлических, полупроводниковых и неорганических материалов c использованием технологий электронно-лучевой нанолитографии и фотолитографии. В настоящее время возможности литографии позволяют выйти за рамки микроэлектроники. Структуры, созданные с помощью литографического оборудования, будут востребованы в междисциплинарных проектах по биотехнологиям, молекулярной электронике, при разработке биосенсоров и, конечно, в области наноэлектроники и создания новой электронной компонентной базы. Принцип работы электронной литографии аналогичен письму острыми палочками на восковых табличках. Только вместо палочки исследователи используют сфокусированный пучок электронов, а пластины покрывают специальным полимером – фоторезистом. Одним из основных этапов литографического процесса является выбор резиста и его нанесение на подложку. Толщина резиста является одним из ключевых параметров, определяющих разрешение литографии и ограничивающих толщину осаждаемого на шаблон материала. Поэтому определение толщины резиста и факторов, от которых она зависит, является важной технологической задачей.
Авторы работы предлагают практические задания для студентов по курсу «Наноинжинирг металлических систем» с целью ознакомления с одним из этапов литографического процесса – нанесения фоторезиста и закрепления навыков работы на сканирующем зондовом микроскопе в режиме атомной силовой микроскопии.
^ Требования к оборудованию
Проведение данной работы возможно в лабораториях оборудованных системами электронной литографии, центрифугой, термостоликом, а также сканирующим зондовым микроскопом. В упрощенном варианте можно не применять электронную литографию, а для профилирования фоторезиста использовать ацетон или измерять заранее приготовленный набор образцов с нанесенным фоторезистом.
^ Этапы выполнения работы
- Нанесение фоторезиста с помощью центрифуги
Внимание: Работы должны проводиться с использованием лабораторного шкафа или в хорошо проветриваемом помещении.
^ Описание этапа. Учащиеся самостоятельно очищают подложки естественно оксидированного кремния Si, предварительно порезанного на кусочки 1х1 см2. Кусочки опускаются в химический стакан, наполненный ацетоном, который затем помещается в ультразвуковую ванну на одну-две минуты. Следующими этапами очистки служат полоскание подложек в изопропиловом спирте и дистиллированной воде с последующей сушкой в потоке азота. Нанесение резиста осуществляют с помощью центрифуги (например, SM 180BT от Sawatec Solutions). Авторы используют резист PMMA 950K A2, так как он позволяет получать структуры с высоким разрешением. Возможно использование любого другого полимерного резиста. Учащиеся самостоятельно программируют центрифугу для вращения подложек со скоростями: 800, 1000, 2000, 3000, 4000 и 5000 об/мин. После нанесения резиста его необходимо выдержать при четко заданной температуре для затвердевания и закрепления на поверхности. Для работы с маленькими образцами школьники используют термостолик HP 150-250 (Sawatec Solutions). Время прогрева 1 мин, температура – 1800 С.
- Профилирование резиста
Описание этапа. Для определения толщины резиста необходимо иметь ступеньку «фоторезист – подложка». Её можно получить, используя профилирование с помощью электронной литографии или просто смыть часть резиста ватной палочкой, смоченной ацетоном. В первом случае школьники отдают свои образцы оператору системы электронной литографии, который формирует тестовые структуры и проявляет фоторезист. Во втором случае, школьники самостоятельно смывают часть резиста ацетоном и высушивают образец в потоке азота.
На Рис.1-3 представлены изображения шаблона цепочки нанодисков в фоторезисте, полученные сканирующей электронной микроскопией (СЭМ) (Рис.1) и сканирующей зондовой микроскопией (СЗМ) (Рис.2 и 3). Шаблоны наноструктур получали на золотом контакте.
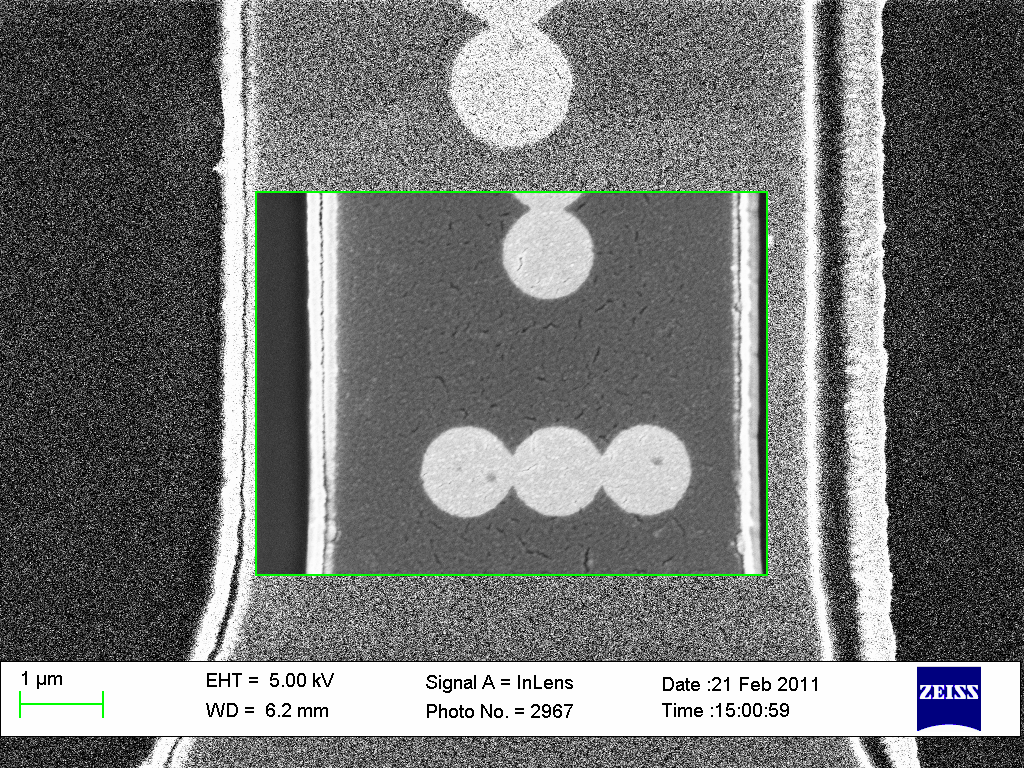
Рис.1. Изображение полимерного шаблона цепочки наноточек, полученное при помощи СЭМ.
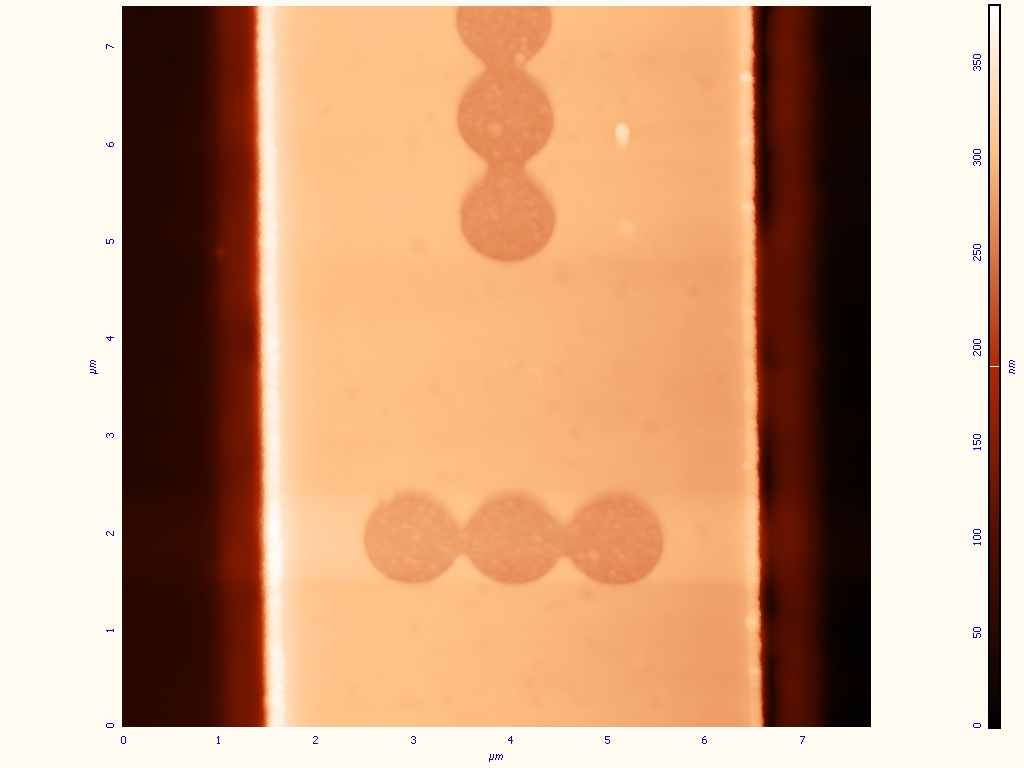
Рис.2. Изображение полимерного шаблона цепочки наноточек, полученное при помощи атомно-силового микроскопа Ntegra Aura компании НТ-МДТ.

Рис.3. Трехмерное изображение шаблона цепочки наноточек, полученное СЗМ.
- Определение толщины резиста с помощью СЗМ
Исследование рельефа поверхности осуществляется методом атомной–силовой микроскопии в полуконтактном режиме. Предполагается, что учащиеся знакомы с основами СЗМ и умеют работать на СЗМ. В нашем случае, школьники предварительно проходят обучение на NanoEducator компании НТ-МДТ.
На Рис.4 представлено СЗМ изображение участка образца со ступенькой, образованной при профилировании фоторезиста. По высоте ступеньки школьники определяют толщину резиста, нанесенного при определенной скорости вращения центрифуги. На Рис.5 показан профиль ступеньки для скорости вращения центрифуги 1000 об/мин.

(a)
(b)

Рис.4. Изображение участка образца частично покрытого резистом (а) и профиль границы «фоторезист – подложка» (b). Скорость вращения образца на центрифуге – 800 об/мин.


Рис.5. Изображение участка образца частично покрытого резистом (а) и профиль границы «фоторезист – подложка» (б). Скорость вращения образца на центрифуге – 1000 об/мин.
Мы предлагаем школьникам проделать измерения для образцов, полученных при вращении центрифуги 2000, 3000, 4000 и 5000 об/мин. Этого количества измерений будет достаточно, чтобы построить кривую зависимости толщины резиста от скорости вращения центрифуги. Экспериментальные графики школьники обрабатывают в программе Origin или Graph, хотя вполне подойдет и Excel. В процессе обработки данных, ребята также осваивают приемы аппроксимирования экспериментальных точек. В результате работы должна быть получена кривая, показанная на Рис.6.

Рис. 6. Зависимость толщины резиста от скорости вращения центрифуги.
Рекомендуется провести заключительный семинар, на котором школьники представят результаты своей работы. Это будет способствовать навыкам развития устной речи, логического построения доклада и формирования презентации.
Заключение
- В процессы выполнения работы учащиеся знакомятся с основами электронной литографии и выполняют один из основных технологических этапов – нанесение резиста на подложки.
- Школьники, используя сканирующий зондовый микроскоп Ntegra Aura, исследуют зависимость толщины фоторезиста от скорости вращения центрифуги.
- Экспериментальные данные обрабатываются в табличном процессоре и строится результирующий график.
- Подготавливается презентация для представления полученных результатов на семинаре.
Представленная разработка апробирована на студентах старших курсов в лаборатории тонкопленочных технологий ДВФУ и направлена не только на развитие практических навыков работы с атомно-силовым микроскопом и центрифугой, но и на привитие научного подхода по обработке и анализу полученных результатов и последующего их представление на научном семинаре.
