Система имплантации ионных пучков для наноэлектроники
| Вид материала | Документы |
- Рабочая учебная программа по дисциплине «физика электронных и ионных процессов (в плазме, 193.47kb.
- Учебно-методический комплекс по курсу:"Расчет потенциала средней силы для ионных каналов", 219.87kb.
- Рабочая учебная программа дисциплины Технология и оборудование производства изделий, 182.16kb.
- Отчет о научно-исследовательской работе в 2010 году Интеграционный проект №97, 237.67kb.
- Разработка импульсного преобразователя напряжения с топологией sepic, 226.39kb.
- В практике дентальной имплантации, 336.79kb.
- Г. И. Старобинская, С. И. Козленко Информационно-справочные материалы для методических, 464.58kb.
- Методом pic моделируется разлет импульсной лазерной плазмы во внешнем электрическом, 21.88kb.
- Семинарских: 32 ч, 46.81kb.
- П. И. Пучков основы этнодемографии учебное пособие, 4426.23kb.
УДК 621.382(06) Микро- и наноэлектроника

1Р.П. куйбеда, 1Т.В. КУЛЕВОЙ, Э.С. Масунов,
1в.и. Першин, 1с.в. петренко, С.М. Полозов,
1Д.Н. Селезнев, А.Л. Ситников, И.М. Шамаилов
Московский инженерно-физический институт (государственный университет),
1Институт теоретической и экспериментальной физики, Москва
СИСТЕМА ИМПЛАНТАЦИИ ИОННЫХ ПУЧКОВ
ДЛЯ НАНОЭЛЕКТРОНИКИ
В настоящее время важной задачей полупроводниковой промышленности является создание установок для ионной имплантации. Традиционно для данных целей использовались пучки таких ионов как бор, сурьма, мышьяк, фосфор и др., с энергиями в десятки и сотни кэВ. Постоянное совершенствование процесса изготовления полупроводников привело к необходимости создания установок для имплантации ионов с энергиями в единицы и даже доли кэВ. При этом обеспечивается создание полупроводников с характерными размерами примесных зон на уровне 5-50 нм. Однако, снижение энергии пучка приводит к уменьшению его интенсивности из-за ограничений по пространственному заряду. Для решения этой проблемы используются два подхода: замедление пучка (это приводит к ухудшению качества пучка) и/или использование кластерных (молекулярных) пучков. (например ионов декаборана B10H14).
В ИТЭФ (при участии МИФИ, ИСЭ, Томск) разрабатываются источники для установок ионной имплантации, используемых в полупроводниковой промышленности. Схема установки показана на рисунке 1 [1-2]: 1 – схематическое изображение магнита источника ионов, 2 – катод и антикатод, 3 – плазма, 4 – система экстракции, 5 – электростатический дефлектор, 6 – анод, 7 – система транспортировки (электростатический ондулятор). Для установки ионной имплантации был изготовлен источник Бернас с косвенным нагревом катода (см. рис.2). Такой источник позволяет получать ленточные пучки ионов различных типов с отношением заряда к массе Z/А=1/10-1/123 (от бора В+ до сурьмы Sb+, включая ионы декаборана B10H14+). При этом энергия ионов может составлять 5-20 кэВ. На рисунке 3 для примера показаны спектры ионов сурьмы (а), фосфора (б) и декаборана (в), полученные на данном источнике.
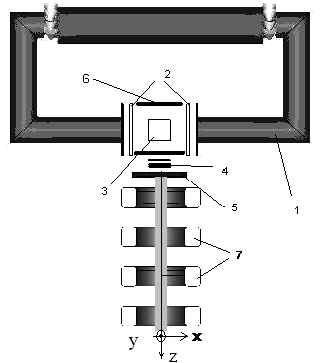 |  | |
| Рис. 1. Схема системы ионной имплантации. | Рис. 2. Источник ионов типа Бернас | |
Для экстракции пучка в установке имплантации используется стандартная трех электродная ускоряюще-замедляющая система. Для системы имплантации была предложена оригинальная система транспортировки на основе электростатического ондулятора.
Список литературы
1. T.V. Kulevoy, E.S. Masunov, S.M. Polozov at al. Transport line for beam generated by ITEP Bernas ion source. Rev. Sci. Instrum. 77, 03C112 (2006).
2. V. Kulevoy, E.S. Masunov, S.M. Polozov at al. Ion sources for the varying needs of ion implantation. Rev. Sci. Instrum. 77, 03B510 (2006).
_______________________________________________________________________
ISBN 978-5-7262-0883-1. НАУЧНАЯ СЕССИЯ МИФИ-2008. Том 8
