Конструкторско-технологические основы создания микросборок высокой плотности упаковки
| Вид материала | Автореферат |
- Программа-минимум кандидатского экзамена по специальности 05. 07. 02 «проектирование,, 170.96kb.
- Создание асимметричных мембран в виде полых волокон из полиэфирсульфона методом двойной, 199.98kb.
- План лекции. Рынок труда и занятость. Влияние плотности населения на трудовую занятость, 35.63kb.
- Программа по дисциплине "Технология микросхем и микропроцессоров" разработана на основе, 170.65kb.
- Календарно-тематический план лекций по курсу кандидатского минимума "основы вычислительной, 101.24kb.
- Задачи раскроя-упаковки представляют собой важный прикладной раздел дискретной оптимизации., 32kb.
- Теоретические и технологические основы горячей штамповки порошковых карбидосталей конструкционного, 639.83kb.
- Учебно-методический комплекс дисциплины технологические основы создания машин природообустройства, 503.4kb.
- Конструкторско-технологическое обеспечение машиностроительных производств общая характеристика, 145.04kb.
- Sokos Olympic Garden» компания «Диалог Информационные Технологии» провела семинар, 16.99kb.
КРАТКОЕ СОДЕРЖАНИЕ РАБОТЫ
Введение содержит обоснование актуальности, описываются объект, предметы и методы исследования, указаны средства обеспечения достоверности и обоснованности полученных результатов и выводов, отмечены научная новизна и практическая значимость результатов, приведены основные положения диссертационной работы, выносимые на защиту, а также сведения об апробации, реализации и внедрении результатов работы, сведения о публикациях и личном вкладе соискателя в работах, опубликованных в соавторстве. Приведены сведения об объеме и структуре работы.
В первой главе проведен анализ современного состояния проектирования и технологии тонкопленочных МСБ, рассмотрены пути повышения их плотности упаковки, а также тенденции развития элементной базы для поверхностного монтажа. Проведен анализ проблем проектирования и технологии тонкопленочных элементов и методов повышения качества тонкопленочных плат. Сформулированы цели и задачи исследования.
Проведенный анализ основных отечественных и зарубежных достижений в области проектирования и технологии тонкопленочных МСБ позволяет сделать следующие выводы:
- Установлено, что разработка МСБ и многокристальных модулей (МКМ) является одним из перспективных направлений мировой электроники. Показано, что наряду с увеличением плотности упаковки ПИС основными путями ее повышения являются:
- Уменьшение размеров тонкопленочных элементов МСБ.
- Применение прогрессивных методов компоновки.
- Создание надежной многоуровневой коммутации.
Основной проблемой, которая препятствует росту плотности упаковки МСБ в РФ, являются устаревшие модели, методы и алгоритмы проектирования и технологии ТПР и МСБ.
- В РФ выпускаются около 20 серий бескорпусных кристаллов (БК) интегральных схем (ИС) модификации (мод.) 1, 2. Выпускаемая номенклатура БК не обеспечивает потребности разработчиков МСБ. Освоение в производстве сдвоенных и счетверенных операционных усилителей (ОУ) и компараторов распространенных классов в бескорпусном исполнении помог бы в значительной степени повысить интеграцию аналоговых МСБ. Анализ основных направлений разработок МКМ показал, что в настоящее время доминируют конструктивы МКМ-L с подложкой из стеклотекстолита, как наиболее дешевые. Однако, учитывая тенденции развития корпусов ИС для поверхностного монтажа в части уменьшения шага и увеличения количества выводов, приближения размеров корпусов к размерам БК, а также стремление разработчиков к повышению плотности упаковки МКМ в перспективе следует ожидать увеличение доли рынка тонкопленочных МКМ (МКМ-D, МКМ-Si), так как максимальная плотность коммутации может быть достигнута только при применении тонкопленочной технологии и использовании подложек из кремния.
- При проектировании ТПР существует ряд проблем, которые препятствуют уменьшению их размеров менее 100 мкм.
- Существующие способы формирования физической структуры ТПР либо не обеспечивают требуемую точность, либо имеют высокую себестоимость.
- Проектирование сопротивлений в МСБ с широким диапазоном номиналов требует как исследования существующих конструкций, так и разработки новой конструкции ТПР с малым коэффициентом формы.
- Неадекватные математические модели сопротивления ТПР и его производственной погрешности.
- Применение в качестве основного критерия допустимой удельной мощности рассеяния резистивной пленки при расчете размеров ТПР.
- В теории и практике проектирования тонкопленочных МСБ имеется ряд недостатков.
- При разработке перечня элементов электрических схем задают номиналы сопротивления ТПР по рядам Е24-Е192, что нередко приводит к дополнительной погрешности сопротивления при топологическом проектировании и уменьшению выхода годных МСБ в производстве.
- Компоновка МСБ по функционально-узловому методу увеличивает себестоимость производства и снижает плотность упаковки тонкопленочных плат.
- Разделение подложки на платы с размерами рекомендуемых стандартных рядов связано с большими и совершенно неоправданными потерями материала подложки.
- Созданию высокотехнологичной и надежной многоуровневой тонкопленочной коммутации с изоляцией из тонкого диэлектрика препятствуют две основные проблемы: проколы изоляции и обрывы проводников на ступеньках изоляции.
- Трудоемкие и недостоверные расчеты стационарных тепловых режимов компонентов и ТПР.
- Для того чтобы уменьшение размеров тонкопленочных элементов не привело к уменьшению выхода годных тонкопленочных плат необходимо:
- Разработать методы и алгоритмы оценки систематических и случайных погрешностей параметров физической структуры ТПР.
- Разработать методы компенсации систематических погрешностей параметров физической структуры ТПР.
- Разработать методы оценки качества тонкопленочной платы.
Во второй главе проведено исследование влияния конструктивно-технологических факторов на сопротивление тонкопленочного резистора.
В п. 2.1 определяются элементы конструкции ТПР, которые могут влиять на его сопротивление. Конструкция ТПР (рис. 1) в самом простом случае содержит: резистивный элемент, два электрода, два контакта между проводящей и резистивной пленкой, четыре контактных площадки перекрытия (КПП) резистивного и проводящего слоев.

Рис. 1. Элементы конструкции ТПР: 1 - резистивный элемент, 2 - электрод, 3 - контакт между проводящей и резистивной пленкой, 4 – КПП, 5 - проводник.
В п. 2.2 разрабатываются физико-математические модели контактного сопротивления. В технической литературе сопротивление ТПР R в первом приближении определяется выражением:
R = Rрэ + Rк= l/b + Rк = Kф + Rк,
где Rрэ - сопротивление резистивного элемента; - удельное поверхностное сопротивление резистивной пленки; l, b - длина и ширина резистора; Kф = l/b - коэффициент формы резистора; Rк - сопротивление двух контактов ТПР.
Наиболее достоверный метод расчета контактного сопротивления основан на численных методах решения и не имеет аналитического выражения. Модель конструкции контакта ТПР при клине травления 0 < α ≤ 45º показана на рис. 2. Формулы для расчета каждого из участков модели приведены в табл. 1.

Рис. 2. Модель конструкции контакта ТПР при клине травления 0 < α ≤ 45º: 1 – резистивный слой; 2 – участок резистивного слоя контакта; 3 – участок адгезионного слоя контакта; 4 – участок проводящего слоя контакта; 5 – электрод ТПР.
Таблица 1.- Формулы для расчета участков контактного сопротивления
| Наименование параметра | 45º < α ≤ 90 | 0 < α ≤ 45º |
| Сопротивление Rp резистивного участка | Rp = 0,5 ρ tp / b | Rр = 0,564 ρ tp /(b tg α) |
| Сопротивление Rа участка адгезионного слоя | Rа = ρа tа2 /(b tp) | Rа = 2 ρа tа2 /(b tp Sin 2α) |
| Сопротивление Rп участка проводящего слоя | Rп = 2 ρп tп / b | Rп = 2 ρп tп / (b tg α) |
где tp – толщина резистивного слоя; ρа, tа – удельное поверхностное сопротивление и толщина адгезионного слоя; ρп, tп - удельное поверхностное сопротивление и толщина проводящего слоя.
Общее контактное сопротивление ТПР рассчитывается по формуле:
Rк = 2 (Rp + Rа + Rп )
В п. 2.3 разрабатываются физико-математические модели сопротивления электродов ТПР. В работе рассмотрена конструкция прямоугольного ТПР, в которой контактные площадки (КП) соединяются с концами электродов (рис. 3,а).
| а 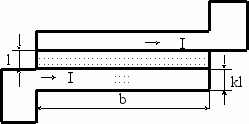  ) б) |
| Рис. 3. Подключение КП к концам электродов ТПР: а) – конструкция; б) – эквивалентная схема. |
Особенностью конструкции такого резистора является большая длина электродов, которая равна ширине резистивного элемента. Ширина электродов определяется соотношением: lэ = kl, где l – длина резистора; k - коэффициент. Данной конструкции ТПР соответствует эквивалентная электрическая схема, приведенная на рис. 3,б, где R – сопротивление резистивного элемента, Rэ1- сопротивление одного электрода. Как следует из рис. 3 общее сопротивление электродов Rэ будет равно удвоенному сопротивлению Rэ1
Rэ = 2Rэ1 = 2п /(kКф)
где п – удельное поверхностное сопротивление проводящей пленки; b – ширина резистора; Кф – коэффициент формы ТПР.
В диссертации разработана конструкция гребенчатого резистора, которая приведена рис. 4,а.

а) б)
Рис. 4. Оптимальная (а) и неоптимальная (б) конструкция гребенчатого резистора.
Сопротивление электродов гребенчатого резистора можно найти по следующим формулам:
при n – нечетном Rэг = 4 п [1/(nКф)+1] / [k (n + 1)];
при n – четном Rэг = 12 п [1/(nКф)+1] / [k (3 n + 2)],
где n – число резистивных элементов; k – коэффициент.

Рис. 5. Влияние КПП на плотность межсоединений: 1 – проводник; 2 – резистивный элемент; 3 – КПП.
В п. 2.4 исследуется влияние КПП резистивного и проводящего слоев на изменение сопротивления ТПР. Как известно, при формировании ТПР, в их конструкции предусматривают четыре КПП резистивного и проводящих элементов, которые исключают влияние несовмещения фотошаблона (ФШ) с рисунком платы на погрешность сопротивления резистора. В этом случае повышение точности сопротивления ТПР приводит к тому, что снижается плотность межсоединений на тонкопленочной плате за счет увеличения промежутка между тонкопленочными элементами (рис. 5).
Для проектирования тонкопленочной платы представляет интерес рассмотрение погрешности сопротивления конструкции резистора без КПП. Конструкция такого резистора, полученного при смещении ФШ резистивного слоя относительно проводящего слоя платы, показана на рис. 6а.
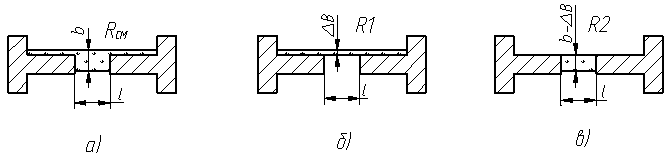
Рис. 6. Формирование погрешности сопротивления ТПР за счет исключения КПП.
Абсолютная ΔKф и относительная Kф погрешность коэффициента формы резистора Rсм находится по формулам:

 ,
,где Kф, Kфсм - коэффициенты формы несмещенного (В = 0) резистора и резистора Rсм; В - величина смещения резистивного слоя относительно проводящего слоя; B = B/b; m - число квадратов углового участка резистивного элемента резистора R1.


а) б)
Рис. 7. а) – неравномерность толщины пленки по оси Y подложки: 1 – подложка, 2 - резистивный слой; б) - градиентная погрешность сопротивления ТПР.
В п. 2.5 производится анализ технологических погрешностей физических параметров ТПР. Технологические (производственные) погрешности ТПР образуются в процессе их изготовления. Основными видами этих погрешностей являются: погрешности удельного поверхностного сопротивления; погрешности длины и ширины ТПР. Рис. 7 показывает формирование градиентной погрешности удельного поверхностного сопротивления.
Процессы фотолитографии и травления формируют систематическую погрешность, которая приводит к уменьшению размеров тонкопленочных элементов МСБ. Профили фоторезиста и тонких пленок, получаемых в процессе фотолитографии и травления, показаны на рис. 8, где lфлс – систематическая погрешность размера топологического элемента.

Рис. 8. Профили фоторезиста и тонких пленок после фотолитографии и травления
В п. 2.6. разрабатывается физико-математическая модель сопротивления (1) ТПР и его погрешности (2).
 , (1)
, (1)где lс, bс - систематические погрешности длины и ширины ТПР, Rк,- контактное сопротивление, Rэ - сопротивления электродов, Rп - сопротивление проводников, соединяющих электроды резистора с КП, обкладками конденсаторов или электродами других ТПР, Rс - погрешность за счет исключения КПП.
Формирование случайных погрешностей сопротивления ТПР происходит на следующих операциях: напыления резистивного слоя (); напыления проводящего слоя (Rэ); проведения первой фотолитографии и травления проводящей пленки (l); проведения второй фотолитографии и травления резистивной пленки (b). Эти события независимы друг от друга, поэтому для расчета случайной производственной погрешности может быть применен аппарат теории вероятностей.
В расчет половины поля допуска введем также систематическую градиентную погрешность с = y max /2, где y max – максимальное значение градиентной погрешности по оси Y подложки (рис. 7). Это вполне допустимо, если уменьшить величину при напылении до значения (1 - с). Математическая модель половины поля допуска R производственной относительной погрешности имеет вид:
 , (2)
, (2)В п. 2.7 осуществляется выбор конструкций ТПР. В результате проведенного анализа установлено, что согласно двух критериев: воспроизводимости сопротивления и занимаемой площади, лучшими формами ТПР для МСБ высокой плотности упаковки являются: резистор прямоугольной формы (Кф 0,067); Z – образный резистор (Кф 20); резистор типа меандр (Кф 40); гребенчатый резистор (0,01 Кф 0,067).
В третьей главе разрабатываются методы повышения качества тонкопленочной микросборки.
В п. 3.1. анализируются существующие способы изготовления ТПР методом фотолитографии, и разрабатывается новый третий способ, а также способ изготовления гребенчатого резистора (рис. 9). Эти способы защищены патентами РФ. Они основаны на применении дешевых проводящих структур, таких как V-Al, V-Cu-Ni и обеспечивает точность формирования ширины ТПР, присущую первому способу. Отличие третьего способа (рис. 9,в) от известных состоит в том, что при второй фотолитографии фоторезистом защищают все проводники, резистивные элементы и КП, за исключением небольших участков КПП резистивного и проводящего слоя.
1-ая фотолитография 2-ая фотолитография 2-ое травление
и травление

Рис. 9. Способы изготовления ТПР.
В п. 3.2 разрабатываются способы компенсации систематических погрешностей тонкопленочных элементов. Рис. 10 демонстрирует необходимость компенсации систематических погрешностей коэффициента формы ТПР и невозможность их компенсации путем изменения удельного поверхностного сопротивления. В общем случае плата МСБ может содержать пять групп резисторов, отличающихся размерами и значением коэффициента формы, которые можно характеризовать различной чувствительностью к систематическим и случайным погрешностям размеров или сопротивлению электродов. На рис. 10,а приведена диаграмма интервалов для каждой группы ТПР, из которой видно, что середина поля допуска 2-5 групп сдвинута вправо относительно середины поля допуска резисторов 1 группы на величину результирующей систематической погрешности. Это происходит вследствие накопления систематических погрешностей, характерной для этой группы. Данное явление приводит к резкому снижению выхода годных плат МСБ, что и демонстрирует рис. 10,б.

а
 ) б)
) б)Рис. 10. а) Диаграмма интервалов групп резисторов. б) Диаграмма интервалов годных резисторов.
Первый способ компенсации. Иногда выход годных плат может быть повышен путем изменения в конструкторской документации номинальных значений сопротивлений ТПР, в соответствии с их точными значениями, которые можно рассчитать по формуле (1). Однако этот метод не всегда приемлем с точки зрения работоспособности устройства.
Второй способ компенсации применяется при проектировании эскизов топологии плат. При Кф 10 задаются шириной ТПР и определяют его длину:
l = Кф (b - bс )
При Кф 0,1 задаются длиной ТПР и определяют его ширину:
b = ( l +lс ) /( R - Rэ )
Недостатком второго метода является низкая точность компенсации систематических погрешностей или увеличение размеров ТПР в диапазоне 0,1 <Кф < 10.


а) б)
| а) Увеличение размеров элементов фотошаблона для первой фотолитографии. | в) Изменение размеров элементов фотошаблона для второй фотолитографии |
Рис. 11. Корректировка размеров элементов фотошаблонов: 1 – КПП; 2 – резистивный элемент; 3 – контактная площадка; 4 – контур элемента фотошаблона.
Третий способ компенсации. Радикальным способом повышения выхода годных плат является полная компенсация каждой систематической погрешности путем введения констант в программы изготовления ФШ (рис. 11).
В п.3.3 рассмотрены инструментальные погрешности сопротивления ТПР, которые интегрируются в элементы ФШ. Разработан метод оценки качества тонкопленочной платы, который основан на результатах измерения сопротивления резисторов и вычисления инструментальных погрешностей ТПР. Суть метода состоит в следующем.
- На плате выбирают эталонный резистор R1.
- Задаются значением погрешности Кд отношения сопротивлений двух ТПР, обусловленной точечными дефектами (обычно Кд = 0,03).
- Производят вычисление допустимой погрешности отношения сопротивлений эталонного и исследуемого резистора R2:
δK =
 + δKд,
+ δKд,- Вычисляют фактическую относительную погрешность:
Ки = (R1и /R2и – R1/R2)/(R1/R2) = (R1и /R2и )(R2/R1) -1,
где R1и, R2и - измеренные сопротивления резисторов платы; R1, R2 – номинальные сопротивления этих же резисторов по конструкторской документации.
- Если исследуемая плата содержит инструментальные погрешности ТПР, то выполняется следующее неравенство: Ки К.
Отличие данного метода от известных решений состоит в том, что он определяет не только качество изготовления платы, но и качество проектирования ее топологии и комплекта фотошаблонов.
В п.3.4 исследуются погрешности формирования тонкопленочных элементов. Разработаны конструкции тестовой схемы, тестовой платы (рис. 12) и алгоритмы расчета систематических и случайных погрешностей параметров ТПР: удельного поверхностного сопротивления, длины, ширины, а также погрешностей, вносимых сопротивлением электродов. Предлагаемые алгоритмы в отличие от известных позволяют дополнительно измерять сопротивление электродов прямоугольного и гребенчатого ТПР и разделить систематическую и случайную погрешности удельного поверхностного сопротивления. Разработанные алгоритмы имеют более высокую точность оценки погрешностей формирования структуры ТПР по сравнению с известными методами. Результаты измерений погрешностей параметров ТПР приведены в табл. 2.


а) б)
Рис. 12. Конструкции: а) тестовой схемы, б) тест-платы.
Таблица 2. - Погрешности физической структуры ТПР
| Систематические погрешности | Случайные погрешности | ||||||||
| c, % | lc, мкм | bc, мкм | Rэп, Ом | Rэг, Ом | , % | l, мкм | b, мкм | Rэп, Ом | Rэг, Ом |
| 3,35 | 8,59 | 3,05 | 1,54 | 0,42 | 9,74 | 7,14 | 2,57 | 1,71 | 0,33 |
В п.3.5 разрабатываются устройства для контроля качества приварки выводов микросхем на полиимидном носителе к КП платы, одно из которых показано на рис. 13.

Рис. 13. Устройство со звуковым (световым) сигналом: 1 - игла, 2 - стержень, 3 –наконечник; 4 – пружина; 5 - нижний корпус; 6 нижняя втулка; 7 - верхний корпус; 8 – хвостовик; 9 - верхняя втулка 10 – контакты.
Настройку устройства на заданное усилие 20 ± 2 г производят нижней и верхней втулками. При приложении к игле заданного усилия должна срабатывать звуковая или световая сигнализация. При контроле качества сварного соединения иглой устройства касаются боковой поверхности ленточного вывода в месте сварки, при этом иглу располагают под углом 30-60º к поверхности платы. Плавно перемещают нижний корпус в направлении иглы до тех пор, пока не услышат звуковой или не увидят световой сигнал. Если при этом отрыва вывода не произошло, то сварное соединение считается качественным.
В п.3.6 проведен анализ технологического процесса изготовления тонкопленочной платы с топологическими размерами менее 50 мкм, в результате которого выработаны следующие рекомендации, позволяющие повысить плотность упаковки МСБ.
- технологический процесс и комплекс оборудования для изготовления тонкопленочных плат с топологическими размерами 10-50 мкм останется в основном неизменным; для подгонки резисторов плат высокой плотности упаковки необходимо применение лазерных установок с диаметром луча 3-5 мкм;
- для повышения выхода годных плат необходимо доведение климатических норм производственных помещений до норм, характерных для производства ПИС средней степени интеграции;
- необходимо внедрение установок напыления, обеспечивающих общую погрешность удельного поверхностного сопротивления для партии подложек не более 5%;
- широкое использование в МСБ пленок хрома, в качестве адгезионного и резистивного слоя, и алюминия, в качестве проводящего слоя, обеспечит снижение трудоемкости, уменьшение сопротивления контактов и уменьшение ширины проводников;
- повышение точности изготовления тонкопленочных элементов достигается применением металлизированных и цветных ФШ;
- минимальная ширина ТПР может составить 3 мкм в случае применения сухого травления резистивной пленки;
- в большинстве случаев ТПР следует конструировать с номинальным значением коэффициента формы, что позволит повысить плотность упаковки, за счет исключения подгоночной части резистора. В качестве подгоночных резисторов можно использовать все рекомендуемые в главе 5 формы ТПР.
В четвертой главе произведена разработка конструктивно-технологических вариантов (КТВ) многоуровневых плат.
В п.4.1 разработано три КТВ многоуровневой платы с полимерной межуровневой (МИ) и защитной (ЗИ). В первом КТВ выводы компонентов присоединяются к КП платы только сваркой (рис. 14), а в третьем только пайкой. Второй КТВ (рис. 14, 15) позволяет установку на плату смешанную комплектацию компонентов с различными способами соединения их выводов. Отличие предлагаемых конструкций от известных технических решений является то, что в качестве МИ и ЗИ применяется термостойкая, толстая (10-30 мкм) пленка органического диэлектрика, что позволяет осуществлять соединение выводов компонентов к КП, расположенным на МИ методами ультразвуковой сварки и пайки, а также исключает проколы изоляции, свойственные тонким пленкам. Новизна предлагаемых решений заключается еще и том, что межуровневые соединения могут осуществляться проволочными перемычками, приваренными ультразвуковой сваркой к КП разных уровней коммутации или путем заполнения припоем отверстий в изоляции, в которых находятся КП разных уровней коммутации.
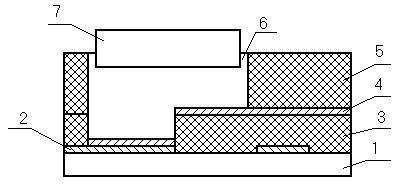
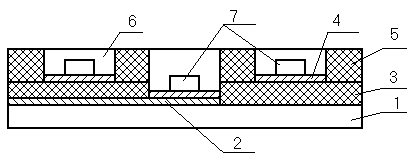
| Рис. 14. Соединения выводов компонентов сваркой в разных уровнях коммутации: 1 - подложка; 2 – КП первого уровня; 3 – МИ; 4 – КП второго уровня; 5 – ЗИ; 6 – окно в изоляции; 7 – выводы ИС. | | Рис. 15. Соединение КП разных уровней коммутации припоем: 1 - подложка; 2 – первый уровень коммутации; 3 – МИ; 4 – второй уровень коммутации; 5 – ЗИ; 6 – припой; 7 – вывод ИС. |
В п. 4.2 разработаны два КТВ кремниевых плат с двумя и тремя уровнями коммутации: двусторонняя плата с металлизацией переходных отверстий и монтажных поверхностей методом HAL (рис. 16) и плата с тремя уровнями коммутации (рис. 17). Отличие этих плат от известных решений состоит в формировании слоя диэлектрика из диоксида кремния толщиной 4-5 мкм за счет термического окисления кремния и ионно-плазменного напыления диоксида кремния на пластину. Кроме того, на одной или обеих поверхностях плат формируют ТПР. В двусторонней плате при металлизации отверстий методом HAL используется защитный слой из пленки хрома. Отличительными особенностями платы с тремя уровнями коммутации является: формирование общей шины, как на диэлектрики, так и на кремнии; использование общей шины в качестве экрана, а самой платы в качестве несущей конструкции.

Рис. 16. Конструкция кремниевой платы с ТПР: 1 – кремниевая подложка; 2 – оксид кремния; 3, 5 – хром;– 4 – медь; 6– высокотемпературный припой; 7 – резистор; 8 – ЗИ; 9 – низкотемпературный припой; 10 – КП.

Рис. 17. Кремниевая плата с тремя уровнями коммутации: 1 – подложка; 2 – диоксид кремния; 3 – хром; 4 – алюминий; 5, 6, 7 – проводники общей шины на кремнии; 8 – проводник общей шины на диоксиде кремния; 9 - проволочная перемычка.
Достоинством кремниевых коммутационных плат является то, что на них возможна установка как всех основных видов бескорпусных кристаллов и компонентов, так и компонентов в миникорпусах. Количество уровней этих плат может быть доведено до 4-5, путем применения органического диэлектрика в качестве МИ.
Применение кремниевых плат обеспечивает более высокую плотность упаковки МСБ по сравнению с печатными платами при сравнительно низкой их себестоимости. Сравнительный анализ показал, что установка миникорпусов с большим количеством выводов на кремниевую плату более выгодна, чем на печатную, так как при этом существенно уменьшается площадь платы, требуемая для трассировки этих компонентов.
В п. 4.2 разрабатываются способы монтажа многоуровневых плат с подложкой из кремния. Разработан способ монтажа БК с объемными организованными выводами на кремниевую плату. В отличие от известных способов, предлагаемое решение позволяет идеально согласовать по температурному коэффициенту линейного расширения кристалл и плату, а также исключить проблему разновысотности объемных выводов, что существенно улучшает качество и надежность МСБ. Впервые разработаны методы монтажа кремниевой многоуровневой платы: с низкой мощностью рассеяния (Руд ≤ 2 Вт/см2), со средней мощностью рассеяния (2 < Руд ≤ 10 Вт/см2), с большой мощностью рассеяния (10 < Руд ≤ 20 Вт/см2) к основанию МСБ. Разработанные методы обеспечивают: согласование ТКЛР платы и основания, требуемый теплоотвод, вибропрочность, а также минимизацию массогабаритных характеристик МСБ.
В пятой главе проведена разработка методов проектирования тонкопленочной микросборки.
В

п. 5.1 показаны особенности применения методов и алгоритмов, рассмотренных в главах 2-4 диссертации, на каждом из этапов проектирования МСБ. Разработан метод выбора номинального сопротивления ТПР при схемотехническом проектировании плат. Для того чтобы оценить площадь, занимаемую ТПР, от величины рассеиваемой в нем мощности экспериментально получены зависимости S = f (P) д

ля ситалловых (рис. 18,а) и поликоровых (рис. 18,б) подложек.
а) б)
Рис. 18. Зависимость занимаемой площади ТПР, изготовленного на: а) ситалловой; б) поликоровой подложке, от рассеиваемой в нем мощности.
Величина перегрева резистора при значениях приведенных на рис. 18 составляет около 60С. Применение данного метода обеспечивает увеличение процента выхода годных плат, а также минимизацию площади ТПР. Рассмотренные методы проектирования позволяют значительно улучшить качество разрабатываемой КД, а также оперативно выявлять расстройку технологического процесса изготовления плат. Отличие предлагаемых этапов проектирования МСБ от известных состоит в том, что их применение повышает плотность упаковки МСБ и улучшает качество их производства.
В п. 5.2 разработан интегрально-группой метод компоновки МСБ (рис. 19). В качестве основных критериев компоновки МСБ этим методом выбраны минимальная себестоимость изготовления плат и их максимальная плотность упаковки. В процессе компоновки МСБ решают следующие задачи:
- по определенным критериям группируют компоненты, для последующего их размещения на платах, конструируемых с минимальным количеством уровней коммутации в рамках двух вариантов: тонкопленочной технологии и технологии печатных плат;
- определяют размеры плат (ы);
- выбирают монтажную структуру, состоящую из материала платы определенной толщины и слоя соединяющего плату и металлическое основание МСБ;
- для выбранной монтажной структуры производят оценку теплового сопротивления кондуктивного тракта компонентов.

Рис. 19. Конструкция МСБ, разработанная интегрально-групповым методом компоновки:
1-основание; 2-тонкопленочная плата; 3-однослойная печатная плата; 4-полупроводниковые приборы; 5 реактивные компоненты; 6-межплатные перемычки.
В п. 5.3 разработан метод расчета стационарного теплового режима тонкопленочной платы. Предложены тепловые модели (рис. 20, 22), тепловая схема (рис. 21) и получены основные расчетные формулы для расчета температуры нагрева, а также собственного и наведенного перегревов компонентов и ТПР расположенных на плате. Получены формулы (3) для расчета теплового сопротивления кондуктивного тракта, а также формулы для расчета размеров зоны теплового влияния (ЗТВ) плоского источника тепла (ИТ). Отличие от известных методов расчета состоит в замене параметра «допустимая удельная мощность рассеяния» на параметр «тепловое сопротивление кондуктивного тракта» и переход от плоской тепловой модели к объемной. Это связано с тем, что удельная мощность рассеяния является функцией площади ТПР (рис. 23) или компонента.
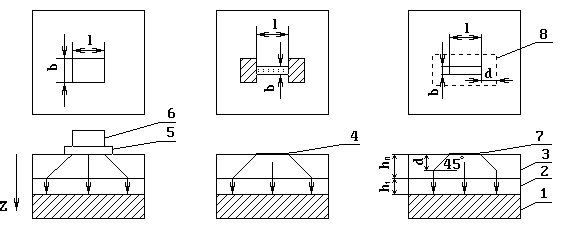
а) б) в)
Рис. 20. Тепловая модель платы для расчета собственного перегрева компонентов и ТПР:
1 - основание корпуса плат; 2 - соединительный слой 1; 3 - плата; 4 - резистор; 5 - соединительный слой 2;
6 - компонент; 7 - плоский источник тепла; 8 - зона теплового влияния.
Rв Rн R1 Rкс
Р
 Ти Тн То Тс
Ти Тн То ТсРис. 21. Тепловая схема для расчета собственного перегрева компонентов и ТПР: Rв, Rн, R1 - тепловые сопротивления кондуктивного тракта: верхней и нижней части платы, СС1; Rкс - тепловое сопротивление корпус - среда; Tи, Tн, Tо, Tс - температуры ИТ; нижней поверхности платы; основания и окружающей среды.
Объемная тепловая модель (рис. 22), состоит из правильной усеченной пирамиды (тепловое сопротивление верхней части платы) и трех параллелепипедов (тепловые сопротивления соединительного слоя (СС) 2, нижней части платы, СС1). Предложенная тепловая модель более адекватно отражает процесс отвода тепла от компонентов и ТПР. На основании этого размеры ТПР могут быть значительно уменьшены, а плотность упаковки МСБ увеличена.
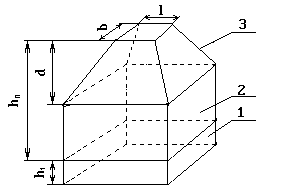
Рис. 22. Объемная тепловая модель монтажной структуры для расчета собственного перегрева ИТ: 1 - CC1; 2 - нижняя часть платы; 3 - верхняя часть платы.
 (3)
(3)где Rв, Rн, R1 - тепловые сопротивления кондуктивного тракта: верхней и нижней части платы, СС1; d – глубина теплового потока, распространяющегося под углом в 45º; S – площадь компонента или ТПР; п , 1 - коэффициенты теплопроводности платы и СС1 hп , h1 - толщина платы и СС1 r1 = h1 /1 - удельные тепловые сопротивление платы и СС1;
Rв
 Rн
Rн  ; R1
; R1 
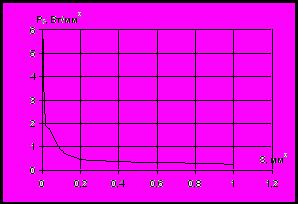

а) б)
Рис. 23. Зависимость удельной мощности рассеяния резистивной пленки от площади ТПР, изготовленных на: а) ситалле; б) поликоре.
В п. 5.4 разработан метод проектирования топологии тонкопленочной платы. Отличие от известных методов состоит в алгоритме расчета размеров ТПР (рис. 24-26) и платы, а также в алгоритме проверочного расчета тепловых режимов компонентов и ТПР. Выбор размеров тонкопленочной платы должен производиться таким образом, чтобы разработанная схема мультипликации фотошаблонов занимала не менее 75-85% площади подложки и не выходила за пределы ее технологических полей.



Рис. 24. Высокоомные ТПР: а)-прямоугольный; а) б)
б)-Z-образный; в) –меандр. Рис. 25. Низкоомные резисторы:
а) – прямоугольный; б) - гребенчатый.

Рис. 26. Схема алгоритма расчета требуемого теплового сопротивления кондуктивного тракта.
Шестая глава посвящена вопросам применения методов и алгоритмов проектирования, изложенных в диссертации, в конструкциях микросборок датчиков первичной информации
В п. 6.1 разработаны требования к оформлению топологического чертежа тонкопленочной МСБ высокой плотности упаковки. Отличие этих требований от известных состоит в том, что каждый слой тонкопленочного элемента изображается в виде цветных линий, а не прямоугольников. Такой подход к выполнению топологического чертежа позволяет уменьшить масштабы и форматы чертежей, повысить удобство их чтения, снизить трудоемкость разработки чертежа и комплекта ФШ.
В п. 6.2-6.4 на основании требований п. 6.1 и методов, изложенных в главах 4, 5 диссертации впервые произведена разработка топологий плат пяти КТВ МСБ:
- МСБ с интегрально-групповым методом компоновки;
- двухуровневой платы с толстопленочной полимерной МИ, выводы компонентов которой присоединяются к КП платы ультразвуковой сваркой;
- двухуровневой платы с толстопленочной полимерной МИ, выводы компонентов которой присоединяются к КП платы ультразвуковой сваркой и пайкой;
- кремниевой двухуровневой платы с металлизацией переходных отверстий методом HAL;
- кремниевой трехуровневой платы с выполнением общей шины и экрана на кремнии.
Результатом этих разработок является повышение плотности упаковки МСБ и пьезоэлектрического дискового гироскопа по сравнению с прототипами (табл. 3).
Таблица 3. Повышение плотности упаковки в разработанных конструкциях.
| Прибор | Объем, см3 | Рост плотности упаковки | Конструктивное решение | |
| Прототип | В диссертации | |||
| Микросборка интегрального акселерометра | 0,79 | 0,52 | 1,53 | Интегрально-групповой метод компоновки |
| Пьезоэлектрический дисковый гироскоп | 11,88 | 5,50 | 2,16 | Двухуровневая плата с толстопленочной полимерной МИ, выводы компонентов которой присоединяются к КП платы ультразвуковой сваркой |
| 6,30 | 1,89 | Двухуровневая плата с толстопленочной полимерной МИ, выводы компонентов которой присоединяются к КП платы ультразвуковой сваркой и пайкой | ||
| Микросборка интегрального акселерометра | 0,79 | 0,41 | 1,93 | Кремниевая двухуровневая плата с металлизацией переходных отверстий методом HAL |
| Микросборка акселерометра с индуктивным датчиком угла | 0,84 | 0,13 | 6,67 | Кремниевая трехуровневая плата с выполнением общей шины и экрана на кремнии |
В п. 6.5 сформулированы новые нормы конструирования (табл. 4) и даны рекомендации по проектированию тонкопленочных МСБ, которые могут быть использованы как в отраслевых стандартах, так и стандартах предприятий.
Таблица 4. Существующие и рекомендуемые стандарты размеров тонкопленочных элементов.
| Требование или ограничение | Существующие стандарты | Рекомендуемые стандарты для подложек | |||
| Ситалл | Поликор | Сапфир | Кремний | ||
| 1. Минимальная ширина пленочного проводника, мкм | 50 | 20 | 20 | 10 | 10 |
| 2. Минимальное расстояние между пленочными элементами, расположенными в одном слое, мкм | 50 | 20 | 20 | 10 | 10 |
| 3. Минимальные размеры КП, мкм | 0,3 | 0,3 | 0,2 | 0,15 | 0,15 |
| 4. Минимальные размеры ТПР, обеспечивающие допуск ± 10%, мкм: - толщина - ширина (жидкое травление) - ширина (сухое травление) - длина | - 200 - 300 | 0,04 50 20 100 | 0,08 50 20 100 | 0,04 25 10 50 | 0,04 25 10 50 |
| 5. Диапазон коэффициента формы ТПР | 0,1-200 | 0,005-1000 | |||
| 6. Толщина межуровневой полимерной изоляции, мкм | 3-5 | 10-30 | |||
| 7. Толщина диоксида кремния, мкм | 1-1,5 | | | | 4-5 |
ОСНОВНЫЕ РЕЗУЛЬТАТЫ И ВЫВОДЫ
В результате диссертационных исследований изложены научно обоснованные технические и технологические решения на основе микро и нанотехнологий по повышению плотности упаковки тонкопленочных МСБ, совокупность которых можно квалифицировать как новое крупное достижение в развитии микро- и наноэлектроники. Внедрение результатов диссертационной работы вносит значительный вклад в развитие экономики страны и повышение ее обороноспособности. В процессе выполнения работы получены следующие новые научные результаты.
- На основе проведенного анализа современного состояния теории и практики проектирования, а также технологии тонкопленочных МСБ установлено, что ныне действующие стандарты РФ по МСБ отражают технический уровень 1980 гг. и сдерживают дальнейшие увеличение плотности упаковки, потому что за гранью этих стандартов находятся неизученные явления обусловленные:
- размерными погрешностями тонкопленочных элементов;
- отводом тепла от ТПР и компонентов;
- контактными явлениями в проводниках и резисторах;
- качеством межуровневых изолирующих слоев;
- обеспечением качества МСБ на этапах синтеза электрических схем, проектирования конструкции, технологического обеспечения производства.
- Разработана теория ТПР с размерами менее 50 мкм. Полученные результаты позволяют повысить точность и стабильность сопротивления ТПР; расширить пределы коэффициента формы ТПР, проектируемых на одной плате, на два порядка; на порядок уменьшить размеры ТПР, существенно не изменяя при этом технологический процесс.
- Разработаны методы повышения качества тонкопленочной МСБ, суть которых состоит в следующем. Разработан новый способ изготовления ТПР методом фотолитографии. Разработано три способа компенсации систематических погрешностей сопротивления ТПР. Разработан метод оценки качества тонкопленочной платы, который основан на результатах измерения сопротивления резисторов и вычисления инструментальных погрешностей ТПР. Разработаны методы и алгоритмы расчета систематических и случайных погрешностей параметров физической структуры ТПР. Разработаны устройства контроля качества сварных соединений.
- Разработаны три КТВ многоуровневой платы с полимерной изоляцией: плата, на которую выводы компонентов монтируются только сваркой, плата со смешанным соединением выводов компонентов, плата, на которую выводы компонентов присоединяются только пайкой. Разработано два КТВ многоуровневой платы с подложкой из кремния. В качестве межуровневой изоляции во всех КТВ используется диоксид кремния толщиной 4-5 мкм. Первый вариант представляет собой двустороннюю плату и предполагает формирование ТПР, металлизацию переходных отверстий и монтажных поверхностей методом HAL. Второй вариант представляет собой трехуровневую плату и предполагает установку компонентов на обе ее поверхности, причем третий уровень коммутации и экран формируются на низкоомном кремнии. Разработан способ монтажа компонентов с матричными и периферийными выводами на плату из кремния. Разработаны варианты монтажа кремниевой платы с малой, средней и большой мощностями рассеяния на основание МСБ. Разработанные КТВ многоуровневых плат позволяют применять современные компоненты как в виде БК, так и в миникорпусах с большим количеством выводов и малым шагом между выводами.
- Сформулированы этапы проектирования тонкопленочных МСБ и рассмотрены их особенности. Разработан интегрально-групповой метод компоновки МСБ. Разработан метод расчета стационарного теплового режима тонкопленочной платы. Показано, что при уменьшении площади ТПР менее 2-3 мм2 удельная мощность рассеяния резистивной пленки не является информативным параметром для проектирования размеров ТПР. Взамен этого параметра предложено использовать тепловое сопротивление кондуктивного тракта источника тепла, расположенного на плате. Разработан метод проектирования топологии тонкопленочной платы.
- Разработаны требования к оформлению топологического чертежа тонкопленочной МСБ высокой плотности упаковки. На основании этих требований и методов, изложенных в главах 4, 5 диссертационной работы впервые произведена разработка топологий плат пяти КТВ МСБ. На основе исследований проведенных в диссертационной работе сформулированы новые нормы конструирования и даны рекомендации по проектированию тонкопленочных МСБ, которые могут быть использованы как в отраслевых стандартах, так и стандартах предприятий.
Полученные результаты диссертационной работы имеют широкий диапазон применения в области проектирования и технологии:
- многокристальных модулей МКМ-D, МКМ-Si, МКМ-С;
- полупроводниковых ИС;
- микросистемной техники;
- датчиков первичной информации и др.
Примером применения результатов работы в МКМ-С и полупроводниковых ИС является расчет минимальных размеров пленочных и диффузионных резисторов по заданной мощности, а также расчет сопротивления контактов резистора. В микросистемной технике и датчиках первичной информации широко распространены тонкопленочные проводники и КП, которые могут быть существенно уменьшены в случае использования приведенных в настоящей работе методов и алгоритмов их расчета.
ОСНОВНЫЕ ПУБЛИКАЦИИ ПО ТЕМЕ ДИССЕРТАЦИИ
Монография и учебное пособие
- Спирин, В.Г. Проектирование и технология тонкопленочных микросборок с топологическими размерами 10-50 мкм: Монография / В.Г. Спирин.- Арзамас: АГПИ, 2005.- 146 с.
- Спирин, В.Г. Тонкопленочные резисторы многокристальных модулей: Учебное пособие / В.Г. Спирин.- АПИ (филиал) НГТУ им. Р.Е. Алексеева; Арзамас: Издательство ОО «Ассоциация ученых» г. Арзамаса, 2007, 112 с.
Статьи в рецензируемых изданиях, рекомендованных ВАК
- Спирин, В.Г. Исследование добротности и немоночастотности резонатора пьезоэлектрического дискового гироскопа / В.Г. Спирин // Датчики и системы.- 2004.- № 5.- С. 43-45.
- Спирин, В.Г. Собственные частоты колебаний резонатора пьезоэлектрического дискового гироскопа / В.Г. Спирин // Датчики и системы. 2004.- № 8.- С. 35-37.
- Спирин, В.Г. Расчет и исследование стационарного теплового режима тонкопленочной микросборки / В.Г. Спирин // Проектирование и технология электронных средств.- 2005.- № 1.- С.27-32.
- Спирин, В.Г. Проблемы проектирования и технологии тонкопленочных микросборок с топологическими размерами 10-50 мкм / В.Г. Спирин // Проектирование и технология электронных средств.-2005.- № 2.- С 15-18.
- Спирин, В.Г. Особенности проектирования микроэлектронной аппаратуры с микросборками высокой интеграции / В.Г. Спирин // Проектирование и технология электронных средств.-2005.- № 3.- С 7-11.
- Спирин, В.Г. Исследование конструктивной погрешности сопротивления тонкопленочного резистора / В.Г. Спирин // Известия вузов. Электроника.- 2005.- № .6- С. 95-96.
- Спирин, В.Г. Контактное сопротивление тонкопленочного резистора / В.Г. Спирин // Нано- и микросистемная техника.- 2007.- № 10.- С. 56-60.
- Спирин, В.Г. Исследование погрешностей определения параметров тонкопленочного резистора / В.Г. Спирин // Заводская лаборатория. Диагностика материалов.- 2008.- № 2.- С. 33-36.
- Спирин, В.Г. Сопротивление электродов тонкопленочного резистора / В.Г. Спирин // Нано- и микросистемная техника.- 2008.- № 7.- С. 19 - 24.
- Спирин, В.Г. Тонкопленочные многоуровневые коммутационные платы с толстопленочной полимерной изоляцией / В.Г. Спирин // Вестник Московского авиационного института.-2008, т.15.- № 3.- С 114-119.
