 Авторефераты по всем темам >>
Авторефераты по техническим наукам
Авторефераты по всем темам >>
Авторефераты по техническим наукам
Методы и приборы лазерной и спектральной эллипсометрии с бинарной модуляцией состояния поляризации
Автореферат докторской диссертации по техническим наукам
На праваха рукопиcи
КОВАЛЕВа ВИТАЛИЙ ИВАНОВИЧ
Методы и приборы лазерной и спектральной эллипсометрииаа аас бинарной модуляцией состояния поляризации.
01.04.01 - Приборы и методы экспериментальной физики
аа АВТОРЕФЕРАТ
диссертации на соискание ученой степени
доктора технических наук
аа Фрязино -а 2011 г.
Работа выполненаа воа Фрязинском филиале Учреждения Российскойа академии
наука Института радиотехники и электроники им. В.А. Котельниковаа РАН
Официальные оппоненты:а доктор физико-математических наук,
профессора
аа Мащенко Владислав Евдокимович
доктор технических наук,
доцентаа
Никитин Алексей Константинович
доктор технических наук,
старший научный сотрудника
Соколовский Александр Алексеевич
а Ведущаяа организация: ааУчреждение Российской академии наук
Физико- технологический институт РАН.
Защита диссертации состоитсяаа л09а декабряаа 2011 г.,а ва 10-00а наа заседанииа
диссертационного совета Д 002.231.03 при Учреждении Российской Академии наук
Институте радиотехники и электроники им. В.А. Котельникова РАНаа поа адресу :
125009, г. Москва, ГСП-9, ул. Моховая, д.11, корп.7
а С диссертацией можно ознакомиться в библиотеке Учреждения Российской
академии наука Институте радиотехники и электроники им. В.А. Котельникова РАН
аа
Автореферата разослана лаа а 2011 г.
Ученыйа секретарь диссертационногоа совета
кандидат физико-математических наук ![]() аВ.Н.Корниенко.
аВ.Н.Корниенко.
аАктуальностьаа темы.
Эллипсометрия - высокочувствительный метод определения оптических параметров образцов по относительному изменению амплитуд и фаз компонент вектора электрического поля электромагнитной волны, расположенных в плоскости падения и перпендикулярно ей, при взаимодействии с исследуемым образцом [1-3]. Возможность одновременного измерения амплитудных и фазовых характеристик позволяет точно определять одновременно толщины пленок и оптические константы материала пленок. Измерение отношения комплексных компонент обеспечивает высокую помехоустойчивость и стабильность спектральных эллипсометрических измерений. Например, сравнительно несложно регистрироватьа в широком спектральном диапазоне изменение фазового сдвига между ортогональными компонентами а?а на 0,01 градуса, что соответствует изменению толщины около 0,01 монослоя при измеренияха тонких окислов на полупроводниках.
Широкое применениее эллипсометрия получила в связи с появлением лазерных источников излучения и компьютеров. Развитие микроэлектроники определило доминирующее развитие эллипсометрии, основанной на анализе отраженного пучка излучения. В настоящее время широкое распространение получила спекроэллипсометрия, в которой измеряются спектры эллипсометрических параметров. Это один из основных методов анализа современных наноструктур.
Эллипсометрические измерения носят универсальный характер. В частности, могут быть выполнены исследования линейного и кругового дихроизма, вращения плоскости поляризации, оптической анизотропии, поляризационной микроскопии.
Универсальность и информативность метода СЭ определили широкую область ее применения.
СЭ позволяет точно определять спектры оптических постоянных всего набора материалова современной технологии (металлов, полупроводников, диэлектриков) в объемном и пленочном состояниях и толщины пленок, поверхностных и переходных слоев в сложных многопленочных структурах в диапазоне от единиц до тысяч нанометров.
СЭ дает возможность исследовать механические, структурные, физико-химические свойства материалов, микрошероховатость поверхности, профиль распределения микропористости и микровключений.
СЭ - эффективное средство in situ контроля процессов напыления и травления.
Основные области применения СЭ:
нанотехнология, физика и химия поверхности и тонких пленок, оптика, кристаллофизика, электрохимия, сенсорные устройства для экологии, биология и медицина.
Существует несколько основных направлений в современной эллипсомерии. Наиболее развитое направление - эллипсометрия с вращающимися поляризационными элементами. Эллипсометрия с фотоупругими скоростными модуляторами также находит широкое применение. Спектральная эллипсометрия с делением отраженного от образца пучка излучения на несколько каналов с различными состояниями поляризации и несколькими фотоприемникамиа используетсяа значительно реже. Нулевая эллипсометрия, основанная на нахождении азимутов поляризатора и анализатора, соответствующих минимуму сигнала на фотоприемнике, широко использовалась ранее с лазерными источниками излучения, но неэффективна в спектральной эллипсометрии.
Отечественная эллипсометрия начала развиваться с середины шестидесятых годов на предприятиях электронной и оптической промышленности и в институте физики полупроводников СО РАН. Было налажено серийное производствоа нулевых лазерных эллипсометров серий ЛЭМ и ЛЭФ с ручным управлением. ( Общее количество произведенных эллипсометров более 700 шт ).
Производство отечественных лазерных эллипсометров с вращающимися анализатором или поляризатором не было налажено. Лазерные эллипсометры этого типа для ex situ иа in situ измерений в большом количестве выпускались в 60-80 годы за рубежом. В 1969 и 1975 годах были созданы первые СЭ с фотоупругим модулятором и вращающимся анализатором, соответственно [6,7]. Основанные в 80-е годыа динамичные фирмы (такие, например, как SOPRA (Франция,1981)а и Woollam (USA,1986)) наряду с ранее известными фирмамиа обеспечили массовый выпуск спектральных эллипсометров. В ИРЭ РАН автором в 1978а году предложено и развивается новое направление эллипсометрии - эллипсометрия с бинарной модуляцией состояния поляризации (ЭБМСП), в которой на исследуемый образец попеременно направляется излучение с двумя состояниями поляризации, иа не используются движущиеся поляризационные элементы. Первый лазерный эллипсометр с БМСП экспонировался на ВДНХ в 1981г.
К настоящемуа времени области применений эллипсометрии быстро расширяются. В инструментальной частиа получили преимущественноеа развитие спектральные эллипсометры с вращающимся компенсатором. Существенно расширилась рабочая спектральная область эллипсометров - от 100нм до мм диапазона.а Интенсивно развиваются отображающие (imaging) эллипсометры с микронным латеральным разрешением [13,14]. Появляются сообщенияа о создании эллипсометров ближнего поля в связке са оптическим или металлическим зондома с латеральным разрешениема до 20 нм [21]. В эллипсометрах с высоким латеральным разрешением решающееа значение имеет приемлемое отношение сигнал/шум для конкретной исследуемой структуры. Естественно, не все азимуты, например, при вращении анализатора, равноценны с точки зрения реализации наибольшей чувствительности измерений. В ЭБМСПа легко выбрать оптимальные азимуты в плечах поляризатора и анализатора и отношение интенсивностей переключаемых пучков для измерений с высоким отношением сигнал/шум и максимальной чувствительностью. Актуальность исследований определяется возможностью существенного улучшения основных параметров эллипсометров, таких как чувствительность, точность по воспроизводимости (precision) и скорость измерений, при использовании ЭБМСП. Такие СЭ
проще и надежнее широко используемых коммерческих СЭ и принципиально лучше согласованы с современными линейками и матрицами фотоприемников.
а Цель работы Цаа развитие предложенного автором нового направления в эллипсометрии - эллипсометрии с бинарной модуляцией состояния поляризации, предполагающее сравнительный анализ возможных способов эллипсометрических измерений, создание новой эффективной элементной базы поляризационной оптики для измерений в широкой спектральной области, разработку и создание семейства автоматических лазерных и спектральных эллипсометров для ex situ и in situ измерений, не содержащих движущихся поляризационных элементов,а разработку современного программного обеспечения для эффективного анализа сложных исследуемых систем. С использованием разработанных эллипсометров предполагалось выполнить широкий комплекс исследований оптических свойства твердотельных структур и жидкостей. Работа должна закончиться подготовкой и практической реализацией серийного изготовления прецизионных и надежных отечественных спектральных автоматических эллипсометров, превосходящих по ряду основных технических параметров эллипсометры, выпускаемые в нашей стране и за рубежом.
Для достижения поставленной цели решались следующие основные задачи :
- Разработка эллипсометров, не содержащих движущихся поляризационныхаа ааэлементов.
- Разработка поляризационных интерферометров - модуляторов для широкой областиаа спектра с использованием светоделительных элементов, параллельных полированным пластинам легированного кремния, установленных под углом Брюстера к падающему на них излучению.
- Разработка бинарных модуляторов состояния поляризации с использованием тонкого симметричного клинаа из двулучепреломляющего материала, эффективно заменяющих цепочку поляризатор - модулятор состояния поляризации, часто используемуюа в современных спектральных эллипсометрах и других типах прецизионных поляризационных приборов.
- Разработка соосного фазосдвигающего устройства (компенсатора) на основе ромба Френеля для широкой области спектра.аа
- Разработка новых методов измерений в эллипсометрии с бинарной модуляцией состояния поляризации.
- Разработка и создание семейства лазерныха и спектральных эллипсометров с бинарной модуляцией состояния поляризации.
- Сравнительный анализ технических параметров эллипсометров с бинарной модуляцией и современных зарубежных спектральных эллипсометров.
- Выполнение цикла исследований материалов и структур электронной техники.
Научно -техническаяа новизна работы азаключается в создании принципиально нового направления в эллипсонметрии,а разработке новой элементной базы поляризационной оптики, создании эллипсометров нового поколения, с использованием которых выполнен цикл исследований полупроводниковых и диэлектрических структур и жидкостей.
К наиболееаа существенным новым результатам, полученным в работе, относятся следующие:
- Предложено и развивается новое направление в эллипсометрии.
- Разработана элементная база поляризационной оптики - бинарные модуляторы состояния поляризации и фазосдвигающие элементы. Эти элементы могут быть успешно использованы практически во всех поляризационных приборах: поляриметрах, рефрактометрах, линейных и круговых дихрометрах, дифференциальных рефлектометрах, поляризационных микроскопах.аа
- аПредложены методы эллипсометрических измерений с использованием бинарной модуляции состояния поляризации.
- Создано семейство спектральных эллипсометров нового поколения с бинарной модуляцией состояния поляризации.
- Выполнен цикл исследований оптических свойств полупроводниковых и диэлектрических структур и жидкостей с использованием созданных спектроэллипсометров. Полученыа новые результаты.
- аРазработан и создан принципиально новый простой компактный автоматический эллипсометр с использованием двух попеременно переключаемых лазеров или светодиодов и устройства объединения ортогонально поляризованных пучков, позволившийаа достичь рекордные для эллипсометрииа точности по воспроизводимостиа 2х 10-5 и 3х10-4 градусов, дляа ?аа и ? соответственно. Это позволяет использовать эллипсометр в качестве высокочувствительного сенсорного устройства.
Положения выносимые на защиту:
- Эллипсометрия с бинарной модуляцией состояния поляризации, предложенная иа развиваемая автором с 1978 г., - новое направление в эллипсометрии, открывающее возможности улучшения основных технических характеристик современных лазерных и спектральных эллипсометров.
- Методы эллипсометрических измерений с бинарной модуляцией, в которых измеряются отношения интенсивностей на двух фотоприемниках, расположенных в блоке анализатора после призмы Волластона. Эти методы позволяют использовать импульсные источники излучения и источники с сильно выраженной линейчатой структурой в спектрах излучения и обеспечивают высокие отношение сигнал/шум и точность по воспроизводимости. Предложенный метод используется в выпускаемых ЗАО Наноиндустрия мелкой серией прецизионных универсальных спектральных эллипсометрах, разработанных автором.
- аМетоды эллипсометрических измерений с бинарной модуляцией с использованием одного фотоприемника (линейки или матрицы фотоприемников). Методы используются в in situ и ex situ спектральных эллипсометрах, разработанных автором в вариантах с 35-элементной и 512- элементной линейками фотодиодов.
- Разработана новая элементная база поляризационной оптики - бинарные модуляторы и фазосдвигающие устройства для широкой области спектра, позволяющие в полной мере реализовать преимущества эллипсометрии с бинарной модуляцией состояния поляризации.
- На основе новых базовых поляризационных элементов и методов разработано и создано семейство прецизионных лазерных и спектральных эллипсометров нового поколения, не использующих движущиеся поляризационные элементы.
- Исследования методом эллипсометрии с бинарной модуляцией состояния поляризации полупроводниковых и диэлектрических структур и жидкостей, показавшие эффективность использования созданных лазерных и спектральных эллипсометров при разработке технологии и в физических исследованиях.
- Впервые реализованный в эллипсометрии метод поочередного включения двух идентичных лазеров или светодиодов с ортогонально поляризованными пучками позволил исключить дорогостоящие модуляторы состояния поляризации и создать высокопрецизионные простые скоростные лазерные и спектральные эллипсометры с широкими возможностями применений при исследовании кинетических явлений, картирования поверхностей и в качестве сенсорного чувствительного устройства.
Практическая значимость проведенных исследований и разработок заключается в следующем:
Эллипсометрия с бинарной модуляцией состояния поляризации, основанная на использовании новой элементной базы и новых методов измерений, позволяет существенно улучшить ряд основных параметров лазерных и спектральных эллипсометров, упростить конструкции эллипсометров и обработку результатов измерений. Опробован ряд автоматических эллипсометров различного назначения.а По разработанной нами технической документации налажен серийный выпуск СЭ БМСП л Эльф с двумя фотоприемниками ЗАО Концерн Наноиндустрия, Москва.
Разработанная нами новая и сравнительно дешевая элементная база может эффективно ис - пользоватьсяа при создании самых разных поляризационных приборов и устройств. Замена традиционно используемых поляризаторов и модуляторов состояния поляризацииаа делает прецизионные поляризационные приборы заметно дешевле и надежнее.
Высокочувствительные компактные эллипсометры с лазерами и светодиодами позволяют создаватьа системы картирования, исследования кинетики параметров структур и эффективныеа сенсорные устройства.
В настоящее время стремительно развивается эллипсометрия с латеральным разрешениема до 1 мкм. Наблюдается несоответствиеа потребностей быстрой обработки больших массивов информации и применения эллипсометрии со сравнительно медленно вращающимисяа поляризационными элементами. Альтернативой несомненно является ЭБМСП, хорошо согласующаяся с необходимостью одновременного интегрированияа сигналов многоэлементных фотоприемников. Особенно привлекательна возможностьа выбора оптимальных условий измерений в ЭБМСП и точной калибровки методом определения азимутов А1 и А2, описанном ниже и исключающем нелинейности, присущие чувствительным ПЗС матрицам. Заметим, что с очевидными проблемами минимизации влияния фоновых излучений (например, плазменного свечения в ростовой камере)аа сталкиваются и разработчики отечественных СЭ в ИФП СО РАН, использующие статические методы измерений в эллипсометрии с делением отраженного от образца пучка излученияа по фронту на несколько пучков, и, соответственно, несколько фотоприемников. Возникают трудности с реалиизацией локальных измеренийа и измерений са многоканальными фотоприемными устройствами.
Апробация работы.
Материалы исследований и разработока докладывались на следующиха Всесоюзных, Российских и Международныха конференциях:
VII Всесоюзная конференция по микроэлектронике, Львов, 1975; 1-ая Всесоюзная конференция по эллипсометрии, Новосибирск , 1977; International Simposium on Reliability of microelectronic devices. Berlin.1978; IV International Conference У Mikronika-79. Warszawa. 1979; 1-аяа Всесоюзная школа- семинар л Проблемы функциональной микроэлектроники Горький. 1980; 9-ая Всесоюзная научно-техническаяа Конференция по микроэлектронике. Казань. 1980; 2-ая Всесоюзная конференция по эллипсометрии. Новосибирск, 1981;Третья Всесоюзная Конференция по эллипсометрии. Новосибирск. 1985;а Четвертая Всесоюзная Конференция по эллипсометрии. Новосибирск,1989; Совещание общества Попова. Москва,1986; Всесоюзная конференция л Физические и физико-химические основы микроэлектроники Вильнюс.1987; Доклад на Межотраслевом Экспертном Совете. 1987; Всезоюзная научно-техническая конференция л Специальные коммутационные элементы, Рязань, 1984; Всесоюзная конференция л Поверхность 89 Черноголовка. 1989; MRS Fall Meeting, Boston,1994; Всероссийская научно-техническая конференция Микро-и наноэлектроника-99. Звенигород,1999; Международная конференция л Взаимодействие излучения са твердым телом - ВИТТ-2003, Минск, 2003; Internationalа Conference УMicro- and Nanoelectronics -2003Ф, Москва-Звенигород, 2003; 25-th ACRS, Chiang-Mai, Thailand, 2004; 10 International Symposium on Microwave and Optical Technology (ISMOT-2005). Fukuoka.Japan. August 22-25. 2005.pp.87; Proceedings of International conference УModern problems of Condensed Matter - 2007Ф, Kiev, Ukraine, 2-4 October 2007, p. 247-248; International Workshop on Photonics and Applications. Can Tho, Vietnam, 15-19 August, 2006, p.81;а 4th International Conference on Spectroscopic Ellipsometry (June 11Ц15, 2007, Stockholm, Sweden); XV Международная научно-техническая конференцияФ Высокие технологии в промышленности России; XXII Международный симпозиум л Тонкие пленки в электронике. Москва, 2009, с.440-446; Оптическая и магнитооптическая спектроскопия тонких ферромагнитных слоёв InMnAs; аХII Международный симпозиум Нанофизика и наноэлектроника, Сборник трудов, Нижний Новгород, 2008, т.2, с. 273-274; PICES XVI Annual Meetings. The changing North Pacific: Previous patterns, future projections, and ecosystem impacts. Victoria, Canada, October 26- November 2, 2007, pp. 108; Proceedings of ICMNE-2007, p. D5; 11 International Symposiumа on Microwave and Optical Technology ( ISMOT 2007). Monte Porzio Catone, Italy, 17-21 December, 2007, pp. 385-388; First Mediterranean Photonics Conference, Ischia, Napoli, Italy, 2008;
Участие в выставках:а
- Елинсон М.И., Игнатов Б.Г., Ковалев В.И., Марьин В.И., Перов П.И., Россуканый Н.М., Тужиков А.В. Оптическая установка для определения параметров микроэлектронных структур. Экспонат ВДНХ. М. 1981. Впервые в качестве модулятора состояния поляризации в эллипсометрии применен поляризационный интерферометр - модулятор.
- Ковалев В.И., Россуканый Н.М. Универсальный автоматический эллипсометр. Экспонат ВДНХ. 1983. Серебряная медаль.
- Ковалев В.И., Руковишников А.И. Эллипсометр с бинарной модуляцией состояния поляризации. Экспонат ВДНХ. 1987. Серебряная медаль.
- Ковалев В.И., Россуканый Н.М. Автоматический эллипсометр для видимой и ИК области спектра. Экспонат на выставке Важнейшие законченные работы АН СССР . 1986.
- Ковалев В.И., Руковишников А.И., Крапивин В.Ф., Климов В.В., Мкртчян Ф.А. Компактный многоканальныйа спектроэллипсометр. Экспонат ВВ - л Инновации 2000. 2000 г. Золотая медаль.
- а Основные результаты диссертационной работы опубликованы в 74 научных работах, из которых 28 статей в рецензируемых изданиях, определенных Высшей аттестационной комиссией,а 8 авторских свидетельств и патентов, 38 статей в других изданиях иа в трудах Международных, Всесоюзных и Всероссийских конференций.
а По разработанной нами технической документации налажен серийный выпуск СЭ БМСПа
л Эльф ЗАО Концерн Наноиндустрия, Москва.а а
ичный вклад автора.
Представленные в диссертации результаты получены лично автором или при его непосредственном участии и руководстве. Paзработка и изготовление электронных схем и устройства и разработка программного обеспечения для автоматических эллипсометров выполнены с.н.с. Руковишниковым А.И. Исследования, отраженные в Главе 5 , выполнены при активном участии с.н.с. Хомича А.В. и Куньковой З.Э.
Результаты, представленные в Гл.6 , получены при участии с.н.с. Россуканого Н.М. и с.н.с. Климова В.И.
Структура и объем диссертации.
Диссертация состоит из введения, 6 глав, заключения, общих выводов и
списка литературы. Объем диссертации - 250 страниц, содержащие 110 рисунков и 6 таблиц.
Список литературы содержит более 200 ссылок.а
Содержание работы.а
Во введении амотивируется актуальность диссертации, формулируются ее цели, приводятся основные результаты, отмечается их новизна и изложены защищаемые положения. Приведен обзор современного состояния спектральной эллипсометрии, включающий теорию эллипсометрии, описание эллипсометрических методов измерений и спектральных эллипсометров широкого использования. Показаны примеры анализа результатов эллипсометрических измерений.а а
а Глава 1. Методы эллипсометрии с бинарной модуляцией состояния поляризации.
Глава 1 содержита 5 разделов. В 1.1 рассмотрены проблемы традиционных подходов в эллипсометрии иа предпосылкиа к разработкеа нового подхода.а
Представленныйа во Введении диссертации обзор состояния эллипсометрии показывает, чтоа устоявшиеся два направления в спектральной эллипсометрии (эллипсометрия с вращающимися поляризационными элементами и эллипсометрия с фотоупругими модуляторами), определяющие мировой рынок современных спектральных эллипсометров, непрерывно развиваются, однако остаются некоторые принципиальные ограничения.
Так, в эллипсометрии с вращающимися элементами удалось исключить влияние поляризационной зависимости фотоприемникова в RAEа или остаточнойа поляризации в излучении источника в RPE, применяя более информативные и точные эллипсометры с вращающимся компенсатором RCE. Оказалось возможным существенно расширить спектральный диапазон эллипсометров с вращающимися элементами и эллипсометров с фотоупругим модулятором PME. PME легко использовать в ИК диапазоне с FTIR в отличие от эллипсометров с вращающимися элементами.а Однако, современные PME остаются дорогостоящими сложными устройствами, плохо согласующимися с линейками и матрицамиа фотодетекторов. Эллипсометры с вращающимися поляризационнымиа элементамиа не позволяют исследовать кинетику процессов, а величина отношения сигнал/шум в большой мере определяется качеством блока вращающегося элемента и фотоприемника.
К середине 70-х появилось множество разработока по оптическим методам исследования, в частности, по лазерной и спектральной эллипсометрии, позволяющих решать основные метрологические задачиа в различных отраслях промышленности, особенно в микроэлектронике. Информативность и уникальные свойства эллипсометрии явились главнойа предпосылкойа начала работ по эллипсометрииа в отделе микроэлектроникиа ФИРЭ РАН. Именно в это время в США появился первый автоматический спектральный эллипсометр с вращающимся анализатором [7], работающий в видимой и УФ области спектра.а
Другие предпосылкиа нетрудно понять из рассмотренияа метрологической работы автораа {3}, изложенной в разделе 1.2. Ко времени публикации {3} существовали единичные публикации с описаниема ИК спектроэллипсометров на основе стандартных монохроматических источников излучения. В {3} фактически измеряются ИК спектры и угловые зависимостиа эллипсометрического параметра ? (Tan ?) с использованием разработанного авторома эффективного отражательного поляризатора. Аналогичные измерения Tan ?а выполняются и в методах НПВО. Возможность переключенияа p- и s - компонент позволила бы существенно увеличить чувствительность и точность измерения Tan ? . Позже, Roseler [9] предложил использовать FTIR спектрометрыа в спектральной эллипсометрии, что обеспечило существенное улучшение их технических характеристик.
Метод эллипсометрических измерений в [9] основан на последовательных измерениях интенсивностей при 4 различных азимутах поляризатора. Естественно, и здесь переключение азимутов может существенно улучшить точность и увеличить скорость измерений.
Работы автора по исследованию квантового размерного эффекта в тонких пленках и оптической диагностике структур микроэлектроники {1-3} также привели к необходимостиа разработкиа нового подхода в эллипсометрии, который бы позволил создавать простые лазерные и спектральные эллипсометрыа с высокими техническими характеристиками.
Еще одна важная предпосылка - появление публикацийа Запасского [5] по прецизионной лазерной поляриметрии с балансными схемами фотоприемников, обеспечивающей чувствительность на уровне до 10-6 градусов. Уровень чувствительности лазерных эллипсометров при измерении эллипсометрических параметров на три порядка ниже.а Возникает предположение, что еслиа мы будем последовательно посылать на образец пучкиа с выбранными азимутами поляризацииа и регистрировать их ортогональные компоненты (например,а после призмы Волластона с определенным азимутом, расположенной после образца), появляется возможность эллипсометрических измерений с существенно улучшенной чувствительностью и точностью. Это и есть принципа эллипсометрических измерений с бинарной модуляцией состояния поляризации. Авторскоеа свидетельство 1978 г {29}а У Поляризационныйа интерферометр - модулятор Уа и предложенные методы измеренийа явились основой созданияа различных автоматических эллипсометров видимого и ИК спектральногоа диапазона. В 1981г. эллипсометр с переключением поляризации экспонировался на ВДНХ.
а В разделе 1.2. Метод псевдоугла Брюстера в исследованиях электрофизических параметров сильно легированных полупроводников приведены результаты исследованияа дисперсии показателей преломления и поглощения и подвижности свободных носителей в сильно легированном кремнии точным и сравнительно простым методом псевдоугла Брюстера, где необходимо измерение величины псевдоугла Брюстера ?Ба и отношения RБ = Rp/ Rs при ? = ?Б , Rp и Rs- коэффициенты отражения электромагнитного излучения, поляризованного параллельно и перпендикулярно плоскости падения, соответственно [4]. В [4] представлены простые аналитические выражения, позволяющие определять показатель преломленияа па и показатель поглощения к по RБа иа ?Б..а Используя эти выражения из [4], мы определили дисперсиюа па иа к в области плазменного края отражения сильно легированных образцов Siа №1 ( п-тип, толщина диффузионного слоя фосфора d = 2,19 мкм, поверхностное сопротивлениеа Rs = 3,6 Ом/?) и №2 (р-тип, толщина диффузионного слоя бора d = 0,2а мкм, Rs = 96 Ом/?).
Угловые измерения отражения в спектральной области от 1,8 до 6 мкм выполнены нами на экспериментальной установке, включающей монохроматор ИКМ-1, поляризатор, систему зеркал, формирующую параллельный пучок излучения за выходной щелью монохроматора, устройство синхронного сканирования угла поворота образца и болометра.
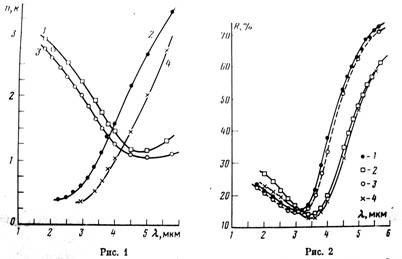
Рис.1. 1. Дисперсия па иа ка в области плазменной частоты. Образеца Siа №1: 1- п
2- к ; образец Siа №2: 3- п,а 4-а ка
Рис.1. 2. Спектры плазменного отражения приа Т = 300? К: 1,2 - образцы №1,№2, измерены при нормальном падении; 3, 4 - образцыа №1,№2 , спектры получены по измеренным методом псевдоугла Брюстераа значениям па иа к .
В разделе 1.3. Методы эллипсометрии с бинарной модуляцией состояния поляризации представлено описание различных методов эллипсометрических измерений, их преимущества и недостатки. Общим для всех методов является определениеа эллипсометрических параметров в соответствии с основным уравнением эллипсометрии:
? = rp / rs = Tan ? exp (i? )аа (1)
?аа и ?а - эллипсометрические углы, определяющие отношение комплексных амплитудных коэффициентов отраженияа rp и rs для p и s-а поляризаций [2]. Измеренные значения параметрова ?аа и ? сопоставляются с расчитаннымиа с помощью формул Френеля, исходя из заданной модели образца.
Наилучшее согласие между расчетом и моделью оценивалось по минимальной величине целевой функции ?, характеризующей квадратичное отклонение экспериментальных (индекс УeФ) и расчетных (УcФ) значений эллипсометрических параметров, определенных при одних и тех же длинах волн ?i
?2 = 1/N ?i [tg?e(?i) - tg?c(?i)]2 + [cos?e(?i) - cos?c(?i)]2,аа (2)
где N Ч количество экспериментальных точек.
Все разнообразие эллипсометрических методов можно разделить на нулевые и фотометрические методы. Стандартная геометрия расположения поляризационных элементов в эллипсометрах: поляризатор (Р ) - компенсатор(С) - образец(S) - аанализатор (А). В нулевых методах эллипсометрические углы определяются по значениям азимутов поляризатора и анализатора, при которых наблюдается минимум интенсивности на фотоприемнике. При использовании так называемых четырехзонных измерений (при различных азимутах компенсатора) реализуется высокая абсолютная точность определенияа ?аа и ? - 0.02?-0.05? , безотносительно к диапазону их значений. Однако малая скорость измерений и неэффективное использование интенсивности определилиа преимущественное использование в спектральной эллипсометрии (СЭ) фотометрических методов с измерением интенсивности пучков. Это методы с вращающимся анализатором, поляризатором или компенсатором, а также метод эллипсометрии с фотоупругим модулятором (ЭФМ) и методы с пространственным разделением (МПД) отраженного от образца пучка света на несколько пучков. Как правило, фотометрические методы имеют абсолютную точность определенияа аа?аа и ?а в диапазоне 0.05-0.5градуса [3], но существенно более высокую скорость измерений иа точность по воспроизводимости. Методы СЭ с вращающимися поляризационными элементами (ВПЭ) хорошо согласуются с линейками и матрицами фотоприемников, в отличие от ЭФМ и МПД, проще для автоматизации, имеют более широкий рабочий спектральный диапазон и их применение является доминирующим. Недостатки СЭВПЭа - невысокая скорость измерений (до10мсек), ошибки, связанные с девиацией пучка, механическими вибрациями, с поляризационной зависимостью фотоприемников и наличием поляризационной составляющей пучка света на входе поляризатора.
В 1978 году автором было предложено новое направление в эллипсометрии -а эллипсометрия с бинарной модуляцией состояния поляризации (ЭБМСП), не использующая движущиеся поляризационные элементы. В ЭБМСП последовательно по времени на исследуемый образец подается излучение с двумя заданными состояниями поляризации. Отраженный от образца пучок излучения либо делится призмой Волластона на два ортогонально поляризованных пучка с азимутами А и А+90?, которые одновременно направляются на два фотоприемника, либоа проходит через поляризационное устройство, выделяющее последовательно по времени поляризацию с азимутами А и А+90?.
Для эллипсометра с конфигурацией поляризаторЧобразецЧанализатор интенсивность света на фотоприемнике
In = I0 (sin2Ansin2Pn + cos2Ancos2Pntg2? + 0.5sin2Ansin2Pncos? tg?), (3)
где Pn и An Ч азимуты поляризатора и анализатора (углы P и A устанавливаются исходя из оптимальных условий измерения); I0 Ч коэффициент, не зависящий от Pn и Anа
Запишем уравнение (3) для азимутов (А, Р), (А+90?,Р), (А, Р+90?) и (А+90?, Р+90?), соответственно:
I1 = ha*I0 (sin2A sin2P + cos2Acos2P tg2? + 0.5sin2Asin2Pcos? tg?)аа (4a)аа
I2 =аа I0 а(cos2Asin2P + sin2Acos2P tg2? - 0.5sin2Asin2Pcos? tg?)а (4b)а
I3 = ha*I0 (sin2Acos2P + cos2Asin2P tg2? - 0.5sin2Asin2Pcos? tg?)а (4c)а
I4 =аа I0 а(cos2A cos2P + sin2Asin2P tg2? + 0.5sin2Asin2Pcos? tg?)аа (4d)а
ha- акоэффициент, характеризующий отношение чувствительностей 2-х каналов в анализаторе. Для каждого из азимутов Pа и P + 90? измеряется отношение сигналов на фотоприемникаха при азимутах анализатораа А и А+ 90?.а По измеренным отношенияма b1 = I1/ I2 /haа иа b2 = I3 / I4 /haа определяются эллипсометрические параметры ? и ? из соотношений:
Tan 2 ? = (x1 - b1b2x2 + c) / (b1b2 x1 - x2аа + c) а(5)
Сos ?а =а [b1x3 - sin 2 A sin 2 P + (b1x4 - cos 2 аA cos 2 P) Tan 2 ?] /а (6)
0.5(b1+1)sin2Asin 2P Tan ?а а
здесь
с = b2 (sin 2 A sin 2 P - cos 2 A cos 2 P) + b1(x4 - x3)
x1 = sin 2 A ,аа x2 = cos 2 A ,аа x3 = cos 2 A sin 2 P,а x4 = sin 2 A cos 2 P
Описанный скоростной и чувствительный метод измеренийа не обеспечивает, как и все фотометрические методы, высокую абсолютную точность измеренийа приа величинах измеряемых отношений, существенно отличающихся от единицы. В ЭБМСПа легко реализовать метод с переключением азимута Ра и Р+90? и нахождением азимутов анализатора А1 и А2, при которых интенсивности падающих на фотоприемник пучков равны. На Рис.1.3 показаны так называемые номограммы в координатах А1-А2 , гдеа цифры, указанные на кривых, это толщины оксида акремния в ангстремах на кремниевой подложке. Длина волны излучения 633 нм. Угол падения на образец 70 градусов, а - отношение интенсивностей переключаемых пучков.
аа Видно, что измерения с введенным в пучок компенсаторома для очень тонких оксидов намного чувствительнее. В отличие от эллипсометров с ВЭ в методе ЭБМСП можно выбрать оптимальные условия измерений для конкретного исследуемого образца и интересуемого диапазона толщин.
Этот метод , как и стандартный нулевой метод эллипсометрии, исключает ошибки, связанные са нелинейностью фотоприемников. При этом уровень сигналов существенно выше, что позволяет использовать метод в спектральной эллипсометрии, в частности, для точной калибровки.а
Отметим, что БМ позволяет изменить алгоритм измерений в широко используемых эллипсометрах с вращающимся анализатором (ЭВА) [7] c шаговым приводом. Обычно используемую сложную калибровку можно заменить на вышеописанную калибровку с определением A1 и A2. Кроме того с БМ реализуется двухзонный режим измерений, что повышаета иха точность.

Рис.1.3.{73,74}.
В ЭБМСП возможны различные способы измерений, представленные в главе 1.
Раздел 1.4.Методы ЭБМСП с двумя фотоприемными устройствами.
Именно балансные системы фотоприемников используются в основном в прецизионных поляриметрах с чувствительностью до 10-6 градуса [5].
Переключение состояния поляризации позволяет реализовать чувствительный эллипсометрический метод, характеристики которого решающим образом определяются используемым бинарным модулятором.
- Метод эллипсометрии с переключением ортогонально поляризованных пучков с азимутами P и P+90? (бинарная модуляция), падающих на образец, в котором отраженные пучкиа направляются призмой Волластона с азимутом Аа на два фотоприемника.
- Метод эллипсометрии, отличающийся от первогоа переключениема двух линейно поляризованных пучков с произвольно устанавливаемымиа азимутами поляризационным устройством с делением пучка по фронту{33}.
- Метод эллипсометрических измеренийа с бинарной модуляцией состояния поляризации, в которома последовательно включаются два идентичных лазерных либо светодиодных источника, причем обеспечивается ортогональность азимутов переключаемых пучков.
4.аа Метод короткоимпульсных эллипсометрических измеренийа с бинарной модуляцией состояния поляризации, в которома импульс излучения преобразуется бинарным модулятором в два последовательных импульса с ортогональными азимутами поляризации.
Раздел 1.5. Методы ЭБМСП с одним фотоприемным устройством (фотодиод, линейка или матрица фотодиодов).
5. Метод эллипсометрических измерений с бинарной модуляцией состояния поляризации, в котором бинарная модуляция осуществляется в плечах поляризатора и анализатора.
6. Метод эллипсометрических измерений с бинарной модуляцией состояния поляризации, в котором бинарная модуляция выполняется только в плече поляризатора, измеряются интенсивности на расположенном за анализатором фотоприемнике и на фотоприемнике, расположенном в опорном канале бинарного модулятора на Рис.11.
7. Метод эллипсометрических измерений с бинарной модуляцией состояния поляризации, в котором бинарная модуляция выполняется только в плече поляризатора, и определяются азимуты А1 и А2, при которых наблюдается равенство интенсивностей после сканируемого по азимуту анализатора.
Глава 2 Разработка и создание новой элементной базы поляризационной оптики.а
аа В Главе 2 приведено описание разработанных автором новых поляризационных элементов, которые составляют элементную базу для поляризационной оптики, и, в частности, эллипсометрии. Эффективность метода эллипсометрии с БМСП определяется ключевыма элементом - бинарным модулятором поляризации. В 1978 году автором был предложен поляризационный интерферометр-модулятор (ПИМ) {29}, который обеспечивает попеременно пучки излучения с ортогональными поляризациями в спектральном диапазоне от 400 нм до 15000нм. Отличительной чертой cоосного ПИМ является использование светоделительных пластин, параллельных полированным легированным кремниевыма пластинам, установленным под углом Брюстера к падающему на них излучению. Известные интерферометры Майкельсона и Маха-Цендера не обеспечивают соосности входного и выходного пучков, в отличие от предложенной нами трапецеидальной геометрии интерферометра. Возможность интерферометрических измеренийа в положениях, когда оба пучка открыты, очень важна, например, при чувствительных измерениях показателя преломления жидкостей и газов, либо двулучепреломленияа в твердотельных материалах.
В устройствах [16] поляризационные элементы устанавливались в плечах, например, интерферометра Маха-Цендера, и соосность не обеспечивалась. Бинарные модуляторы состояния поляризации на основе интерферометров Майкельсона и Маха-Цендера рассмотрены в публикациях аAzzama 1993 г.[18,19]. Необходимость использования дополнительного ахроматическогоа полуволнового устройства ограничивает аиспользование амодуляторов в широком спектральном диапазоне.

Рис.2.1. 1-поляризатор, 2 и 3 - идентичные светоделительные пластины ( BaF2 или ZnSe ) , параллельные пластинам кремния 4 и 5 , установленным под углом Брюстера к падающему на них пучку, поляризованному перпендикулярно плоскости рисунка. Кремниевые пластины 6-,9 ( пластины 6,7 для снижения потерь можно заменить зеркалами)развернуты относительно пластин 4,5 на 90 градусов и установлены под углом Брюстера. Обтюратор 10 попеременно открывает ортогонально поляризованные пучки.а
В главе 2 также приведены конструкции поляризатора и переключателя состояния поляризатора с делением пучков по фронту (Рис.3.1)а ав которых используются полированные кремниевые пластины, установленные под углом Брюстера. Высокая степень легирования пластина исключает влияние отражения от задней границы и обеспечивает более слабую зависимость степени поляризацииа от длины волны и угловой апертуры пучка.
Широкий спектральный диапазон, высокая степень поляризации, возможность варьирования азимутов переключаемых пучков в большом диапазоне позволяют эффективно использовать этот соосный ПСПа в ИК спектральных эллипсометрах.


а).а аб).
а аРис.2.2.
Ключевой элемент спектральных эллипсометров с бинарной модуляцией состояния поляризации - бинарный модулятор поляризации {34} показан на Рис.2а. Коллимированный пучок излучения расщепляется клином из кальцита ( CaCO3) на два ортогонально поляризованных коллимированных пучка, которые сферическим зеркалом 3 фокусируются в точках В и С, где попеременно перекрываются обтюратором 2. Далее пучки снова становятся коллимированными и совмещаются клином с направлением первоначального пучка. Фактически мы имеем геометрию поляризационного интерферометра. Этот простой БП эффективно заменяет стандартную дорогостоящуюа цепочку поляризатор-модулятор состояния поляризации. Основные характеристики:
Совмещение пучков не хуже 0,01 градуса, степень поляризации -10-5, рабочий спектральный диапазон ПСП -240-2400 нм. Скорость прерывания пучков - до нескольких кГц.
Кальцит является идеальным материалом для БМ, показанного на Рис.2а. Расширение спектрального диапазона обеспечивает сравнительно новый материал- а-ВВО ( а-ВаВ2О4), прозрачный в области 189-3500 нм. Особенности дисперсии этого материала и меньшая разность обыкновенного и необыкновенного показателей преломленияа не позволяют использовать вышеописанную конструкцию во всей области прозрачности кристаллов. В главе 2 дано описание двухстороннего варианта БМ с использованием сходящегося пучка, что позволяет существенно повысить отношение сигнал/шум в УФ области спектра. Работа в сходящихся пучках позволяет использовать дешевые малоразмерные призмы.
Схема четвертьволнового фазосдвигающего устройства, предложенная нами в 1986г.{35}, показана на Рис.2б. Ромб Френеля из плавленого кварцаа и пара зеркал,а установленных под углом 12-13 градусов к падающему на них пучку обеспечивают соосность и улучшение ахроматичности, так как дисперсия диэлектриков и, соответственно, фазовый сдвиг в ромбе и фазовый сдвиг при отражении от зеркал имеют противоположные зависимости от длины волны. Аналогичная конструкция описана позже в работе 2002 г.[28].
Глава3.а Разработка и создание лазерных и спектральных эллипсометров для ИК области спектра.
В Главе 3 представлены результаты разработок лазерных эллипсометров для ИК области спектра на основе новых поляризационных элементов. Принципиальная схемаа автоматической многоволновой эллипсометрической установки показана в {4}. На выходе ПИМ с частотой 160 Гц попеременно формируется линейно-поляризованное излучение с азимутами Р и Р+90? . Отраженное от образца излучение проходит через анализатор с азимутом на блок фотоприемников. Сканируя азимут анализатора при автоматическом считывании значений азимута с дискретностью 10', определяем два азимута А1 и А2, при которых сигналы I1и I2, соответствующие переключаемым ПИМ пучкам, равны. По А1 и А2 определяются эллипсометрические и электрофизические параметры.
Технические параметры установки:
Длина волны излучения 0,63; 1,15; 3,39; 10,6 мкм.(He-Ne лазер ЛГ-126 и CO2 лазер).
Время измерения - 5 сек; Диапазон измеряемых толщин- 0,001-20 мкм. Погрешность определения толщин- 0,5 нм; Погрешность определения показателя преломления 0,005; Погрешность определения концентрацииа свободных носителей заряда (при N> 1019 см-3)- 5%. Погрешность определения подвижности свободных носителей заряда 15%. Погрешность определения эллипсометрических параметрова ? и ?а 0,02?-0,04?а на длинах волн 0,63-3,39 мкм и 0,1? на длине волны 10,6 мкм. Диапазон автоматического сканирования угла падения излучения на образец-30-90 градусов. Погрешность определения азимута анализатора -0,02?.
В Главе 3 представлен двухлучевой дифференциальный ИК эллипсометр, описанный в {37}.
Эллипсометр имеет высокую чувствительность при определении разности эллипсометрических параметров эталонного и исследуемого образцов.
Широкий спектральный диапазон, меньшие потери излучения и возможность выбора произвольных значений переключаемых азимутов поляризации характерны для ИК эллипсометра, предложенного в {33}. Система деления пучка по фронту и переключения пучков обеспечивает очень широкий спектральный диапазон от 400 нм до 50 мкм (Табл.аа в Гл.3) при высокой степени поляризации пучков.

Рис.3.1. 1-призменный монохроматор ИКМ-1, 2- зеркальная система коллимации пучка, 3-диафрагма, 4-обтюратор, попеременно прерывающий верхную от плоскости рисунка и нижную половинки пучка.5,6, 9и10- плоские зеркала, 7,8,11 и 12 - пластины легированного кремния, установленные под углом Брюстера к падающему пучку, 14-исследуемый образец, 15-анализатор отражательного типа , 16-линза, 17 - болометр (либо фотоприемник Ge:Au) - регистрирующаяа система.
Глава 4.а Разработка и создание лазерных и спектральных эллипсометров для УФ, видимой и ближней ИК спектральной области.а
Глава 4 посвящена разработке и созданию лазерных и спектральных эллипсометров для УФ, видимой и ближней ИК спектральной области.
Универсальный сканирующий спектроэллипсометр ES-2 (Эльф).
Спектральный диапазон 270-1050 нм. Диапазон изменения углов падения - 45-90 градусов. Время измерения спектров эллипсометрических параметров аа?аа и ?а - 20 сек. Точность определенияа аа?аа и ? поа воспроизводимостиаа 0.003 и 0.005 градусов, а показателя преломления и толщины пленок 0,001 и 0,01нм, соответственно. Долговременная стабильность 0,01 градуса. Диаметр пучка 3 и 0,2 мм (с микроприставкой). Предусмотрена возможность использования УФ светодиодов UVTOPаа для работы в спектральном диапазоне от 270 нм с высокой надежностью и отношением сигнал/шум.

Рис.4.1.
Универсальный сканирующий спектроэллипсометр ES-2.

Рис. 4.2.аа Многоканальныйа компактный спектроэллипсометр с 512-элементной линейкой фотодиодов. Источник - галогенная лампа. Спектральный диапазон-380-800 нм. Угол падения излучения на образец-70 градусов. Минимальное время измерения спектров эллипсометрических параметрова ?аа и ?аа -0,6 сек. Точность измерения эллипсометрических параметрова ?аа и ?а по воспроизводимостиа 0.003 и 0.01 градуса, соответственно. Долговременная стабильностьа ?аа и ?аа - 0.01 градуса. Точность измерения оптического пропускания жидкостейа и поворота плоскости поляризации: 0.05% и 0,001 градуса, соответственно. Точность определения показателя преломления -0,001.
Проблема недостаточного ресурса стандартных ксеноновых ламп в коммерческих спектральных эллипсометрах решается использованием экономичного импульсного ксенонового источника излучения РХ-2 (Ocean Optics,Inc.){14}. Последовательно по ходу пучка излучения расположены линзовый осветитель, монохроматор МДР-3, управляемый от компьютера, БМСП, расположенный вертикально образец, модифицированная призма Волластона с воздушным зазором и два кремниевых фотодиода S5226-8BQ (Hamamatsu). Одновременное интегрирование сигналов на фотоприемниках обеспечивает высокое отношение с/ш при использовании сравнительно нестабильных ксеноновых ламп и импульсных ксеноновых ламп РХ-2 (длительность импульса излучения 5 мкс, частота повторения импульсов до 220 Гц, ресурс 109 импульсов). На Рис.4.3а показаны спектры действительной и мнимой частей псевдодиэлектрической функции кремниевых пластин с тонким термическим окислом в УФ части спектра. Спектральные зависимости, вычисленные в рамках однослойной модели (термический окисел толщиной 4.4 нм и 29 нм на кремниевой подложке), хорошо соответствуют экспериментальным данным. Основные технические характеристики импульсного двухканального СЭ: Спектральный диапазон 270-1100 нм. Спектральное разрешение 1.3 нм в диапазоне 270-370 нма и 2.6 нм в диапазоне 370-1100 нм. Диапазон углов падения излучения на образец 40-90 градусов. Точность определения эллипсометрических параметрова cos? и tg? аапо воспроизводимости и их долговременная стабильность 10-4 ав области длин волн более 450 нм.
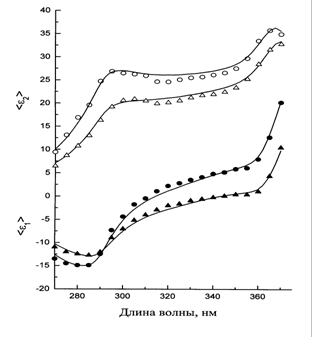
Рис.4.3.
На Рис.4.4.а показан многоканальныйа СЭа с геометрией: источник излучения - бинарный модулятор - ахроматический компенсатор - образец - второй бинарный модулятор - миниспектрограф- линейка 35 фотодиодов. Минимальное время измерения спектров - 0,6 сек.
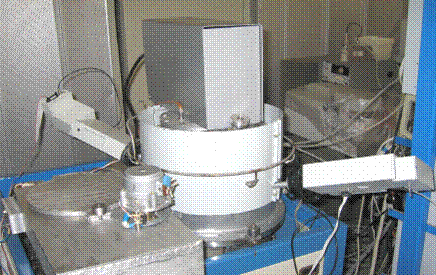
Рис 4.4. In situа многоканальный спектральный эллипсометр для исследования в реальном времени роста полупроводниковых структур методом индуктивно связанной плазмы ( ФТИАН).
В главе 4 дано описание некоторых других схем эллипсометров, удобных для конкретных приложений. Например, при использовании ПЗС матриц фотоприемников и локальных измерениях имеет определенные преимущества эллипсометр с геометрией: источник излучения - БМ с опорным фотоприемником - компенсатор-образец - стандартный анализатор - ПЗС матрица. Достаточно измерить отношения сигналов на апикселах матрицы к опорному сигналу для каждого из переключаемых пучков. Естественно, увеличивается скорость измерений, упрощается конструкция. Такой эллипсометр можно использовать и для in situ измерений.
Основной вывод представленных выше глав - эллипсометрия с бинарной модуляцией состояния поляризации дает широкие возможности для разработок новых поляризационных элементов иа создания широкого семейства эллипсометров различного назначения, исключающих основные недостатки современных коммерческих эллипсометров. Открываются возможности нового подхода при создании других поляризационных приборов: линейных и циркулярных дихрометров, дифференциальных поляризационных рефлектометров, ближнеполевых эллипсометров.
Глава 5.аа Исследование полупроводниковых и диэлектрических материалов и структур методом спектральной эллипсометрии с бинарной модуляцией состояния поляризации.а
5.1.Спектральная эллипсометрия многослойных гетероструктур ZnS/ZnSe {11,12}.
При исследовании слоев селенида цинка, сульфида цинка и многослойных структур ZnS/ZnSe, полученных методом химического газофазного осаждения из элементоорганических соединений на GaAs-подложках, эллипсометрические измерения проводились на универсальном автоматическом двухканальном спектроэллипсометре с БМСП на основе серийного монохроматора МДР-3 со спектральным разрешением 1 нм.
Для локальных эллипсометрических измерений использовалась приставка, изготовленная на основе двух сферических зеркал с фокусным расстоянием 50 мм, что позволило значительно уменьшить ошибки анализа слоев с большими толщинами, обусловленные их неоднородностью, и проводить картографирование поверхности образца с локальностью не хуже 0.2 ? 0.5 мм при угле падения 70. Качество гетероструктур оценивалось методами фотолюминесценции и рентгеновской дифрактометрии, а толщины определялись методами эллипсометрии и по спектрам отражения.
Из-за упругих напряжений вследствие несоответствия параметров решетки эпитаксиальных слоев и подложки и наличия дефектов в объеме пленки оптические константы тонких пленок А2B6 и соответствующих монокристаллов несколько различаются. Для определения дисперсии показателей преломления и поглощения тонких эпитаксиальных слоев ZnS и ZnSe выращены простые слои соединений А2B6. В спектрах cos? иа tg? двух структур ZnSe/GaAs с различной толщиной эпитаксиального слоя, зарегистрированных с приставкой для локальных измерений, хорошо заметно изменение характера кривых вблизи края запрещенной зоны селенида цинка. Двухслойная модель поверхностный оксидный слой/пленка ZnSe/подложка GaAs (рис. 1) удовлетворительно описывает экспериментальные результаты. Наличие особенностей вблизи энергий E0/(E0 +?0) критических точек и совпадение абсолютных величин n и k с литературными данными свидетельствуют о высоком структурном качестве слоев ZnSe. Вследствие упругих напряжений максимум спектра показателя поглощения k смещен в коротковолновую сторону по сравнению с известными данными для объемных монокристаллов селенида цинка. Отметим, что использование микроприставки в СЭ-измерениях дает возможность исследовать достаточно толстые пленки, при этом достигается хорошее совпадение как в области прозрачности ZnSe, так и в коротковолновой части спектра
Данные измерений одиночных слоев позволили нам с большей достоверностью анализировать эллипсометрические спектры многослойных структур, в том числе брэгговских зеркал на основе ZnSe/ZnS. На рис. 5.1а приведены результаты измерений и расчета в рамках 10- и 12-слойной модели для двух структур (ZnSe/ZnS)n/ZnSe/GaAs, причем толщины слоев как ZnS, так и ZnSe в многослойной структуре принимались одинаковыми во всех парах слоев. Расчет и эксперимент хорошо согласуются во всем спектральном диапазоне, величина ? не превышает 0.02Ч0.03. Спектры отражения, рассчитанные для угла падения 20 по определенным из СЭ параметрам (рис. 3), совпадают с измеренными (рис. 2, в и г).
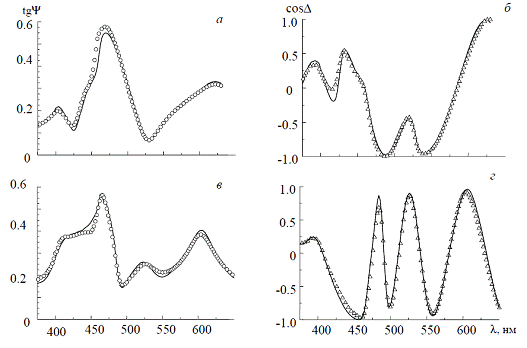
Рис.5.1.. Эллипсометрические спектры tg? (0) и cos? (?) двух многослойных структур в сопоставлении с модельными расчетами для структур: поверхностный оксидный слой 4 нм/четыре пары слоев (46 нм ZnSe/58 нм ZnS)/63 нм ZnSe/GaAs (а и б) и поверхностный оксидный слой 5 нм/пять пар слоев (41.5 нм ZnSe/45.5 нм ZnS)/271 нм ZnSe/GaAs (в и аг).
Распределенный брэгговский рефлектор (РБР), состоящий из чередующихся четвертьволновых слоев двух материалов с различными показателями преломления, является важным компонентом поверхностно излучающих лазерных резонаторов. Согласно нашим измерениям для пары ZnS/ZnSe на ? = 480 нм ?n = 0.35 и расчет показывает, что коэффициент отражения на этой длине волны для РБР с 20 парами должен быть >99 %.
При выращивании РБР на основе ZnS/ZnSe главное внимание уделено снижению шероховатости растущей поверхности.а В результате для лучшего выращенного образца РБР с 20 парами коэффициент отражения 99 % на ? = 480 нм.
Приведены экспериментальный и расчетный спектры. Коэффициенты отражения в области максимума практически совпадают, хотя более узкая экспериментальная полоса свидетельствует о разбросе периода РБР. Следует отметить, что столь высокий коэффициент отражения на полупроводниковых РБР для синей области спектра получен впервые.
5.2. Исследование изменения оптических свойств пленок полиметилметакрилата и полистирена при ионном облучении методом СЭ {15} .
аа Мы использовали метод СЭ с бинарной модуляцией состоянияа поляризации. В универсальном автоматическом спектроэллипсометре последовательно расположены: импульсная ксеноновая ампа PX-2а -дифракционный монохроматор МДР-3 - коллимирующие зеркала - бинарный модулятор - зеркальный объектив (диаметр сфокусированного пучка до 150 мкм) - модифицированная призма Волластона - два сферических зеркала - два кремниевых фотодиода - ПК). Спектральный диапазон эллипсометра -270-1050 нм. Одновременное интегрирование на фотоприемниках существенно увеличивает отношение сигнал/шум при работе с импульсными и нестабильными источниками излучения.
Результаты наших СЭ исследований показали, что при облученииа PMMA ионами азота при дозах нижеа 1 x1015 cm2 сильная дисперсияаа n(?) иа k(?) наблюдаетсяа в спектральном диапазонеа 300-600 nm (Рис.5.2.). Величины n(?) иа k(?) возрастают с уменьшением ?. При ?>а 600 нм наблюдается слабая дисперсия n(?) иа k(?).
При дозах облучения более 1x1015 cm2 спектральное поведение n(?) иа k(?) PMMA пленока наблюдается сильное увеличение коэффициента экстинкции и пленки не могут использоваться как волноводный материал. Максимум в зависимостиа n(?) сдвигается в длинноволновую сторону, аа k возрастает на три порядка в коротковолновой части спектра. Облучениеа PMMA и PS ионами можно использовать как эффективное средство изменения оптических свойств и изготовления диэлектрических планарных волноводов
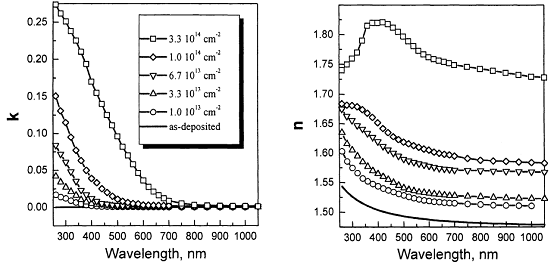
Рис.5.2. Влияние N ионной имплантации (300 KeV) на оптические свойства PMMA пленок, полученных из Tan ? и cos ?аа спектров
5.3. Спектральная эллипсометрияа скрытых графитизированных слоев в ионно-имплантированном алмазе.аа
Эллипсометрический анализ скрытых графитизированных слоев, образованных в He+имплантированном и отожженном алмазе, выполнен в {18}. Спектры эллипсометрических параметров, измеренных в области длин волн 360-1050 нм при углах падения 65, 70 и 75 градусов, согласуются в рамках трехслойной модели. С использованием дополнительных измерений оптического пропускания, атомносиловой и интерферометрической микроскопии, определены с высокой точностью n и k спектры, толщина и шероховатость графитизированных слоев.
5.4.Оптические свойства наноструктурированных пленок a-C:H:Si.
аВ {70} показана эффективность использования СЭ в комплексе с Рамановской спектроскопией, атомносиловой микроскопией и измерениями фотопроводимостиа для определения свойств пленок микрокристаллического (ic-Si:H) и аморфного (a-Si:H),а полученных методома PECVD при низких температурах и отожженных при различных температурах в диапазоне 300-600? C. Спектры действительной и мнимой частей псевдодиэлектрическойа функции, аизмеренные на СЭ в области 270-1100 нм анализируются с помощью аппроксимации эффективной среды Бруггемана ( BEMA). Удовлетворительное описание экспериментальных СЭ спектров обеспечивает введение подповерхностного слоя толщиной 30-40 нм с относительно высоким (15-20%) содержанием пустот. В соответствии с данными СЭ главным эффектом отжига пленок было уменьшение толщины и /или концентрации пустот подповерхностного слоя без заметного изменения свойств поверхностного слоя.аа
Во всем спектральном диапазоне наблюдалось полное совпадение спектров пропускания, измеренных и рассчитанных с использованием спектров n(?) и k(?).Показатель преломления по своей величине и спектральной зависимости в целом совпадал с данными для пленок a-C::H:Si, осажденных при низких содержаниях тетраметилсилана в метане [30], тогда как рост коэффициента экстинкции с уменьшением длины волны в наших пленках был выражен слабее, чем в образцах из работы [30].
В разделе5.5 диссертации показаны результаты исследования оптических свойств тонких аал-мазных пленок, осажденных с использованием прекурсора - поли (нафтилгидрокарбина) {71}.
Раздел 5.6 представляет аСЭ измерения алмазоподобных пленок на Cu {21}.
Оптические и фотоэлектрические свойстваа напыленных и отожженных PECVD пленок поликристаллического кремния {16,55} отражены в разделе 5.7.
В разделе 5.8. показана эффективность СЭа исследования SIMOX структур.
Спектроэллипсометрические исследования тонких композитных слоев GaAs-MnAs и ферромагнитных слоева InMnAs {22,23,26,27} представлены в разделе 5.9 диссертации.
аГава 6. азерная иа светодиодная эллипсометрия с бинарной модуляцией состояния поляризации в сенсорных устройствах.
Нами разработан компактный и скоростной эллипсометр (Рис.6.1.), работающий по следующей схеме: пучки двух идентичных светодиодов попеременно поступают на клин из кальцита (или призму Волластона) так, чтобы ортогонально поляризованные пучки от светодиодов совмещались в один и направлялись на образец под углом, например, 70 градусов. Отраженные пучки проходята через второй клин (или призму Волластона) и направляются на два идентичных фотодиода. Измеряются отношения интенсивностей на фотодиодах при последовательном включении светодиодов и определяются эллипсометрические параметры ? и ?. Скорость измерений ограничивается инерционностью фотоприемников и временем преобразования АЦП. Для светодиода с длиной волны излучения 620 нм получены рекордные для эллипсометрии значения для точности по воспроизводимости (precision): 2х10-5? для ? ааиа 3х10-4? для ?. Такие крайне простые и дешевые малогабаритные эллипсометры с бинарной модуляцией состояния поляризацииаа удобны для картографирования, исследования кинетики различных процессов и применений в сенсорных устройствах.

а аРис. 6.1.
На Рис.6.2 показано, кака с увеличением концентрации паров гексана толщина сенсорной пленки меняется от 435 до 525 нм. Наблюдается хорошее соответствие с рассчитанной номограммой. При этом разрешение по толщине лучше 0,01 нм.
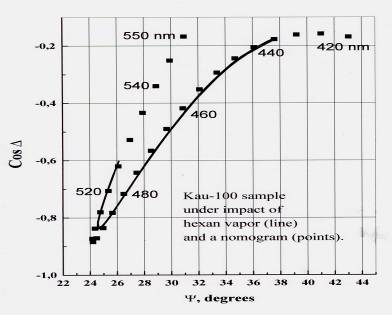
Рис. 6.2.
В ряде работ используется одновременно в условиях in situа микромеханические кантилеверы
и эллипсометрияа в качестве сенсорных устройств[15]. Эллипсометрияа обеспечивает измерение толщины молекулярного слоя с точностью 0,1 нм и поверхностное напряжение в разрешением 5х10 -5 Н/м. В таких задачах решающее значение имеет чувствительность эллипсометра.
В заключенииа сформулированы основные результаты работы, которые состоят в следующем:
- Показаны перспективы предложенного и последовательно развиваемого автором нового направления в эллипсометрии - эллипсометрии с бинарной модуляцией состояния поляризации, которые определяются быстро растущими требованиями к техническим параметрам современных эллипсометров. Например, высокое отношение с/ш в спектральных отображающих (imaging) эллипсометраха с высоким латеральным разрешением достигается максимально возможным временем интегрирования в условиях наивысшей чувствительности. Эллипсометрия с БМ хорошо подходит, в отличие от эллипсометров с вращающимися поляризационными элементами и эллипсометров с фазовыми модуляторами, для этих целей.
- Предложены и экспериментально отработаны различные методы измерений с бинарной модуляцией состояния поляризации. Каждый из них имеет специфические преимущества.
- Разработана новая элементная база поляризационной оптики.
- Разработано и создано семейство автоматических лазерных, светодиодных и спектральных эллипсометров нового поколения, не содержащих движущихся поляризационныха элементов.
- На основе созданных спектральных эллипсометров выполнен цикл исследований оптических свойств полупроводниковых и диэлектрических материалов и структура и жидкостей. Показана информативность метода эллипсометрии с бинарной модуляцией и высокое качество развитого программного обеспечения.
- Продемонстрированы большие потенциальные возможности сенсорных устройств с использованием малогабаритных надежных светодиодных эллипсометров.а
а ааВа процессе выполнения работы в полной мере решены все поставленные задачи. Вышеперечисленные основные результаты составляют прочную основу дальнейшего успешного развития эллипсометрии с бинарной модуляцией состояния поляризации.
Отметим появление сообщений о реализации поляризационных устройств с бинарной модуляцией. В ИФП РАН (Новосибирск) в 2005г. предложен эллипсометр с коммутирующими поляризационными элементами. В период с 2005 по 2008 г. в MIT (Boston) создан дихрометр-микроскоп с использованием двух светодиодов с длиной волны 280 нм [20]. В [29] предложен метод измерения двулучепреломления с использованием двух лазеров с ортогональными поляризациями. Однако еще с 1994 г. в университете Suffolk (Boston) работает наш прецизионный эллипсометр с двумя лазерными диодами для решения более сложных задач. Для иллюстрации приведены некоторые публикации нескольких коллективов авторов из США а[23-27] со ссылками в тексте на успешное использование изготовленных нами лазерных эллипсометров с БМ. Область применений переключения ортогонально поляризованных пучков стремительно расширяется в различных областях науки и техники. Следует ожидать растущий интерес и к эллипсометрии с БМ.а На ЗАО Концерн Наноиндустрия, Москва начато серийное производство спектральных эллипсометров с бинарной модуляцией состояния поляризации (Приложение 1 в Диссертации).а
Основные результаты диссертационной работы опубликованы в следующих работах:
- Огрин Ю.Ф., Луцкий В.Н., Арифова М.У., Ковалев В.И., Сандомирский В.Б., Елинсон М.И. Температурная зависимость электропроводности и эффекта Холла в квантово-размерных пленках. Письма ЖЭТФ, 1967, т.53, в.4(10), с. 1218-1224.
- Огрин Ю.Ф., Ковалев В.И.а Электромеханический метод фазовой модуляции излучения. Радиотехника и электроника, 1970, т.15, в.4,с. 851.
- Ковалев В.И., Елинсон М.И., Габучян В.М., Шульженко М.П. Определение электрофизических параметров сильно легированных полупроводников методом псевдоугла Брюстера. Микроэлектроника,1976, т.5,а с.76-78.
- Елинсон М.И., Ковалев В.И., Россуканый Н.М., Шаповалов В.И., Габучян В.М., Шульженко М.П. Автоматическая эллипсометрическаяа установка. Электронная промышленность, 1982, Вып.10-11 (116-117), с. 100-102.
- Габучян В.М., Шульженко М.П., Лобзин С.Е., Ковалев В.И. Метод и устройство для измерения концентрации свободных носителей заряда. Электронная техника. Сер. 8. Управление качеством, стандартизация, метрология, испытания, 1982, вып. 1(93)-2(94), с. 93-94.
- Васильев Н.Н.,а Ковалев В.И.а Универсальный автоматический эллипсометр . Электронная промышленность,а №7, 1991,с. 29-30.
- Kovalev V.I., Rukovishnikov A.I., Rossukanyi N.M., Perov P.I. New high precision and high speed automatic ellipsometer with polarization switching for in situ control in semiconductor device technologies. Physics of Semiconductor Devices ( New Delhi:Tata McGraw-Hill), 1991, pp. 244-249.
- Perovа P.I., Kovalev V.I., Rukovishnikov A.I., Rossukanyi N.M. and Johnson W.H. Hydrogen-sensitive palladium film study with precise and fast ellipsometers . Int. J. Electronics.1994, v. 76, n.5, с. 797-803.
- Ковалев В.И., Руковишников А.И., Перов П.И., Россуканый Н.М., Авдеева Л.А. Разработка оптических методов и аппаратуры для контроля технологии и параметров полупроводниковых структур нано - и микроэлектроники.аа Радиотехника и электроника, 1999, т.44, №11,с.1404 -1407.
- Климов В.В., Ковалев В.И., Крапивин В.Ф., Мкртычан Ф.А., Руковишников А.И.а Адаптивная информационная система для экологического мониторинга водной среды. Вопросы радиоэлектроники, серия Общетехническая, 2002, в.2, с. 88-91.
- Ковалев В.И., Кузнецов П.И., Житов В.А., Захаров Л.Ю., Руковишников А.И., Хомич А.В., Якущева Г.Г., Гапоненко С.В. Спектральная эллипсометрияа многослойных гетероструктур ZnS-ZnSe. Журнал прикладной спектроскопии, 2002, т. 69, c. 258-263.
- Kuznetsov P. I., Yakushcheva G.G.,а Kovalev V.I., Ermolenko M.V. Optical properties of multilayer heterostructures based on ZnSe/ZnS. In УPhysics, Chemistry, and Application of NanostructuresФ, World Scientific, 2003 p. 102-106.
- Ковалев В.И., Руковишников А.И. Компактный многоканальный спектроэллипсометр. Приборы и техника эксперимента, 2003, с.164-165.
- Ковалев В.И., Руковишников А.И.. Импульсный спектральный эллипсометр с бинарной модуляцией состояния поляризации. Приборы и техника эксперимента, 2003,с.162-163.
- Leontyev A.V., Kovalev V.I., Khomich A.V., Komarov F.F., Grigoryev V.V., Kamishan A.S. PMMA and polystyrene films modification under ion implantation studied by spectroscopic ellipsometry. Proceedings SPIE, 2004, v.5401, p. 129-136.аа
- Кhomich A.V., Kovalev V.I., Vedeneev A.S., Kazanskii A.G., Forsh P.A., He D., Wang X.Q., Mell H., Vlasov I.I., Zavedeev E.V. Optical and photoelectrical characterization of as-deposited and annealed PECVD polysilicon thin films.а Proceedings SPIE, 2004, v.5401, p. 200-207.
- Komarov F.F., Leontyev A.V., Khomich A.V., Kovalev V.I. The formation of dielectric microwaveguides at the system polymer/SiO2/Si by using of ion irradiation. Vacuum, 2005, v. 78, p. 617-622.
- Khomich A.V., Kovalev V.I., Zavedeev E.V., Khmelnitskiy R.A., Gippius A.A. Spectroscopic ellipsometry study of buried graphitized layers in ion implanted diamond. Vacuum, 2005, v. 78, p. 583-587.
- Mkrtchan F.A.,.Krapivin V.F., Kovalev V.I., Klimov V.V.Rukovishnikov A.I., Nguen Si Hong, Bui Cuok Nghia. Adaptive Spectroellipsometric Technology for the Precise Real-Time Monitoring of the Water Systems. Environmental Informatics and Education, №6, 2006, рр.124-130.
- Mkrtchyan F.A.,Krapivin V. F.,Kovalev V. I.,Klimov V.V. An adaptive spectroellipsometric technology for ccological monitoringof sea water. PICES Scientific Report,2006,No.36,pp.215-218.
- Иовдальский В.А., Пелипец О.В., Зубков Н.П., Ковалев В.И. Исследование состава алмазоподобных пленок углерода, используемых в изделиях микроэлектроники. Электронная техника. Сер. 1. СВЧ-техника, 2007,а в.а 1а (489), с.70-78.
- Вихрова О.В., Данилов Ю.А., Демидов Е.С., Звонков Б.Н., КовалевВ.И.,а Кунькова З.Э.а и др. Ферромагнетизм в напыленных лазером GaMnAs слоях.аа Известия РАН, сер. Физическая, 2007, т. 71, №1, с. 37-39.
- Ганьшина Е.А., Голик Л.Л., Ковалев В.И., Кунькова З.Э., Вашук М.В., Вихрова О.В., Звонков Б.Н., Сафьянов Ю.Н., Сучков А.И. Оптическая и магнитооптическая спектроскопияа тонких композитных слоёв GaAs-MnAs, Известия РАН, сер. Физическая, 2008, т.72, №2, с. 176-179.
- Самарцев И.Э., Крапивин В.Ф., Ковалев В.И., Ковалев С.В., Потапов И.И.а Экономическая эффективность технологии гибких информационно - моделирующих систем в задачах мониторинга окружающей среды. Экономика природопользования, 2009, №1, с. 88-100.
- Фролов В.Д., Герасименко В.А., Кононенко В.В., Пименов С.М., Хомич А.В., Ковалев В.И.,аа Кирпиленко Г.Г., Шелухин Е.Ю. Оптические свойства наноструктурированныха пленока а-С:Н:Si. Российские нанотехнологии, 2009, т.4 , № 5-6, с. 138-143.
- аGanТshina E.A., Golik, L.L., Kovalev V.I., KunТkova Z.E., Temiryazeva M.P., Danilov Yu.A., Vikhrova O.V., Zvonkov B.N., Rubacheva A.D., Tcherbak P. N., Vinogradov A.N.,Zhigalina O.M., Resonant enhancement of the transversal Kerr effect in the InMnAs layers. J. Phys.: Condens. Matter 22, 2010, 396002 (9pp) doi:10.1088/0953-8984/22/39/396002
- GanТshina E.A., Golik L.L., Kovalev V.I., KunТkova Z.E., Temiryazeva M.P., Danilov Yu.A.,Vikhrova O.V.,Zvonkov B.N.,On nature of resonant transversal Kerr effect in InMnAs and GaMnAs layers.Solid State Phenomena, 2011, Vols.168-169, p.35-38. Online available since 2010/Dec/30 at www.scientific.net
- Mkrtchyan F. A., Krapivin V. F., Kovalev V. I., and Klimov V. V. An adaptive spectroellipsometer for ecological monitoring," Microwave and Optical Technology Letters, 2009, Vol. 51, No. 11, pp.2792-2795.
- Ковалев В.И., Елинсон М.И., Игнатов Б.Г., Перов П.И., Габучян В.М. Поляризационный интерферометр - модулятор. А.С. №771601.1980. Пр.14.7.1978.
- Габучян В.М., Шульженко М. П., Лобзин С.Е., Кирсанов Н.С., Ковалев В.И. Устройствоа для бесконтактного измерения параметров планарно- эпитаксиальных структур.а А.С.№687925. 1979.
- Ковалев В.И., Елинсон М.И. Способ эллипсометрических измерений.А.С. №1288558. 1985. Пр.20.04.1983.Оп. 7.02.1985.Б.И. №5.
- Ковалев В.И., Елинсон М.И., Перов П.И. Эллипсометр. А.С.№1160810.- 1985. Пр. 20.04.1983.
- Ковалев В.И.а Спектральный эллипсометр. А.С.№1369471. 1988.а Пр. 28.02.1986.
- Ковалев В.И., Эллипсометр. А.С.№ 1695145 . 1989. Пр. 3.08.1988.
- Ковалев В.И., Россуканый Н.М. Ахроматическоеа фазосдвигающее устройство. А.С.№1337860.1987.Пр.27.02.1986.
- Ковалев В.И.а Эллипсометр. Патент Россииа № 1695145. Зарегистрирован 10.01.1996г.
- Ковалев В.И., Елинсон М.И., Габучян В.М., Шульженко М.П. Двухлучевой эллипсометр на основе Не- Ne лазера ЛГ-126. Тезисы докладов 1 Всесоюзной конференции по эллипсометрии.а Новосибирск.1977, с.73.
- Kovalev V.I., Elinson M.I., Karnaukhov V.A., Potapov V.T. Optical method investigations of structures used in the linear integral circuit production. Proceedings of the International Simposium on Reliability of microelectronic devices. Berlin. 1978. p. 62-65.
- Kovalev V.I., Elinson M.I. Polarization optical device for the investigation ofа microelectronic structures. IV International Conference У Mikronika-79. Abstracts.p.112, 20-22 November 1979. Warszawa.
- Ковалев В.И., Елинсон М.И., Игнатов Б.Г., Россуканый Н.М., Тужиков А.В. Эллипсометр-гониофотометр для экспрессного определения параметров материалов микроэлектроники. Тезисы докладова 1 Всесоюзной школы - семинара л Проблемы функциональной микроэлектроники Горький. 1980. С.31.
- Ковалев В.И., Елинсон М.И., Габучян В.М. Исследование кремниевых структур методами эллипсометрии с поляризационной модуляцией. Тезисы докладов наа 9 Всесоюзной научно-технической конференции по микроэлектронике. Казань. 1980 , С. 28.
- Ковалев В.И., Габучян В.М., Елинсон М.И., Россуканый Н.М. Эллипсометр с дискретной модуляцией состояния поляризации для экспрессных измерений в видимой и ИК области области спектра.2 Всесоюзная конференция по эллипсометрии. Новосибирск, 1981, с. 120.
- Шаповалов В.И., Лискин Ю.Ф., Просвирников В.В., Ковалев В.И.,а НикитенкоН.Д., Петрова И.М. Исследование деградационных процессова в контактной области герконов.аа Всеcоюзная научно-техническая конференция л Специальные коммутационные элементы,19-21 сентября 1984 , Рязань, с.26.
- Россуканый Н.М., Ковалев В.И., Елинсон М.И. ИК - эллипсометр на основе СОа и СО2 лазеров. Всесоюзная Конференция по эллипсометрии. Новосибирск. 1985. с. 96.
- Ковалев В.И., Габучян В.М., Елинсон М.И. Эллипсометрия с дискретной модуляцией состояния поляризации. Всесоюзная Конференция по эллипсометрии. Новосибирск. 1985, с.87.
- Ковалев В.И., Россуканый Н.М.,Руковишников А.И. Эллипсометрия с дискретной модуляцией состояния поляризации - эффективный метод исследования электронных структур. Тезисы докладов на ежегодном Совещании общества Попова,4.10.1986,с. 31.
- Ковалев В.И., Елинсон М.И., Руковишников А.И. Автоматические эллипсометры для исследования материалов и структур микроэлектроники. Тезисы докладов на I Всесоюзной конференции л Физические и физико-химические основы микроэлектроники Вильнюс.1987. С. 174-176.
- Скоростной автоматический эллипсометр с бинарной модуляцией состояния поляризации для картографирования и исследований in situ. Сборник достижений АН СССР. 1989, с.27.
- Ковалев В.И., Руковишникова А.И. Малогабаритный автоматический эллипсометр для исследований in situ. Всесоюзная конференция л Поверхность 89 Черноголовка,4-6 июля 1989, с. 155.
- Kovalev V.I., Perov P.I., Rukovishnikov A.I.,Rossukanyi N.M., Perov P.I., Johnson W.H. and Driscoll J.N. Novel polarization-optical technique and devices for fast and pricise characterization of thin films for chemical sensors, MRS Fall Meeting,а 1994. p. 43.
- Ковалев В.И., Руковишников А.И., Хомич А.В. Применение спектральной эллипсометрии с бинарной модуляцией состояния для исследования ионно-имплантированных структур. Труды Международной конференции л Взаимодействие излучения са твердым телом - ВИТТ-2003, Минск, Беларусь,8-10 октября, с. 365-367.
- Ковалев В.И., Леонтьев А.В., Хомич А.В. Спектральная эллипсометрия пленок ПММА и полистирола, облученных ионами азота. - ВИТТ-2003,Минск, Беларусь, 8-10 октября, с. 262-264.
- Заведеев Е.В., Хмельницкий Р.А., Хомич А.В., Ковалев В.И. Островковая графитизация в алмазах, имплантированных водородом и дейтерием. Труды Международной конференции л Взаимодействие излучения са твердым телом - ВИТТ-2003, Минск, Беларусь,8-10 октября, с. 262-264.
- Leontyev A.V., Kovalev V.I., Khomich A.V., Komarovа F.F. PMMA and polysterene films modification under ion implantation studiesd by spectroscopic ellipsometry. - Internationalа Conference УMicro- and Nanoelectronics -2003Ф,Москва-Звенигород, 6-10 октября ,-с. Р1-26.
- Khomich A.V., Kovalev V.I., Vedeneev A.S., Kazanskii A.G., Forsh P.A., He D., Wang X.Q., Mell H.Optical and photoelectrical characterization of as-deposited and annealed PECVD polysilicon thin films.-International Conference У Micro- and Nanoelectronics -2003Ф, Москва-Звенигород, 6-10 октября, с. Р1-27.
- Kovalev V.I.,Rukovishnikov A.I., Khomich A.V. Advanced capabilities of binary modulation polarization ellipsometry. - - Internationalа Conference УMicro- and Nanoelectronics -2003Ф ,Москва-Звенигород, 6-10 октября , с. 1-4.
- Mkrtchan F.A., Krapivin V.F., Kovalev V.I., Klimov V.V.,Rukovishnikov A.I., Golovachev S.P. An adaptive spectroellipsometric technology for the ecological monitoring of the aquatic environment. Proceeding of 25-th ACRS, Chiang-Mai, Thailand, 2004, pp. 13-15.
- Mkrtchan F.A., Krapivin V.F., Kovalev V.I., Klimov V.V. Spectroellipsometric technology for ecological monitoring of the aquatic environment. / Proceedings of the First Mediterranean Photonics Conference, 25-28 June 2008, Ischia, Napoli, Italy, pp. 333-335.
- Klimov V.V., Kovalev V.I., Krapivin V.F., Mkrtchan F.A., УAn expert system to diagnose pollutant spills in the water surfaceФ, Proceedings of the 12-th Conference on Control Systems and Computer Science, Bucharest, May, 1999, pp. 277-283.
- Mkrtchan F.A., Krapivin V.F., Kovalev V.I., Klimov V.V., Golovachev S.P.An Adaptive Polarization Optics Technology for Ecological Monitoring of the Aquatic Envirenment. Proceedings of the International Symposium PIERS 2006-TOKYO (Progress In Electromagnetics Research Symposium), August 2-5, 2006, Tokyo, Japan, pp. 1886-1891.
- Мкртчян Ф.А., Климов В.В., Ковалев В.И. Экологический мониторинг водной среды на базе адаптивного идентификатора. Материалы седьмого международного симпозиума л Проблемы экоинформатики . Москва, 7-9 декабря, 2006, с.171-175.
- Kovalev V.I., Rukovishnikov A.I., Khomich et al. Spectroscopic ellipsometry based on binary modulation polarization for thin film structure study. Proceedings of International conference УModern problems of Condensed Matter - 2007Ф, Kiev, Ukraine, 2-4 October 2007, p. 247-248.
- Mkrtchan F.A., Krapivin V.F., Kovalev V.I., Klimov V.V. Spectroellipsometric adaptive identifier For ecological monitoring of the aquatic environment. Proceedings of the 22-th International Symposium on Okhotsk Sea& Sea Ice.18- 23а February 2007, Mombetsu, Hokkaido, Japan, pp.30 -32.аа
- аMkrtchan F.A., Krapivin V.F., Klimov V.V., Kovalev V.I. Spectroellipsometric Adaptive Identifier for the Ecological Monitoring Water Envirenment. Book of Proceedings 11 International Symposiumа on Microwave and Optical Technology ( ISMOT 2007). Monte Porzio Catone, Italy, 17-21 December, 2007, pp. 385-388.
- Крапивин В.Ф., Ковалев В.И., Климов В.В., Мкртчян Ф.А., Потапов И.И. Спектроэллипсометрическая технология для контроля качества воды. Экология производства,2005,№8, с. 38-41.
- Крапивин В.Ф., Климов В.В., Мкртчян Ф.А., Ковалев В.И. Возможности СВЧ-радиометрии и спектроэллипсометрии в мониторинге водных систем. В Сборнике Фундаментальное исследованиеа океанов и морей,а 11 том, л Наука, Москва, 2006, с. 512-531.
- Ковалёв В.И., Мадонов А.В., ЛазаревА.В., Руковишников А.И.,Ковалев С.В. Многоканальные спектроэллипсометры и некоторые особенности их программного обеспечения. Матер. YIII Межд. Симпозиума Проблемы экоинформатики 16-17 декабря 2008г. Москва, с.141-146.а
- Ганьшина Е.А., Голик Л.Л., Ковалев В.И., Кунькова З.Э., Звонков Б.Н., Виноградова А.Н. Оптическая и магнитооптическая спектроскопия тонких ферромагнитных слоёв InMnAs, ХII Международный симпозиум Нанофизика и наноэлектроника, Сборник трудов, Нижний Новгород, 2008, т.2, с. 273-274.
- Ковалев В.И. Руковишников А.И. Ковалев С.В. Хомич А.А. Исследование планарных кремниевых и алмазных структур методом спектральной эллипсометрии с дискретной модуляцией состояния поляризации. Химия твердого тела: монокристаллы, наноматериалы, нанотехнологии. 9 Мееждународная научная конференция. Кисловодск, 16 октября 2009 г. Ставрополь.с. 162-164.
- KovalevV.I., KhomichA.V., Ralchenko V.G., et al. Variable-angle spectroscopic ellipsometry studies of amorphous a-C:H:Si and ultrananocrystalline CVD diamondа films for MEMS. Proceedings of ICMNE-2007, p. D5.
- Булычев Б.М., Генчель В.К., Звукова Т.М., Сизов А.И., Александров А.Ф.,а Коробов В.А.,а Большаков А.П., Герасименко В.А., Канзюба М.В., Седов В.С.,а Совык Д.Н., Ральченко В.Г.,а Ковалев В.И.,а Хомич Ф.В. Синтез и оптические свойства тонких алмазных пленок, осажденных с использованием прекурсора-поли (нафтилгидрокарбина). XV Международная научно-техническая конференцияФ Высокие технологии в промышленности России XXII Международный симпозиум У Тонкие пленки в электроникеФ. Сборник трудов. Москва, 2009, с.440-446.
- Krapivin V.F., Mkrtchan F.A., Kovalev V.I., Klimov V.V. An adaptive system to identify the spots of pollutants on the water surface. Материалы VIII Международного симпозиума. Проблемы экоинформатики. Москва.16-17 декабря 2008. с.35-46.
- Ковалев В.И., Габучян В.М., Елинсон М.И.,Гришин В.П.,Смородин И.Н.,Пантин А.Н.,Козакова Н.И. Эллипсометрия с дискретной модуляцией состояния поляризации. Сборник л Эллипсометрия в науке и технике Новосибирск, Наука.1987.с.43-49.
- Ковалев В.И., Руковишников А.И., Бондаренко А.А., Васильев Н.Н., Габучян В.М.,Россуканый Н.М.,Тихомиров Н.А. Автоматические эллипсометрыаа дляаа научныхаа исследованийаа иаа технологии. Сборник Эллипсометрия в науке и технике. Новосибирск, Наука. 1990, с. 68-72.
аСписок цитируемой итературы
[1].Azzam R.M.A.,Bashara N.M.,Ellipsometry and Polarized Light,North-Holland,Amsterdam,1977.
[2]. Fujiwara H., Spectroscopic Ellipsometry: Principles and Applications, New York, Wiley, 2007.
[3].Tompkins H.G., Irene E.A. Handbook of ellipsometry, William Andrew/Springer. 2005.
[4] Potter R.F. Applied Optics, 1965, vol.4, p. 53.
[5].Запасский В.С., Феофилов П.П. Развитие поляризационной магнитооптики парамагнитных кристаллов. Успехи Физических наук, 1975, т.116, в.1, 41-78.
[6] Jasperson S. N. and Schnatterly S. E. An improved method for high reflectivity ellipsometry based on a new polarization modulation technique, Rev. Sci. Instrum., 1969,40,761Ц767.
[7] Aspnes D. E.,Studna A. A high precision scanning ellipsometer, Appl. Opt.,1975, 14, 220Ц228.
[8] Drevillon B., Perrin J., Marbot R. et al. Fast polarization modulated ellipsometer using a microprocessor system for digital Fourier analysis, Rev. Sci. Instrum.,1982, 53 ,969Ц977.
[9] Roseler A., Spectroscopic ellipsometry in the infrared, Infrared Physics, 1981, 21,349Ц355.
[10] Zangooie S., Schubert M., Thompson D. W., and Woollam J. A. Infrared response of multiple-component free-carrier plasma in heavily doped p-type GaAs, Appl. Phys. Lett., 2001,78 , 937Ц939. [11]а Arwin H., Askendahl A., Tengvall P., Thompson D.W., Woollam J.A. Infraredаа ellipsometry studies of thermal stability of protein monolayers and multilayers.-Phys. stat. sol., (c) 5, No. 5, 2008, p. 1438-1441.
[12] Hilfiker J. N., Bungay C. L., R. A. Synowicki R. A., Tiwald T. E., Herzinger C. M., Johs B., K. Pribil G. K. and Woollam J. A., Progress in spectroscopic ellipsometry: Applications from vacuum ultraviolet to infrared, J. Vac. Sci. Technol. A, 2003, 21, 1103Ц1108.
[13] Meng Y.H., Chen S., Jin G. An auto-focusing method for imaging ellipsometry system.-Phys. stat. sol., (c) 5, No. 5, 2008, p. 1046-1049.
[14]Meng Y.H., Chen Y.Y., Qi C.,et al. An automatic imaging spectroscopic ellipsometer for characterization of nano-film pattern on solid substrate. -Phys. stat. sol., (c) 5, No. 5, 2008, p. 1050-1053.
[15 ].Godin M., Laroche O., Tabard-Cossa V., Beaulieu L.Y.,Grutter P.,Williamsа P.J. Combined in situ micromechanical cantilever-based sensing and ellipsometry.Review of Sci. Instr., 2003, vol. 74,n.11, 4902-4907.
[16]Abraham M. and Tadjeddine A. The influence of plasma waves on the dispersion of surface plasmons: experimental evidence. J. Physique , 1987, 48, 267-275.
[17]а Azzam, R. M. A., Binary polarization modulator: a simple device for switching light polarization between orthogonal states.Optics Letters, Vol. 13, Issue 9, pp. 701-703 (1988)
[18]а Azzam, R. M. A., Polarization Michelson Interferometer (POLMINT) as a Global Polarization State Generator and for Measurement of the Coherence and Spectral Properties of Quasi- Monochromatic Light, Rev. Sci. Instrum.,1993, 64, 834-838.
[19]Azzam, R.M.A., Polarization Michelson Interferometer (POLMINT): Its Use for Polarization Modulation and Temporal Pulse Shearing, Opt. Commun.,1993, 98, 19-23.
[20] Zeskind BJ, Jordan CD, Timp W., Trapani L, Waller G, Horodincu V, Ehrlich DJ, and Matusudaira P. Nucleic acid and protein mass mapping by live-cell deep-ultraviolet microscopy. Nature Methods, 2007, 4(7), 567-569.
[21] Karageorgiev P.,Orendi H.,Stiller B., Brehmer L. Appl. Phys. Lett. 2001, 79, 1730Ц1732.
[22] Callegaro L.,Puppin E. Lasers and light-emitting diodes as sources for fixed-wavelength magneto-optical phase modulated ellipsometry. Rev. Sci. Instrum., 1995, Vol. 66, No. 11, 5375-5376.
[23] аFeresenbet E., Raghavan D., Holmes G. A. The influence of silane coupling agent composition on the surface characterization of fiber and on fiber-matrix interfacial shear strength.
The Journal of Adhesion. 2003, [24] Sidorenko A., Zhai X. W., A. Greco A., and Tsukruk V. V. Hyperbranched Polymer Layers as Multifunctional Interfaces.а Langmuir, 2002, 18, 3408-3412.
[25]. Reukov V.,Vertegel A., Burtovyy A., Kornev K, Luzinov I and Paul Miller. Fabrication of nanocoated fibers for self-diagnosis of bacterial vaginosis. [26]. Bonhomme G., LeMieux M., Weisbecker P. et al. Oxidation kinetics of an AlCuFeCr approximant compound: an ellipsometric study. Journal of Non-Crystalline Solids, 2004, [27] LeMieux M. C., Peleshanko S., Anderson D., K., and V. V. Tsukruk V. V. Adaptive Nanomechanical Response of Stratified Polymer Brush Structures. Langmuir, 2007, 23, 265-273.
[28] аalexandria.tue.nl/extra2/200213830.pdf J-Charles Cigal. [29] Mackey Jeffrey R, Salari Ezzatollah and Tin Padetha. Optical material stress measurement using two orthogonally polarized sinusoidally intensity-modulated semiconductor lasers. Meas. Sci. Technol. 2002, 13, 179Ц185.
[30]. Zhang X., Weber W.H., Vassell W.C., Potter Y.J., Tamor M.A. ааOptical study ofа silicon-con- taining amorphous hydrogenated carbon. J. Appl. Phys. 1998. V.83. P. 2820.
 Авторефераты по всем темам >>
Авторефераты по техническим наукам
Авторефераты по всем темам >>
Авторефераты по техническим наукам
