 Авторефераты по темам >>
Разные специальности - [часть 1] [часть 2]
Авторефераты по темам >>
Разные специальности - [часть 1] [часть 2]
Управление локализацией электронов в полупроводниковых гетероструктурах
Автореферат кандидатской диссертации
На правах рукописи
АЛЕЩЕНКО Юрий Анатольевич
УПРАВЛЕНИЕ ЛОКАЛИЗАЦИЕЙ ЭЛЕКТРОНОВ В ПОЛУПРОВОДНИКОВЫХ ГЕТЕРОСТРУКТУРАХ
Специальность 01.04.07 - Физика конденсированного состояния
А в т о р е ф е р а т
диссертации на соискание ученой степени
доктора физико-математических наук
Москва
2012
Работа выполнена в Федеральном государственном бюджетном учреждении науки Физическом институте им. П.Н. Лебедева
Российской академии наук
Официальные оппоненты: аа доктор физико-математических наук,
профессор Горелик Владимир Семенович
Физический институт им. П.Н. Лебедева
РАН
а доктор физико-математических наук,
профессор Елесин Владимир Федорович
Национальный исследовательский
ядерный университет МИФИ
а доктор физико-математических наук,
профессор Воробьев Леонид Евгеньевич
Санкт-Петербургский государственный
политехнический университет
Ведущая организация: Федеральное государственное бюджетное
учреждение науки Институт общей
физики им. А.М. Прохорова
Российской академии наук
Защита состоится л22 октября 2012 г. в 12.00 часов на заседании Диссертационного аасовет Д 002.023.03аа приаа Физическомаа институтеаа им. П.Н. Лебедева Российской академии наук по адресу: 119991 Москва, Ленинский проспект, 53.
С диссертацией можно ознакомиться в библиотеке Физического института им. П.Н. Лебедева Российской академии наук.
Автореферат разослан л_____ ___________ 2012 года
Учёный секретарь
диссертационного совета Д 002.023.03
доктор физико-математических наук,
профессор А.С. Шиканов
а
ОБЩАЯ ХАРАКТЕРИСТИКА РАБОТЫ
Актуальность темы. Физика полупроводниковых гетероструктур в настоящее время является одним из наиболее динамично развивающихся направлений физики твердого тела [1,2]. Достижения в этой области стали возможными благодаря успехам технологии, прежде всего методов молекулярно-лучевой эпитаксии (МЛЭ) и литографии высокого разрешения. Эти методы позволяют создавать совершенные монокристаллические полупроводниковые слои и многослойные гетероструктуры с толщиной слоев 1Ц10 нм, сравнимой с длиной волны де Бройля носителей заряда, что открывает принципиальную возможность наблюдения и использования явлений, обусловленных волновой природой электрона. К ним, в частности, относится интерференция электронных волн и вызванные ею так называемые размерные квантовые эффекты, такие, например, как квантование энергии электронов в тонких слоях, резонансный характер прохождения электронов через эти слои и т.д. На основе гетероструктур с квантово-размерными слоями (наноструктур) создан широкий круг приборов опто- и наноэлектроники, среди них полупроводниковые лазерные диоды с квантовыми ямами (КЯ) и квантовыми точками (КТ) в качестве активной области; транзисторы с высокой подвижностью электронов двумерного электронного газа, локализованного вблизи гетерограницы; резонансно-туннельные диоды; фотоприемники и светоизлучающие приборы на основе межзонных и межподзонных переходов в квантово-размерных слоях. К наивысшим технологическим достижениям в области квантовых приборов следует, несомненно, отнести создание квантового каскадного лазера группой исследователей из Bell Laboratories (США) под руководством Ф. Капассо [3]. В основу этого прибора легли идеи о возможности оптического усиления при переходах между квантованными электронными состояниями в структуре с множественными КЯ в сильном электрическом поле, высказанные в 1971 году российскими учеными Р.Ф. Казариновым и Р.А. Сурисом [4]. Параметры этих приборов в значительной степени определяются энергетическим спектром и волновыми функциями (ВФ) уровней размерного квантования, распределением электронной плотности по толщине структуры (т.е., локализацией электронной ВФ), а также темпами эмиссии и захвата носителей заряда на уровни размерного квантования.
Диссертационная работа, посвященная исследованию возможностей управления локализацией электронной волновой функции в полупроводниковых гетероструктурах, является актуальной как с научной, так и с практической точек зрения.
Целью работы является исследование возможностей управления локализацией электронной волновой функции в полупроводниковых гетероструктурах, разработка методов диагностики локализации волновой функции, исследование физических эффектов, связанных с локализацией электронной волновой функции в квантово-размерных структурах с различными видами несовершенств, разработка принципов создания приборов, основанных на управлении локализацией электронной волновой функции.
Объекты и методы исследования. В качестве объектов исследования были выбраны полупроводниковые гетероструктуры с квантовыми ямами на основе системы GaAs/AlGaAs, выращенные методом молекулярно-лучевой эпитаксии. Основными методами исследования в данной работе являлись методы спектроскопии вторичного излучения - комбинационного рассеяния (КР) света и фотолюминесценции (ФЛ), - дающие информацию об электронной и фононной подсистемах исследуемых материалов и обладающие высоким пространственным разрешением, определяемым диаметром сфокусированного лазерной пучка на поверхности образца.
Научная новизна работы состоит в следующем:
- С помощью спектроскопии резонансного КР подтверждена теоретически предсказанная возможность локализации электронных состояний в барьерах сверхрешеток GaAs/AlGaAs, проявляющаяся в спектрах как резонансное селективное усиление GaAs- и AlAs-подобных LO мод барьеров AlGaAs, формирование их обертонов и составных частот. Обнаружен эффект передислокации электронных возбуждений из барьеров в квантовые ямы при сужении барьеров. В этом случае селективно усиливается LO мода КЯ GaAs, проявляются ее обертоны, а при сопоставимых относительных вероятностях нахождения электрона в КЯ и барьере формируются составные LO моды этих пространственно разделенных компонентов сверхрешетки.
- Обнаружен зависящий от температуры сдвиг резонансной частоты фотолюминесценции квантовой области структур одиночных квантовых ям GaAs/AlGaAs, вызванный макроскопическими флуктуациями ширины квантовых ям на целое число монослоев при выращивании методом МЛЭ с прерываниями роста на границах раздела. Этот сдвиг объясняется локализацией носителей заряда в более широких за счет флуктуаций областях квантовой ямы при низких температурах и более равномерным распределением носителей при повышении температуры. В результате температурная зависимость положения пика фотолюминесценции для узких (~ 3 нм) квантовых ям не повторяет температурный ход ширины запрещенной зоны объемного материала (со сдвигом вследствие эффекта размерного квантования). Для широких квантовых ям температурный сдвиг резонансной частоты менее выражен из-за более слабого проявления эффекта размерного квантования. Для объяснения наблюдаемого температурного сдвига резонансной частоты фотолюминесценции развита общая теория межзонной спонтанной рекомбинации двумерных носителей заряда в структурах КЯ с макроскопическими шероховатостями границ раздела.
- Предложен приближенный метод расчета электронного спектра квантовых точек, возникающих вследствие пересечения круговых (в силу условий роста) флуктуаций ширин квантовых ям/барьеров на соседних границах раздела сверхрешеток. Метод основан на сведении трехмерной задачи к одномерной (метод декомпозиции). Метод успешно применен для анализа данных фотолюминесценции сверхрешеток.
- Экспериментально обнаружен эффект резкого изменения энергии ионизации примеси при передислокации электронной волновой функции в системе квантовых ям во внешнем электрическом поле, вызывающем инверсию двух нижних электронных подзон размерного квантования в соседних квантовых ямах, более широкая из которых селективно легирована донорной примесью.
- В структурах одиночных квантовых ям GaAs/AlxGa1-xAs с асимметричными по высоте барьерами обнаружена 2D-3D трансформация размерности экситонных состояний с ростом внешнего электрического поля.
- Предложена оригинальная конструкция активного элемента униполярного полупроводникового лазера, в которой эффект 2D-3D трансформации размерности электронных состояний использован для эффективного подавления однофононной безызлучательной релаксации между лазерными подзонами, что обеспечивает более легкую реализацию инверсной населенности..
Практическая значимость работы состоит в следующем:
- Продемонстрированы возможности спектроскопии резонансного КР для тестирования локализации электронной волновой функции в квантово-размерных структурах.
- Предложен способ получения из анализа экспериментальной формы линии ФЛ функции распределения макроскопических флуктуаций ширины одиночной квантовой ямы на целое число монослоев, возникающих при выращивании структуры методом МЛЭ с прерываниями роста на гетерограницах.
- Обнаруженный экспериментально эффект интерференционной ионизации примеси может иметь важное практическое значение, так как позволяет повысить на несколько порядков величину модуляции латеральной проводимости канала полевого транзистора в виде системы КЯ, благодаря изменению внешним электрическим полем как подвижности, так и концентрации электронов.
- Создан многопериодный активный элемент униполярного полупроводникового лазера оригинальной конструкции. В его основе лежит физическая идея о подавлении межподзонной безызлучательной релаксации за счет использования зависимости ВФ в структурах КЯ с сильно асимметричными по высоте барьерами от квазиимпульса. Экспериментально подтверждена работоспособность предложенной конструкции.
В результате проведенных исследований развито новое научное направление в физике полупроводников - создание активного элемента полупроводникового униполярного лазера на основе гетероструктур с переменной размерностью электронных состояний.
Научные положения, выносимые на защиту
ПОЛОЖЕНИЕ 1. Метод спектроскопии резонансного КР эффективен для тестирования локализации электронной волновой функции в сверхрешетках, где за счет сужения барьеров (квантовых ям) возможна передислокация электронной волновой функции из барьеров в квантовые ямы и обратно.
ПОЛОЖЕНИЕ 2. Температурный сдвиг резонансной частоты межзонного перехода в спектрах фотолюминесценции узких квантовых ям определяется не только температурным ходом ширины запрещенной зоны объемного материала и эффектом размерного квантования, но и локализацией носителей заряда при низких температурах на макроскопических (возникших при выращивании методом МЛЭ с прерываниями роста на гетерограницах) флуктуациях ширины квантовой ямы. На температурной зависимости положения пика фотолюминесценции для узкой квантовой ямы наблюдается излом, который соответствует точке, где тепловая энергия носителей заряда при понижении температуры становится меньше средней величины дисперсии энергий основного состояния, обусловленной флуктуациями ширины КЯ. Из анализа экспериментальной формы линии фотолюминесценции можно получить функцию распределения макроскопических флуктуаций на гетерограницах.
ПОЛОЖЕНИЕ 3. Перекрытие круговых (в силу условий роста) флуктуаций толщин соседних квантовых ям в сверхрешетках может привести к формированию естественных квантовых точек с эквидистантными энергетическими состояниями, объясняемыми близкой к квадратичной зависимостью поперечника областей перекрытия от координаты в плоскости слоев. Энергетический спектр таких квантовых точек при малых перекрытиях флуктуаций соседних квантовых ям может быть рассчитан с помощью процедуры сведения трехмерной задачи к одномерной. Подобная процедура может быть использована и для решения обратной задачи нахождения профиля квантовой точки (проволоки), обладающей эквидистантным спектром.
ПОЛОЖЕНИЕ 4. Передислокация электронной волновой функции в системе легированных квантовых ям при инверсии двух нижних электронных подзон из-за их антикроссинга во внешнем электрическом поле сопровождается резким уменьшением энергии ионизации примеси, локализованной в более широкой квантовой яме. Благодаря этому эффекту, в диапазоне напряженностей поля 25?40 КВ/см энергия ионизации донорной примеси Si в двухъямной структуре уменьшается от 15,5 мэВ до нуля.
ПОЛОЖЕНИЕ 5. В спектрах фотолюминесценции структур одиночных квантовых ям GaAs/AlxGa1-xAs с асимметричными по высоте барьерами наблюдается 2D-3D трансформация размерности экситонных состояний с ростом внешнего электрического поля. По мере смещения максимума электронной волновой функции в низкий барьер с ростом поля, энергия связи экситона сначала уменьшается, а затем происходит трансформация 2D экситона в квази-3D экситон, в состав которого входят тяжелая дырка в квантовой яме и электрон резонансного надбарьерного состояния. Развит приближенный метод расчета электронного спектра структур с переменной размерностью электронных состояний, учитывающий вклад непрерывного спектра, в том числе и во внешнем электрическом поле.
ПОЛОЖЕНИЕ 6. Многопериодная трехъямная структура, включающая квантовую яму с асимметричными по высоте барьерами, перспективна для эффективного активного элемента униполярного лазера. В случае, если связанная с этой КЯ подзона служит нижним лазерным состоянием, то за счет существования этого состояния только в ограниченной области волновых векторов в плоскости слоев обеспечено эффективное подавление безызлучательного перехода в нее с верхней лазерной подзоны, в результате чего время жизни электронов в верхнем лазерном состоянии возрастает в несколько раз по сравнению с существующими униполярными лазерами на основе квантовых ям с симметричными по высоте барьерами. Экспериментально доказано, что время безызлучательной релаксации между лазерными подзонами в созданном нами многопериодном активном элементе униполярного лазера достигает 9 пс и превышает время безызлучательной релаксации с нижней лазерной подзоны, что обеспечивает инверсную населенность в такой системе.
ПОЛОЖЕНИЕ 7. Продемонстрирована возможность управления внешним электрическим полем размерностью нижней лазерной подзоны в активном элементе униполярного лазера на основе квантовых ям с асимметричными по высоте барьерами. Это позволяет реализовать на основе таких структур активный элемент квантового униполярного лазера с рекордными характеристиками.
Приоритет результатов. Все полученные автором научные результаты, вынесенные на защиту, получены впервые.
Апробация работы. Материалы диссертационной работы докладывались и обсуждались на Всероссийских и Международных конференциях и симпозиумах:
- Международных симпозиумах Наноструктуры: Физика и Технология (Санкт Петербург, 1996, 1998, 1999, 2000, 2003; 2005),
- Российских конференциях по физике полупроводников (Москва, 1997; Новосибирск, 1999; Санкт Петербург, 2003; Звенигород, 2005; Нижний Новгород, 2011),
- Всероссийском совещании Нанофотоника (Нижний Новгород, 1999),
- International Conference УAdvanced Laser TechnologiesФ УALTТ99Ф (Italy, 1999),
- I-III Симпозиумах по когерентному оптическому излучению полупроводниковых соединений и структур (Москва, Звенигород, 2007, 2009, 2011),
- Симпозиумах Полупроводниковые лазеры: физика и технология (Санкт-Петербург, 2008, 2010).
Результаты работы, как в целом, так и отдельные ее части докладывались на семинарах Физического института им. П.Н. Лебедева РАН, Университета имени Фридриха - Александра (Эрланген, Германия).
Публикации. По теме диссертации опубликовано 38 работ в научных журналах и трудах российских и международных конференций, основные из которых приведены в конце автореферата.
СОДЕРЖАНИЕ РАБОТЫ
Структура и объем диссертации. Диссертация состоит из введения, пяти глав, заключения и списка литературы. Объем диссертации составляет 261 страницу, включая 90 рисунков и 4 таблицы. Список литературы включает 38 наименований авторских публикаций и 185 наименований цитируемой литературы.
Во введении обоснована актуальность темы исследования, сформулированы цели и задачи работы, ее научная новизна и практическая значимость, а также положения, выносимые на защиту.
В первой главе на примере сверхрешеток (СР) GaAs/AlxGa1?xAs (x = 0,35) доказывается эффективность спектроскопии резонансного КР (РКР) света для тестирования локализации электронной ВФ в реальном пространстве. Исследуемые структуры включали 40 периодов КЯ шириной 3 нм, разделенных барьерными слоями, толщина которых в разных образцах составляла 20, 8, 4 и 2 нм. Приводятся рассчитанные методом огибающей зависимости пространственного распределения ВФ ![]() а(x - координата вдоль оси роста) для первых и вторых подзон размерного квантования электронов (c1, c2) и тяжелых дырок (h1, h2) в СР с шириной барьера db = 8 нм, а также зависимости от db относительных вероятностей нахождения электрона We и дырки Wh в барьерах и КЯ исследуемых структур для подзон c2 и h2 при температуре 300 К. Последние зависимости получены интегрированием
а(x - координата вдоль оси роста) для первых и вторых подзон размерного квантования электронов (c1, c2) и тяжелых дырок (h1, h2) в СР с шириной барьера db = 8 нм, а также зависимости от db относительных вероятностей нахождения электрона We и дырки Wh в барьерах и КЯ исследуемых структур для подзон c2 и h2 при температуре 300 К. Последние зависимости получены интегрированием ![]() апо x. Как следует из пространственного распределения ВФ, для СР с шириной барьеров 8 нм волновые функции подзон c2 и h2 в большей мере локализованы в барьерах за счет того, что подзона c2 расположена выше барьера, а подзона h2 - чуть ниже его потолка. При сужении барьеров вероятность локализации электронов в КЯ возрастет от ~0 (db = 20 нм) до ~0,4 (db = 2 нм), причем зависимости We,h(db) сильно нелинейны, то есть они не объясняются простым уменьшением доли барьеров при их сужении. Для дырок же вероятность нахождения в квантовых ямах и барьерах оказываются близкими (~0,4Ц0,6) во всем диапазоне изменения ширины барьеров.
апо x. Как следует из пространственного распределения ВФ, для СР с шириной барьеров 8 нм волновые функции подзон c2 и h2 в большей мере локализованы в барьерах за счет того, что подзона c2 расположена выше барьера, а подзона h2 - чуть ниже его потолка. При сужении барьеров вероятность локализации электронов в КЯ возрастет от ~0 (db = 20 нм) до ~0,4 (db = 2 нм), причем зависимости We,h(db) сильно нелинейны, то есть они не объясняются простым уменьшением доли барьеров при их сужении. Для дырок же вероятность нахождения в квантовых ямах и барьерах оказываются близкими (~0,4Ц0,6) во всем диапазоне изменения ширины барьеров.
Резонансное КР помимо энергии фононов позволяет получить дополнительную информацию об электрон-фононном и электрон-фотонном взаимодействиях, а также об электронной зонной структуре полупроводника. Получение этой информации становится невозможным вдали от резонанса возбуждающего излучения с сильным межзонным переходом вследствие суммирования по многим промежуточным состояниям в вероятности рассеяния. В резонансных условиях возбуждения только одно или малое число промежуточных состояний вносят основной вклад в вероятность КР. В этих условиях наблюдается многократное увеличение интенсивности оптических мод первого порядка и появление в спектрах обертонных и составных линий, интенсивность которых вдали от резонанса в сотни раз меньше интенсивности линий КР первого порядка.
(a) а |
(б) а
|
Рис. 1.1. Спектры КР четырех СР GaAs/AlGaAs с db = 20, 8, 4 и 2 нм (спектры 1?4, соответственно), снятые при температуре 300 К и возбуждении излучением с длиной волны 632,8 нм (а), а также при возбуждении с длиной волны 647,1 нм (б). |
|
Автором впервые обнаружена селективность РКР для оптических мод КЯ и барьеров в зависимости от локализации соответствующих ВФ. При возбуждении спектров КР структур с барьерами шириной 20 и 8 нм излучением с энергией фотона 1,96 эВ вблизи резонанса с переходом c2?h2 зарегистрировано преимущественное резонансное усиление GaAs- и AlAs-подобных LO мод барьеров Al0,35Ga0,65As в области 279 и 378 см-1 и проявление в спектрах обертонов и составных линий только этих мод, так как переход c2?h2 формируется состояниями с преимущественным распределением ВФ в области барьеров (Рис. 1.1а). Пики в области 2LO рассеяния обусловлены обертоном 2LO GaAs-подобной моды (558 см-1), составной линией LOGaAs + LOAlAs (657 см-1) и обертоном 2LO AlAs-подобной моды AlGaAs (756 см-1). Большая интенсивность этих пиков в спектре 1 объясняется тем, что для структуры с шириной барьера 20 нм энергия возбуждающего излучения оказывается выше энергии перехода c2?h2 примерно на энергию LO фонона, и этот переход попадает в область 2LO рассеяния. Энергия перехода c2?h2 для СР с шириной барьера 8 нм оказывается в области 1,96 эВ, поэтому этот переход смещается в область 1LO рассеяния (спектр 2 на Рис. 1.1а). Те же условия реализуются и для структуры с шириной барьера 20 нм при возбуждении с энергией 1,916 эВ (спектр 4 на Рис. 1.1б).
Как показывают расчеты, при сужении барьеров вероятность локализации электронов в КЯ возрастет. Поэтому растет относительная интенсивность LO моды КЯ GaAs в области 292 см-1, и в спектрах КР сверхрешеток с барьерами 2 нм эта мода становится доминирующей (Рис. 1.1а). Рост относительной интенсивности LO моды КЯ GaAs можно объяснить передислокацией электронных (экситонных) возбуждений из области барьера в КЯ при сужении барьеров. Это подтверждает и появление в спектре СР с барьерами 2 нм дополнительной особенности в области 570 см-1 (отмечена стрелкой на Рис. 1.1б), которая является составной модой LO фонона КЯ GaAs и GaAs-подобного LO фонона барьера AlGaAs. Ее интенсивность сопоставима с интенсивностями обертона 2LO GaAs-подобной моды при 558 см-1 и составной линии LOGaAs + LOAlAs барьера AlGaAs при 657 см-1 в этом же спектре.
В з 1.2 обсуждаются спектры ФЛ и КР тех же структур при температуре 77 К. Следствием высокой степени локализации вторых электронных и дырочных подзон в широких барьерах СР является появление дополнительных пиков ФЛ при энергиях, превышающих энергию перехода между первыми состояниями электронов и тяжелых дырок c1?h1. На основании расчетов методом огибающей дополнительные пики отнесены к переходам с участием более высоких состояний электронов и тяжелых (легких) дырок. Сопоставление спектров ФЛ структуры с db = 20 нм при возбуждении с энергиями 2,41 и 2,54 эВ свидетельствует об исчезновении в последнем случае широкой полосы при 2,14 эВ, отнесенной к вкладам переходов из квазиконтинуума электронных состояний выше барьера в верхние подзоны тяжелых и легких дырок. Дело в том, что с ростом избыточной энергии фотовозбужденных носителей повышается вероятность их рассеяния в X- и L-долины, минимумы которых для исследуемых структур находятся вблизи дна зоны проводимости барьерных слоев AlGaAs в точке ?. Как показывает расчет методом огибающей, в структуре с шириной барьеров 20 нм происходит обращение КЯ и барьеров в X-долине зоны проводимости, в результате чего в широких КЯ в X-точке образца формируются близко расположенные подзоны. В этой структуре подзона c2 в точке ? зоны проводимости оказывается ниже дна X-долины на величину порядка энергии оптического фонона AlGaAs. Для сохранения импульса при переходе X - ? должен испускаться оптический фонон с большим волновым вектором. Фононная боковая полоса перехода X - ? действительно проявляется в спектре ФЛ в области пика перехода c2?h2 (1,98 эВ). На этом основании исчезновение широкой полосы при 2,14 эВ в спектре ФЛ структуры с db = 20 нм при возбуждении излучением с энергией 2,54 эВ связывается с конкуренцией непрямых переходов, сопровождающихся быстрым переносом электронов из X- в ?-долину зоны проводимости в реальном пространстве.
В спектрах ФЛ исследуемых структур также проявился переход между первым состоянием электронов и третьим состоянием тяжелых дырок (c1?h3), энергия которого возрастала по мере сужения барьеров от 1,84 эВ (db = 20 нм) до 1,89 эВ (db = 2 нм). При возбуждении КР излучением с энергией кванта 1,916 эВ наименьшая отстройка от резонанса на переходе c1?h3 и соответственно наибольший рост интенсивности КР наблюдаются для СР с шириной барьеров 2 нм. В этом случае относительная вероятность нахождения электрона в КЯ для подзоны c1 исследуемых структур практически не изменяется при уменьшении db, оставаясь на уровне ~ 0,7, а относительная вероятность локализации дырок в КЯ возрастает. В соответствии с расчетом наибольшее резонансное усиление КР наблюдается на LO моде КЯ GaAs, которая становится доминирующей при уменьшении отстройки от резонанса с переходом c1?h3, причем обертон 2LO удается зарегистрировать только для этой моды. Это служит дополнительным подтверждением чувствительности РКР к локализации экситонной ВФ.
Вторая глава посвящена исследованию влияния флуктуаций гетерограниц раздела на оптические свойства квантово-размерных структур. Под флуктуациями понимается шероховатость гетерограниц из-за формирования островков толщиной в несколько монослоев (МС), вызывающих локальные изменения толщины КЯ. Масштабы флуктуаций варьируются в широком диапазоне (от атомного масштаба до макроскопических расстояний) по поверхности пластины. Наиболее ярко эти эффекты проявляются в структурах с узкими КЯ, где приводят к значительным сдвигам уровней. В этой связи представляется оправданным описание квантово-размерных структур как неупорядоченной совокупности КТ произвольных размеров [5]. Естественно ожидать локализации ВФ экситона на таких флуктуациях и проявления эффектов локализации в оптических спектрах. Если протяженность областей флуктуаций (островков) на гетерограницах раздела превышает диаметр двумерного экситона (?20 нм для КЯ GaAs), то может наблюдаться расщепление линий ФЛ с появлением максимумов при энергиях, соответствующих эмиссии из КЯ с ширинами в целое число МС. Это обычно имеет место для образцов, выращенных методом МЛЭ с прерываниями роста на границах раздела, что в случае системы GaAs/AlxGa1?xAs способствует поверхностной диффузии Ga и Al на большие расстояния по пластине и формированию протяженных островков роста [6]. В настоящее время распространено представление о бимодальном распределении размеров флуктуаций на гетерограницах раздела квантово-размерных структур [7]. Иными словами, существуют не только макроскопические островки, вызывающие расщепление линии ФЛ, но и микрошероховатости на поверхности островков роста. Такой подход позволяет объяснить расщепление пиков ФЛ, соответствующее дробному числу МС. Статистическое распределение флуктуаций ширины КЯ является одной из причин неоднородного уширения и близкой к гауссовой формы линии для экситонной рекомбинации. Выполненные ранее работы были посвящены, в основном, исследованию влияния флуктуаций гетерограниц в квантово-размерных структурах на ширину линии ФЛ и времена рекомбинации.
В з 2.2 рассмотрено влияние макроскопических шероховатостей гетерограниц на температурную зависимость энергии межзонного перехода в структурах одиночных КЯ. Методом ФЛ исследованы структуры одиночных КЯ GaAs/Al0,3Ga0,7As шириной 2,5-30 нм, выращенных методом МЛЭ с прерываниями роста на 60 с на каждой гетерогранице. На Рис. 2.1а представлены температурные зависимости положения пика экситонного перехода c1-h1 между первыми уровнями размерного квантования электрона и тяжелой дырки для исследованных структур, пунктиром изображена взятая из литературы [8] температурная зависимость ширины запрещенной зоны объемного GaAs. Видно, что для КЯ шириной 30 нм температурная зависимость экситонного перехода фактически совпадает с температурной зависимостью ширины запрещенной зоны объемного GaAs (малое число экспериментальных точек ограничено спектральным диапазоном используемого спектрометра). Эту же зависимость, но с учетом эффекта размерного квантования, повторяет и температурная зависимость экситонного перехода для КЯ шириной 10 нм. Для КЯ шириной 2,5 нм температурная зависимость оказывается более плоской. Этот эффект связан с неравномерным распределением порожденных светом носителей заряда вдоль слоев квантово-размерной структуры с переменной шириной КЯ. При понижении температуры концентрация частиц в более широких областях превышает среднюю концентрацию в КЯ, поэтому эти области дают больший вклад в интенсивность ФЛ при усреднении. В то же время, расстояние между электронными и дырочными уровнями в более широких областях меньше, чем среднее значение в КЯ. Следовательно, максимум усредненной интенсивности сдвигается к меньшим частотам от положения, соответствующего средней ширине КЯ. Эффект проявляется сильнее в узких КЯ, что связано с большим относительным вкладом флуктуаций. При этом заметно, что при дальнейшем понижении температуры температурная зависимость пика ФЛ экситонного перехода опять повторяет ход ширины запрещенной зоны объемного GaAs.
(а) аЭнергия, эВ аТемпература, К а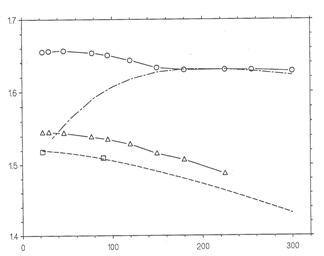 |
(б) а аДлина волны, мкм а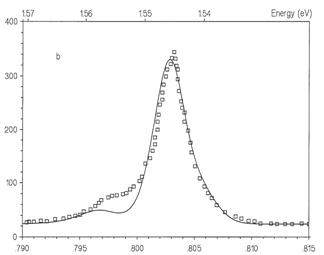
|
Рис. 2.1. Температурные зависимости положения пика экситона с тяжелой дыркой в спектрах ФЛ одиночных КЯ GaAs/AlxGa1?xAs шириной 2,5 нм (кружки), 10 нм (треугольники) и 30 нм (квадраты) (а); Спектр ФЛ квантовой ямы GaAs/AlxGa1?xAs шириной 10 нм, измеренный при температуре 30 К (б). |
|
Для описания основных особенностей спектров ФЛ исследованных структур в рамках квазиклассического приближения развита теория межзонной спонтанной рекомбинации двумерных носителей заряда в КЯ с макроскопическими шероховатостями границ раздела. Рассмотрены отклонения положений правой и левой границ КЯ zr и zl от их номинальных значений ![]() аи
аи ![]() ана величины ?zr и ?zl, соответственно. Эти флуктуации влекут за собой локальные изменения ширины КЯ L и положения ее центра zi. В главном порядке квазиклассического приближения изменение свойств КЯ определяется флуктуациями их ширины ?L, которые вызывают локальные сдвиги уровней размерного квантования. Если отклонения положения гетерограницы ?zr(l) распределены в соответствии с функциями распределения Pr(l)(?zr(l)), то функция распределения флуктуаций ширины квантовых ям ?L выражается как
ана величины ?zr и ?zl, соответственно. Эти флуктуации влекут за собой локальные изменения ширины КЯ L и положения ее центра zi. В главном порядке квазиклассического приближения изменение свойств КЯ определяется флуктуациями их ширины ?L, которые вызывают локальные сдвиги уровней размерного квантования. Если отклонения положения гетерограницы ?zr(l) распределены в соответствии с функциями распределения Pr(l)(?zr(l)), то функция распределения флуктуаций ширины квантовых ям ?L выражается как
|
|
Связь между функциями распределения флуктуаций ширины КЯ и флуктуаций расстояний между уровнями P?(?) легко установить при малых флуктуациях ширин КЯ. В этом случае сдвиг уровней линеен по ?L:
|
|
![]() а - энергии электронов (дырок), отсчитываемые от краев зоны проводимости (валентной зоны), и
а - энергии электронов (дырок), отсчитываемые от краев зоны проводимости (валентной зоны), и
|
При отсчете частоты в энергетических единицах от энергии возбуждения свободной электрон-дырочной пары получено следующее выражение для результирующей интенсивности ФЛ, учитывающей вклады экситонов и свободных электрон-дырочных пар:
|
(2.1) |
Здесь pcv ? матричный элемент оператора импульса между блоховскими состояниями зоны проводимости и валентной зоны; ?ex ? экситонная ВФ в том случае, когда координаты электрона и дырки совпадают; me и mh - химические потенциалы для электронов и дырок; ![]() а? частота (в энергетических единицах), отсчитываемая от энергии возбуждения свободной электрон-дырочной пары;
а? частота (в энергетических единицах), отсчитываемая от энергии возбуждения свободной электрон-дырочной пары; ![]() а? изменение ширины запрещенной зоны
а? изменение ширины запрещенной зоны ![]() аиз-за пространственного квантования;
аиз-за пространственного квантования; ![]() а - приведенная плотность состояний, которая в случае параболических зон имеет вид:
а - приведенная плотность состояний, которая в случае параболических зон имеет вид:
|
mr = memh/(me + mh) ? приведенная масса.
Рассчитанная с помощью выражения (2.1) температурная зависимость экситонного максимума (а он доминирует в спектре вплоть до комнатной температуры) в предположении гауссового распределения флуктуаций положений границ КЯ со стандартным отклонением в 1 МС изображена на Рис. 2.1а штрих-пунктирной линией. Очевидное несоответствие теоретической и экспериментальной кривых возникает при низких температурах, точнее при ![]() . Это условие физически означает, что тепловая энергия становится меньше средней величины дисперсии энергий основного состояния, обусловленной флуктуациями ширины КЯ. Поэтому при низких температурах процесс установления термодинамического равновесия вдоль структуры заметно замедляется. Если время установления равновесия становится больше характерного радиационного времени жизни, то сдвиг пика ФЛ к низким энергиям прекращается. Оценка
. Это условие физически означает, что тепловая энергия становится меньше средней величины дисперсии энергий основного состояния, обусловленной флуктуациями ширины КЯ. Поэтому при низких температурах процесс установления термодинамического равновесия вдоль структуры заметно замедляется. Если время установления равновесия становится больше характерного радиационного времени жизни, то сдвиг пика ФЛ к низким энергиям прекращается. Оценка ![]() адля случая флуктуаций ширины КЯ на 1 МС дает значение 13 мэВ или ~150 К, что прекрасно согласуется с экспериментом.
адля случая флуктуаций ширины КЯ на 1 МС дает значение 13 мэВ или ~150 К, что прекрасно согласуется с экспериментом.
Анализ температурной зависимости (2.1) показывает, что при любой температуре низкоэнергетическая часть экситонного пика воспроизводит в явном виде функцию распределения расстояния между уровнями электронов и дырок P?(?). Следовательно, эта функция и функция распределения флуктуаций ширины КЯ PL(?L) могут быть получены из анализа экспериментальных спектров ФЛ. В качестве примера получена функция распределения флуктуаций P?(?) для КЯ шириной 10 нм. Наилучшая подгонка к экспериментальной форме линии ФЛ получена при использовании суммы трех гауссианов различной ширины:
|
(2.2) |
Здесь ?i = 2,2 мэВ, ?ii = 3,0 мэВ, ? = 0,8, а ?ML есть сдвиг энергии перехода, вызванный изменением ширины КЯ на 1 МС (0,283 нм). Центральный гауссиан соответствует вкладу КЯ шириной n = 37 МС (10,47 нм), в то время как левый и правый гауссианы есть соответствующие вклады макроскопических ступенек n - 1 и n + 1. Теоретический спектр ФЛ квантовой ямы шириной 10 нм при T = 100 К, рассчитанный с помощью уравнения (2.1) с функцией распределения (2.2), представлен сплошной линией на Рис. 2.1б. Слабый пик со стороны высоких энергий теоретического спектра есть вклад свободных электрон-дырочных пар. Некоторое несоответствие теоретического и экспериментального спектров в области высоких энергий связано с пренебрежением возбужденными состояниями экситона, а также вкладом экситона с легкой дыркой.
В з 2.3 обуждаются проявления локализации экситонов на шероховатостях гетерограниц в спектрах микрофотолюминесценции структур КЯ. Методика микрофотолюминесценции позволяет различить в спектре индивидуальные вклады протяженных флуктуаций гетерограниц структур КЯ. Этой методикой исследовались 40-периодные структуры GaAs/Al0,3Ga0,7As, которые содержали КЯ шириной 3 нм, разделенные барьерными слоями, толщина db которых в разных образцах составляла от 20 до 2 нм. Структуры были выращены методом МЛЭ с прерываниями роста на гетерограницах на 30 с. При сильной расфокусировке лазерного пучка на образце в спектрах ФЛ структур с db = 2 и 20 нм при температуре 300 К доминируют пики с максимумами при 1,553 и 1,577 эВ соответственно, обусловленные экситонными переходами между первыми состояниями электрона и тяжелой дырки. Каждый пик имеет плечо в области высоких энергий, которое является вкладом экситона с легкой дыркой.
В условиях резкой фокусировки возбуждающего излучения в пятно диаметром w < 20 мкм на спектры межзонной ФЛ накладываются новые рекомбинационные пики с шириной на полувысоте 3?5 мэВ (Рис. 2.2а). Как показывает расчет методом огибающей, дополнительные пики, наблюдаемые для структуры с широкими барьерными слоями, отвечают флуктуациям толщин КЯ на целое число МС. Цифры при пиках в спектре I показывают, на сколько МС отличается локальная ширина КЯ, соответствующая данному максимуму, от среднего значения, дающего наибольший вклад в спектр ФЛ. Так, максимум межзонной ФЛ отвечает толщине КЯ в 12 монослоев по 0,283 нм (3,4 нм), а, например, пик 4 характеризует КЯ, толщина которых на 4 МС меньше. В то же время, тонкая структура в спектре II СР с тонкими барьерами не коррелирует с рассчитанными энергиями межзонных переходов для структур КЯ, отличающихся на целое число МС, и, скорее всего, связана с флуктуациями типа КТ. Проявление пиков ФЛ, обусловленных флуктуациями толщин КЯ, становится возможным, когда параметр w приближается к размерам неоднородностей КЯ в плоскости пластины. Размеры областей с постоянными толщинами КЯ возрастают для структур, выращенных, как в нашем случае, с прерываниями роста на границах раздела. Количество и положение наблюдаемых пиков варьируются при сканировании сфокусированного (w < 20 мкм) лазерного пучка по поверхности образца, отражая локальную микроструктуру в различных областях.
(а) а |
(г) а(в) ав а
|
(б) а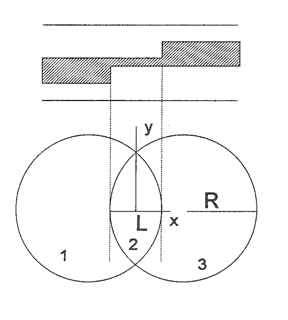
|
|
Рис. 2.2. Спектры ФЛ сверхрешеток GaAs/AlGaAs с db = 20 (спектр I) и 2 нм (спектры II и III), снятые в режиме микрозонда (а); Геометрия модельной структуры (б); Зависимости эффективного потенциала |
|
Интересной особенностью образца с тонкими барьерными слоями (db = 2 нм) является проявление в некоторых точках в условиях резкой фокусировки возбуждающего излучения на образце и тонкой структуры, отличной от обсуждавшейся ранее. Примером такого спектра является спектр III. Здесь наблюдаются две серии практически эквидистантных пиков, обозначенных строчными и прописными буквами английского алфавита. Расстояние между соседними пиками в каждой серии варьируется в интервале всего 15,6?18,2 мэВ. Проявление двух наборов пиков, скорее всего, вызвано тем, что в пределы пятна сфокусированного на образце возбуждающего излучения попадают две особенности типа КТ, которые обсуждаются далее. На поверхности структуры с тонкими барьерами встречались также участки, где в спектре ФЛ проявлялся лишь один набор почти эквидистантных пиков, однако чаще всего спектр не содержал подобных особенностей и напоминал спектр II. Для структуры с широким барьерами спектры, подобные спектру III, не были зарегистрированы ни в одной точке.
Проявление в спектре ФЛ эквидистантных пиков, положение которых не соответствует энергетическому спектру КЯ с шириной, равной целому числу МС, может быть обусловлено образованием КТ в результате флуктуаций параметров КЯ и барьеров. В силу условий роста в установке МЛЭ без вращения подложки наиболее вероятными представляются флуктуации, имеющие круговую форму в плоскости, перпендикулярной оси роста. Наличие в спектрах ФЛ структуры с широкими барьерами пиков, соответствующих ширинам КЯ, кратным целому числу МС, говорит о том, что радиусы этих флуктуаций R достаточно велики, так что в отдельной флуктуации латеральное квантование не проявляется. Предположим, что круговые флуктуации толщины возникли в процессе роста в некоторых областях соседних слоев, причем центры флуктуаций не совпадают, вызывая появление области перекрытия. Ширина барьера в этой области оказывается меньше, и возникает КТ.
В случае L << R хорошим приближением является модельная структура на Рис. 2.2б, включающая три области: область перекрытия круговых флуктуаций (область 2), а также области слева (область 1) и справа от нее (область 3). В каждой из этих областей потенциал в уравнении Шредингера не зависит от координат x, y и является кусочно-постоянным по z, то есть U(x,y,z) = Ui(z), где i = 1, 2, 3 ? номер области. Для расчета энергетического спектра рассматриваемой структуры использовался приближенный метод решения задачи, состоящий в следующем. Решение трехмерного уравнения Шредингера в каждой из областей 1, 2, 3 может быть представлено в виде ![]() аТогда для функции Z(z) получается уравнение
аТогда для функции Z(z) получается уравнение
|
(2.3) |
Уравнение (2.3) имеет вид уравнения Шредингера для одномерного движения в потенциале Ui(z). Считая, что главный вклад вносит основное состояние, можно ограничиться одним первым уровнем размерного квантования ?1 в каждой из областей 1, 2 и 3. Тогда для функции ?(x,y) получается единственное уравнение, которое с учетом того, что ? = ?(x,y), можно записать в виде
|
(2.4) |
то есть при таком подходе трехмерная задача сводится к двумерной, в которой роль потенциала играет собственное значение одномерного движения вдоль оси роста z. Если границу области постоянства значения ?1 (?1(x,y) = const), то есть границу области перекрытия двух окружностей y = f(x), аппроксимировать кусочно-постоянной функцией, то процедуру, аналогичную использованной ранее, можно применить и к уравнению (2.4), сведя таким образом исходную трехмерную задачу к одномерной.
Исследована точность предложенной процедуры и показано, что путем сведения задачи к одномерной можно вычислять энергетический спектр квантовых нитей и КТ сложной формы с точностью порядка нескольких процентов. Для примера на Рис. 2.2в и г представлены зависимости нормированного значения эффективного барьера ![]() аот координаты y/l0 и энергии локализованных состояний
аот координаты y/l0 и энергии локализованных состояний ![]() аот номера уровня N для структур, образованных в результате флуктуаций толщины барьера в двухъямной системе, для радиуса флуктуации
аот номера уровня N для структур, образованных в результате флуктуаций толщины барьера в двухъямной системе, для радиуса флуктуации ![]() аи набора значений ширины области перекрытия L. В этих соотношениях l0 = (2?2h2/mU0)1/2 - длина волны электрона с энергией, соответствующей высоте барьера,
аи набора значений ширины области перекрытия L. В этих соотношениях l0 = (2?2h2/mU0)1/2 - длина волны электрона с энергией, соответствующей высоте барьера, ![]() ,
, ![]() . Как видно из Рис. 2.2в и г, при малых L (кривые 1 и 2) вид зависимостей U(y) близок к параболическому, а уровни энергии почти эквидистантны.
. Как видно из Рис. 2.2в и г, при малых L (кривые 1 и 2) вид зависимостей U(y) близок к параболическому, а уровни энергии почти эквидистантны.
Выполнены численные оценки для реальных параметров исследованных структур и продемонстрировано качественное согласие результатов с экспериментальными данными. Решена обратная задача нахождения профиля цилиндрической КТ, обладающей эквидистантным спектром.
|
|
|
|
Рис. 3.1. Спектр ФЛ двухъямной структуры GaAs/AlGaAs без внешнего поля при температуре 20 К и плотности мощности возбуждающего излучения на образце 4 Вт/см2 (a), трансформации спектра с ростом плотности мощности возбуждающего излучения до 12 Вт/см2 (б) и при повышении температуры до 90 К (в); Теоретические и экспериментальные зависимости от поля энергий экситонных переходов c1?h1, c1?h2 и c2?h1, а также энергии переходов Si0?h1 между примесным уровнем и зоной тяжелых дырок (г); Теоретическая (сплошная линия) и экспериментальная зависимости |
|
Третья глава посвящена экспериментальной проверке эффекта интерференционной ионизации примеси, предсказанного в [9]. Этот эффект обусловлен инверсией двух нижних подзон размерного квантования туннельно связанных КЯ, одна из которых легирована, при их антикроссинге во внешнем электрическом поле, параллельном оси роста структуры. В результате инверсии локализованное состояние электрона на примесном атоме, формирующееся, в основном, из состояний нижней подзоны, изменяет свою энергию связи и форму ВФ.
В з 3.2 описана методика исследований эффекта интерференционной ионизации примеси во внешнем электрическом поле и экспериментальная структура. Последняя включала нижнюю нелегированную КЯ шириной 5,7 нм, барьерный слой Al0,34Ga0,66As толщиной 3,4 нм и более близкую к поверхности широкую КЯ шириной 7,9 нм с d-слоем легирующей примеси Si в центре.
В з 3.3 приведены результаты исследований образца без внешнего электрического поля. Расчеты показывают, что искажение потенциального рельефа встроенным полем приводит к тому, что ВФ электронов и дырок в основном состоянии оказываются локализованными в разных КЯ. В результате интеграл перекрытия для переходов между первыми подзонами размерного квантования электронов и тяжелых дырок (c1-h1) оказывается значительно меньше, чем для переходов между второй подзоной электронов и первой подзоной тяжелых дырок (c2-h1), а также первой подзоной электронов и второй подзоной тяжелых дырок (c1-h2), для которых ВФ локализованы в одной КЯ. Cпектры ФЛ структуры представлены на Рис. 3.1а. В спектре доминирует узкий пик с максимумом при 1,599 эВ, к которому со стороны низких энергий примыкает широкая полоса, содержащая вклады нескольких перекрывающихся пиков. Разложение спектра на составляющие дает шесть гауссовых контуров. Штриховыми линиями показаны гауссовы контуры, используемые для аппроксимации спектров, штрих-пунктирными линиями изображены результирующие контуры. Сравнение экспериментальных данных с результатами теоретического расчета позволяет отнести пики в области 1,599, 1,588 и 1,576 эВ к экситонным переходам c2-h1, c1-h2 и c1-h1, соответственно. Большая интенсивность пиков, отвечающих переходам c2-h1 и c1-h2 с участием более высоких подзон, коррелирует с результатами расчетов распределения ВФ.
Пики с максимумами при 1,566, 1,552 и 1,543 эВ соответствуют переходам с энергиями, меньшими энергии экситонного перехода c1-h1 (1,576 эВ), поэтому их связь с примесями представляется наиболее вероятной. Ближайший к экситонному переходу c1-h1 (1,576 эВ) пик при 1,566 эВ соответствует переходам электронов с нейтральных атомов примеси Si в нижнюю подзону тяжелых дырок (Si0-h1). На основании литературных данных [10] соседние с переходом Si0-h1 низкоэнергетические пики (1,552 и 1,543 эВ) отнесены к переходам с участием остаточной акцепторной примеси углерода C в нейтральном зарядовом состоянии (c1-C0, Si0-C0). Для подтверждения примесной природы пиков в области низких энергий проведены измерения зависимости спектров ФЛ от интенсивности возбуждающего излучения и температуры. С ростом плотности мощности возбуждающего излучения (Рис. 3.1б) наблюдается быстрое насыщение интенсивности пиков в области низких энергий, связанное с конечным числом доноров Si и акцепторов C в КЯ. При увеличении температуры наблюдается ослабление спектров ФЛ, связанное с ростом вероятности термического заброса носителей из ямы в барьерные слои, причем интенсивность спектра со стороны низких энергий уменьшается быстрее. Этот эффект типичен для спектров ФЛ примесных состояний и объясняется термической ионизацией доноров и акцепторов.
В з 3.4 обсуждаются величина энергии ионизации примеси Si в КЯ GaAs/AlGaAs и ее изменение во внешнем электрическом поле. Примесный пик Si0-h1 (1,566 эВ) отстоит от пика экситонного перехода c1-h1 (1,576 эВ) на 10 мэВ. Для определения энергии ионизации примеси ![]() ак этому значению нужно добавить величину энергии связи экситона
ак этому значению нужно добавить величину энергии связи экситона ![]() . Вариационные расчеты с учетом встроенного поля в структуре дают величину
. Вариационные расчеты с учетом встроенного поля в структуре дают величину ![]() амэВ, тогда
амэВ, тогда ![]() амэВ. Это превышает известные значения энергии ионизации 12-13 мэВ. Дело в том, что d-легирование приводит к появлению в центре КЯ V-образного потенциала, вызывающего понижение энергии низших уровней по отношению к энергии более высоких состояний и, соответственно, к росту величины
амэВ. Это превышает известные значения энергии ионизации 12-13 мэВ. Дело в том, что d-легирование приводит к появлению в центре КЯ V-образного потенциала, вызывающего понижение энергии низших уровней по отношению к энергии более высоких состояний и, соответственно, к росту величины![]() . Согласно расчетам, при уровне d-легирования 6,31011 см-2 увеличение энергии ионизации достигает 3-4 мэВ. В этом случае положение пика ФЛ 1,566 эВ неплохо согласуется с теоретическими расчетами для энергии перехода Si0-h1.
. Согласно расчетам, при уровне d-легирования 6,31011 см-2 увеличение энергии ионизации достигает 3-4 мэВ. В этом случае положение пика ФЛ 1,566 эВ неплохо согласуется с теоретическими расчетами для энергии перехода Si0-h1.
На Рис. 3.1г приведены экспериментальные данные, а также результаты теоретического расчета (сплошные линии) положения пиков ФЛ в зависимости от напряженности электрического поля, возникающего при приложении к верхнему электроду структуры напряжения от +0,4 до -2,4 В. Каждому значению поля отвечают, как правило, несколько экспериментальных точек для каждого перехода, которые измерены на различных образцах, приготовленных из одной структуры. Пики непрямых переходов c2-h1 и c1-h2 быстро сдвигаются с ростом поля за счет линейного эффекта Штарка. В то же время, положение экситонного пика c1-h1 при напряженностях поля менее 25 кВ/см практически не зависит от величины поля, так как для прямых переходов линейный эффект Штарка отсутствует, а квадратичный эффект мал.
Наиболее принципиальным является антикроссинг линий спектра c1-h1 и c2-h1 на Рис. 3.1г при напряженности поля около 30 кВ/см, поскольку при этом происходит передислокация электронной ВФ нижней подзоны из легированной в нелегированную КЯ. Расчет в приближении d-образного потенциала примеси дает следующее выражение для энергии ионизации примеси:
|
(3.1) |
где ![]() , m - эффективная масса электрона, a Ц параметр решетки, g - константа авзаимодействия электрона с потенциалом примеси,
, m - эффективная масса электрона, a Ц параметр решетки, g - константа авзаимодействия электрона с потенциалом примеси, ![]() а - огибающая ВФ для электрона в нижней подзоне размерного квантования, x0 - координата примесного атома вдоль оси роста структуры. Множитель
а - огибающая ВФ для электрона в нижней подзоне размерного квантования, x0 - координата примесного атома вдоль оси роста структуры. Множитель![]() , зависящий как от положения примеси в КЯ, так и от электрического поля, приводит к сильной зависимости энергии ионизации примеси от поля.
, зависящий как от положения примеси в КЯ, так и от электрического поля, приводит к сильной зависимости энергии ионизации примеси от поля.
Рассчитанная с помощью (3.1) зависимость положения пика примесной ФЛ Si0-h1 от поля изображена сплошной линией на Рис. 3.1г. Для сравнения там же показаны зависимости положения примесного пика от поля в отсутствие эффекта изменения энергии ионизации примеси (пунктир) и соответствующая зависимость для перехода c1-h1 свободных электронов и дырок (штрих-пунктирная линия). Последняя была получена из экспериментальной зависимости энергии экситонного перехода c1-h1 от поля с учетом теоретически рассчитанной энергии связи экситона c1-h1. Как видно из Рис. 3.1.г, в области полей 25-40 кВ/см, где происходит передислокация электронной ВФ из широкой в более удаленную от поверхности узкую КЯ, кривая Si0-h1 быстро сближается с зависимостью для перехода c1-h1 свободных электронов и дырок. Это свидетельствует о резком уменьшении энергии ионизации примеси.
Теоретическая и экспериментальная зависимости энергии ионизации примеси от электрического поля, полученные как разность между расчетной зависимостью энергии перехода c1-h1 свободных электронов и дырок и теоретической и экспериментальной зависимостями для перехода Si0-h1, представлены на Рис. 3.1д. Как видно из рисунка, в слабом поле величина энергии ионизации примеси достигает 15,5 мэВ, а с ростом поля - уменьшается до нуля. Следует подчеркнуть, что интерференционная ионизация примеси, связанная с антикроссингом нижних подзон размерного квантования в соседних КЯ, происходит при гораздо меньших напряженностях внешнего электрического поля, чем в случае непосредственной ионизации примеси электрическим полем.
Четвертая глава посвящена экспериментальному исследованию эффекта трансформации размерности электронных состояний в КЯ с асимметричными по высоте барьерами. Как известно, в потенциальной яме с симметричными барьерами всегда есть, по крайней мере, один уровень энергии. Напротив, для потенциальной ямы с асимметричными барьерами и массами частицы m, m1 и m2 в яме и барьерах U1 и U2 соответственно существует критическая ширина d, такая, что для более узкой ямы связанного электронного состояния не возникает:
|
|
Если учесть изменение продольной компоненты импульса, то исчезновение связанных состояний при больших волновых векторах возможно и для структуры с симметричными барьерами за счет разницы эффективных масс - это может даже приводить к превращению потенциальной ямы в барьер и наоборот. Однако в этом случае критические значения волновых векторов kc, при которых исчезают или возникают связанные состояния, оказываются слишком большими с точки зрения как возможности обнаружения, так и корректности описания.
В [11] был исследован закон дисперсии для КЯ с асимметричными барьерами. С учетом разницы эффективных масс в соседних слоях было показано, что локализованное электронное состояние может существовать в ограниченной области двумерного импульсного пространства. При увеличении соответствующего импульса в зависимости от соотношения высот асимметричных барьеров и эффективных масс, а также ширины КЯ возможно как исчезновение связанных состояний (переход в непрерывный спектр, лувеличение размерности), так и их возникновение (уменьшение размерности), а также наличие последовательности нескольких таких трансформаций. Была также предсказана возможность управления внешним электрическим полем, параллельным оси роста структуры, размерностью экситонных состояний в структурах КЯ с асимметричными барьерами, основанная на этом эффекте.
В з 4.2 представлены результаты исследований спектров ФЛ структур с одиночной КЯ GaAs шириной d = 10, 4 или 3 нм, заключенной между асимметричными барьерами AlGaAs с концентрациями AlAs 40 и 6 % соответственно. Ширины КЯ были выбраны с таким расчетом, чтобы в структурах с КЯ шириной 10 и 4 нм существовало связанное состояние электрона в яме без внешнего поля, а в структуре с КЯ шириной 3 нм - отсутствовало. Общие для всех спектров пики ФЛ вблизи 1,59 и 2,07 эВ (Рис. 4.1а) обусловлены вкладами нижнего и верхнего барьеров соответственно. В спектре 1 структуры с КЯ шириной 10 нм доминирует интенсивный пик экситона Q, связанного с первыми уровнями размерного квантования электронов и тяжелых дырок (с1-h1). При сужении КЯ до 4 нм этот пик теряет интенсивность, уширяется и сдвигается к пику низкого барьера b, так как уровень с1 оказывается вблизи потолка низкого барьера (спектр 2). В спектре 3 структуры с КЯ шириной 3 нм, где связанное состояние электрона в яме отсутствует, проявляются только пики ФЛ барьеров.
|
|
Рис. 4.1. Спектры ФЛ структур с d = 10 (1), 4 (2) и 3 (3) нм при температуре 80 К и возбуждении излучением с длиной волны 488 нм. На вставке справа ? коротковолновые участки соответствующих спектров, измеренные при 10-кратном усилении. Вставки слева иллюстрируют переходы, наблюдающиеся в спектрах 1 и 3 (а); Зависимости от напряжения, приложенного к верхнему полупрозрачному электроду, для экситонных пиков c1-h1 (кривая 1) и низкого барьера (кривая 2), а также для энергий |
|
Для того, чтобы проследить за эволюцией экситонного состояния КЯ при плавном изменении эффективной высоты низкого барьера, были приготовлены электрические контакты к структурам с КЯ шириной 4 и 3 нм. По мере изменения приложенного к структуре напряжения от +0,4 до Ц1,4 В пик ФЛ экситона КЯ шириной 4 нм ослабевает, уширяется и медленно сдвигается к низким энергиям (Рис. 4.1б, кривая 1), так как эффект Штарка для прямых переходов незначителен. По той же причине положение экситонного пика низкого барьера остается практически неизменным (кривая 2), хотя он тоже ослабевает и уширяется при уменьшении напряжения из-за ослабления кулоновского притяжения формирующих экситон электрона и дырки в электрическом поле. Помимо этого фактора важную роль в ослаблении пика экситона КЯ играет также увеличение асимметрии потенциального рельефа для электронов с ростом поля.
Согласно расчетам, двумерное электронное состояние должно исчезнуть в полях, отвечающих напряжению на структуре Ц0,6 В, однако соответствующий экситонный пик наблюдается в спектре до напряжения Ц1,4 эВ. В области напряжений от Ц0,6 до Ц1,4 эВ ФЛ обусловлена переходом между локализованным состоянием дырки и электронными состояниями в непрерывном спектре с энергиями вблизи потолка низкого барьера. По своей природе это - квазитрехмерный экситон. Слабая зависимость положения экситонного пика от напряжения на структуре в области от Ц0,6 до Ц1,4 В указывает на то, что центр тяжести электронной ВФ по-прежнему находится в КЯ. Рассчитанные, исходя из этих представлений, зависимости показанных на Рис. 4.1б параметров ech и ebh (кривые 3 и 4 соответственно) от напряжения хорошо коррелируют с экспериментальными данными при напряжениях до Ц1,4 В.
Резкая зависимость от напряжения положения экситонного пика при напряжениях менее Ц1,4 В свидетельствует о том, что в этой области экситон становится существенно непрямым. Существование такого экситона возможно только при наличии некоторой структуры в непрерывном спектре электронных состояний, связанной, например, с резонансами из-за отражений на скачке потенциала, сформированного на гетерогранице барьера Al0,06Ga0,94As и нижнего контактного слоя n+GaAs. В этом случае экситон формируется электроном резонансного состояния и локализованной в КЯ тяжелой дыркой, а необходимое для конечной силы осциллятора перекрытие ВФ обеспечивается за счет туннелирования электронов резонансного состояния в КЯ через треугольный барьер. Электрическое поле разрывает экситон КЯ при напряжении около Ц1,6 В. Трехмерный экситон нижнего барьера разрывается раньше, при напряжении Ц1,45 В.
Был также поставлен обратный эксперимент для создания связанного электронного состояния в КЯ шириной 3 нм, где оно без внешнего поля отсутствовало. Для этого при температуре 20 К к верхнему полупрозрачному электроду структуры прикладывалось напряжение +0,6 В. В этих условиях вблизи пика ФЛ низкого барьера был зарегистрирован вклад экситонного перехода. Этот эффект объясняется эффективным увеличением низкого барьера при положительном напряжении, вызывающим формирование связанного электронного состояния в КЯ.
В пятой главе предложен активный элемент униполярного полупроводникового лазера, основанный на эффекте трансформации размерности электронных состояний в КЯ с асимметричными по высоте барьерами. Действительно, если нижняя лазерная подзона в таком активном элементе имеет точку 2D-3D трансформации при малых продольных импульсах, то можно подавить однофононные безызлучательные переходы в нее с верхней лазерной подзоны. Такие переходы являются основным механизмом безызлучательной рекомбинации между параллельными лазерными подзонами в униполярных лазерах, не позволяя увеличить время этого процесса выше 1,5?2 пс. Увеличение этого времени важно для повышения эффективности униполярного лазера. Исследован активный элемент на основе КЯ GaAs/AlGaAs, сконструированный для межподзонной оптической накачки (так называемый фонтанный режим), хотя полученные результаты могут быть использованы и в инжекционном униполярном лазере.
|
|
Рис. 5.1. Зонная диаграмма активного элемента униполярного лазера на основе КЯ с асимметричными барьерами (а); Спектры ФЛ многопериодной структуры GaAs/AlGaAs с асимметричными барьерами, на вставке - разложение пика с максимумом при 1,5589 эВ на гауссовы контуры (б). |
|
В з 5.2 описана оптимизация активного элемента на основе расчетов времен межподзонной релаксации с участием оптических фононов и дипольных матричных элементов Z13 и Z23 (первый должен быть большим для повышения эффективности оптической накачки, большая величина второго обеспечивает эффективную излучательную релаксацию). На Рис. 5.1а показана зонная диаграмма оптимизированного активного элемента. Он включает (в направлении подложки) легированный Si барьер nAl0,35Ga0,65As (ND = 1,0Х1017 см-3) шириной 5 нм; КЯ1 GaAs шириной 8,2 нм; барьер Al0,35Ga0,65As шириной 1,4 нм; КЯ2 GaAs шириной 4,9 нм, легированную Si (ND = 1,0Х1017 см-3); барьер Al0,35Ga0,65As шириной 3,0 нм; КЯ3 GaAs шириной 2,5 нм; низкий барьер Al0,09Ga0,91As шириной 36 нм и высокий барьер Al0,35Ga0,65As шириной 15 нм. Основное состояние ![]() аи верхняя лазерная подзона
аи верхняя лазерная подзона ![]() алокализованы в КЯ1, нижняя лазерная подзона
алокализованы в КЯ1, нижняя лазерная подзона ![]() - в КЯ2. Верхней лазерной подзоной
- в КЯ2. Верхней лазерной подзоной ![]() аслужит восьмое электронное состояние, так как состояния с третьего по седьмое локализованы преимущественно в области низкого барьера. Барьер между КЯ2 и КЯ3 препятствует паразитному переходу между лазерными подзонами через состояния квазинепрерывного спектра и позволяет повысить степень локализации в КЯ2 подзоны
аслужит восьмое электронное состояние, так как состояния с третьего по седьмое локализованы преимущественно в области низкого барьера. Барьер между КЯ2 и КЯ3 препятствует паразитному переходу между лазерными подзонами через состояния квазинепрерывного спектра и позволяет повысить степень локализации в КЯ2 подзоны ![]() , обладающей свойством 2D-3D трансформации. Уровень легирования структуры и распределение легирующей примеси подобраны таким образом, чтобы концентрация носителей в нижней подзоне
, обладающей свойством 2D-3D трансформации. Уровень легирования структуры и распределение легирующей примеси подобраны таким образом, чтобы концентрация носителей в нижней подзоне ![]() асоставляла Ns = 1011 см-2 и обеспечивалось условие плоских зон для низкого барьера.
асоставляла Ns = 1011 см-2 и обеспечивалось условие плоских зон для низкого барьера.
Описанная структура предназначена для межподзонного возбужения излучением CO2 лазера, поэтому разница энергий подзон ![]() аи
аи ![]() асоставляет 121 мэВ. Структура должна генерировать лазерное излучение с длиной волны 15 мкм. Расчеты показывают, время безызлучательной релаксации между лазерными подзонами превышает 6 пс, что в 4 раза больше, чем для фонтанного лазера с симметричными барьерами [12], время ухода с верхней лазерной подзоны на первое состояние квазинепрерывного спектра t3c1 достигает 3,83 пс, произведение Z13ХZ23, определяющее усиление, превышает 200 A2, а расстояние между нижней лазерной подзоной и основным состоянием близко к энергии LO фонона, что обеспечивает быстрое (за время 0,5 пс) опустошение нижней лазерной подзоны. Указанные параметры облегчают реализацию инверсной населенности.
асоставляет 121 мэВ. Структура должна генерировать лазерное излучение с длиной волны 15 мкм. Расчеты показывают, время безызлучательной релаксации между лазерными подзонами превышает 6 пс, что в 4 раза больше, чем для фонтанного лазера с симметричными барьерами [12], время ухода с верхней лазерной подзоны на первое состояние квазинепрерывного спектра t3c1 достигает 3,83 пс, произведение Z13ХZ23, определяющее усиление, превышает 200 A2, а расстояние между нижней лазерной подзоной и основным состоянием близко к энергии LO фонона, что обеспечивает быстрое (за время 0,5 пс) опустошение нижней лазерной подзоны. Указанные параметры облегчают реализацию инверсной населенности.
Параграф 5.3 посвящен экспериментальной проверке идей, заложенных в конструкцию активного элемента. Представлены данные ФЛ для одиночной КЯ GaAs шириной 2,5 нм с симметричными барьерами Al0,4Ga0,6As, ширина верхнего из которых (40 нм) с хорошим приближением могла считаться бесконечной, а ширина нижнего, более близкого к подложке, в разных образцах варьировалась в интервале b = 4?10 нм. При сужении барьера продемонстрирована возможность варьировать время жизни связанного электронного состояния в широких пределах. Получено изменение времени жизни связанного электронного состояния между двумя предельными случаями, когда оно определяется туннелированием из КЯ через узкий барьер (b = 4 нм) и когда доминирует излучательная рекомбинация (b = 8 нм).
Сравнение спектров ФЛ одиночной КЯ GaAs шириной 4 нм, окруженной асимметричными барьерами Al0,4Ga0,6As и Al0,06Ga0,94As, и аналогичной структуры с дополнительной туннельно связанной КЯ с симметричными барьерами свидетельствует о том, что состояние в КЯ с симметричными барьерами, находящееся в резонансе с состоянием в КЯ с асимметричными барьерами, позволяет значительно повысить степень локализации электронной ВФ в последней при нулевом волновом векторе. Эта степень локализации определяет силу осциллятора лазерного перехода. В то же время, критический волновой вектор для 2D?3D трансформации размерности электронного состояния меняется при этом незначительно.
В з 5.4 представлены результаты исследований ФЛ в двухъямной структуре с КЯ GaAs шириной 5,3 и 2,8 нм, разделенными барьером Al0,35Ga0,65As толщиной 4 нм и окруженными асимметричными барьерами Al0,35Ga0,65As и Al0,09Ga0,91As, во внешнем электрическом поле. Подобные исследования для структур с асимметричными барьерами представляют значительный интерес в силу ожидаемого антикроссинга уровней в сложных системах и выхода электронного состояния в КЯ с асимметричными барьерами в непрерывный спектр, а также из-за возможности реализации рассматриваемой ситуации в инжекционном униполярном лазере. Показано, что внешнее электрическое поле позволяет управлять размерностью нижнего электронного состояния. Развит оригинальный метод расчета электронного спектра структур с переменной размерностью электронных состояний, учитывающий вклад непрерывного спектра.
Особенности ФЛ трехъямных структур с асимметричными барьерами обсуждаются в з 5.5. Активная область структур, представляющих собой прототип активного элемента униполярного лазера, была заключена между барьерами Al0,35Ga0,65As и включала слои со следующими номинальными параметрами: КЯ GaAs шириной 8,2 нм, барьер Al0,35Ga0,65As шириной 1,4 нм, КЯ GaAs шириной 5,1 нм, барьер Al0,35Ga0,65As шириной 3,0 нм, КЯ GaAs шириной 2,5 нм и низкий барьер Al0,09Ga0,91As шириной 34,0 нм. Показано, что приложение к структурам внешнего электрического поля позволяет получить эффект, аналогичный трансформации размерности состояний в структуре с оптимальными параметрами.
Результаты экспериментальных исследований многопериодного активного элемента униполярного лазера с асимметричными барьерами представлены в з 5.6. Структура активного элемента описана в з 5.2. Насчитывающие 70 периодов активного элемента структуры были выращены в процессе МЛЭ. Активный элемент был заключен между верхними слоями GaAs толщиной 1750 нм и nAl0,35Ga0,65As (ND = 5Х1016 см-3) толщиной 30 нм и нижними слоями Al0,35Ga0,65As толщиной 15 нм, GaAs толщиной 750 нм и Al0,9Ga0,1As толщиной 5000 нм (обкладочный слой). Слои GaAs толщиной 1750 и 750 нм формировали волновод для ИК излучения. Чтобы приблизить квантово-размерную структуру к поверхности для зондирования ее видимым излучением при исследованиях ФЛ использовался образец, где верхний слой GaAs толщиной 1750 нм был заменен слоем GaAs толщиной 20 нм.
По данным рентгеновской дифракции, вариации периода структур не превышают 0,2 нм, а содержание AlAs в слоях соответствует заданному, т.е., 35 и 9,5%. В спектрах межзонной ФЛ структур доминирует вклад квантовой области с максимумом около 1,559 эВ (Рис. 5.1б). Разложение этого пика на гауссовы контуры позволяет выявить вклады переходов между первым состоянием электрона и первым (1,5586 эВ, c1-h1) и вторым (1,5716 эВ, c1-h2) состояниями тяжелой дырки. Энергии этих переходов с учетом энергии связи экситона соответствуют переходам в структуре с номинальными параметрами. Третий пик в спектре ФЛ при 1,5784 эВ обусловлен переходом между первым состоянием электрона и вторым состоянием тяжелой дырки (c1-h2) в части структуры, расположенной в приповерхностной области, в которой имеется встроенное поле, сдвигающее уровни размерного квантования. Узкий пик при 1,6354 эВ связан с переходом между четвертыми уровнями размерного квантования электронов и тяжелых дырок (c4-h4), при этом электронный уровень преимущественно локализован в низком барьере. Для изучения переходов из более высоких состояний были измерены также спектры возбуждения ФЛ при регистрации в области, отмеченной на Рис. 5.1б пунктирной стрелкой. Результаты этих измерений приведены на Рис. 5.2а вместе с результатами расчетов энергий переходов с учетом энергии связи экситона и соответствующих интегралов перекрытия ![]() , пропорциональных интенсивностям ФЛ. Видно неплохое согласие энергий наблюдаемых переходов с теоретическими расчетами для структуры с номинальными параметрами. Наиболее значимым является наблюдение межзонных переходов с участием электронных уровней c2 и c8 (заключены в рамки), т.к. c8 соответствует верхнему лазерному уровню
, пропорциональных интенсивностям ФЛ. Видно неплохое согласие энергий наблюдаемых переходов с теоретическими расчетами для структуры с номинальными параметрами. Наиболее значимым является наблюдение межзонных переходов с участием электронных уровней c2 и c8 (заключены в рамки), т.к. c8 соответствует верхнему лазерному уровню ![]() , а c2 ? нижнему лазерному уровню
, а c2 ? нижнему лазерному уровню ![]() .
.
|
|
Рис. 5.2. Спектры возбуждения ФЛ многопериодной структуры GaAs/AlGaAs и интегралы перекрытия для структуры с номинальными параметрами (а); Спектр поглощения той же структуры, на вставке - геометрия эксперимента (б). |
|
При анализе спектров ФЛ остается некоторая неопределенность, связанная с учетом энергии связи экситонов. Поэтому представляется интересным сопоставление с результатами измерений межподзонного ИК поглощения. На Рис. 5.2б представлена геометрия эксперимента по нарушенному многократному полному внутреннему отражению и спектр поглощения структуры. Наблюдаются переходы при энергиях 179,4, 161,2, 137,2 и 120,0 мэВ, которые хорошо согласуются с рассчитанными энергиями межподзонных переходов c4-c12 (c5-c13), c6-c13 (c2-c11), c5-c11 (c7-c13) и c1-c8 (c6-c11, c8-c13) соответственно. Наибольший интерес представляет наблюдение межподзонного перехода c1-c8 при 120 мэВ, так как он соответствует переходу ![]() -
-![]() , предназначенному для накачки излучением СО2 лазера. В то же время, в области 80 мэВ (15,5 мкм) не обнаружено межподзонного перехода c2-c8, что может служить косвенным подтверждением слабой заселенности лазерной подзоны
, предназначенному для накачки излучением СО2 лазера. В то же время, в области 80 мэВ (15,5 мкм) не обнаружено межподзонного перехода c2-c8, что может служить косвенным подтверждением слабой заселенности лазерной подзоны ![]() авследствие быстрой релакасации с нее в подзону
авследствие быстрой релакасации с нее в подзону ![]() , отстоящую на энергию оптического фонона.
, отстоящую на энергию оптического фонона.
Важными характеристиками исследуемых структур являются времена жизни электронов на верхнем и нижнем лазерных состояниях, так как они определяют возможность реализации инверсной населенности в предложенной конструкции активного элемента униполярного лазера. Для их исследования использовался перестраиваемый лазер титан-сапфир и стрик-камера в качестве детектора. Эксперименты по исследованию кинетики ФЛ были выполнены с временным разрешением лучше 8 пс. В первой конфигурации эксперимента возбуждение осуществлялось при энергии, соответствующей расстоянию между первым дырочным уровнем и верхним лазерным состоянием (c8-h1). Энергия регистрации варьировалась от энергии между первыми дырочным и электронным уровнем (c1-h1) до энергии, отвечающей положению узкого пика в спектре ФЛ. Этот пик связан с переходом между четвертым уровнем размерного квантования электронов, локализованным в низком барьере, и четвертым дырочным уровнем (c4-h4). C приближением энергии регистрации к переходам с участием нижнего лазерного состояния c2 время рекомбинации уменьшается от значений, соответствующих межзонной рекомбинации (288 пс), до 9 пс, т.е., время жизни на верхнем лазерном уровне ![]() адостигает 9 пс. По мере приближения энергии регистрации к переходу c4-h4 время релаксации возрастает до 38 пс. Таким образом, дополнительный барьер действительно препятствует каскадному переходу между лазерными подзонами через состояния квазинепрерывного спектра.
адостигает 9 пс. По мере приближения энергии регистрации к переходу c4-h4 время релаксации возрастает до 38 пс. Таким образом, дополнительный барьер действительно препятствует каскадному переходу между лазерными подзонами через состояния квазинепрерывного спектра.
Во второй конфигурации энергия возбуждения немного превышала расстояние по энергии между вторым дырочным уровнем и нижним лазерным состоянием (c2-h2). Обнаружено, что при приближении энергии регистрации к энергии между первым дырочным уровнем и нижним лазерным состоянием (c2-h1) время рекомбинации уменьшается до значений, меньших используемого временного разрешения, т.е., меньше 8 пс. Таким образом, время жизни на верхнем лазерном уровне ![]() асоставляет 9 пс и превышает время жизни на нижнем лазерном уровне
асоставляет 9 пс и превышает время жизни на нижнем лазерном уровне ![]() , что обеспечивает инверсную населенность в такой системе.
, что обеспечивает инверсную населенность в такой системе.
В Заключении отмечено, что в диссертационной работе оптическими методами проведены исследования широкого круга гетероструктур с квантово-размерными слоями. Исследования объединены единым подходом, основанным на анализе локализации волновых функций в исследуемых структурах. Сформулированы также основные результаты работы:
- Методом спектроскопии РКР подтверждена теоретически предсказанная возможность локализации электронных состояний в барьерах СР GaAs/AlxGa1?xAs. Обнаружен эффект передислокации электронных возбуждений из барьеров в квантовые ямы при сужении барьеров.
- Показано, что метод спектроскопии РКР эффективен для тестирования локализации электронной ВФ в квантово-размерных структурах.
- Обнаружен перенос электронов в реальном пространстве между X- и ?-долинами зоны проводимости в структурах множественных КЯ GaAs/AlxGa1?xAs с широким барьерными слоями.
- Обнаружен зависящий от температуры сдвиг резонансной частоты в спектрах узких КЯ GaAs/AlxGa1?xAs, обусловленный локализацией носителей заряда при низких температурах на макроскопических (возникших при выращивании методом МЛЭ с прерываниями роста на гетерограницах) флуктуациях ширины квантовой ямы. На температурной зависимости положения пика фотолюминесценции для узкой квантовой ямы обнаружен излом, который соответствует точке, где тепловая энергия носителей заряда при понижении температуры становится меньше средней величины дисперсии энергий основного состояния, обусловленной флуктуациями ширины КЯ.
- В рамках квазиклассического приближения развита общая теория межзонной спонтанной рекомбинации двумерных носителей заряда в структурах КЯ с макроскопическими шероховатостями границ раздела. Показано, что из анализа экспериментальной формы линии ФЛ можно получить функцию распределения макроскопических флуктуаций на гетерограницах.
- Показано, что узкие эквидистантные пики, зарегистрированные в спектрах микрофотолюминесценции СР GaAs/AlxGa1?xAs, являются следствием формирования электронных состояний нового типа в структурах типа КТ, возникающих в результате перекрытия флуктуаций ширины соседних КЯ. Эквидистантный спектр новых состояний объясняется близкой к квадратичной зависимостью поперечника областей перекрытия и, соответственно, ширины эффективной КЯ, от координаты в плоскости слоев.
- Развит приближенный метод расчета электронного спектра КТ произвольной формы, основанный на сведении трехмерной задачи к одномерной. Решена обратная задача нахождения профиля КТ (проволоки), обладающей эквидистантым спектром.
- Обнаружен эффект резкого изменения энергии ионизации примеси при передислокации электронной ВФ в системе КЯ во внешнем электрическом поле. Благодаря этому эффекту, в диапазоне напряженностей поля 25?40 КВ/см энергия ионизации донорной примеси Si в двухъямной структуре GaAs/AlxGa1?xAs уменьшается от 15,5 мэВ до нуля.
- В спектрах ФЛ двухъямных гетероструктур GaAs/AlxGa1?xAs с ?-легированием в центре одной из КЯ обнаружены аномально большие интенсивности экситонных переходов c2?h1 и c1?h2 по сравнению с интенсивностью экситонного пика c1?h1, что объясняется локализацией ВФ для первых подзон размерного квантования электронов и тяжелых дырок в разных КЯ из-за встроенного поля в структуре.
- Обнаружена 2D-3D трансформация размерности экситонных состояний в структурах одиночных КЯ GaAs/AlxGa1-xAs с сильно асимметричными по высоте барьерами с ростом внешнего электрического поля. Показано, что модель квазинепрерывного спектра позволяет корректно описать все участки экспериментальной зависимости положения пика экситона одиночной КЯ с сильно асимметричными по высоте барьерами от приложенного к структуре напряжения при учете энергетической релаксации в квазинепрерывном спектре и туннелирования через треугольный барьер.
- Предложен, оптимизирован и реализован активный элемент униполярного лазера на основе структур квантовых ям GaAs/AlxGa1-xAs с сильно асимметричными по высоте барьерами, отличающийся эффективным подавлением безызлучательной релаксации между лазерными подзонами с участием оптического фонона за счет существования нижней лазерной подзоны лишь в ограниченной области волновых векторов k в плоскости слоев.
- Продемонстрирована возможность управления внешним электрическим полем размерностью нижней лазерной подзоны в активном элементе униполярного лазера на основе структур квантовых ям GaAs/AlxGa1-xAs с сильно асимметричными по высоте барьерами.
- Экспериментально доказано, что время безызлучательной релаксации между лазерными подзонами в созданном нами многопериодном активном элементе униполярного лазера на основе структур квантовых ям GaAs/AlxGa1-xAs с сильно асимметричными по высоте барьерами достигает 9 пс и превышает время безызлучательной релаксации с нижней лазерной подзоны, что обеспечивает инверсную населенность в такой системе.
Список основных публикаций по теме диссертации
[A1] Алещенко Ю.А., Заварицкая Т.Н., Капаев В.В., Копаев Ю.В., Мельник Н.Н. Резонансное комбинационное рассеяние света и эффекты передислокации в сверхрешетках GaAs/AlGaAs // Письма в ЖЭТФ. - 1994. - Т. 59, № 4 - С. 235Ц239.
[А2] Алещенко Ю.А., Заварицкая Т.Н., Капаев В.В., Копаев Ю.В., Мельник Н.Н. Фотолюминесценция при умеренных уровнях возбуждения и резонансное комбинационное рассеяние света в сверхрешетках GaAs/AlGaAs // ФТП. - 1996. - Т. 30, № 5 - С. 812?819.
[А3] Aleshchenko Yu.A., Gorbatsevich A.A., Tokatly I.V. Optical properties of quantum-scale structures with randomly inhomogeneous heteroboundaries // Phys. Low-Dim. Struct. - 1996. - V. 7/8 ? P. 137?152.
[А4] Aleshchenko Yu.A., Kapaev V.V., Kopaev Yu.V., MelТnik N.N. Equidistatnt spectrum of fluctuation states in heterostructures // Abstracts of invited lectures and contributed papers ofа Int. Symp. УNanostructures: Physics and TechnologyФ (St.Petersburg, Russia, June 24?28, 1996), P. 95?98.
[А5] Алещенко Ю.А., Капаев В.В., Копаев Ю.В., Мельник Н.Н. Обусловленный флуктуациями параметров эквидистантный спектр локализованных состояний в квантово-размерных структурах // Письма в ЖЭТФ. - 1996. - Т. 63. В. 4 - С. 260?265.
[А6] Aleshchenko Yu.A., Kapaev V.V., Kopaev Yu.V., MelТnik N.N. Geometrical parameter fluctuations and localized electronic states in quantum-scale structures // Semicond. Sci. Technol. - 1997. ? V. 12, No. 12 - P. 1565?1573.
[А7] Aleshchenko Yu.A., Kazakov I.P., Kapaev V.V., Kopaev Yu.V., Kornyakov N.V., Tyurin A.E. Interference ionization of impurity by electric field in coupled quantum wells // Semicond. Sci. Technol. - 2000. ? V. 15, No. 6 - P. 579?583.
[А8] Алещенко Ю.А., Казаков И.П., Капаев В.В., Копаев Ю.В., Корняков Н.В., Тюрин А.Е. Интерференционная ионизация примеси электрическим полем в системе квантовых ям // Письма в ЖЭТФ. - 1999. - Т. 69, В. 3 ? С. 194?199.
[А9] Aleshchenko Yu.A., Kazakov I.P., Kapaev V.V., Kopaev Yu.V., Kornyakov N.V., Tyurin A.E. Electric field induced interference impurity ionization in coupled quantum wells // Proc. 7th Int. Symp. УNanostructures: Physics and TechnologyФ (St.Petersburg, Russia, June 14?18, 1999), P. 344?347.
[А10] Алещенко Ю.А., Казаков И.П., Капаев В.В., Копаев Ю.В., Корняков Н.В., Тюрин А.Е. Интерференционная ионизация примеси электрическим полем в туннельно связанных квантовых ямах // Тезисы докладов IV Всероссийской конференции по физике полупроводников ПолупроводникиТ99 (Новосибирск, 25?29 октября 1999 г.), С. 39.
[А11] Kopaev Yu.V., Aleshchenko Yu.A., Kapaev V.V., Tokatly I.V. Electric and magnetic field dependent dimensionality of electronic states in quantum-scale semiconducting and superconducting geterostructures // International Journal of Modern Physics B. - 1998. ? V. 12, Nos. 29?31 - P. 2932?2934.
[А12] Алещенко Ю.А., Казаков И.П., Капаев В.В., Копаев Ю.В. Трансформация размерности экситонных состояний в квантовых ямах с несимметричными барьерами в электрическом поле // Письма в ЖЭТФ. - 1998. - Т. 67, В. 3 ? С. 207?211.
[А13] Алещенко Ю.А., Капаев В.В., Копаев Ю.В. Изменение размерности экситонных состояний в квантовых ямах с асимметричными барьерами во внешнем электрическом поле // Тезисы докладов III Всероссийской конференции по физике полупроводников ПолупроводникиТ97 (Москва, 1?5 декабря 1997 г.), С. 245.
[А14] Aleshchenko Yu.A., Kazakov I.P., Kapaev V.V., Kopaev Yu.V., Tyurin A.E. Electric field dependent dimensionality of excitonic states in single quantum well structures with symmetric barriers // Proc. 6th Int. Symp. УNanostructures: Physics and TechnologyФ (St.Petersburg, Russia, June 22?26, 1998), P. 362?365.
[А15] Алещенко Ю.А., Капаев В.В., Копаев Ю.В. Униполярные полупроводниковые лазеры на асимметричных квантовых ямах // Тезисы докладов IV Российской конференции по физике полупроводников ПолупроводникиТ99 (Новосибирск, 25?29 октября 1999 г.), С. 346.
[А16] Aleshchenko Yu.A., Kapaev V.V., Kopaev Yu.V. Unipolar semiconductor lasers on asymmetric quantum wells // Book of Abstracts of Int. Conf. УAdvanced Laser TechnologiesФ УALTТ99Ф (Potenza-Lecce, Italy, September 20?24, 1999).
[А17] Aleshchenko Yu.A., Kapaev V.V., Kopaev Yu.V., Kornyakov N.V. Unipolar semiconductor lasers on asymmetric quantum wells // Nanotechnology. - 2000. - V. 11 ? P. 206?210.
[А18] Алещенко Ю.А., Капаев В.В., Копаев Ю.В. Униполярные полупроводниковые лазеры на асимметричных квантовых ямах // Материалы Всероссийского совещания Нанофотоника (Нижний Новгород, 15?18 марта 1999 г.), С. 44?46.
[А19] Aleshchenko Yu.A., Kapaev V.V., Kopaev Yu.V. Unipolar semiconductor lasers on asymmetric quantum wells // Proc. SPIE. - 2000. - V. 4070, No. 2 ? P. 132?137.
[А20] Aleshchenko Yu.A., Kapaev V.V., Kopaev Yu.V., Kornyakov N.V. Unipolar semiconductor lasers on asymmetric quantum wells // Proc. 8th Int. Symp. УNanostructures: Physics and TechnologyФ (St.Petersburg, Russia, June 19?23, 2000), P. 19?22.
[А21] Aleshchenko Yu.A., Kapaev V.V., Kopaev Yu.V., KopТev P.S., Ustinov V.M., Zhukov A.E. Specific features of the behavior of electronic states in GaAs/AlGaAs double quantum well structure with strongly asymmetric barriers in an external electric field // Proc. 11th Int. Symp. УNanostructures: Physics and TechnologyФ (St.Petersburg, Russia, June 23?28, 2003), P. 21?22.
[А22] Алещенко Ю.А., Капаев В.В., Копаев Ю.В., Копьев П.С., Устинов В.М., Жуков А.Е. Особенности поведения электронных состояний в квантовых ямах с асимметричными по высоте барьерами в электрическом поле // Тезисы докладов VI Российской конференции по физике полупроводников Полупроводники 2003 (Санкт-Петербург, 27?31 октября 2003 г.), С. 299?300.
[А23] Алещенко Ю.А., Жуков А.Е.,а Капаев В.В., Копаев Ю.В., Копьев П.С., Устинов В.М. Особенности перестройки электронного спектра двухъямной гетероструктуры GaAs/AlGaAs с переменной размерностью электронных состояний во внешнем электрическом поле // ЖЭТФ. - 2004. - Т. 125, В. 4 ? С. 879 ? 890.
[А24] Aleshchenko Yu.A., Kapaev V.V., Kopaev Yu.V., KopТev P.S., Ustinov V.M., Zhukov A.E. Behavior of electron states in GaAs/AlGaAs double quantum well structure with strongly asymmetric barriers in an external electric field // International Journal of Nanoscience. - 2004. - V. 3, Nos. 1 & 2 ? P. 203?211.
[А25] Aleshchenko Yu.A., Kapaev V.V., Kopaev Yu.V., KopТev P.S., Ustinov V.M., Zhukov A.E. Control of the population of the upper laser level in quantum well structures with strongly asymmetric barriers by the electric field // Proc. 13th Int. Symp. УNanostructures: Physics and TechnologyФ (St. Petersburg, Russia, June 20?25, 2005), P. 94?95.
[А26] Алещенко Ю.А., Жуков А.Е., Капаев В.В., Копаев Ю.В., Копьев П.С., Устинов В.М. Управление заселенностью верхней рабочей подзоны в структурах униполярного лазера электрическим полем // Тезисы докладов VII Российской конференции по физике полупроводников Полупроводники 2005 (Москва, Звенигород, 18-23 сентября 2005 г.), С. 212.
[А27] Алещенко Ю.А., Жуков А.Е., Капаев В.В., Копаев Ю.В., Копьев П.С., Устинов В.М. Управление заселенностью верхней рабочей подзоны электрическим полем в структурах с асимметричными барьерами для униполярного лазера // ФТП. - 2008. - Т. 42, В. 7 - С. 856?863.
[А28] Алещенко Ю.А., Капаев В.В., Копаев Ю.В. Униполярные полупроводниковые лазеры на гетероструктурах с переменной размерностью электронных состояний // Труды Симпозиума по когерентному оптическому излучению полупроводниковых соединений и структур (Москва, Звенигород, 28-30 ноября 2007 г.), Издательство ФИАН, C. 171?182 (2008).
[А29] Алещенко Ю.А., Капаев В.В., Копаев Ю.В. Униполярные лазеры на полупроводниковых гетероструктурах с переменной размерностью электронных состояний // Тезисы докладов Симпозиума Полупроводниковые лазеры: физика и технология (Санкт-Петербург, 5-7 ноября 2008 г.), С. 12.
[А30] Алещенко Ю.А., Капаев В.В., Копаев Ю.В. Многопериодная структура для фонтанного режима генерации униполярного лазера // Труды II Симпозиума по когерентному оптическому излучению полупроводниковых соединений и структур (Москва, Звенигород, 16-18 ноября 2009 г.), Издательство ФИАН, С. 39?48 (2010).
[А31] Алещенко Ю.А., Капаев В.В., Копаев Ю.В., Садофьев Ю.Г., Скориков М.Л. // Многопериодная структура для фонтанного режима генерации униполярного лазера, Квантовая электроника. - 2010. - Т. 40, N 8 - С. 685-690.
[А32] Aleshchenko Yu.A., Kapaev V.V., and Kopaev Yu.V. Structures with variable dimensionality of electronic states for unipolar lasers // Journal of Russian Laser Research. - 2010. - V. 31, No. 6 - P. 533-553.
[А33] Алещенко Ю.А., Капаев В.В., Копаев Ю.В. Многопериодные структуры с асимметричными барьерами как прототип активного элемента униполярного лазера // Тезисы докладов 2-го Российского симпозиума Полупроводниковые лазеры: Физика и технология (Санкт Петербург, 10-12 ноября 2010 г.), Издательство Политехнического университета, С. 13.
[А34] Aleshchenko Yu.A., Kapaev V.V., and Kopaev Yu.V. Unipolar lasers on the structures with variable dimensionality of electronic states // Semiconductor Science and Technology. - 2011. - V. 26, No. 1 - P. 014021-1Ц13.
[А35] Алещенко Ю.А., Капаев В.В., Копаев Ю.В., Кочиев М.В., Цветков В.А. Времена жизни электронов в многопериодных структурах квантовых ям с асимметричными барьерами // Х Российская конференция по физике полупроводников (Нижний Новгород, 19-23 сентября 2011 г.), Тезисы конференции, С. 48.
[А36] Алещенко Ю.А., Капаев В.В., Копаев Ю.В. Времена межподзонной безызлучательной релаксации в многопериодных структурах квантовых ям с асимметричными барьерами // III Симпозиум по когерентному оптическому излучению полупроводниковых соединений и структур (Москва - Звенигород, 28-30 ноября 2011), Тезисы докладов, С. 13-14.
Список цитируемой литературы
[1] Алферов Ж.И., Нобелевская лекция по физике 2000 // УФН, 2002, т. 172, с. 1068Ц1086.
[2] Кремер Г., Нобелевская лекция по физике 2000 // УФН, 2002, т. 172, с. 1091Ц1110.
[3] Faist J., Capasso F., Sivco D.L., Sirtori C., Hutchinson A.L., Chu S.N.G., Cho A.Y. Quantum cascade laser // Science. - 1994 - V. 264, No. 5158 - P. 553?556.
[4] Казаринов Р.Ф., Сурис Р.А. О возможности усиления электромагнитных волн в полупроводнике со сверхрешеткой // ФТП. ? 1971. ? Т. 5, В. 4 - С. 797?800.
[5] Bastard G., Delalande C., Meynadier M.H., Frijlink P.M., Voos M. Low-temperature exciton trapping on interface defects in semiconductor quantum wells // Phys. Rev. B. - 1984. - V. 29, No. 12 - P. 7042?7044.
[6] Tu C.W., Miller R.C., Wilson B.A., Petroff P.M., Harris T.D., Kopf R.F., Sputz S.K., Lamont M.G. Properties of (Al,Ga)As/GaAs heterostructures grown by molecular beam epitaxy with growth interruption // J. Cryst. Growth. - 1987. - V. 81, Nos. 1Ц4 - P. 159?163.
[7] Warwick C.A., Jan W.Y., Ourmazd A., Harris T.D. Does luminescence show semiconductor interfaces to be atomically smooth? // Appl. Phys Lett. - 1990. - V. 56, No. 26 - P. 2666?2668.
[8] Дмитриев А.Г. Температурная зависимость ширины запрещенной зоны GaAs // ФТП. - 1995. - Т. 29, № 3 - С. 442?447.
[9] Белявский В.И., Копаев Ю.В., Корняков Н.В., Шевцов С.В. Эффект изменения энергии ионизации примесей при передислокации волновых функций в системе квантовых ям // Письма в ЖЭТФ. ? 1995. ? Т. 61, В. 12 - С. 1004?1009.
[10] van der Ziel J.P., Tang X., Johnson R. Optical studies of very high-purity GaAs grown by metal-organic chemical-vapor deposition using a point-of-use arsine (AsH3) generator // Appl. Phys. Lett. - 1997. V. 71, No. 6 ? P. 791?793.
[11] Капаев В.В., Копаев Ю.В. Зависимость от импульса размерности электронных состояний в гетероструктурах // Письма в ЖЭТФ. ? 1997. ? Т. 65, В. 2 - С. 188?193.
[12] Gauthier-Lafaye O., Sauvage S., Boucaud P., Julien F.H., Glotin F., Prazeres R., Ortega J.-M., Thierry-Mieg V., Planel R. Investigation of mid-infrared intersubband stimulated gain under optical pumping in GaAs/AlGaAs quantum wells // J. Appl. Phys. - 1998. - V. 83, No. 6 - P. 2920?2926.
 Авторефераты по темам >>
Разные специальности - [часть 1] [часть 2]
Авторефераты по темам >>
Разные специальности - [часть 1] [часть 2]